Electronics
Innovating across frequencies, materials, and microsystems
Staff
Publications
2026
Yalagala, B. P., Tanwear, A., Cerezo-Sánchez, M., Parvizi, H., Amjadi, M., Heidari, H. (2026) Large-scale and cost-effective fabrication of ultra-thin, biodegradable microelectrode arrays and pressure sensors using laser micromachining. Advanced Materials Technologies,
Hassouna, S., Zubair, M., Raza, A., Ahmed, M., Kazim, J., Imran, M. A., Abbasi, Q. H. (2026) RISCS: RIS-aided integrated sensing and communications – a cyber-physical security perspective. IEEE Transactions on Consumer Electronics,
Dwidar, M., Li, Q., Tian, L., Shi, J., Cheng, H., Mitchell, J., Ashraf, H., Al-Khalidi, A., Wasige, E., Li, C. (2026) Experimental and Numerical Investigation on the Effects of the Stress of SiN Passivation on AlGaN/GaN Heterostructures and Their Surface.
Serghiou, T., Morais, R., Vieira, D. H., Alves, N., Parvizi, R., Kettle, J. (2026) Biodegradable and bio-inspired UV light recognition via sustainable synaptic transistors for artificial intelligence vision systems. Advanced Intelligent Systems, (doi: 10.1002/aisy.202501338)
Alshehhi, A., Abbasi, Q. H., Ghannam, R. (2026) Photoplethysmography for measuring cognitive load in XR environments: a systematic review. Advanced Sensor Research,
Asadullah, *, Shoaib, N., Khan, M. U., Ahmed, A., Aburas, A. A., Abbasi, Q. H. (2026) Dual-band composite high gain MIMO antenna for 5G NR applications employing shareable small cell radio unit. Scientific Reports, (doi: 10.1038/s41598-026-39955-w)
Shojaei Baghini, M., McKinlay, M., Mukherjee, D., Garcia Nunez, C., Heidari, H. (2026) S-Band FeGa/ZnO Magnetoelectric Resonating Antennas for Ultra-Compact Microwave Devices.
Saunders, K., Herffurth, T., Bublitz, S., Mühlig, C., Munser, A.-S., Herguedas, E., Redondo, A., Gibson, D., Clark, C., Garcia Nunez, C., Schröder, S. (2026) Optical losses in SiNx and SiOxNy coatings deposited by plasma-enhanced chemical vapor deposition for gravitational wave detectors. Applied Optics, 65, pp. A187-A200. (doi: 10.1364/AO.578011)
Lindsay, C., Garcia Nuñez, C., Fleming, L., Brinkley, I., Pomfret, J., Mazur, M., Kot, M., Zhu, W., Saunders, K., Reid, S., Herguedas, E., Redondo-Cubero, A., Gibson, D. (2026) Optical, composition, durability, and environmental properties of the microwave plasma-assisted sputter-deposited silicon nitride. Applied Optics, 65, pp. A176-A186. (doi: 10.1364/ao.578043)
Bertoldo, L. H. T., Ozório, M., Vieira, D. H., Morais, R. M., Rollo, A., Kettle, J., Alves, N. (2026) Sustainable manufacturing of fully printed Zn/ZnO/CNT Schottky diodes on kraft paper. ACS Applied Electronic Materials, 8, pp. 1088-1098. (doi: 10.1021/acsaelm.5c02004)
Bruce, N., Wagih, M. (2026) Simulated in-vivo implantable antenna measurements in gel phantoms and human subjects: channel gain, directivity, and RSSI. IEEE Antennas and Propagation Magazine, 68, pp. 62-115. (doi: 10.1109/MAP.2025.3630872)
Owen‐Newns, D., Robertson, J., Donati, G., Al-Taai, Q., Figueiredo, J., Wasige, E., Lüdge, K., Romeira, B., Hurtado, A. (2026) Neuromorphic photonic processing and memory with spiking resonant tunneling diode neurons and neural networks. Advanced Intelligent Systems, (doi: 10.1002/aisy.202500800)
Na, X., Zhang, J., Chen, Z., Selamneni, V., Chen, H., Heidari, H., Amjadi, M. (2026) Programmable multifunctional bistable structures for energy transfer and dissipation. Advanced Science, (doi: 10.1002/advs.202518883)
Kumar Chaudhary, V., Zubair, M., Ur-Rehman Kazim, J., Imran, M., Abbasi, Q. H. (2026) Non-destructive testing for composite materials: methods, challenges, and future outlook. IEEE Sensors Review, (doi: 10.1109/SR.2026.3661000)
Lai, K. T., Tapar, J., Harrison, P. D., Wu, S., Elksne, M., Hu, C., Pusino, V., Cumming, D. R.S. (2026) Paper-based short-wave infrared spectroscopy for glucose quantification with human serum. Sensors and Actuators B: Chemical, 448, (doi: 10.1016/j.snb.2025.138963)
Shojaei Baghini, M., Gyoreva, K., Nekoeian, D., Ofiare, A., Heidari, H. (2026) Planar by Print: Nanoparticle Ink-Bonded Magnetoelectric Antennas.
Huang, H., Abbas, H. (2026) From PSNR to frequency evidence: evaluating super-resolution reliability on low-SNR fluorescence channels. Photonics, 13, (doi: 10.3390/photonics13020143)
Beniwal, A., Gond, R., Karagiorgis, X., Rawat, B., Li, C. (2026) Sustainable, flexible and ambient temperature operated polyaniline-based chemiresistive ammonia sensor with eco-friendly design. IEEE Sensors Letters, 10, (doi: 10.1109/LSENS.2026.3656224)
Rizvi, N. R., Ahmad, M., Shafique, A., Heidari, H., Weides, M., Imran, M. A. (2026) A survey of microwave-implemented superconducting qubit control and readout circuits. IEEE Transactions on Quantum Engineering, (doi: 10.1109/TQE.2026.3659400)
Chen, B., Macdonald, S., Attallah, M., Chapman, P., Ghannam, R. (2026) A review of prototyping in extended reality: linking immersive design to physical fabrication. IEEE Transactions on Visualization and Computer Graphics, (doi: 10.1109/TVCG.2026.3658829)
Harwell, J. R., Zhang, T., Rollo, A., Wagih, M., Kettle, J. (2026) Additively manufacturing printed circuit boards with low waste footprint by transferring electroplated zinc tracks. Communications Materials, 7, (doi: 10.1038/s43246-025-01031-7)
Tariq, F., Hameed, H., Malik, T., Mollel, M., Imran, M. A., Abbasi, Q. H. (2026) Hybrid ResNet–Vision Transformer ensemble for early glaucoma detection from fundus images. IEEE Sensors Journal, (doi: 10.1109/JSEN.2025.3650333)
Akram, Z., Elsayed, M., Hameed, H., Ali, M. S., Kazim, J. u. R., Imran, M. A., Abbasi, Q. H. (2026) A scalable and integrated reconfigurable intelligent surface. Advanced Electronic Materials, 12, (doi: 10.1002/aelm.202500674)
Huang, H., Abbas, H. (2026) Cross-modality guided super-resolution for weak-signal fluorescence imaging via a multi-channel SwinIR framework. Electronics, 15, (doi: 10.3390/electronics15010204)
Wagih, M., Chattopadhay, S. (2026) Sustainable and circular microwave systems: importance and a strategic perspective [Speaker’s Corner] IEEE Microwave Magazine, 27, pp. 112-115. (doi: 10.1109/MMM.2025.3621544)
Wu, S., Pusino, V., Cumming, D. R.S. (2026) An angular dispersion-free resonant metasurface for quantum photon pair generation. EPJ Applied Metamaterials, 13, (doi: 10.1051/epjam/2025013)
Nawaz, M. W., Alam, M. M., Swash, R., Abbasi, Q. H., Imran, M. A., Popoola, O. (2026) Enhancing intelligence in multi-agent systems with edge-assisted causal knowledge aggregation. npj Wireless Technology, 2, (doi: 10.1038/s44459-025-00006-x)
Buttar, H. M., Ur Rahman, M. M., Nawaz, M. W., Mian, A. N., Zahid, A., Abbasi, Q. H. (2026) Non-contact lung disease classification via orthogonal frequency division multiplexing-based passive 6G integrated sensing and communication. Communications Medicine, 6, (doi: 10.1038/s43856-025-01181-2)
Chaudhary, V. K., Zubair, M., Ur-Rehman Kazim, J., Imran, M., Abbasi, Q. (2026) Performance of Flexible Gasper-Curve Based Microwave Array Sensor for Non-Destructive Testing of CFRP Composites.
2025
Zhang, J., Selamneni, V., Yalagala, B. P., King, B., Wang, J., Khurelbaatar, L., Garcia Nunez, C., Wagih, M., Amjadi Kolour, M., Heidari, H. (2025) Laser-engineered interfacial-dielectrophoresis aligned nanowire networks for transparent electromagnetic interference shielding films. ACS Nano, (doi: 10.1021/acsnano.5c13772)
Khusna, E.M., Zhong, M., Jiang, Y., Yi, Y., Li, C. (2025) Circuit-Based Analysis of Cross-Linked Metasurfaces: A Compact Model for Top and Side Incidence.
Zhong, M., Al-Taai, Q., Jiang, Y., Li, C., Brennan, J., Weides, M., Stanley, M., Ridler, N. (2025) Metasurface-based Lens Antenna for Quantum Computing Applications.
Shojaei Baghini, M., Armada-Moreira, A., Clemente, A. D., Mukherjee, D., Ofiare, A., Harwell, J., Dysko, M., Benetti, L., Bolster, D., Mazon Maldonado, L., Nekoeian, D., Maini, M., Elsayed, M., Cecchi, R., Ferreira, R., Kettle, J., Cochran, S., Holmes, W., Garcia Nunez, C., Selmi, L., Toschi, N., Giugliano, M., Heidari, H. (2025) Bio-integrated µBots with overtone ultra-wideband magnetoelectric antennas for wireless telemetry. arXiv, (doi: 10.48550/arXiv.2512.12311)
Hassouna, S., Kazim, J., Kizilkaya, B., Ansari, S., Nasir, A., Imran, M. A., Abbasi, Q. H. (2025) RIS-Assisted Open RAN for Real-Time Teleoperation.
Fang, X., Wagih, M. (2025) Sustainable, 3D-printed liquid metal reprogrammable resonator towards fully circular RF sensing and identification. IEEE Transactions on Microwave Theory and Techniques, (doi: 10.1109/TMTT.2025.3638629)
Lubna, L., Hameed, H., Liaqat, S., Abbasi, Q. H., Imran, M. A. (2025) Deep Learning-Driven Monitoring of Physiotherapy Steps Using UWB Radar Technology. (doi: 10.1109/AP-S/CNC-USNC-URSI55537.2025.11266483)
Ameer, A., Ghannam, R. (2025) Education in a changing climate: a systematic review for low and middle-income countries (LMICs) Sustainable Development, (doi: 10.1002/sd.70490)
Ishfaq, F., Khan Marwat, S. N., Khan, W. U., Shahzad, S., Khan, S., Abbasi, Q. H. (2025) A machine learning based empathy mapping framework for enhancing user experience through app review analysis. Scientific Reports, (doi: 10.1038/s41598-025-30729-4)
Zhong, M., Al-Taai, Q., Stanley, M., Barr, K., Brennan, J., Rossi, A., Ridler, N., Weides, M., Li, C. (2025) Metasurface for Wireless Quantum Computation.
Yalagala, B. P., Masalehdan, T., Ge, C., Kirimi, M. T., Mercer, J., Amjadi Kolour, M., Heidari, H. (2025) Lab to fab process using ablation lasers: a light weight, flexible and biocompatible microheaters for wearable therapy applications. ACS Applied Bio Materials, 8, pp. 9931-9946. (doi: 10.1021/acsabm.5c01263)
Ge, Y., Wang, J., Li, S., Yu, L., Tang, C., Imran, M. A., Abbasi, Q. H. (2025) Continuous AoA-ToF maps feature for single-pair WiFi sensing of human activity recognition. IEEE Sensors Journal, 25, pp. 42029-42040. (doi: 10.1109/JSEN.2025.3616769)
Arslan, M. M., Cui, T., Yang, X., Zhao, N., Shah, S. A., Abbasi, Q. H. (2025) WBAN sensing synergy protocol for IoMT: an optimized framework enhancing energy efficiency and bandwidth for scalable healthcare monitoring. IEEE Sensors Journal, 25, pp. 41946-41962. (doi: 10.1109/JSEN.2025.3615127)
Ishabakaki, P. A., Hameed, H., Farooq, M., Mollel, M., Abbas, H., Imran, M. A., Abbasi, Q. H. (2025) Non-invasive vital signs sensing: advances, challenges, and future directions in radio frequency based techniques. IEEE Open Journal of Antennas and Propagation, (doi: 10.1109/OJAP.2025.3632192)
Zhong, M., Al-Taai, Q., Jiang, Y., Li, C. (2025) An ultrathin broadband high efficiency terahertz metalens antenna. IEEE Transactions on Terahertz Science and Technology, (doi: 10.1109/TTHZ.2025.3631605)
Shojaei Baghini, M., Elsayed, M., McGlynn, E., Wang, H., Nekoeian, D., Heidari, H. (2025) Effect of demagnetizing fields and encapsulation on wireless magnetoelectric output for medical devices. IEEE Journal of Electromagnetics, RF, and Microwaves in Medicine and Biology, (doi: 10.1109/JERM.2025.3622953)
Jiang, Y., Zhong, M., Khusna, E. M., Li, C. (2025) A hybrid ray-full-wave design approach for metasurface-based microwave components. Microwave Journal,
Mu, S., Wagih, M. (2025) Integrated RF energy harvesting and power conversion circuits review: a roadmap for wireless-powered System-on-Chip (SoCs) IEEE Journal of Microwaves, 5, pp. 1191-1211. (doi: 10.1109/JMW.2025.3606571)
Duran-Toro, V., Crisp, R. W., Koçar, E., Wasner, F., Signorelli, L., Shojaei Baghini, M., di Gianvincenzo, P., Heidari, H., Bachmann, J., Moya, S. E., Gregurec, D. (2025) Barium titanate-coated cobalt ferrite core-shell magnetoelectric nanoparticles for wireless actuation technologies. ACS Applied Nano Materials, 8, pp. 20676-20684. (doi: 10.1021/acsanm.5c03654)
Elsayed, M., Linardopoulou, K., Akaydin, A., Ghadban, N., Heidari, H., Le Kernec, J. (2025) Bespoke SDRadar platform for Animal Welfare. (doi: 10.1109/RadarConf2559087.2025.11204895)
Akaydin, A., Elsayed, M., Heidari, H., Le Kernec, J. (2025) Multiple Moving Target Tracking and Vital Signs Monitoring using SDRadar. (doi: 10.1109/RadarConf2559087.2025.11205143)
Imroze, F., Yalagala, B., Kumar, N., Elsayed, M., Ahmad, M., Graham, R., Georgiev, V., Heidari, H., Weides, M. (2025) Cryogenic neuromorphic synaptic behaviour using 180 nm silicon MOSFETs for emerging computing systems. Advanced Intelligent Systems, (doi: 10.1002/aisy.202500506)
Hassouna, S., Kaur, J., Kizilkaya, B., Kazim, J. u. R., Ansari, S., Kherani, A. A., Lall, B., Abbasi, Q. H., Imran, M. (2025) Development of open radio access networks (O-RAN) for real-time robotic teleoperation. Communications Engineering, 4, (doi: 10.1038/s44172-025-00524-0)
Adams, S., McKinlay, M., García Núñez, C., Kang, L., Dixon, S., Gibson, D., Feeney, A. (2025) Thin-film Flexural Ultrasonic Transducers for Air-coupled Measurement. (doi: 10.1109/IUS62464.2025.11201545)
Wu, S., Zhu, S., Lai, K. T., Hou, L., Pusino, V., Cumming, D. R.S. (2025) A linear-to-linear cross-polarization conversion q-BIC metasurface for transmission mode mid-infrared spectral filtering. Laser and Photonics Reviews, (doi: 10.1002/lpor.202501360)
Imroze, F., Tang, X., Kumar, N., Dixit, A., Georgiev, V., Heidari, H., Weides, M. (2025) Impact of Dielectric Material and BOX Thickness on Self-Heating in FDSOI Transistors.
Mazón-Maldonado, L., Zhang, J., Cerezo-Sánchez, M., Shojaei Baghini, M., Parvizi, R., Heidari, H. (2025) MEMS-based magnetoelectric antennas for wireless power transmission in brain-implantable devices. Advanced Materials Technologies, (doi: 10.1002/admt.202501057)
Noor, S. M. U., Shah, S. A. A., Shah, I. A., Khan, S., Nasir, J., Koziel, S., Abbasi, Q. (2025) A highly miniaturized circularly polarized self-duplexing implantable antenna with enhanced performance for wireless capsule endoscopy applications. Scientific Reports, 15, (doi: 10.1038/s41598-025-19415-7)
Han, R., Abohmra, A., Pires, T., Ponciano, J., Abbas, H., Alomainy, A., Tahir, F. A., Imran, M., Abbasi, Q. (2025) Advancements in terahertz-enabled photoconductive antenna design: a review. International Journal of Microwave and Wireless Technologies, (doi: 10.1017/S1759078725102274)
Shawky, M. A., Shah, S. T., Abdellatif, A. G., Imran, M. A., Abbasi, Q. H., Ansari, S., Taha, A. (2025) Reconfigurable intelligent surface-assisted cross-layer authentication for secure and efficient vehicular communications. IEEE Internet of Things Journal,
Wilberforce, T., Kanakana Katumba, M. G., Ndou, N., Maladzhi, R.W., Klenam, D., Thomson, G., Junaid, S., Azmat, F., Tariq, R., Ghannam, R. (2025) An unsupervised machine learning approach to understand staff perception on Project based Learning using CDIO framework in African Engineering Education context – The case of South Africa. SEFI Journal of Engineering Education Advancement,
Barr, K., Euan, P., Zhong, M., Al-Taai, Q., Foshat, P., Stanley, M., Ridler, N., Delfanazari, K., Weides, M., Li, C., Rossi, A. (2025) Breaking the Cryogenic (Wiring) Bottleneck with Wireless Microwave Excitation of an NbN Superconducting.
Waheed, M., Ganie, J. A., Zhong, M., Al-Taai, Q., Saurav, K., Li, C. (2025) Design and Analysis of Wide Band Linear to Circular Polarization Converter for Sub−THz Applications.
Ahmad, A., Zubair, M., Chaudhary, V. K., Kazim, J. U. R., Imran, M. A., Abbasi, Q. (2025) Label-Free Glucose Sensing Using a High-Q Terahertz Metamaterial Absorber.
Chaudhary, V. K., Zubair, M., Kazim, J. U. R., Imran, M., Abbasi, Q. (2025) Peano-Meander Curve Based Microwave Array Sensor For Nondestructive Testing of CFRP Composites.
Ge, C., Yalagala, B. P., Masalehdan, T., Shojaei Baghini, M., Gregurec, D., Heidari, H. (2025) Large area, cost-effective, and ultra-fast fabrication of mini-coils toward noninvasive magnetic applications. Advanced Engineering Materials, (doi: 10.1002/adem.202501120)
Jacquin, T., Wanstall, S., Park, I., Stokes, A. A., Heidari, H., Lim, T., Amjadi, M. (2025) Wearable, near temperature insensitive laser-induced graphene nanocomposite strain sensors. Journal of Materials Chemistry C, (doi: 10.1039/D5TC02865E)
Ullah, R., Abbas, H., Nabi, S. W. (2025) Exploring Advanced Deep Learning Models for Super Resolution of 3D Dental CBCT Volumes. (doi: 10.5281/zenodo.17038615)
Khan, H. Z., Zafar, J., Jabbar, A., Kazim, J. u. R., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2025) Advancements in metasurfaces for polarization control: a comprehensive survey. Next Research, 2, (doi: 10.1016/j.nexres.2025.100407)
Ibrahim, A., Khan, M. Z., Imran, M., Larijani, H., Abbasi, Q. H., Usman, M. (2025) RadSpecFusion: Dynamic attention weighting for multi-radar human activity recognition. Internet of Things, 33, (doi: 10.1016/j.iot.2025.101682)
He, Q., Wang, H., Zhang, J., Ghahremani Arekhloo, N., Karagiorgis, X., Yalagala, B. P., Skabara, P. J., Heidari, H., Zeze, D. A., Hosseini, E. S. (2025) A wearable and highly sensitive PVDF–TrFE–BaTiO 3 piezoelectric sensor for wireless monitoring of arterial signal. ACS Applied Electronic Materials, 7, pp. 7562-7571. (doi: 10.1021/acsaelm.5c00548)
Ge, Y., Hameed, H., Shafique, A., Zhang, W., Li, S., Khan, M. Z., Cooper, J., Imran, M. A., Abbasi, Q. H. (2025) A driver fatigue detection scheme using 3D mmWave imaging radar. IEEE Sensors Journal, (doi: 10.1109/JSEN.2025.3599713)
Arslan, M. M., Guan, L., Yang, X., Zhao, N., Shah, A. A., Khan, M. B., Rehman, M., Shah, S. A., Abbasi, Q. H. (2025) Advancements in blood group classification: a novel approach using machine learning and RF sensing technology. IEEE Journal of Selected Areas in Sensors, (doi: 10.1109/JSAS.2025.3601060)
Jabbar, A., Azam, N., Ishabakaki, P., Ur Rehman, M., Imran, M. A., Sevegnani, M., Larijani, H., Shah, S. A., Abbasi, Q., Usman, M. (2025) Millimeter-wave contactless vital sign monitoring using dynamic metasurface antenna. IEEE Antennas and Wireless Propagation Letters, (doi: 10.1109/LAWP.2025.3597972)
Imroze, F., Kumar, N., Adamu-Lema, F., Georgiev, V., Heidari, H., Weides, M. (2025) Linear variation of threshold voltage with back bias for 22nm FDSOI at cryogenic temperature. (doi: 10.1109/drc66027.2025.11105733)
Sun, X., Li, Z., Sun, Y., Marsh, J. H., Cumming, D. R.S., Sweeney, S. J., Kelly, A. E., Hou, L. (2025) Narrow-linewidth monolithic topological interface state extended laser with optical injection locking. Science Advances, 11, (doi: 10.1126/sciadv.ady8963)
Signorelli, L., Wolters, A., Durán Toro, V., Englhard, J., Shojaei Baghini, M., Koçar, E., Wasner, F., Goldenstein, N. I., Heidari, H., Bachmann, J., Hescham, S., Gregurec, D. (2025) Biocompatible PVDF nanofibers with embedded magnetite nanodiscs enable wireless magnetoelectric stimulation in premotor cortex. Advanced Healthcare Materials, (doi: 10.1002/adhm.202503082)
Wang, H., Ahmad, M., Tanwear, A., Arekhloo, N. G., Zuo, S., Nazarpour, K., Heidari, H. (2025) Electronic interface design considerations for biomagnetic sensing using TMR sensors. IEEE Transactions on Magnetics, 61, pp. 1-12. (doi: 10.1109/TMAG.2025.3577734)
Ding, Y., Donati, E., Li, H., Heidari, H. (2025) Event-driven implementation of a physical reservoir computing framework for superficial EMG-based gesture recognition. IEEE Transactions on Artificial Intelligence, (doi: 10.1109/TAI.2025.3592899)
Khan, M. Z., Ahmad, J., Arshad, K., Assaleh, K., Abbas, H., Imran, M., Abbasi, Q. H. (2025) RFALL: multi-directional fall detection and pseudo localization using RFID tag arrays. IEEE Sensors Journal, (doi: 10.1109/JSEN.2025.3588747)
Wagih, M. (2025) Circular and Sustainable RF-Enabled Wireless Flexible Electronics.
Ruiz-Garcia, I., Keel, E., Konanahalli, A., Gibson, D., Amjadi Kolour, M., Caffio, M., Heidari, H., Garcia Nunez, C. (2025) Sustainable occupancy sensing platform via triboelectric and piezoresistive pressure sensors. IEEE Sensors Letters, (doi: 10.1109/LSENS.2025.3589020)
Imroze, F., Yalagala, B., Ahmad, M., Elsayed, M., Graham, R., Colletta, G., Heidari, H., Weides, M. (2025) Hysteresis-Induced Neuromorphic Behavior in 180nm Bulk PMOS Devices at 3K. (doi: 10.1109/ICMTS63811.2025.11068927)
Kumar, M., Song, C., Huang, Y., Zhou, J., Shen, S., Mitcheson, P., Ding, Y., Goussetis, G., Wagih, M. (2025) From MHz to mmWaves: a review of application-driven UK-based wireless power research. IEEE Microwave Magazine, 26, pp. 78-92. (doi: 10.1109/MMM.2024.3471985)
Wagih, M., Ghannam, R. (2025) Hands-on electromagnetics education based on RF transmission line equivalent circuits: an open source kit and NanoVNA evaluation. IEEE Microwave Magazine, 26, pp. 149-157. (doi: 10.1109/MMM.2025.3555762)
Wang, Z., Yalagala, B. P., Heidari, H., Feeney, A. (2025) Highly sensitive parylene C based flexible pressure sensors for wearable systems. Small Science, 5, (doi: 10.1002/smsc.202500081)
Alsulami, B. N., Harwell, J., Zante, G., Abbott, A. P., Feeney, A., Kettle, J. (2025) Hybrid delamination of silver contacts from c-Si solar cells: a low environmental impact recycling approach. Resources, Conservation and Recycling, 221, (doi: 10.1016/j.resconrec.2025.108429)
Khan, M. Z., Taylor, W., Usman, M., Ahmad, J., Ramzan, N., Khawaja, B. A., Vallappil, A. K., Imran, M., Abbasi, Q. H. (2025) RFiDAR: contactless RFID and radar data fusion for enhanced human activity recognition. IEEE Internet of Things Magazine, 8, pp. 60-69. (doi: 10.1109/iotm.001.2400222)
Elbestar, M., Aly, S., Ghannam, R., Eraqi, H. (2025) AirFusion: sensor data fusion for air quality monitoring. International Journal of Remote Sensing, (doi: 10.1080/01431161.2025.2516692)
Javaid, A., Farhan, M., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) Cost-effective and Recycled Flexible Strain Sensor for Joint Stiffness Monitoring in Tele-rehabiliation. (doi: 10.1109/ISCAS56072.2025.11044002)
Masalehdan, T. T., Ge, C., Shojaei Baghini, M., Wang, H., Eslahi, H., Parvizi, R., Heidari, H. (2025) Deep Brain Neurostimulation Through Engineered Circular Spiral Micro-Coils. (doi: 10.1109/iscas56072.2025.11043644)
Wang, J., Zhang, J., Ding, Y., Kirimi, M. T., Mirzai, N., Mercer, J., Heidari, H. (2025) Intelligent Rapid Antenna Design with Integrated Impedance Matching Network for Wireless Communication System. (doi: 10.1109/ISCAS56072.2025.11043645)
Cuenca, J. A., Al-Moathin, A., Kappers, M. J., Mandal, S., Kuball, M., Oliver, R. A., Li, C., Williams, O. A. (2025) Microwave plasma modelling for thick diamond deposition on III-nitrides. Carbon, 241, (doi: 10.1016/j.carbon.2025.120349)
Abbasi, Q., Ardao, S. D., Forgan, R., Gauchotte-Lindsay, C., Lu, B., Todman, A., Watkins, P., Muellenbroich, C. (2025) Engineering Inclusive and Interdisciplinary Research Excellence: The DiveIn Approach to Diversity in Postgraduate Research. (doi: 10.1109/ETOP64842.2025.11030640)
Waheed, M., Zubair, M., Hassan, M. B., Javed, I., Abbasi, Q. H., Mehmood, M. Q. (2025) Fostering Critical Thinking in STEM Education for Underserved Communities with a Low-Cost 3D-Printed Microscope. (doi: 10.1109/ETOP64842.2025.11030700)
Fang, X., Wagih, M. (2025) Circular wireless RF systems with recyclable and degradable components based on additively-manufactured liquid metal interconnects. IEEE Transactions on Circuits and Systems I: Regular Papers, (doi: 10.1109/TCSI.2025.3568321)
Ullah, M., Zhao, N., Guan, L., Zhang, Z., Cui, T., Yang, X., Abbasi, Q. H. (2025) Advanced wireless multitarget activity detection using harmonic beam generation and convolutional neural networks. IEEE Transactions on Instrumentation and Measurement, 74, (doi: 10.1109/TIM.2025.3576952)
Wang, Z., Yalagala, B. P., Zhang, J., Hafezi, M., Heidari, H., Feeney, A. (2025) Wireless and self-powered wearable pressure sensors based on chitosan for artificial mechanoreceptors. Advanced Materials Technologies, 10, (doi: 10.1002/admt.202401858)
Dutta, T., Imroze, F., Adamu-Lema, F., Heidari, H., Weides, M. (2025) Interplay of short-channel and narrow-width effects in FDSOI transistors at cryogenic temperatures. IEEE Transactions on Electron Devices, 72, pp. 3407-3414. (doi: 10.1109/TED.2025.3572029)
Keal, M. E., Scott, S., Alsulami, B. N. N., Kettle, J., Feeney, A., Edge, J. S., Anderson, P. A., Harper, G. D.J., Walton, A., Zante, G., Abbott, A. P. (2025) Design for recycle of devices to ensure efficient recovery of technology critical metals. RSC Sustainability, 3, pp. 2455-2471. (doi: 10.1039/D5SU00128E)
Ge, Y., Zhu, Y., Liaqat, S., Huang, D., Yu, L., Tang, C., Imran, M., Wang, W., Abbasi, Q. H. (2025) Implementation of voxel selective ellipse normalization to enhance radar respiration estimation in metallic chamber. IEEE Internet of Things Journal, 12, pp. 15533-15544. (doi: 10.1109/JIOT.2025.3527747)
Arslan, M. M., Rahman, S. U., Shah, A. A., Zhao, N., Zhang, Z., Cui, T., Yang, X., Shah, S. A., Abbasi, Q. H. (2025) Noncontact respiratory abnormality monitoring: a hybrid empirical mode and variational mode decomposition approach with software-defined radio and deep learning. IEEE Sensors Journal, 25, pp. 20374-20387. (doi: 10.1109/jsen.2025.3558625)
Qu, C., Maini, I., Guo, Q., Stacey, A., Moran, D. A. J. (2025) Extreme enhancement-mode operation accumulation channel hydrogen-terminated diamond FETs with Vth < −6 and high on-current. Advanced Electronic Materials, 11, (doi: 10.1002/aelm.202400770)
Mondal, B., Pampili, P., Mukherjee, J., Moran, D., Parbrook, P. J., Schulz, S. (2025) Interplay of carrier density and mobility in Al-rich (Al,Ga)N-channel HEMTs: Impact on high-power device performance potential. APL Electronic Devices, 1, (doi: 10.1063/5.0277051)
Kapoulea, S., Eslahi, H., Ali, Z., Mughal, M. W., Ahmad, M., Weides, M., Heidari, H. (2025) Cryo-CMOS 0.432mW UHF Filter for Scalable Quantum Computing in 22nm FD-SOI Technology. (doi: 10.1109/iscas56072.2025.11043435)
Abbas, Y., Ambade, R. B., Umair Khan, M., Chang, R., Zweiri, Y., Mohammad, B., Anjum, D., Abdul Samad, Y. (2025) Sustainable high-pressure homogenization of hexagonal boron nitride for triboelectric nanogenerators: advancing self-powered environmental monitoring in portable electronics. Journal of Materials Chemistry A, 13, pp. 14773-14785. (doi: 10.1039/d4ta08698h)
Javed, I., Zubair, M., Hassan, M. B., Cabrera, H., Abbasi, Q. H., Mehmood, M. Q. (2025) Empowering Communities in Microscopy through Place-Based Training and Outreach Models. (doi: 10.1109/ETOP64842.2025.11030623)
Batool, F., Zubair, M., Raza, M. H., Javed, I., Abbasi, Q. H., Mehmood, M. Q. (2025) Empowering K-12 Optics Education: An Outreach-Based Approach to Outcome-Oriented Learning. (doi: 10.1109/ETOP64842.2025.11030694)
Wu, S., Connolly, P. W.R., Pusino, V., Buller, G. S., Cumming, D. R.S. (2025) Polarization-controlled transmissive plasmonic color filter using a dimer-aperture array. Advanced Science, 12, (doi: 10.1002/advs.202501941)
Hashmi, H., Ullah, H., Ali, M. S., Noman, M., Abutarboush, H., Tahir, F. A., Abbasi, Q. H. (2025) A High Gain Pencil Beam Multilayer Antenna for 5G Communication. (doi: 10.23919/EuCAP63536.2025.10999321)
Fang, X., King, B., Wagih, M. (2025) A Sustainable and Low-Waste Temperature Sensor Based on 3D Liquid Metal and Carbon/PolymerLoaded Lossy Transmission Lines. (doi: 10.23919/EuCAP63536.2025.10999916)
Wagih, M. (2025) Improving the Multi-GBPS Signal Integrity Using Goubau-Inspired Hybrid Surface Wave Lines. (doi: 10.23919/EuCAP63536.2025.10999762)
Fang, X., Bruce, N., Wagih, M. (2025) Sustainable Broadband Monopole Antennas Based on Recyclable Liquid Metals and Biodegradable 3D-Printed Dielectrics. (doi: 10.23919/EuCAP63536.2025.11000018)
Arshad, M. M., Noman, M., Ali, M. S., Abutarboush, H. F., Tahir, F., Abbasi, Q. (2025) Transmissive Metasurface for Satcom Applications. (doi: 10.23919/EuCAP63536.2025.10999280)
Ishabakaki, P., Taylor, W., Farooq, M., Hameed, H., Mollel, M., Abbas, H., Imran, M., Abbasi, Q. (2025) A Robust Method for Estimating Respiration Rate Using Wi-Fi in Noisy Environments. (doi: 10.1109/ICMAC64768.2025.11003231)
Sagheer, M., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) Advancing Early Detection of Multifocal Breast Cancer with Electrical Impedance Tomography. (doi: 10.1109/ICMAC64768.2025.11003259)
Ahmad, A., Zubair, M., Kazim, J. U.-R., Imran, M. A., Abbasi, Q. (2025) An Ultrathin Terahertz Hexa-Band Fractal Meta-Absorber for Chemical Sensing Applications. (doi: 10.1109/ICMAC64768.2025.11003254)
Noman, M., Zafar, J., Ur-Rehman, M., Tahir, F. A., Imran, M., Abbasi, Q. H. (2025) Circular Dichroism in Dual-Band via Asymmetric Transmissive Chiral Metasurface. (doi: 10.1109/ICMAC64768.2025.11003225)
Fatima, A., Hameed, H., Saleemi, B., Imran, M. A., Abbasi, Q. H., Abbas, H. (2025) Contactless Body Gesture Recognition for Enhancing Non-Verbal Communication: A Deep Learning Approach Using RF Sensing. (doi: 10.1109/ICMAC64768.2025.11003228)
Sagheer, M., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) Portable Electrical Impedance Tomography for Enhanced Thorax Monitoring and Pulmonary Diagnosis. (doi: 10.1109/ICMAC64768.2025.11003260)
Saleemi, B., Fatima, A., Hameed, H., Liaqat, S., Farooq, M., Imran, M., Abbasi, Q. H. (2025) RF Sensing for Automated Classification of Stimming Behaviors in ASD: A First Step Toward Contactless Screening. (doi: 10.1109/ICMAC64768.2025.11003255)
Lubna, L., Hameed, H., Imran, M. A., Abbasi, Q. H. (2025) RFID Based Smart Mask For Speech Recognition. (doi: 10.1109/ICMAC64768.2025.11003241)
Cheng, H., Jiang, L., Ofiare, A., Shi, J., Ju, T., Mcgenn, W., George, D., Li, C. (2025) 50 nm InP HEMTs with Tgates Fabricated by Single-Step Electron Beam Lithography for High-Frequency Applications.
Ahmad, W., Li, C. (2025) Leveraging AI and Robotics for Global Engagement and Authentic Assessment.
Wagih, M. (2025) Life Cycle Assessment (LCA)-Driven Design for the Microwave Engineer: How to Develop Sustainable Wireless Systems? [Sustainability Keynote]
Elsayed, M., Ghadban, N., Abbas, H., Jafri, A. R., Abbasi, Q., Le Kernec, J. (2025) Design and Implementation of an Agile L-Band Frequency Synthesiser for Modern Radar Systems. (doi: 10.1109/RADAR58436.2024.10993895)
Kelly, J., Wang, J., Ofiare, A., Ridler, N., Li, C. (2025) Evaluation of On-Wafer Noise Parameter Measurement Techniques at Cryogenic Temperatures. (doi: 10.1109/ARFTG63706.2025.10989790)
Noman, M., Abutarboush, H., Qureshi, K. K., Zahid, A., Tahir, F. A., Imran, M., Abbasi, Q. H. (2025) Circular dichroism and cross polarization conversion using chiral metasurface. IEEE Open Journal of Antennas and Propagation, (doi: 10.1109/OJAP.2025.3568270)
King, B., Bruce, N., Wagih, M. (2025) Large-area conductor-loaded PDMS flexible composites for wireless and chipless electromagnetic multiplexed temperature sensors. Advanced Science, 12, (doi: 10.1002/advs.202412066)
Cildir, A., Tahir, F. A., Farooq, M., Zahid, A., Imran, M., Abbasi, Q. H. (2025) A highly efficient and broadband metasurface for linear-to-linear and linear-to-circular polarization conversion in reflection mode. Photonics and Nanostructures - Fundamentals and Applications, 64, (doi: 10.1016/j.photonics.2025.101382)
Eslahi, H., Kapoulea, S., Ali, Z., Mughal, M. W., Ullah, F., Ahmad, M., Weides, M., Heidari, H. (2025) De-embedding methodology to characterize linearity of active filters under process variations. IEEE Transactions on Very Large Scale Integration Systems, 33, pp. 1462-1466. (doi: 10.1109/tvlsi.2024.3513478)
Brennan, J., Barbosa, J., Li, C., Ahmad, M., Imroze, F., Rose, C., Karar, W., Stanley, M., Heidari, H., Ridler, N. M., Weides, M. (2025) Classical interfaces for controlling cryogenic quantum computing technologies. arXiv, (doi: 10.48550/ARXIV.2504.18527)
Su, H., Huang, S., Su, D., Garcia Nuñez, C., Heidari, H., Zhang, H., Lan, J., Gao, X., Yue, H. (2025) L-Cysteine@Island-Like Co3S4 on Co3O4 nanosheet arrays heterostructure: electrochemical chiral sensing of L-tryptophan. ACS Applied Nano Materials, 8, pp. 8397-8406. (doi: 10.1021/acsanm.5c01052)
Jabbar, A., Ur-Rehman, M., Imran, M. A., Abbasi, Q., Larijani, H., Usman, M. (2025) Electronically Steered Dynamic Metasurface Antenna: Unlocking Fixed-Frequency Beamsteering in Leaky-Wave Antenna System. (doi: 10.1109/icmac64768.2025.11003269)
Akram, Z., Elsayed, M., Hameed, H., Ali, M. S., Kazim, J., Tahir, F. A., Imran, M., Abbasi, Q. H. (2025) 1-bit Phase Reconfigurable Unit Cell for X-band Intelligent Reflective Surface. (doi: 10.1109/ICMAC64768.2025.11003245)
Ali, M. S., Akram, Z., Nikbakhtnasrabadi, F., Kazim, J., Abbas, H., Tahir, F. A., Imran, M., Abbasi, Q. H. (2025) Optically Transparent and Flexible Metasurface for Wideband Cross-Polarization Applications in the V-band.
Fatima, A., Hameed, H., Imran, M. A., Abbasi, Q. H., Abbas, H. (2025) Utilizing contactless sensing technology for the identification of hand and head movements in conjunction with facial expressions. IEEE Sensors Journal, (doi: 10.1109/JSEN.2025.3552489)
Zhao, Y. et al. (2025) 6G Near-Field Technologies White Paper 2.0. (doi: 10.12142/FuTURE.202504001)
Farooq, M., Saleemi, B., Ishabakaki, P., Shah, S. A., Taha, A., Imran, M., Abbasi, Q. H., Abbas, H. T. (2025) Contactless Sleep Quality Monitoring Exploiting Radar Signal.
Abac, A. G. et al. (2025) Search for continuous gravitational waves from known pulsars in the first part of the fourth LIGO-Virgo-KAGRA observing run. Astrophysical Journal, 983, (doi: 10.3847/1538-4357/adb3a0)
Rollo, A., Cameron, J., Fernandes Dias, J. D., Cichocki, R., Synkiewicz-Musialska, B., Ren, J., Zhang, S., Kettle, J. (2025) Hybrid agricultural monitoring system with detachable, biodegradable, and printed pH sensors with a recyclable wireless sensor network for sustainable sensor systems. ACS Applied Electronic Materials, 7, pp. 2731-2740. (doi: 10.1021/acsaelm.4c02141)
Khan, M. Z., Ge, Y., Mollel, M., Mccann, J., Abbasi, Q. H., Imran, M. (2025) RFSensingGPT: a multi-modal RAG-enhanced framework for integrated sensing and communications intelligence in 6G networks. IEEE Transactions on Cognitive Communications and Networking, (doi: 10.1109/TCCN.2025.3558069)
McPartlin, B., Wagih, M. (2025) Sub-1 GHz indoor RSSI-based localization: an experimental evaluation of trilateration, multilateration, and machine learning fingerprinting methods. IEEE Journal of Selected Areas in Sensors, 2, pp. 121-135. (doi: 10.1109/JSAS.2025.3545784)
Kaur, J., Tan, K., Shafique, A., Popoola, O. R., Imran, M. A., Abbasi, Q. H., Abbas, H. (2025) Location estimation for supporting adaptive beamforming. Ad Hoc Networks, 170, (doi: 10.1016/j.adhoc.2025.103765)
Qu, C., Maini, I., Zhang, J., Ganin, A., Moran, D. A.J. (2025) Catalytic-enhanced thermal hydrogen-termination of diamond for electronic applications. Diamond and Related Materials, 154, (doi: 10.1016/j.diamond.2025.112225)
Hao, Y., Liu, Y., Liu, B., Amarantidis, G., Ghannam, R. (2025) Integrating AI in engineering education: a comprehensive review and student-informed module design for UK students. IEEE Transactions on Education, 68, pp. 173-185. (doi: 10.1109/TE.2025.3536105)
Kettle, J., Mukherjee, R., Zhang, S., Harwell, J., Bainbridge, A., Wagih, M., Martinez Diez, A., Menendez Suarez, M., Sanchez, P.a. (2025) Towards an Internet of Things circular economy using printed circuits on reusable steel substrates. Advanced Electronic Materials, 11, (doi: 10.1002/aelm.202400529)
Ghadban, N., Hammed, H., Miranda, E., Abbasi, Q. H., Imran, M. A., Cooper, J., Le Kernec, J. (2025) Artificial Intelligence and Radar-Enhanced Audio-Visual Speech Recognition for the Next Generation of Communication Technologies.
Aljohani, K., Kizilkaya, B., Hussain, S., Abbasi, Q. H., Imran, M. A., Ansari, S. (2025) A Comparative Analysis of 5G and WiFi6 for VR Immersive Education.
Ahmad, A., Zubair, M., Kazim, J. U.-R., Imran, M. A., Abbasi, Q. (2025) An Ultrathin Terahertz Tri-Band Fractal Meta-Absorber for Liquid Chemical Sensing Applications. (doi: 10.1109/iWAT64079.2025.10931200)
Li, Q., Wang, J., Li, C. (2025) Impact of Out-of-plane Thermal Strain on Electron Charge Density in AlGaN/GaN HEMTs. (doi: 10.1117/12.3041528)
Rüsseler, A. K., McKinlay, M., Matthes, J. N., Garcia Nuñez, C., Gehrke, P., Jupé, M., Hoffmann, G.-A., Wienke, A., Ristau, D. (2025) Miniaturized Electro-Optical Modulator Based on Substrate-Free Thin Films. (doi: 10.1117/12.3040506)
Wagih, M., Bruce, N., Komolafe, A., Ullah, I., Shi, J., Beeby, S. (2025) Heterogenous and Flexible E-Textile Power Electronics: Enabling Novel Battery-Free Wearable Applications and Outperforming Rigid Electronics. (doi: 10.23919/E-Textiles63767.2024.10914237)
Serghiou, T., Fernandes, J. D., Karthikeyan, V., Assi, D. S., Vieira, D. H., Alves, N., Kettle, J. (2025) Sustainable and tunable synaptic Electrolyte-Gated Organic Field-Effect Transistors (EGOFETs) for light adaptive visual perceptive systems. Advanced Functional Materials, 35, (doi: 10.1002/adfm.202417355)
Fatima, A., Hameed, H., Reay, M., Imran, M. A., Abbasi, Q. H., Abbas, H. (2025) Contactless Sensing for Sign Language Phrase Recognition.
Anwar, U., Dong, Y., Arslan, T., Dashtipour, K., Gogate, M., Hussain, A., Abbasi, Q. H., Imran, M. A., Russ, T. C., Lomax, P. (2025) Privacy-preserving facial emotion classification with visual micro-Doppler signatures for hearing aid applications. IEEE Transactions on Instrumentation and Measurement, 74, (doi: 10.1109/TIM.2025.3548782)
Ahmad, A., Zubair, M., Kazim, J. U.-R., Imran, M. A., Abbasi, Q. H. (2025) A T-Shaped Fractal Multi-Band THz Absorber for Skin Cancer Diagnostics.
Ishabakaki, P., Hameed, H., Farooq, M., Mollel, M., Abbas, H., Imran, M. A., Abbasi, Q. H. (2025) A Two-Stage Deep Learning Framework for Enhanced Radio Frequency Sensing Reliability.
Hameed, H., Fatima, A., Lubna, L., Liaqat, S., Arshad, K., Assaleh, K., Imran, M., Abbasi, Q. H. (2025) AI-Driven RF Sensing for Workplace Employee Health and Fitness Monitoring.
Liaqat, Z., Saddiqi, J., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) Capacitive Pressure Sensitive Smart Shoe Insole for Gait Improvement of Cerebral Palsy Patients.
Farooq, M., Ishabakaki, P. A., Shah, S. A., Taha, A., Imran, M. A., Abbasi, Q., Abbas, H. T. (2025) Contactless Sleep Quality and Vital Signs Monitoring for Autism Spectrum Disorder Detection.
Ishabakaki, P. A., Farooq, M., Hameed, H., Mollel, M., Abbas, H., Imran, M. A., Abbasi, Q. (2025) Deep Learning-Based Identification of Random Body Movements for Enhanced RF Sensing.
Ahsan, M. H., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) E-Waste to Harvesting Energy: Triboelectric Nanogenerator-based Self-Powered Wireless Sensor System for Step Counting and Game Control.
Khan, M. Z., Ansari, S., Abbas, H., Imran, M., Abbasi, Q. (2025) Few-Shot RF Spectrogram Analysis using Vision-Language Models for Activity Recognition.
Chaudhary, V. K., Zubair, M., Ur-Rehman Kazim, J., Imran, M., Abbasi, Q. (2025) Hilbert-Curve Array Sensor For Nondestructive Testing of CFRP Composites.
Elsayed, M., Akaydin, A., Hameed, H., Abbasi, Q., Le Kernec, J., Heidari, H. (2025) Moving Target Vital Signs Monitoring using SDRadar.
Noman, M., Tahir, F. A., Kazim, J. U. R., Imran, M., Abbasi, Q. H. (2025) Multi-Band Circular Dichroism and Asymmetric Transmission using Chiral Metasurface.
Abbas, S., Rafique, A., Noureen, S., Mehmood, M. Q., Zubair, M., Imran, M. A., Abbasi, Q. H. (2025) Non-Invasive Glucose Monitoring Using Wireless Circular Spiral Resonator Sensor.
Taylor, W., Cooper, J., Abbasi, Q. H., Imran, M. A. (2025) Optimising Wi-Fi Detection Systems: A Novel Approach to Subcarrier Selection in Multiple Locations.
Chaudhary, V. K., Zubair, M., Kazim, J. U. R., Imran, M., Abbasi, Q. (2025) Performance of Hilbert-Curve Based Microwave Sensor for Non-destructive Testing of CFRP.
Noman, M., Tahir, F. A., Kazim, J. U. R., Imran, M., Abbasi, Q. H. (2025) Asymmetric Transmissive Chiral Metasurface Enabled Triple-Band Circular Dichroism.
Xia, Y., Li, H., Vaskeviciute, M., Faccio, D., Karimullah, A. S., Heidari, H., Ghannam, R. (2025) Temperature‐tunable cholesteric liquid crystal optical combiners for extended reality applications. Advanced Intelligent Systems, 7, (doi: 10.1002/aisy.202400411)
Abohmra, A., Zubair, M., Ur Rehman, M., Abbas, H., Imran, M. A., Abbasi, Q. H. (2025) Frontiers in quantum antennas: theoretical foundations, practical applications, and future outlook. IEEE Open Journal of Antennas and Propagation, (doi: 10.1109/OJAP.2025.3545596)
Ju, T., Cheng, H., Ofiare, A., Li, C. (2025) Planar Baluns for mm-Wave Applications.
Xie, Y., Garcia Nunez, C., Wang, H., Gao, X., Zhang, H., Jiang, F., Jia, K., Li, Q., Bai, H., Yao, F., Yue, H. (2025) Hollow transition metal chalcogenides derived from vanadium-based metal organic framework for hybrid supercapacitors with excellent energy-density and stability. Journal of Colloid and Interface Science, 680, pp. 446-455. (doi: 10.1016/j.jcis.2024.11.099)
Khan, M. Z., Ge, Y., Ullah, U., Ansari, S., Imran, M., Abbasi, Q. H. (2025) TelcoGPT: A Hybrid Embedding Approach for Telecom-Specific Q&A and Code Retrieval. (doi: 10.1109/INFOCOMWKSHPS65812.2025.11152931)
Zafar, J., Khan, H. Z., Jabbar, A., Kazim, J. U. R., Ur Rehman, M., Siddiqui, A. M., Abbasi, Q. H., Imran, M. A. (2025) Asymmetric multi-band reflective metasurface for linear and circular polarizations conversion in Ku, K, Ka, and U Bands. Scientific Reports, 15, (doi: 10.1038/s41598-024-81388-w)
Beeby, S. P., Torah, R. N., Wagih, M., Isaia, B., Black, S., Saunders, J., Yang, K. (2025) Heterogeneous e‐textiles: materials, manufacturing and sustainability. Advanced Materials Technologies, 10, (doi: 10.1002/admt.202400844)
Hameed, H., Lubna, L., Liaqat, S., Fatima, A., Assaleh, K., Arshad, K., Abbasi, Q. H., Imran, M. A. (2025) Revolutionizing Activity Recognition Through Walls with Deep Learning.
Ahmed, I., Noman, M., Imran, M., Tahir, F. A., Abbasi, Q. H. (2025) Metasurface Design for RCS Reduction Applications.
Zafar, J., Khan, H. Z., Jabbar, A., Kazim, J. u. R., Ur Rehman, M., Siddiqui, A. M., Abbasi, Q. H., Imran, M. A. (2025) Multi-band reflective metasurface for efficient linear and circular polarization conversion. Optical and Quantum Electronics, 57, (doi: 10.1007/s11082-025-08037-y)
Kaur, J., Tan, K., Khan, M. Z., Popoola, O. R., Imran, M. A., Abbasi, Q. H., Abbas, H. T. (2025) Fingerprinting-based indoor localization in a 3x3 meter grid using OFDM signals at Sub-6 GHz. Applied AI Letters, 6, (doi: 10.1002/ail2.104)
Khan, H. Z., Jabbar, A., Kazim, J. U. R., Zafar, J., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2025) Reflective metasurface for multi-band polarization conversion for satellite applications in 6G networks. IEEE Open Journal of Antennas and Propagation, 6, pp. 332-343. (doi: 10.1109/OJAP.2024.3514122)
Beniwal, A., Gond, R., Karagiorgis, X., Rawat, B., Li, C. (2025) Room temperature operated Fe2O3/PANI-based flexible and eco-friendly ammonia sensor with sub-ppm detectability. IEEE Sensors Letters, 9, (doi: 10.1109/LSENS.2025.3527229)
Beniwal, A., Ganguly, P., Khandelwal, G., Gond, R., Rawat, B., Li, C. (2025) Additive strategies to mitigate humidity interference effects on PEDOT:PSS sensors for ammonia detection. IEEE Sensors Journal, (doi: 10.1109/JSEN.2025.3533298)
Shukla, P., Gond, R., Beniwal, A., Li, C., Rawat, B. (2025) Disposable and highly sensitive humidity sensor based on PEDOT:PSS/GO heterostructure. IEEE Journal on Flexible Electronics, (doi: 10.1109/jflex.2025.3533498)
Ma, Y., Li, C. (2025) Experimental Demonstration of a Combined RF-Ultrasonic Wireless Powering System. (doi: 10.1109/RWS62086.2025.10904837)
Cheng, H., Wang, J., Kelly, J., Ofiare, A., Thoms, S., Li, C. (2025) HEMT with ultra-low contact resistance for millimeter wave and sub-terahertz applications: design, fabrication and characterization. IEEE Transactions on Electron Devices, 72, pp. 142-146. (doi: 10.1109/TED.2024.3499935)
Javed, I., Shah, A. R., Ahmad, A., Abbasi, Q. H., Zubair, M., Mehmood, M. Q. (2025) Advanced Multi-mode Microscopy Enabled by Meta-optics.
Wagih, M., Karimian, S., Fang, X., Kettle, J., Driver, S., Selver, E., Herring, J. (2025) Biodegradable RF PCBs Towards Sustainable Wireless and IoT. (doi: 10.36399/gla.pubs.368649)
Wan, M. I., Ahmad, M., Wang, H., Heidari, H., Malik, S. (2025) Current excitation based improved resistance measurement system for remote sensors. IEEE Transactions on Instrumentation and Measurement, 74, (doi: 10.1109/TIM.2025.3614807)
Abualhayja'a, M., Wagih, M., Centeno, A., Imran, M. A., Mohjazi, L. (2025) How much power is needed for RIS to beat relays? A sustainability framework. IEEE Access, 13, pp. 64061-64075. (doi: 10.1109/ACCESS.2025.3560131)
Ahmad, A., Zubair, M., Kazim, J. U.-R., Imran, M. A., Abbasi, Q. H. (2025) Multiband Terahertz Spiral Metasurface for Detection of Malaria with Enhanced Sensitivity.
Farage, M. E., Li, C. (2025) Rectangular Waveguide-based CRLH Frequency Scanning Array Antenna Operating at W-band.
Shariff, B. G. P., Ali, T., Mane, P. R., Pathan, S., Abbasi, Q. H., Ur-Rehman, M., Antar, Y. M. M., Sharma, S. K., Kishk, A. A. (2025) Wideband narrow-beam 16-element two-port MIMO array antenna with high isolation for automotive radar and 5G millimeter wave applications. IEEE Open Journal of Antennas and Propagation, 6, pp. 1502-1523. (doi: 10.1109/ojap.2025.3588252)
2024
Shafique, A., Naqvi, S. A. A., Raza, A., Ghalaii, M., Papanastasiou, P., McCann, J., Abbasi, Q. H., Imran, M. A. (2024) A hybrid encryption framework leveraging quantum and classical cryptography for secure transmission of medical images in IoT-based telemedicine networks. Scientific Reports, 14, (doi: 10.1038/s41598-024-82256-3)
Javed, I., Satti, A. J., Ahmad, A., Zubair, M., Abbasi, Q. H., Mehmood, M. Q. (2024) Wide-angle Metalens for Enhanced Imaging Capabilities.
Wang, Z., Yalagala, B., Heidari, H., Feeney, A. (2024) A Flexible and Self-Powered Chitosan-BaTiO3 Composite Pressure Sensor for E-Skin Applications. (doi: 10.1109/SENSORS60989.2024.10785172)
Parvizi, R., Imroze, F., Zhao, J., Weides, M., Imran, M. A., Heidari, H. (2024) Deep-N-Well-Assisted CMOS Photovoltaic Micro-Cells for Powering the Wearable Sensors. (doi: 10.1109/sensors60989.2024.10785050)
Khalid, M. S., Quraishi, I. S., Nawaz, M. W., Sajjad, H., Yaseen, H., Mehmood, A., Ur Rahman, M. M., Abbasi, Q. H. (2024) A low-cost PPG sensor-based empirical study on healthy aging based on changes in PPG morphology. Physiological Measurement, 46, (doi: 10.1088/1361-6579/ada246)
Sharma, E., Ahmad, M., Khan, A. U., Somappa, L., Baghini, M. S., Heidari, H., Malik, S. (2024) Current-excitation based ΔR-to-frequency converter for resistive sensors. IEEE Sensors Journal, 24, pp. 41081-41089. (doi: 10.1109/JSEN.2024.3429246)
Nieto-Sierra, L., Lloret, F., Gallardo, J. J., García-Núñez, C., Pelayo-García, M., Alba, G., Gibson, D., Araujo, D. (2024) Systematic approach for high piezoelectric AlN deposition. Journal of Alloys and Compounds, 1008, (doi: 10.1016/j.jallcom.2024.176723)
Ge, C., Masalehdan, T., Shojaei Baghini, M., Toro, V. D., Signorelli, L., Thomson, H., Gregurec, D., Heidari, H. (2024) Microfabrication technologies for nano-invasive and high-resolution magnetic neuromodulation. Advanced Science, 11, (doi: 10.1002/advs.202404254)
Hameed, H., Lubna, , Usman, M., Kazim, J. U. R., Assaleh, K., Arshad, K., Hussain, A., Imran, M., Abbasi, Q. H. (2024) Artificial intelligence enabled smart mask for speech recognition for future hearing devices. Scientific Reports, 14, (doi: 10.1038/s41598-024-81904-y)
Nawaz, M. W., Zhang, W., Flynn, D., Zhang, L., Swash, R., Abbasi, Q. H., Imran, M. A., Popoola, O. (2024) 6G edge-networks and multi-UAV knowledge fusion for urban autonomous vehicles. Physical Communication, 67, (doi: 10.1016/j.phycom.2024.102479)
Song, G., Wang, X., Ghannam, R. (2024) Immersive quantum: A systematic literature review of XR in quantum technology education. Computers and Education: X Reality, 5, (doi: 10.1016/j.cexr.2024.100087)
Zhang, W., Hejda, M., Al-Taai, Q. R. A., Owen-Newns, D., Romeira, B., Figueiredo, J. M. L., Robertson, J., Wasige, E., Hurtado, A. (2024) Photonic-electronic spiking neuron with multi-modal and multi-wavelength excitatory and inhibitory operation for high-speed neuromorphic sensing and computing. Neuromorphic Computing and Engineering, 4, (doi: 10.1088/2634-4386/ad8df8)
Zhang, T., Bainbridge, A., Harwell, J., Zhang, S., Wagih, M., Kettle, J. (2024) Life cycle assessment (LCA) of circular consumer electronics based on IC recycling and emerging PCB assembly materials. Scientific Reports, 14, (doi: 10.1038/s41598-024-79732-1)
Sheeraz, M., Aslam, A. R., Drakakis, E. M., Heidari, H., Altaf, M. A. B., Saadeh, W. (2024) A Closed-loop ear-worn wearable EEG system with real-time passive electrode skin impedance measurement for early autism detection. Sensors, 24, (doi: 10.3390/s24237489)
Dias, J. D., Vieira, D. H., Serghiou, T., Rivas, C. J., Constantino, C. J.L., Jimenez, L. B., Alves, N., Kettle, J. (2024) Influence of the chemical structure of perylene derivatives chemical structure on the performance of Honey-Gate Organic Field-Effect Transistors (HGOFETs) and their application in UV light detection. ACS Applied Electronic Materials, (doi: 10.1021/acsaelm.4c01773)
Zhang, J., Wagih, M., Yang, X., Das, R., Wang, H., Mirzai, N., Mercer, J., Ho, J. S., Heidari, H. (2024) Highly integrated two-port rectenna system for wirelessly powering multisite autonomous vascular implantable networks. IEEE Transactions on Microwave Theory and Techniques, (doi: 10.1109/TMTT.2024.3492392)
McKinlay, M., Fleming, L., Pelayo García, M., Nieto Sierra, L., Villar Castro, P., Araujo, D., García, B. J., Gibson, D., Garcia Nunez, C. (2024) On the piezoelectric properties of zinc oxide thin films synthesised by plasma assisted DC sputter deposition. Advanced Materials Interfaces, 11, (doi: 10.1002/admi.202400252)
Robertson, J., Black, D., Al-Taai, Q., Donati, G., Maylsheva, E., Romeira, B., Figueiredo, J., Dolores-Calzadilla, V., Wasige, E., Hurtado, A. (2024) Ultrafast Temporal Integration and Pattern Recognition with Photonic-Electronic RTD Spiking Neurons. (doi: 10.1109/IPC60965.2024.10799637)
Hameed, H., Elsayed, M., Kaur, J., Usman, M., Tang, C., Ghadban, N., Le Kernec, J., Hussain, A., Imran, M., Abbasi, Q. (2024) RF sensing enabled tracking of human facial expressions using machine learning algorithms. Scientific Reports, 14, (doi: 10.1038/s41598-024-75909-w)
Lin, X., Fan, Y., Zhang, L., Ma, K., Sun, Y., Tukmanov, A., Abbasi, Q., Imran, M. A. (2024) Resource allocation for RIS-aided mmWave system with cooperative and non-cooperative base stations. IEEE Transactions on Vehicular Technology, (doi: 10.1109/TVT.2024.3493772)
Farooq, M., Shah, S. A., Zheng, D., Taha, A., Imran, M., Abbasi, Q. H., Abbas, H. T. (2024) Contactless heart sound detection using advanced signal processing exploiting radar signals. IEEE Journal of Biomedical and Health Informatics, (doi: 10.1109/JBHI.2024.3490992)
Ofiare, A., Kelly, J., wang, j., CHENG, H., Li, C. (2024) Accurate Broadband On-Wafer Noise Parameter Measurement with Dedicated 2 GHz – 50 GHz Passive Source Tuner: Measurement Uncertainty Contributions.
Elbestar, M., Aly, S. G., Ghannam, R. (2024) Advances in air quality monitoring: a comprehensive review of algorithms for imaging and sensing technologies. Advanced Sensor Research, 3, (doi: 10.1002/adsr.202300207)
Mudassar, B., Tahir, S., Khan, F., Shah, S. A., Shah, S. I., Abbasi, Q. (2024) Privacy-preserving data analytics in Internet of Medical Things. Future Internet, 16, (doi: 10.3390/fi16110407)
Noman, M., Abutarboush, H., Tahir, F. A., Zahid, A., Imran, M., Abbasi, Q. H. (2024) A novel multifunctional chiral metasurface with asymmetric transmission. Scientific Reports, 14, (doi: 10.1038/s41598-024-76001-z)
Ghahremani Arekhloo, N., Wang, H., Parvizi, H., Tanwear, A., Zuo, S., McKinlay, M., García Núñez, C., Nazarpour, K., Heidari, H. (2024) Motion artifact variability in biomagnetic wearable devices. Frontiers in Medical Technology, 6, (doi: 10.3389/fmedt.2024.1457535)
Hejda, M., Zhang, W., Al-Taai, Q. R. A., Malysheva, E., Owen-Newns, D., Figueiredo, J. M.L., Romeira, B., Robertson, J., Dolores-Calzadilla, V., Wasige, E., Hurtado, A. (2024) Programmable optical synaptic linking of neuromorphic photonic-electronic RTD spiking circuits. ACS Photonics, 11, pp. 4279-4287. (doi: 10.1021/acsphotonics.4c01199)
Wagih, M., Bainbridge, A., Alsulami, B., Kettle, J. (2024) Environmental Life-Cycle Assessment (LCA) of wireless RF systems: a comparative sustainability analysis and a microwave engineers’ guide to LCA. IEEE Journal of Microwaves, (doi: 10.1109/JMW.2024.3455575)
Pelayo Garcia, M., Saddik, K. B., Shojaei Baghini, M., Hughes, D. A., Gibson, D., García, B. J., Garcia Nunez, C. (2024) Giant piezoelectric effect induced by porosity in inclined ZnO thin films. Advanced Electronic Materials, 10, (doi: 10.1002/aelm.202400138)
Morais, R. M., Vieira, D. H., Ozório, M. d. S., Nogueira, G. L., Rollo, A., Kettle, J., Alves, N. (2024) Green, biodegradable, and flexible resistive heaters-based upon a novel laser-induced graphene manufacturing process. Advanced Sustainable Systems, 8, (doi: 10.1002/adsu.202400166)
Blakesley, J. C. et al. (2024) Roadmap on established and emerging photovoltaics for sustainable energy conversion. Journal of Physics: Energy, 6, (doi: 10.1088/2515-7655/ad7404)
Ge, Y., Chen, Z., Cooper, J., Imran, M., Abbasi, Q. H. (2024) 3D-DFD: A Driver Fatigue Detection Scheme using 3D mmWave Imaging Radar. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686347)
Mohammadian, N., Kumar, D., Fugikawa-Santos, L., Nogueira, G. L., Zhang, S., Alves, N., Ballantine, D., Kettle, J. (2024) Bias and temperature stress effects in IGZO TFTs and the application of step-stress testing to increase reliability test throughput. IEEE Transactions on Electron Devices, (doi: 10.1109/TED.2024.3462693)
Zaidi, F., Hameed, H., Farooq, M., Fatima, A., Arshad, K., Assaleh, K., Abbasi, Q. H. (2024) Privacy-Preserving Visual Cues Communication for Hearing-Impaired People Using Deep Learning. (doi: 10.1109/ICIP51287.2024.10647125)
Ma, Y., Jiang, Y., Li, C. (2024) A universal model for ultrasonic energy transmission in various media. Sensors, 24, (doi: 10.3390/s24196230)
Wagih, M., Marrocco, G., Zarifi, M., Grosinger, J., Song, C., Abbasi, Q. (2024) Antenna-enabled sensors and systems, the new frontier in sustainable wireless systems. IEEE Open Journal of Antennas and Propagation, 5, pp. 1136-1139. (doi: 10.1109/OJAP.2024.3458268)
Bhatti, S., Manzoor, H. U., Zoha, A., Ghannam, R. (2024) Computational optimization for CIGS/CdS/GaAs layered solar cell architecture. Energies, 17, (doi: 10.3390/en17184758)
Xia, Y., Ahmed, Z., Karimullah, A., Mottram, N., Heidari, H., Ghannam, R. (2024) Thermal controlled cholesteric liquid crystal wavelength filter lens for photosensitive epilepsy treatment. Cell Reports Physical Science, 5, (doi: 10.1016/j.xcrp.2024.102158)
Kaur, J., Lin, X., Tan, K., Popoola, O., Imran, M., Abbasi, Q., Zhang, L., Abbas, H. T. (2024) Location-based adaptive beamforming and beam steering for mobile communication in multipath environments. London Journal of Engineering Research, 24, pp. 41-49.
Khan, M. Z., Usman, M., Tahir, A., Farooq, M., Qayyum, A., Ahmad, J., Abbas, H., Imran, M., Abbasi, Q. H. (2024) Transparent RFID tag wall enabled by artificial intelligence for assisted living. Scientific Reports, 14, (doi: 10.1038/s41598-024-64411-y)
Khan, H. Z., Jabbar, A., Kazim, J. u. R., Ur Rehman, M., Imran, M. A., Abbasi, Q. (2024) Multi-band ultrathin reflective metasurface for linear and circular polarization conversion in Ku, K and Ka bands. Communications Engineering, 3, (doi: 10.1038/s44172-024-00266-5)
Wali, M.R., Ali, M. S., Kazim, J., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) A Broadband CP Square Slot Antenna Array for Future 5G Communication Systems. (doi: 10.1109/WINCOM62286.2024.10656508)
Hassan, Q., Ali, M. S., Kazim, J., Tahir, F. A., Imran, M., Abbasi, Q. (2024) Design of RF MEMS Shunt Capacitive Switches Using Dimples and Meanders. (doi: 10.1109/WINCOM62286.2024.10657564)
Ahmad, N., Shoaib, N., Nawaz, H., Abbasi, Q. H., Nikolaou, S. (2024) Dual-polarized (CP, LP, slant), series-fed, monopulse planar array antenna. IEEE Transactions on Antennas and Propagation, (doi: 10.1109/TAP.2024.3451169)
Wang, J., Ofiare, A., Li, Q., Kelly, J., Wasige, E., Li, C. (2024) On-wafer Characterisation of Noise Parameters of GaN HEMTs between 77 K and 400 K. (doi: 10.1109/ARFTG61196.2024.10661062)
LI, X., Elnagar, D., Song, G., Ghannam, R. (2024) Advancing medical education using virtual and augmented reality in low- and middle-income countries: a systematic and critical review. Virtual Worlds, 3, pp. 384-403. (doi: 10.3390/virtualworlds3030021)
McKinlay, M., Shojaei Baghini, M., Pelayo Garcia, M., Yalagala, B., Heidari, H., Gibson, D., Garcia Nunez, C. (2024) Study of triboelectric potential for tunable contact-electrification field effect transistors. IEEE Sensors Letters, 8, (doi: 10.1109/LSENS.2024.3442311)
Abdellatif, S. O., Ghannam, R., Khalifa, Z. (2024) Optoelectronic and morphological surface resistance evaluation of laser-induced graphene counter electrodes for potential applications in cesium lead halide perovskite solar cells. ACS Applied Electronic Materials, 6, pp. 5391-6324. (doi: 10.1021/acsaelm.4c00786)
Foo, Y. K., Li, X., Ghannam, R. (2024) Enhancing tennis practice: sensor fusion and pose estimation with a smart tennis ball. Sensors, 24, (doi: 10.3390/s24165306)
Sohaib, R., Shah, S. T., Onireti, O., Sambo, Y., Abbasi, Q., Imran, M. (2024) DRL-based Joint Resource Scheduling of eMBB and URLLC in O-RAN. (doi: 10.1109/ICCWorkshops59551.2024.10615451)
Shah, S. T., Fazal, M., Shawky, M. A., Sohaib, R. M., Faraz Hasan, S., Imran, M. A., Abbasi, Q. (2024) Throughput Optimization in Ambient Backscatter-Based Energy Constraint Cognitive Radio Networks. (doi: 10.1109/ICCWorkshops59551.2024.10615668)
Alsulami, B. N. N., Zante, G., Abbott, A. P., Feeney, A., Kettle, J. (2024) LCA-Informed Approach for Lower Environmental Impact Recycling of Crystalline Silicon Solar Cells. (doi: 10.23919/AM-FPD61635.2024.10615664)
Sadeghfar, F., nikbakht, M., Parvizi, R. (2024) Green synthesis of Ag/Yb2O3 nanostructures based-MIP for tamoxifen detection: Advancing from refractometers to sensor. Journal of Molecular Structure, 1309, (doi: 10.1016/j.molstruc.2024.138110)
Bhatti, S., Khan, A. R., Zoha, A., Hussain, S., Ghannam, R. (2024) A machine learning frontier for predicting LCOE of photovoltaic system economics. Advanced Energy and Sustainability Research, 5, (doi: 10.1002/aesr.202300178)
Pelayo Garcia, M., Gibson, D., McAughey, K. L., Hughes, D. A., García Núñez, C. (2024) Ultra-inclined nanocolumnar ZnO films sputtered using a novel masking configuration providing controlled and restricted oblique angle deposition for enhanced sensing platforms. Advanced Physics Research, 3, (doi: 10.1002/apxr.202400020)
Haider, S. S., Noman, M., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) A Fractal Dual-Band Polarization Diversity Antenna Array for 5G Communications. (doi: 10.1109/WINCOM62286.2024.10655841)
Wagih, M. (2024) RF-Enabled Flexible and Printed Electronics: a Route to Sustainable Wireless Sensors and Systems. (doi: 10.1109/FLEPS61194.2024.10603633)
Han, R., Abohmra, A., Pires, T., Karthikeyan, V., Tahir, F., Ponciano, J., Imran, M., Abbasi, Q. (2024) Terahertz Photoconductive Antenna Based on Tai-Chi Totem and Plasmonic Structure for Cancer Detection. (doi: 10.1109/WINCOM62286.2024.10655272)
Zubair, M., Jabbar, A., Tahir, F. A., Kazim, J. U. R., Ur Rehman, M., Imran, M., Liu, B., Abbasi, Q. H. (2024) A high-performance sub-THz planar antenna array for THz sensing and imaging applications. Scientific Reports, 14, (doi: 10.1038/s41598-024-68010-9)
Khan, M. Z., Usman, M., Ahmad, J., Ur Rahman, M. M., Abbas, H., Imran, M., Abbasi, Q. H. (2024) Tag-free indoor fall detection using transformer network encoder and data fusion. Scientific Reports, 14, (doi: 10.1038/s41598-024-67439-2)
Hameed, H., Ishabakaki, P. A., Farooq, M., Fatima, A., Arshad, K., Assaleh, K., Imran, M. A., Abbasi, Q. H. (2024) BSLR: Bridging Communication Gaps with Wi-Fi Enabled British Sign Language Recognition. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686089)
Farooq, M., Hameed, H., Ishabakaki, P., Shah, S. A., Taha, A., Imran, M., Abbasi, Q., Abbas, H. T. (2024) Breathing Rate Variability Impact on Heart Rate Estimation Through Radar Sensing. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10734335)
Elsayed, M., Ghadban, N., Abbasi, Q. H., Le Kernec, J. (2024) Case Study on Radar-Based Vital Signs Monitoring and the Effect of Target Aspect Angle. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687157)
Wagih, M., Ghannam, R. (2024) Combining Equivalent Circuits, NanoVNAs, and Standard EDA Tools for Engaging Electromagnetics and RF Engineering Laboratory Exercises. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687211)
Fatima, A., Hameed, H., Imran, M. A., Abbasi, Q. H., Abbas, H. (2024) Contactless Sensing for Recognizing Common Signs in ASL and BSL. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686773)
Kaur, J., Zhang, W., Shawky, M., Popoola, O. R., Imran, M., Abbasi, Q. H., Abbas, H. T. (2024) Data Generation and Analysis of USRP and OptiTrack for the Moving UGV Localization. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687220)
Hassouna, S., Kaur, J., Jamshed, M. A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2024) Data Rate Performance of RIS in the Near-Field Regime Considering the Impact of EMI. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686587)
Elsayed, M., Kaur, J., Kazim, J., Abbas, H. T., Imran, M. A., Abbasi, Q. H., Le Kernec, J. (2024) Design and Implementation of 3-6 GHz 4-Channel Beam Steering Circuit with 6-bit Digital Phase Shifters. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686907)
Kaur, J., Elsayed, M., Kazim, J., Le Kernec, J., Imran, M., Abbasi, Q. H., Abbas, H. T. (2024) Design and Implementation of a Phased Array System for Indoor Applications. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686935)
Zubair, M., Jabbar, A., Tahir, F. A., Ur-Rehman, M., Imran, M. A., Liu, B., Abbasi, Q. H. (2024) Design of Efficient and High Gain Sub-THz Series-Fed Antenna Array for THz Communication. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686915)
Shawky, M. A., Alquraan, M., Abualhayja'a, M., Alblaihed, K., Adel, A., Gamal, A., Mostafa, K., Kaur, J., Taha, A., Shah, S. T., Ansari, S., Abbasi, Q. (2024) Efficient Cross-Layer Handover Authentication for Secure Communication in VANETs. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686008)
Alblaihed, K. A., Abbasi, Q. H., Imran, M., Mohjazi, L. (2024) Gain Enhancement using Superstrate of Microstrip Patch Antenna Array for 5G Applications. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686327)
Noman, M., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) High Code Density Orientation Insensitive Chipless RFID Tag for Future Wireless Communication. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686114)
Pires, T., Han, R., Karthikeyan, V., Abohmra, A., Tahir, F., Abbas, H., Imran, M., Abbasi, Q. (2024) Hybrid Metal-Topological Insulator Terahertz Metasurface for Ultrasensitive Refractive Index Biosensing. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686427)
Sharif, A., Ouyang, J., Arshad, K., Assaleh, K., Imran, M., Abbasi, Q. H. (2024) Inkjet Printed UHF RFID Humidity Sensor for Metallic Surface Assets. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686231)
Ali, M. S., Rains, J., Kazim, J., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) PET based Flexible Intelligent Reflective Surface for Millimeter-Wave Applications. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686363)
Reay, M., Hameed, H., Imran, M. A., Abbasi, Q. H. (2024) Privacy Preserving Radio Frequency Speech Sensing With Deep Learning Towards Improved Hearing Aids. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686586)
Ishabakaki, P., Hameed, H., Farooq, M., Saeed, U., Shah, S. A., Imran, M. A., Abbasi, Q. H. (2024) RF-based Respiration Disorders Sensing and Classification Using Machine Algorithms. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686093)
Khan, M. Z., Bilal, M., Luke, A. M., Arshad, K., Assaleh, K., Shah, S. T., Imran, M., Abbasi, Q. (2024) RFiDARFusion: Enhancing Contactless Activity Monitoring with Radar and RFID Fusion. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687056)
Taylor, W., Cooper, J., Abbasi, Q., Imran, M. (2024) Smart Fatigue Monitoring using RF Sensing Employing a Deep Learning Convolutional Neural Network. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687161)
Wagih, M., Shi, J., Li, M., Whittaker, T., Whittow, W., Beeby, S. (2024) Temperature-Sensitive Microstrip Patch Antenna Radiation using Large-Area Artificially-Engineered Carbon-Loaded Composites. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686656)
Han, R., Pires, T., Abohmra, A., Tahir, F. A., Imran, M., Abbasi, Q. (2024) Terahertz Photoemitter Using Plasmonic Inter-combined Tooth Based on MoS2-GaAs Structure. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10687001)
Sun, M., Ge, Y., Li, W., Ansari, S., Imran, M., Abbasi, Q. H. (2024) Wireless Tracking for Joint Communication and Sensing. (doi: 10.1109/AP-S/INC-USNC-URSI52054.2024.10686583)
Beniwal, A., Khandelwal, G., Mukherjee, R., Mulvihill, D. M., Li, C. (2024) Eco-friendly textile-based wearable humidity sensor with multinode wireless connectivity for healthcare applications. ACS Applied Bio Materials, 7, pp. 4772-4784. (doi: 10.1021/acsabm.4c00593)
Taylor, W., Hill, D., Adam, R., Cooper, J., Abbasi, Q. H., Imran, M. A. (2024) Hybrid Sensing for Fatigue Detection Using Wearables and RF. IEEE Sensors Journal, 24, pp. 22764-22772. (doi: 10.1109/JSEN.2024.3404637)
Haq, B., Jamshed, M. A., Ali, K., Kasi, B., Arshad, S., Khan Kasi, M., Ali, I., Shabbir, A., Abbasi, Q. H., Ur Rehman, M. (2024) Tech-driven forest conservation: combating deforestation with internet of things, artificial intelligence, and remote sensing. IEEE Internet of Things Journal, 11, pp. 24551-24568. (doi: 10.1109/jiot.2024.3378671)
Alblaihed, K. A., Abohmra, A. A. Y., Ur Rehman, M., Abbasi, Q. H., Imran, M. A., Mohjazi, L. (2024) Wideband series-fed patch antenna array with high gain and low sidelobe: linearly and circularly polarized for 5G V2X applications. IEEE Open Journal of Antennas and Propagation, (doi: 10.1109/OJAP.2024.3424330)
Hassouna, S., Jamshed, M. A., Ur-Rehman, M., Arshad, K., Imran, M. A., Abbasi, Q. H. (2024) Rate Optimization and Power Allocation in RIS-assisted Multi-user OFDM Communication. (doi: 10.1109/WCNC57260.2024.10570710)
Fan, D., Yang, X., Zhao, N., Guan, L., Arslan, M. M., Ullah, M., Imran, M. A., Abbasi, Q. H. (2024) A contactless breathing pattern recognition system using deep learning and WiFi sign. IEEE Internet of Things Journal, 11, pp. 23820-23834. (doi: 10.1109/JIOT.2024.3386645)
Shojaei Baghini, M., Parvizi, R., Walton, F., Heidari, H. (2024) Electrothermal modeling of monolithically integrated GaN-based µLED devices. IEEE Transactions on Electron Devices, 71, pp. 4203-4209. (doi: 10.1109/TED.2024.3406313)
Nourinovin, S., Rahman, M. M., Naftaly, M., Philpott, M. P., Abbasi, Q., Alomainy, A. (2024) Highly sensitive terahertz metasurface based on electromagnetically induced transparency-like resonance in detection of skin cancer cells. IEEE Transactions on Biomedical Engineering, 71, pp. 2180-2188. (doi: 10.1109/TBME.2024.3364386)
Abbasi, Q. H. (2024) Promising neurological treatment via microwave brain stimulation: a comment on “Advancements in non-invasive microwave brain stimulation: a comprehensive survey” by F. E. S. Pereira et al. Physics of Life Reviews, 49, pp. 130-131. (doi: 10.1016/j.plrev.2024.04.002)
Heidari, H., Zuo, S. (2024) Sensor readout circuit for a biomagnetism measurement system.
Lindsay, C., Garcia Nunez, C., Fleming, L. S., Pomfret, J., Saunders, K., Ahmadzadeh, S., Tait, S., Reid, S., Martin, I., Gibson, D. R. (2024) Microwave Plasma Assisted Sputtering of a Combined Ta2O5/SiO2 and a-Si:H/SiO2 Two Stack Optical Coating Design Concept for Gravitational Wave Detectors. (doi: 10.1117/12.3022968)
Saunders, K., Mazur, M., Clark, C., Gibson, D., Garcia Nunez, C. (2024) Optical and Structural Properties of Silicon Nitride Thin Films Deposited by Plasma Enhanced Chemical Vapor Deposition for High Reflectance Optical Mirrors. (doi: 10.1117/12.3022947)
Pelayo Garcia, M., McKinlay, M., Gibson, D., Garcia Nunez, C. (2024) High-Performance Piezophototronic Devices Based on Zinc Oxide Nanostructured Thin Films Synthesized by Physical Vapour Deposition. (doi: 10.1117/12.3017252)
Keel, E., Caffio, M., Gibson, D. R., Garcia Nunez, C. (2024) Potential Broadband Photodetector Concept Based on Three-Dimensional Graphene Foam. (doi: 10.1117/12.3017247)
Jabbar, A., Alsyed, M., Kazim, J. U. R., Pang, Z., Le Kernec, J., Imran, M. A., Abbasi, Q. H., Ur Rehman, M. (2024) 60 GHz Programmable Dynamic Metasurface Antenna (DMA) for next-generation communication, sensing, and imaging applications: from concept to prototype. IEEE Open Journal of Antennas and Propagation, 5, pp. 705-726. (doi: 10.1109/OJAP.2024.3386452)
Wang, X., Song, G., Ghannam, R. (2024) Enhancing teamwork and collaboration: a systematic review of algorithm-supported pedagogical methods. Education Sciences, 14, (doi: 10.3390/educsci14060675)
Shawky, M. A., Shah, S. T., Abdrabou, M., Usman, M., Abbasi, Q. H., Flynn, D., Imran, M. A., Ansari, S., Taha, A. (2024) How secure are our roads? An in-depth review of authentication in vehicular communications. Vehicular Communications, 47, (doi: 10.1016/j.vehcom.2024.100784)
Mansour, R., Tarhini, F., Bruce, N., Blanche, J., Wagih, M., Taha, A., Williams, K., Copper, J., Imran, M., Oien, K., Heidari, H., Flynn, D. (2024) In vitro assessment of benzothiadiazole-based photoactive polymers against ovarian, prostate and bladder cancer cell lines for photodynamic therapy. Advanced Materials Interfaces, 16, (doi: 10.1007/s12672-025-03654-1)
AlQallaf, N., AlQallaf, A., Ghannam, R. (2024) Solar energy systems design using immersive virtual reality: a multi-modal evaluation approach. Solar, 4, pp. 329-350. (doi: 10.3390/solar4020015)
Demeneghi, J. A., Kaur, J., Tan, K., Abbas, H. (2024) Sub-6 GHz beamforming with low-cost software-defined radio: Design, testing, and performance evaluation. Physical Communication, 65, (doi: 10.1016/j.phycom.2024.102391)
Xia, Y., Li, H., Vaskeviciute, M., Faccio, D., Karimullah, A., Heidari, H., Ghannam, R. (2024) Cholesteric Liquid Crystal Based Reconfigurable Optical Combiner for Head-Mounted Display Application. (doi: 10.1109/VRW62533.2024.00158)
Dudek, A., Al-Khalidi, A., Wincza, K., Wagih, M. (2024) Sub-THz On-Chip CPW Monopole on InP with Cross-shaped Slot for Bandwidth Enhancement. (doi: 10.23919/EuCAP60739.2024.10501645)
Asad, S. M., Zhang, X., Sun, Y., Bin Rais, R. N., Hussain, S., Abbasi, Q. H., Imran, M. A. (2024) Blockchain-empowered secure spectrum sharing for next generation train networks. IEEE Access, 12, pp. 66690-66700. (doi: 10.1109/ACCESS.2024.3398997)
Lin, X., Zhang, L., Tukmanov, A., Liu, Y., Abbasi, Q., Imran, M. A. (2024) On the design of broadbeam of reconfigurable intelligent surface. IEEE Transactions on Communications, 72, pp. 3079-3094. (doi: 10.1109/TCOMM.2024.3354200)
Shah, S. T., Shawky, M. A., Kazim, J. u. R., Taha, A., Ansari, S., Hasan, S. F., Imran, M. A., Abbasi, Q. (2024) Coded environments: data-driven indoor localisation with reconfigurable intelligent surfaces. Communications Engineering, 3, (doi: 10.1038/s44172-024-00209-0)
Khan, M. S., Murtaza, I., Shuja, A., Khan, H. R., Abid, R., Nuñez, C. G., Fahad, S., Tariq, H., Naveed, A. (2024) Tailored NiO-pBOA-GNP ternary nanocomposite: advances in flexible supercapacitors and practical applications for wearable technology and environmental monitoring. Journal of Energy Storage, 86, (doi: 10.1016/j.est.2024.111128)
Hameed, H., Tahir, A., Usman, M., Zhu, J., Lubna, , Abbas, H., Ramzan, N., Cui, T. J., Imran, M. A., Abbasi, Q. (2024) Wi-fi and radar fusion for head movement sensing through walls leveraging deep learning. IEEE Sensors Journal, 24, pp. 14952-14961. (doi: 10.1109/JSEN.2023.3337515)
Ali, Z., Paliwal, P., Ahmad, M., Heidari, H., Gupta, S. (2024) Fast settling phase-locked loops: a comprehensive survey of applications and techniques. IEEE Circuits and Systems Magazine, 24, pp. 62-79. (doi: 10.1109/MCAS.2024.3383809)
Meates, I., Alkaraki, S., Aslam, M., Abbasi, Q., Evans, A., Jilani, S. F. (2024) A Compact High-Gain 28 GHz Antenna Array for Beyond 5G Wireless Networks. (doi: 10.23919/EuCAP60739.2024.10501487)
Noman, M., Haider, U. A., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) A Highly Compact Double-Sided Orientation Insensitive Chipless Tag for Radio Frequency Identification Applications. (doi: 10.23919/EuCAP60739.2024.10501576)
Cildir, A., Tahir, F. A., Imran, M., Abbasi, Q. (2024) An Innovative Metasurface Polarizer Working in 5G Frequency Bands. (doi: 10.23919/EuCAP60739.2024.10501126)
Stephenson, J., Wagih, M. (2024) An Investigation into the Effects of Multi-Path and NLOS Propagation on Antenna-Based. (doi: 10.23919/EuCAP60739.2024.10501090)
Farooq, M., Hameed, H., Taha, A., Imran, M., Abbasi, Q. H., Abbas, H. T. (2024) Contactless Respiration Variability Detection and Accuracy Test Using UWB Radar. (doi: 10.23919/EuCAP60739.2024.10501651)
Ali, M. S., Kazim, J. u.R., Tahir, F. A., Imran, M., Abbasi, Q. H. (2024) Design of Intelligent Reflective Surface Unit Cell for 5G mmWave Applications. (doi: 10.23919/EuCAP60739.2024.10501296)
Jabbar, A., Abbasi, Q., Imran, M. A., Ur-Rehman, M. (2024) Impact of Dielectric Substrate, Feed Connector, and Fabrication Tolerances on the Performance of Planar Millimeter-Wave Antenna Arrays. (doi: 10.23919/EuCAP60739.2024.10501171)
Lin, X., Zhou, Z., Zhang, L., Tukmanov, A., Abbasi, Q., Imran, M. A. (2024) Joint Wide Illumination and Null Insertion Design in RIS-assisted System. (doi: 10.23919/EuCAP60739.2024.10501227)
Wagih, M., Song, C. (2024) Microwave to mmWave Wireless Power Transfer: An Overview of the Design Challenges with a Focus on UK-Based R&D. (doi: 10.23919/EuCAP60739.2024.10501269)
Khan, H. Z., Tahir, F. A., Jabbar, A., Abbasi, Q. H., Imran, M. A. (2024) Multi-Band Anisotropic Metasurface: Simultaneous Linear and Circular Polarization for Robust Satellite Communication. (doi: 10.23919/eucap60739.2024.10501327)
Asim, M., Ozair Iqbal, M., Aman, W., Ur Rahman, M., Abbasi, Q. H. (2024) Pathloss-based non-Line-of-Sight Identification in an Indoor Environment: An Experimental Study. (doi: 10.23919/EuCAP60739.2024.10501521)
Hassouna, S., Jamshed, M. A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2024) RIS-Enabled Near-Field Localization with EMI. (doi: 10.23919/EuCAP60739.2024.10501364)
Rains, J., Tukmanov, A., Abbasi, Q., Imran, M. (2024) RIS-Enhanced MIMO Channels in Urban Environments: Experimental Insights. (doi: 10.23919/EuCAP60739.2024.10501311)
Sharif, A., Arshad, K., Assaleh, K., Imran, M., Abbasi, Q. (2024) UHF RFID Sensor Antenna for Fat Content and Adulteration Detection of Milk. (doi: 10.23919/EuCAP60739.2024.10501377)
Pires, T., Han, R., Karthikeyan, V., Abohmra, A., Tahir, F. A., Abbas, H., Imran, M., Abbasi, Q. (2024) Ultrahigh Sensitive Terahertz Metasurface with 2D MoS2 for Refractive Index Biosensing. (doi: 10.23919/EuCAP60739.2024.10500958)
Abac, A. et al. (2024) Observation of gravitational waves from the coalescence of a 2.5−4.5 M⊙ compact object and a neutron star. arXiv, (doi: 10.48550/arXiv.2404.04248)
Jabbar, A., Kazim, J. U. R., Pang, Z., Abbasi, M. A. B., Abbasi, Q., Imran, M. A. (2024) A wideband frequency beam-scanning antenna array for millimeter-wave industrial wireless sensing applications. IEEE Sensors Journal, 24, pp. 13315-13325. (doi: 10.1109/JSEN.2024.3370135)
Qayyum, A., Butt, M. A., Ali, H., Usman, M., Halabi, O., Al-Fuqaha, A., Abbasi, Q., Imran, M. A., Qadir, J. (2024) Secure and trustworthy artificial intelligence-extended reality (AI-XR) for metaverses. ACM Computing Surveys, 56, (doi: 10.1145/3614426)
Saeed, U., Shah, S. A., Ghadi, Y. Y., Hameed, H., Shah, S. I., Ahmad, J., Abbasi, Q. H. (2024) British Sign Language detection using ultra-wideband radar sensing and residual neural network. IEEE Sensors Journal, 24, pp. 11144-11151. (doi: 10.1109/jsen.2024.3364389)
Zhao, Y. et al. (2024) 6G Near-field Technologies White Paper.
Wagih, M., Komolafe, A., Ullah, I., Weddell, A. S., Beeby, S. (2024) A wearable all-printed textile-based 6.78 MHz 15 W-output wireless power transfer system and its screen-printed Joule heater application. IEEE Transactions on Industrial Electronics, 71, pp. 3741-3750. (doi: 10.1109/TIE.2023.3277112)
Abbasi, Q. H. (2024) Bridging digital and electromagnetic realms for enhanced wireless communication: current space. National Science Review, 11, (doi: 10.1093/nsr/nwae041)
Guan, L., Yang, X., Zhao, N., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2024) Domain-independent gesture recognition using single-channel time modulated array. IEEE Transactions on Antennas and Propagation, 72, pp. 3386-3399. (doi: 10.1109/TAP.2024.3373054)
Ahmed, U., Khan, A. R., Mahmood, A., Rafiq, I., Ghannam, R., Zoha, A. (2024) Short-term global horizontal irradiance forecasting using weather classified categorical boosting. Applied Soft Computing, 155, (doi: 10.1016/j.asoc.2024.111441)
Heidari, H., Zuo, S. (2024) Biomagnetism measurement system for sensing biomagnetic signals.
Shafqat, A., Noman, M., Ali, M. S., Abutarboush, H. F., Tahir, F. A., Abbasi, Q. H. (2024) A Miniaturized Multi-Wideband Antenna for Variable-Size Tablet Computers and Mobile Phones. (doi: 10.1109/iWAT64079.2025.10931193)
Beniwal, A., Li, C. (2024) Disposable and Flexible PEDOT:PSS-Based Temperature Sensor for Healthcare Applications. (doi: 10.1109/APSCON60364.2024.10465834)
Al-Qallaf, N., Elnagar, D. W., Aly, S. G., Elkhodary, K., Ghannam, R. (2024) Empathy, education and awareness: A VR hackathon’s approach to tackling climate change. Sustainability, 16, (doi: 10.3390/su16062461)
Zhao, M., Zhu, S., Chen, X., Fromenteze, T., Abbasi, Q. H., Alomainy, A., Fusco, V., Yurduseven, O. (2024) Three-dimensional computational polarimetric imaging with a hyperuniform frequency-diverse metacavity transceiver. IEEE Transactions on Instrumentation and Measurement, 73, (doi: 10.1109/TIM.2024.3375963)
Ghannam, R. (2024) Bridging Engineering and Education: Technologies for Enhanced Training Experiences.
Bainbridge, A., Grant, K., Clark, L., Kettle, J. (2024) Evaluation of the environmental impact within semiconductor packaging materials. (doi: 10.23919/EMPC55870.2023.10418417)
Todorov, A. R., Goyal, K., Torah, R. N., Wagih, M., Ardern-Jones, M. R., Day, S. W., Beeby, S. P. (2024) Design of a flexible, wearable interdigitated capacitive sensor for monitoring biomarkers of atopic dermatitis. IEEE Sensors Journal, 24, pp. 6856-6866. (doi: 10.1109/JSEN.2023.3342992)
Omeke, K., Mollel, M., Shah, S., Zhang, L., Abbasi, Q., Imran, M. A. (2024) Towards a sustainable Internet-of-Underwater-Things based on AUVs, SWIPT and reinforcement learning. IEEE Internet of Things Journal, 11, pp. 7640-7651. (doi: 10.1109/JIOT.2023.3319250)
Kaur, J., Bhatti, S., Tan, K., Popoola, O. R., Imran, M. A., Ghannam, R., Abbasi, Q., Abbas, H. T. (2024) Contextual beamforming: Exploiting location and AI for enhanced wireless telecommunication performance. APL Machine Learning, 2, (doi: 10.1063/5.0176422)
AlQallaf, N., Ghannam, R. (2024) Immersive learning in photovoltaic energy education: a comprehensive review of virtual reality applications. Solar, 4, pp. 136-161. (doi: 10.3390/solar4010006)
Abac, A. G. et al. (2024) Ultralight vector dark matter search using data from the KAGRA O3GK run. arXiv, (doi: 10.48550/arXiv.2403.03004)
Ali, Z., Elsayed, M., Tiwari, G., Ahmad, M., Le Kernec, J., Heidari, H., Gupta, S. (2024) Impact of receiver thermal noise and PLL RMS jitter in radar measurements. IEEE Transactions on Instrumentation and Measurement, 73, (doi: 10.1109/TIM.2024.3370745)
Lin, X., Zhou, Z., Zhang, L., Tukmanov, A., Abbasi, Q., Imran, M. A. (2024) RIS-assisted Resource Allocation under Base Stations' Non-cooperation Scheme. (doi: 10.1109/GLOBECOM54140.2023.10437328)
Hassouna, S., Jamshed, M. A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2024) RIS-assisted near-field localization using practical phase shift model. Scientific Reports, 14, (doi: 10.1038/s41598-024-54859-3)
Hussain, S., Kasica, M., Abbas, H., Abbasi, Q., Imran, M. (2024) AI-Enabled Metaverse – the Future of Education.
Azargoshasb, T., Navid, H. A., Yadollahzadeh, S., Aghbolaghi, R., Parvizi, R., Parsanasab, G. M. (2024) Carbon quantum dot embedding silica–molecularly imprinted polymer coated optical fiber as ratiometric biosensors toward dopamine detection. IEEE Sensors Journal, 24, pp. 4510-4522. (doi: 10.1109/jsen.2023.3347262)
Alsulami, B. N. N., David, T. W., Essien, A., Kazim, S., Ahmad, S., Jacobsson, T. J., Feeney, A., Kettle, J. (2024) Application of large datasets to assess trends in the stability of perovskite photovoltaics through machine learning. Journal of Materials Chemistry A, 12, pp. 3122-3132. (doi: 10.1039/D3TA05966A)
Lee, C. S., Li, M., Lou, Y., Abbasi, Q. H., Imran, M. (2024) An acoustic system of sound acquisition and image generation for frequent and reliable lung function assessment. IEEE Sensors Journal, 24, pp. 3731-3747. (doi: 10.1109/jsen.2023.3344136)
Buttar, H. M., Pervez, K., Ur Rahman, M. M., Mian, A. N., Riaz, K., Abbasi, Q. H. (2024) Noncontact monitoring of dehydration using RF data collected off the chest and the hand. IEEE Sensors Journal, 24, pp. 3574-3582. (doi: 10.1109/JSEN.2023.3334590)
Zhong, M., Jiang, Y., Ma, Y., Li, C. (2024) An Ultra-wideband Off-axis Reflector Lens. (doi: 10.1109/RWS56914.2024.10438633)
Ma, Y., Jiang, Y., Li, C. (2024) Combined RF-Ultrasonic Wireless Powering System for Sensor Applications in Harsh Environment. (doi: 10.1109/RWS56914.2024.10438557)
Ding, Y., Li, H., Liang, X., Vaskeviciute, M., Faccio, D., Heidari, H. (2024) A Physical Reservoir Computing Processor for ECG-to-PCG Signals Prediction. (doi: 10.1109/ISCAS58744.2024.10557860)
Wagih, M., Shi, J., Li, M., Komolafe, A., Whittaker, T., Schneider, J., Kumar, S., Whittow, W., Beeby, S. (2024) Wide-range soft anisotropic thermistor with a direct wireless radio frequency interface. Nature Communications, 15, (doi: 10.1038/s41467-024-44735-z)
Ghahremani Arekhloo, N., Parvizi, H., Zuo, S., Wang, H., Nazarpour, K., Heidari, H. (2024) Investigating the Advantages of Magnetomyography in Assistive Healthcare Technology. (doi: 10.1109/icecs58634.2023.10382891)
Samuel, A. K., Faqeeh, A. H., Li, W., Ertekin, Z., Wang, Y., Zhang, J., Gadegaard, N., Moran, D. A.J., Symes, M. D., Ganin, A. Y. (2024) Assessing challenges of 2D-molybdenum ditelluride for efficient hydrogen generation in a full-scale proton exchange membrane (PEM) water electrolyzer. ACS Sustainable Chemistry and Engineering, 12, pp. 1276-1285. (doi: 10.1021/acssuschemeng.3c06616)
Xia, Y., Yalagala, B. P., Karimullah, A. S., Heidari, H., Ghannam, R. (2024) Beyond flexibility: transparent silver nanowire electrodes on patterned surfaces for reconfigurable devices. Advanced Engineering Materials, 26, (doi: 10.1002/adem.202301165)
Khosravi, S., Li, H., Khan, A. R., Zoha, A., Ghannam, R. (2024) Exploring the elusive mind: a multimodal wearable sensor solution for measuring mind wandering in university students. Advanced Sensor Research, 3, (doi: 10.1002/adsr.202300067)
Li, S., Zhu, S., Ge, Y., Zeng, B., Imran, M. A., Abbasi, Q. H., Cooper, J. (2024) Depth-guided deep video inpainting. IEEE Transactions on Multimedia, 26, pp. 5860-5871. (doi: 10.1109/TMM.2023.3340089)
Mair, F. S., Nickpour, F., Nicholl, B., Macdonald, S., Joyce, D. W., Cooper, J., Dickson, N., Leason, I., Abbasi, Q. H., Akin, I. F., Deligianni, F., Camacho, E., Downing, J., Garrett, H., Gray, M. J., Lowe, D. J., Imran, M. A., Padmanabhan, S., McCowan, C., Clarkson, P. J., Walker, L. E., Buchan, I. (2024) Developing SysteMatic: prevention, precision and equity by design for people living with multiple long-term conditions. Journal of Multimorbidity and Comorbidity, 14, pp. 1-9. (doi: 10.1177/26335565241272682)
2023
Ghadban, N., Usman, M., Tang, C., Ghanam, H., Hameed, H., Vinciarelli, A., Abbasi, Q. H., Imran, M. A. (2023) Detecting Phonetic Characters using Radar Data. (doi: 10.1109/RADAR54928.2023.10371167)
Farooq, M., Ge, Y., Qayyum, A., Tang, C., Hussain, A., Imran, M. A., Taha, A., Abbasi, Q. H., Abbas, H. T. (2023) Privacy-Preserving Speaker Recognition Using Radars for Context Estimation In Future Multi-Modal Hearing Assistive Technologies. (doi: 10.1109/RADAR54928.2023.10371189)
Lindig, S., Ascencio-Vásquez, J., Leloux, J., Moser, D., Aghaei, M., Fairbrother, A., Gok, A., Ahmad, S., Kazim, S., Lobato, K., van Sark, W.J.G.H.M., Pearsall, N., Burduhos, B.G., Raghoebarsing, A., Oreski, G., Schmitz, J., Theelen, M., Yilmaz, P., Kettle, J., Reinders, A.H.M.E. (2023) Performance and Degradation in Silicon PV Systems under Outdoor Conditions in Relation to Reliability Aspects of Silicon PV Modules – Summary of Results of COST Action PEARL PV. (doi: 10.1109/PVSC48320.2023.10359742)
Khan, M. S., Murtaza, I., Shuja, A., Asghar, M. A., Garcia Nunez, C., Abid, R., Haider, A., Faraz, M. (2023) Unveiling the electrochemical advantages of a scalable and novel aniline-derived polybenzoxazole-reduced graphene oxide composite decorated with manganese oxide nanoparticles for supercapacitor applications. Journal of Energy Storage, 73, (doi: 10.1016/j.est.2023.109109)
Ge, Y., Tang, C., Li, H., Chen, Z., Wang, J., Li, W., Cooper, J., Chetty, K., Faccio, D., Imran, M., Abbasi, Q. H. (2023) A comprehensive multimodal dataset for contactless lip reading and acoustic analysis. Scientific Data, 10, (doi: 10.1038/s41597-023-02793-w)
Skeldon, K. et al. (2023) Research Firsts Exhibition. (doi: 10.17605/OSF.IO/ZQC5P)
Hameed, H., Lubna, , Ghadban, N., Usman, M., Arshad, K., Assaleh, K., Alkhayyat, A., Imran, M. A., Abbasi, Q. (2023) TAQWA: Teaching Adolescents Quality Wadhu/Ablution Contactlessly Using Deep Learning. (doi: 10.1109/ICSPIS60075.2023.10343835)
Wang, Z., Yalagala, B. P., Hafezi, M., Heidari, H., Feeney, A. (2023) A Bioprotein-Based Flexible and Self-Powered Pressure Sensor Towards a Biomimic of an Artificial Pacinian Corpuscle. (doi: 10.1109/ICECS58634.2023.10382948)
Mazón Maldonado, L., Shojaei Baghini, M., Parvizi, R., Heidari, H. (2023) Enhancing Isolation in Solidly Mounted Resonators for Brain Implantable Microbots. (doi: 10.1109/ICECS58634.2023.10382828)
Nesbitt, R., Shah, S. T., Wagih, M., Imran, M. A., Abbasi, Q. H., Ansari, S. (2023) Next-generation IoT: harnessing AI for enhanced localization and energy harvesting in backscatter communications. Electronics, 12, (doi: 10.3390/electronics12245020)
Pavlidou, A., Liang, X., Ghahremani Arekhloo, N., Li, H., Marquetand, J., Heidari, H. (2023) Spontaneous muscle activity classification with delay-based reservoir computing. APL Machine Learning, 1, (doi: 10.1063/5.0160927)
Hameed, H., Lubna, ., Usman, M., Abbas, H., Tahir, A., Arshad, K., Assaleh, K., Alkhayyat, A., Imran, M. A., Abbasi, Q. H. (2023) Contactless Privacy-Preserving Head Movement Recognition Using Deep Learning for Driver Fatigue Detection. (doi: 10.1109/ISNCC58260.2023.10323825)
Garcia, M. P., Gibson, D., Hughes, D. A., Garcia Nuñez, C. (2023) A refined quasi-static method for precise determination of piezoelectric coefficient of nanostructured standard and inclined thin films. Advanced Physics Research, (doi: 10.1002/apxr.202300091)
Ansari, S., Imran, M. A., Taha, A., Usman, M., Abbasi, Q. H. (2023) Conclusion. Institution of Engineering and Technology
Shawky, M. A., Sohaib, R. M., Usman, M., Abbasi, Q. H., Imran, M. A., Ansari, S., Taha, A. (2023) Cooperative intelligent transport systems for net-zero. Institution of Engineering and Technology
Abualhayjaa, M., Hassouna, S., Centeno, A., Abbasi, Q. H., Ur Rehman, M., Imran, M. A., Mohjazi, L. (2023) Intelligent reflective surfaces (IRSs) for green networks. Institution of Engineering and Technology
Wagih, M., Vital, D. (2023) Sustainable RF wireless power transfer and energy harvesting and their applications. Institution of Engineering and Technology
(2023) The Role of 6G and Beyond on the Road to Net-Zero Carbon. (doi: 10.1049/PBTE108E)
Wang, J., Ofiare, A., CHENG, H., Wasige, E., Li, C. (2023) Benchmarking a High Electron Mobility Transistor Using an Active Load-Pull System at 120 GHz -170 GHz.
Jiang, Y., Zhong, M., Ma, Y., Khusna, E. M., Yi, Y., Ofiare, A., Al-Taai, Q., Al-Moathin, A., Li, C. (2023) An X-band Lens Antenna Based on Metasurface. (doi: 10.1109/UCMMT58116.2023.10310524)
Hameed, H., Elsayed, M., Farooq, M., Kaur, J., Usman, M., Hussain, A., Abd El-Latif, A. A., Imran, M., Abbasi, Q. H. (2023) Non-Invasive Hand Gestures Recognition With Machine Learning Algorithms. (doi: 10.1201/9781003614197-12)
Taylor, W., Nioche, A., Murray-Smith, R., Cooper, J., Abbasi, Q., Imran, M. (2023) Contactless Healthcare Monitoring System Performance Analysis of Multiple Devices. (doi: 10.1109/IMBioC56839.2023.10305099)
Chen, Z., Tang, C., Ge, Y., Imran, M., Abbasi, Q. H. (2023) Integrating RF-Visual Technologies for Improved Speech Recognition in Hearing Aids. (doi: 10.1109/IMBioC56839.2023.10305132)
Wagih, M., Bruce, N. (2023) The Limits of Implantable Bluetooth Links in DIY Gel Phantoms: A Channel Gain Evaluation. (doi: 10.1109/IMBioC56839.2023.10305124)
Li, C., Ofiare, A., Wang, J., Cheng, H., Al-Khalidi, A., Wasige, E. (2023) Case Studies on Millimetre-wave and Terahertz On-chip Circuit Test Cluster for 6G Communications and Beyond programme at the University of Glasgow.
Tajabadi, A., Abbas, H., Imran, M., Abbasi, Q. H., Roy, V. A. L. (2023) Design Workflow for Lenz Lens-based NMR Probe.
Orchard, J. R., Ivanov, P., McKenzie, A. F., Hill, C. H., Javed, I., Munro, C. W., Kettle, J., Hogg, R. A., Childs, D. T.E., Taylor, R. J.E. (2023) Small signal modulation of photonic crystal surface emitting lasers. Scientific Reports, 13, (doi: 10.1038/s41598-023-45414-7)
Shojaei Baghini, M., Heidari, H. (2023) Magnetoelectric Bulk Acoustic Resonators for the Ultra High Frequency (UHF) Band.
Ghannam, R., Chan, C. (2023) Teaching undergraduate students to think like real-world systems engineers: a technology-based hybrid learning approach. Systems Engineering, 26, pp. 728-741. (doi: 10.1002/sys.21683)
Hassan, A. G., Sumaid, M., Ahmed, F., Shoaib, N., Abbasi, Q. H., Nikolaou, S. (2023) Reconfigurable absorptive and polarization conversion metasurface consistent for wide angles of incidence. Scientific Reports, 13, (doi: 10.1038/s41598-023-45351-5)
Lin, X., Liu, Y., Zhang, L., Tukmanov, A., Abbasi, Q., Imran, M. A. (2023) Beamforming on Reconfigurable Intelligent Surface: a Codebook Design for Spatial Coverage with Beam Squint Effect. (doi: 10.1109/ICCWorkshops57953.2023.10283606)
Al-Moathin, A., Zhong, M., Al-Taai, Q., Jiang, Y., Farage, M., Kazim, J. u. R., Ali, M. Z., Nikbakhtnasrabadi, F., Powell, M., Khartri, P., Stanley, M., Rossi, A., Heidari, H., Imran, M. A., Abbasi, Q. H., Ridler, N. M., Weides, M., Li, C. (2023) Characterization of a Compact Wideband Microwave Metasurface Lens for Cryogenic Applications. (doi: 10.1109/ARFTG57476.2023.10279542)
Pervez, K., Aman, W., Ur Rahman, M. M., Nawaz, M. W., Abbasi, Q. H. (2023) Hand-breathe: non-contact monitoring of breathing abnormalities from hand palm. IEEE Sensors Journal, 23, pp. 25136-25143. (doi: 10.1109/JSEN.2023.3246631)
Lee, C. S., Lou, Y., Li, M., Abbasi, Q. H., Imran, M. (2023) Locating nidi for high-frequency chest wall oscillation smart therapy via acoustic imaging of lung airways as a spatial network. IEEE Access, 11, pp. 109408-109421. (doi: 10.1109/ACCESS.2023.3317443)
Ahmad, N., Nawaz, H., Shoaib, N., Abbasi, Q. H., Nikolaou, S. (2023) Ambiguity resolution in amplitude comparison-based monopulse direction finding antenna systems. IEEE Antennas and Wireless Propagation Letters, 22, pp. 2605-2609. (doi: 10.1109/LAWP.2023.3298664)
Ramzan, N., Liaqat, S., Tahir, A., Abbas, H., Kirn, N., Imran, A. M., Abbasi, Q. (2023) A Vital Signs Monitoring System.
Williams, C., Michaels, H., Crossland, A. F., Zhang, Z., Shirshova, N., MacKenzie, R. C.I., Sun, H., Kettle, J., Freitag, M., Groves, C. (2023) Decarbonising electrical grids using photovoltaics with enhanced capacity factors. Energy and Environmental Science, 16, pp. 4650-4659. (doi: 10.1039/D3EE00633F)
Abbott, R. et al. (2023) Search for gravitational waves associated with fast radio bursts detected by CHIME/FRB during the LIGO–Virgo observing run O3a. Astrophysical Journal, 955, (doi: 10.3847/1538-4357/acd770)
Kürner, T. et al. (2023) 6G Technology Overview (third edition)
Shah, S. A., Abbasi, Q. H., Ahmad, J., Imran, M. A. (2023) Advanced sensing techniques for intelligent human activity recognition using machine learning. Electronics, 12, (doi: 10.3390/electronics12193990)
Assi, D. S., Huang, H., Kandira, K. U., Alsulaiman, N. S., Theja, V. C. S., Abbas, H., Karthikeyan, V., Roy, V. A. L. (2023) Charge mediated Copper Iodide based artificial synaptic device with ultrahigh neuromorphic efficacy. Physica Status Solidi - Rapid Research Letters, 17, (doi: 10.1002/pssr.202300191)
Lubna, , Mufti, N., Ullah, S., Sharif, A., Nawaz, M. W., Alkhayyat, A., Imran, M. A., Abbasi, Q. H. (2023) IoT enabled vehicle recognition system using inkjet-printed windshield tag and 5G cloud network. Internet of Things, 23, (doi: 10.1016/j.iot.2023.100873)
Shah, A., Niksan, O., Jain, M. C., Colegrave, K., Wagih, M., Zarifi, M. H. (2023) Microwaves see thin ice: a review of ice and snow sensing using microwave techniques. IEEE Microwave Magazine, 24, pp. 24-39. (doi: 10.1109/MMM.2023.3293617)
Cheng, H., Wang, J., Kelly, J., Li, C. (2023) Recent Development of THz InP HEMTs at the University of Glasgow.
Bhatti, S., Manzoor, H. U., Michel, B., Bonilla, R. S., Abrams, R., Zoha, A., Hussain, S., Ghannam, R. (2023) Revolutionizing low-cost solar cells with machine learning: a systematic review of optimization techniques. Advanced Energy and Sustainability Research, 10, (doi: 10.1002/aesr.202300004)
Li, S., Zhu, S., Huang, Y., Liu, S., Zeng, B., Imran, M. A., Abbasi, Q. H., Cooper, J. (2023) Short-long-term propagation-based video inpainting. IEEE MultiMedia, 30, pp. 91-104. (doi: 10.1109/MMUL.2023.3309476)
Ullah, I., Wagih, M., Sun, Y., Li, Y., Hajdu, K., Courson, R., Dreanno, C., Prado, E., Komolafe, A., Harris, N. R., White, N. M., Beeby, S. (2023) Wirelessly powered drug-free and anti-infective smart bandage for chronic wound care. IEEE Transactions on Biomedical Circuits and Systems, 17, pp. 900-915. (doi: 10.1109/TBCAS.2023.3277318)
Kelly, J., Wang, J., Cheng, H., Ofiare, A., Li, C. (2023) Temperature Dependent Hall Parameter Measurements of Heterogeneous InGaAs/InP Ultrafast Transistors.
Hussain, N., Aljaloud, K., Hussain, R., Alqahtani, A. H., Khan, Z. U., Tahir, F. A., Abbasi, Q. H. (2023) Dual-sense slot-based CP MIMO antenna with polarization bandwidth reconfigurability. Scientific Reports, 13, (doi: 10.1038/s41598-023-42569-1)
Ge, Y., Li, W., Farooq, M., Qayyum, A., Wang, J., Chen, Z., Cooper, J., Imran, M. A., Abbasi, Q. H. (2023) LoGait: LoRa sensing system of human gait recognition using dynamic time wraping. IEEE Sensors Journal, 23, pp. 21687-21697. (doi: 10.1109/JSEN.2023.3297438)
Pelayo Garcia, M., García Núñez, C., Gibson, D., Hughes, D. (2023) Piezoelectric device and method of forming.
Ghannam, R. (2023) Active Learning and Interactive Electronics for Teaching Engineering.
Cerezo-Sanchez, M., McGlynn, E., Bartoletti, S., Prasad Yalagala, B., Casadei Garofani, B., Capodiferro, A., Russell, E., Palazzolo, G., Walton, F., Curia, G., Heidari, H. (2023) Bioresorbable insertion aids for brain implantable flexible probes: a comparative study on silk fibroin, alginate, and disaccharides. Advanced NanoBiomed Research, 3, (doi: 10.1002/anbr.202200117)
Romeira, B., Adão, R., Nieder, J. B., Al-Taai, Q., Zhang, W., Hadfield, R. H., Wasige, E., Hejda, M., Hurtado, A., Malysheva, E., Dolores-Calzadilla, V., Lourenço, J., Alves, D. C., Figueiredo, J. M.L., Ortega-Piwonka, I., Javaloyes, J., Edwards, S., Davies, J. I., Horst, F., Offrein, B. J. (2023) Brain-inspired nanophotonic spike computing: challenges and prospects. Neuromorphic Computing and Engineering, 3, (doi: 10.1088/2634-4386/acdf17)
Kazim, J. u. R., Tahir, A., Rains, J., Cui, T. J., Jabbar, A., Jamshed, M. A., Ur-Rehman, M., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2023) In-home monitoring using wireless on the walls for future healthcare: real-world demonstration. Advanced Intelligent Systems, 5, (doi: 10.1002/aisy.202300007)
Al-Taai, Q. R., Hejda, M., Zhang, W., Romeira, B., Figueiredo, J. M.L., Wasige, E., Hurtado, A. (2023) Optically-triggered deterministic spiking regimes in nanostructure resonant tunnelling diode-photodetectors. Neuromorphic Computing and Engineering, 3, (doi: 10.1088/2634-4386/acf609)
Ali, M. Z., Abdoalbaset, A., Usman, M., Zahid, A., Heidari, H., Imran, M. A., Abbasi, Q. H. (2023) Quantum for 6G communication: a perspective. IET Quantum Communication, 4, pp. 112-124. (doi: 10.1049/qtc2.12060)
Hassouna, S., Jamshed, M. A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2023) Rate optimization using low complex methods with reconfigurable intelligent surfaces. Journal of Information and Intelligence, 1, pp. 267-280. (doi: 10.1016/j.jiixd.2023.06.004)
Beniwal, A., Ganguly, P., Gond, R., Rawat, B., Li, C. (2023) Room temperature operated PEDOT: PSS based flexible and disposable NO2 gas sensor. IEEE Sensors Letters, 7, (doi: 10.1109/lsens.2023.3308518)
Nourinovin, S., Rahman, M. M., Philpott, M. P., Abbasi, Q. H., Alomainy, A. (2023) Terahertz characterisation of ordinary and aggressive types of oral squamous cell carcinoma as a function of cancer stage and treatment efficiency. IEEE Transactions on Instrumentation and Measurement, 72, (doi: 10.1109/TIM.2023.3312469)
Saeed, U., Shah, S. A., Ghadi, Y. Y., Khan, M. Z., Ahmad, J., Shah, S. I., Hameed, H., Abbasi, Q. (2023) Extracting visual micro-doppler signatures from human lips motion using UoG radar sensing data for hearing aid applications. IEEE Sensors Journal, 23, pp. 22111-22118. (doi: 10.1109/JSEN.2023.3308972)
Abdellatif, S. O., Moustafa, A., Khalid, A., Ghannam, R. (2023) Integration of capacitive pressure sensor-on-chip with lead-free perovskite solar cells for continuous health monitoring. Micromachines, 14, (doi: 10.3390/mi14091676)
Ejaz, A., McKinlay, M., Ahmadzadeh, S., Garcia, M. P., Fleming, L., Mazur, P., Mazur, M., Gibson, D., Garcia Nunez, C. (2023) Investigation and band gap analysis of pulsed Dc magnetron sputtered diamond‐like carbon to enhance contact‐electrification and durability of triboelectric nanogenerators. Advanced Materials Technologies, 8, (doi: 10.1002/admt.202300450)
Asim, M., Ozair Iqbal, M., Aman, W., Ur Rahman, M., Abbasi, Q. H. (2023) Pathloss-based non-Line-of-Sight Identification in an Indoor Environment: An Experimental Study.
McGann, G., Garcia Nuñez, C., Fleming, L., Hutson, D., Waddell, E., Gibson, D. (2023) Band gap engineering of Pb1-xCdxSe thin films providing mid-IR photoluminescent based light emitting diodes for use in non-dispersive infrared gas sensors. IEEE Sensors Letters, (doi: 10.1109/LSENS.2023.3307081)
Nawaz, M. W., Popoola, O., Imran, M. A., Abbasi, Q. H. (2023) K-DUMBs IoRT: Knowledge Driven Unified Model Block Sharing in the Internet of Robotic Things. (doi: 10.1109/VTC2023-Spring57618.2023.10200507)
Farooq, M., Shawky, M. A., Fatima, A., Tahir, A., Khan, M. Z., Abbas, H., Imran, M., Abbasi, Q. H., Taha, A. (2023) Room-Level Activity Classification from Contextual Electricity Usage Data in a Residential Home. (doi: 10.1109/ITC-Egypt58155.2023.10206425)
Shojaei Baghini, M., Broekens, K., Oderwald, M., Breedveld, P., Heidari, H., van der Heiden, M. (2023) Fiber-Bragg-Grating Coupled Magnetostrictive Sensors for Magnetic Tracking of Biomedical Implants. (doi: 10.1109/NEWCAS57931.2023.10198071)
Zhang, J., Wagih, M., Hoare, D., Mirzai, N., Mercer, J., Das, R., Heidari, H. (2023) Highly Integrated and Ultra-Compact Rectenna with Wireless Powering for Implantable Vascular Devices. (doi: 10.1109/NEWCAS57931.2023.10198083)
Mushtaq, M., Wani, M. I., Saquib, S., Ahmad, M., Somappa, L., Baghini, M. S., Heidari, H., Malik, S. (2023) Mismatch and Offset-Voltage Compensation Technique for Current Excitation Based Resistive Sensors Interface. (doi: 10.1109/NEWCAS57931.2023.10198102)
Cheng, Y., Zuo, S., Ranford-Cartwright, L., Mirzai, N., Heidari, H. (2023) Portable Diagnostic Platform for Rapid Detection of 2μL Paramagnetic Particles in 5s. (doi: 10.1109/NEWCAS57931.2023.10198080)
Pecunia, V. et al. (2023) Roadmap on energy harvesting materials. Journal of Physics: Materials, 6, (doi: 10.1088/2515-7639/acc550)
Linardopoulou, K., Viora, L., Fioranelli, F., Le Kernec, J., Abbasi, Q., King, G., Jonsson, N. (2023) Time-series Observations of Cattle Mobility: Accurate Label Assignment from Multiple Assessors, and Association with Lesions Detected in the Feet.
Sharif, A., kumar, R., Arshad, K., Assaleh, K., Chattha, H. T., Imran, M. A., Abbasi, Q. H. (2023) Nature-inspired spider web shaped UHF RFID reader antenna for IoT and healthcare applications. Scientific Reports, 13, (doi: 10.1038/s41598-023-39825-9)
Hameed, H., Usman, M., Tahir, A., Ahmad, K., Hussain, A., Imran, M. A., Abbasi, Q. H. (2023) Recognizing British sign language using deep learning: a contactless and privacy-preserving approach. IEEE Transactions on Computational Social Systems, 10, pp. 2090-2098. (doi: 10.1109/TCSS.2022.3210288)
Xia, Y., Yuan, M., Dobrea, A., Li, C., Heidari, H., Mottram, N., Ghannam, R. (2023) Reconfigurable wearable antenna for 5G applications using nematic liquid crystals. Nano Select, 4, pp. 513-524. (doi: 10.1002/nano.202200209)
Tajabadi, A. M.A.A.S., Dehghani, P., Assi, D. S., Karthikeyan, V., Huang, C.-B., Abbas, H. T., Roy, V. A.L. (2023) Compact magnetic field amplification by tuned Lenz lens. IEEE Sensors Journal, (doi: 10.1109/JSEN.2023.3297254)
Chishti, A. R., Aziz, A., Hussain, R., Hassan, F., Algarni, A., Abbasi, Q. H. (2023) Shared Aperture Folded Dipole Antenna for Wireless Biomedical Applications.
Hassouna, S., Jamshed, M. A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2023) Configuring reconfigurable intelligent surfaces using a practical codebook approach. Scientific Reports, 13, (doi: 10.1038/s41598-023-31596-7)
Jabbar, A., Pang, Z., Safdar, G. A., Abbasi, Q., Imran, M., Ur Rehman, M. (2023) A Compact Wideband Millimeter-Wave Beam-Scanning Antenna Array for Industry 4.0 and Beyond Applications. (doi: 10.1109/iWAT57058.2023.10171680)
Lu, P., Wagih, M., Goussetis, G., Shinohara, N., Song, C. (2023) A comprehensive survey on transmitting antenna systems with synthesized beams for microwave wireless power transmission. IEEE Journal of Microwaves, 3, pp. 1081-1101. (doi: 10.1109/jmw.2023.3285825)
Lee, C. S., Li, M., Lou, Y., Abbasi, Q., Imran, M. (2023) Acoustic lung imaging utilized in continual assessment of patients with obstructed airway: a systematic review. Sensors, 23, (doi: 10.3390/s23136222)
Cumming, D. R.S., Pusino, V. (2023) Addressable Monolithic InSb on GaAs Focal Plane Arrays for MWIR Imaging. (doi: 10.1109/IWASI58316.2023.10164484)
Buttar, H. M., Aman, W., Rahman, M. M. U., Abbasi, Q. H. (2023) Countering active attacks on RAFT-based IoT blockchain networks. IEEE Sensors Journal, 23, pp. 14691-14699. (doi: 10.1109/JSEN.2023.3274687)
Zante, G., Daskalopoulou, E., Elgar, C. E., Marin Rivera, R., Hartley, J., Simpson, K., Tuley, R., Kettle, J., Abbott, A. P. (2023) Targeted recovery of metals from thermoelectric generators (TEGs) using chloride brines and ultrasound. RSC Sustainability, 1, pp. 1025-1034. (doi: 10.1039/D3SU00087G)
Jabbar, A., Jamshed, M. A., Abbasi, Q., Imran, M. A., Ur-Rehman, M. (2023) 60 GHz High Gain Planar Antenna Array for Millimeter-Wave Industrial Applications. (doi: 10.1109/USNC-URSI52151.2023.10237884)
Shareef, A. A., Kaur, J., Imran, M. A., Ali, H. T. M., Abbasi, Q. H., Abbas, H. T. (2023) A Statistical Analysis of Feature Transformation for Efficient Localisation in Urban Environments. (doi: 10.1109/USNC-URSI52151.2023.10238286)
Han, R., Abohmra, A., Nourinovin, S., Pires, T., Ur Rehman, M., Alomainy, A., Ponciano, J., Imran, M., Abbasi, Q. H. (2023) A Terahertz Photoconductive Antenna Design for Gain Enhancement Based on the Chinese Totem Tai-Chi. (doi: 10.1109/USNC-URSI52151.2023.10238226)
Pires, T., Han, R., Nourinovin, S., Abbas, H., Alomainy, A., Imran, M. A., Abbasi, Q. (2023) Comparison between a Highly Sensitive H-shape Terahertz Metasurface Absorber and an EIT-like Terahertz Metasurface for Refractive Index Biosensing.
Khan, M. Z., Qayyum, A., Arshad, K., Assaleh, K., Abbas, H., Imran, M. A., Abbasi, Q. H. (2023) Contactless Fall Detection using RFID Wall and AI. (doi: 10.1109/USNC-URSI52151.2023.10238313)
Jabbar, A., Abbasi, Q., Imran, M. A., Ur-Rehman, M. (2023) Design of Efficient and Wideband 60 GHz Series-Fed Millimeter-Wave Antenna Array for Next-Generation Multi-Gigabit Industrial Applications. (doi: 10.1109/USNC-URSI52151.2023.10237573)
Abbasi, Q. H., Totten, E., Devlin, M., Abdoalbaset, A., Imran, M. A. (2023) Design of Graphene-based Thermal Mitigation for Phase Array Antenna Systems. (doi: 10.1109/USNC-URSI52151.2023.10238327)
Hassouna, S., Ur Rehman Kazim, J., Rains, J., Jamshed, M. A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2023) Indoor Field Trials for RIS-aided Wireless Communications. (doi: 10.1109/USNC-URSI52151.2023.10237732)
Farooq, M., Qayyum, A., Ge, Y., Khan, M. Z., Taha, A., Imran, M. A., Abbasi, Q. H., Abbas, H. T. (2023) LoRa-based Privacy-Aware and Contactless Surveillance in Next-generation Smart Homes. (doi: 10.1109/USNC-URSI52151.2023.10238314)
Nowack, T. S., Shah, Y. D., Grant, J. P., Escorcia Carranza, I., Kenney, M. G., Faccio, D., Wasige, E., Cumming, D. R.S. (2023) Metasurface optics with on-axis polarization control for terahertz sensing applications. IEEE Transactions on Terahertz Science and Technology, 13, pp. 373-380. (doi: 10.1109/TTHZ.2023.3263648)
Griffiths, G. J., Alkaraki, S., Aslam, M., Abbasi, Q. H., Evans, A., Jilani, S. F. (2023) Millimeter-wave Defected Ground Structure-based MIMO Antenna for 6G Wireless Applications. (doi: 10.1109/USNC-URSI52151.2023.10238146)
Hussain, R., Al-Garni, A., Iqbal, S. S., Abbasi, Q. H. (2023) Multi-Band CubeSat Antenna and Design Considerations for Space Environment. (doi: 10.1109/USNC-URSI52151.2023.10238047)
Wagih, M., Whittaker, T., Whittow, W. G. (2023) Phased Array-Free Multi-Directional 5.8 GHz Wireless Power Transmission Using A Fresnel Lens. (doi: 10.1109/USNC-URSI52151.2023.10237659)
Wagih, M. (2023) RF Energy Harvesting using Complex-Conjugate Rectennas Along Single-Wire Transmission Lines. (doi: 10.1109/USNC-URSI52151.2023.10237703)
Liu, Y., Li, H., Liang, X., Deng, H., Zhang, X., Heidari, H., Ghannam, R., Zhang, X. (2023) Speech recognition using intelligent piezoresistive sensor based on polystyrene sphere microstructures. Advanced Intelligent Systems, 5, (doi: 10.1002/aisy.202200427)
Zubair, M., Akinsolu, M. O., Abohmra, A., Imran, M. A., Liu, B., Abbasi, Q. H. (2023) Terahertz Antenna Design Using Machine Learning Assisted Global Optimization Techniques. (doi: 10.1109/USNC-URSI52151.2023.10237823)
Keel, E., Ejaz, A., Mckinlay, M., Garcia, M. P., Caffio, M., Gibson, D., Garcia Nunez, C. (2023) Three-dimensional graphene foam based triboelectric nanogenerators for energy systems and autonomous sensors. Nano Energy, 112, (doi: 10.1016/j.nanoen.2023.108475)
Alblaihed, K. A., Abbasi, Q. H., Imran, M. A., Mohjazi, L. (2023) Wideband of Microstrip Patch Antenna for 28 GHz 5G Applications. (doi: 10.1109/USNC-URSI52151.2023.10237641)
Kazim, J. u. R., Ali, M. Z., Al-Moathin, A., Nikbakhtnasrabadi, F., Khatri, P., Powell, M., Stanley, M., Ridler, N. M., Rossi, A., Weides, M., Heidari, H., Imran, M. A., Abbasi, Q. H., Li, C. (2023) Wireless Microwave Signal Transmission for Cryogenic Applications. (doi: 10.1109/USNC-URSI52151.2023.10237549)
Wagih, M., Song, C. (2023) mmWave Wireless Power Transmission to Flexible Rectennas in Absorptive and Reflective Media. (doi: 10.1109/USNC-URSI52151.2023.10237399)
Guan, L., Wu, T., Yang, X., Zhao, N., Zhang, Z., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2023) Multiperson respiratory monitoring using single-channel continuous-wave radar with time modulated array. IEEE Transactions on Instrumentation and Measurement, 72, (doi: 10.1109/TIM.2023.3287258)
Chishti, A. R., Aziz, A., Aljaloud, K., Tahir, F. A., Abbasi, Q. H., Khan, Z. U., Hussain, R. (2023) A sub 1 GHz ultra miniaturized folded dipole patch antenna for biomedical applications. Scientific Reports, 13, (doi: 10.1038/s41598-023-36747-4)
Yassin, M. E., Hussein, K. F. A., Abbasi, Q. H., Imran, M. A., Mohassieb, S. A. (2023) Flexible antenna with circular/linear polarization for wideband biomedical wireless communication. Sensors, 23, (doi: 10.3390/s23125608)
Kazim, J. U. R., Rains, J., Abbas, H., Imran, M. A., Abbasi, Q. H. (2023) Future Healthcare Enabled by Reconfigurable Intelligent Surfaces.
Le Kernec, J., Li, Z., Abbasi, Q. H., Romain, O., Fioranelli, F., Yang, S. (2023) Method and Device for Human Activity Classification Using Radar Micro Doppler and Phase.
Dhongde, A., Ofiare, A., Karami, K., Wasige, E. (2023) Buffer-Free GaN-on-SiC HEMTs with Bond Pad Heat Sinks.
Wang, J., Li, Q., Kelly, J., Li, C. (2023) Investigation of Noise Performance of AlGaN/GaN HEMTs.
Wang, J., Li, Q., Kelly, J., Li, C. (2023) Noise Performance and RF Performance of AlGaN/GaN HEMTs on Diamond Substrate.
Wang, Z., Ren, A., Zhang, Q., Zahid, A., Abbasi, Q. H. (2023) Recognition of approximate motions of human based on micro-doppler features. IEEE Sensors Journal, 23, pp. 12388-12397. (doi: 10.1109/JSEN.2023.3267820)
Saeed, U., Shah, S. A., Khan, M. Z., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Imran, M. A., Abbasi, Q. H. (2023) Software-defined radio based contactless localization for diverse human activity recognition. IEEE Sensors Journal, 23, pp. 12041-12048. (doi: 10.1109/JSEN.2023.3265867)
Leitenstorfer, A. et al. (2023) The 2023 Terahertz Science and Technology Roadmap. Journal of Physics D: Applied Physics, 56, (doi: 10.1088/1361-6463/acbe4c)
Zhang, J., Das, R., Hoare, D., Wang, H., Ofiare, A., Mirzai, N., Mercer, J., Heidari, H. (2023) A compact dual-band implantable antenna for wireless biotelemetry in arteriovenous grafts. IEEE Transactions on Antennas and Propagation, 71, pp. 4759-4771. (doi: 10.1109/TAP.2023.3266786)
Asad, S. M., Klaine, P. V., Rais, R. N. B., Mollel, M. S., Hussain, S., Abbasi, Q. H., Imran, M. A. (2023) Context-aware handover skipping for train passengers in next generation wireless networks. Journal of Communications and Networks, 25, pp. 285-298. (doi: 10.23919/JCN.2023.000016)
Karami, K., Dhongde, A., Cheng, H., Reynolds, P. M., Reddy, B. A., Ritter, D., Li, C., Wasige, E., Thoms, S. (2023) Robust sub-100 nm T-Gate fabrication process using multi-step development. Micro and Nano Engineering, 19, (doi: 10.1016/j.mne.2023.100211)
Zhao, J., Parvizi, R., Ghannam, R., Law, M.-K., Walton, F., Imran, M. A., Heidari, H. (2023) Self-powered implantable CMOS photovoltaic cell with 18.6% efficiency. IEEE Transactions on Electron Devices, 70, pp. 3149-3154. (doi: 10.1109/TED.2023.3268630)
Shi, L.-F., Zahid, A., Ren, A., Ali, M. Z., Yue, H., Imran, M. A., Shi, Y., Abbasi, Q. H. (2023) The perspectives and trends of THz technology in material research for future communication - a comprehensive review. Physica Scripta, 98, (doi: 10.1088/1402-4896/accd9d)
Wagih, M., Nesbitt, R., Ansari, S., Abbasi, Q. H., Imran, M. A. (2023) RFID-Enabled Energy Harvesting using Unidirectional Electrically-Small Rectenna Arrays. (doi: 10.23919/EuCAP57121.2023.10133250)
Bairaktarova, D., Valentine, A., Ghannam, R. (2023) The use of extended reality (XR), wearable, and haptic technologies for learning across engineering disciplines. Routledge
Alomari, S., Al-Taai, Q., Elksne, M., Al-Khalidi, A., Wasige, E., Figueiredo, J. (2023) Speed limitations of resonant tunneling diode-based photodetectors. Optics Express, 31, pp. 18300-18317. (doi: 10.1364/OE.486701)
Ghahremani Arekhloo, N., Parvizi, H., Zuo, S., Wang, H., Nazarpour, K., Marquetand, J., Heidari, H. (2023) Alignment of magnetic sensing and clinical magnetomyography. Frontiers in Neuroscience, 17, (doi: 10.3389/fnins.2023.1154572)
Sharif, A., Kumar, R., Althobaiti, T., Alotaibi, A. A., Safi, L., Ramzan, N., Imran, M. A., Abbasi, Q. H. (2023) Bio-inspired circular polarized UHF RFID tag design using characteristic mode analysis. IEEE Sensors Journal, 23, pp. 10847-10855. (doi: 10.1109/JSEN.2023.3262323)
Kaur, J., Shawky, M., Mollel, M. S., Popoola, O., Imran, M. A., Abbasi, Q. H., Abbas, H. T. (2023) AI-enabled CSI fingerprinting for indoor localisation towards context-aware networking in 6G. (doi: 10.1109/WCNC55385.2023.10118652)
Zaidi, B. A., Shawky, M. A., Taha, A., Abbasi, Q. H., Imran, M. A., Ansari, S. (2023) An Efficient Deep Learning-based Spectrum Awareness Approach for Vehicular Communication. (doi: 10.1109/WCNC55385.2023.10118615)
Hassouna, S., Jamshed, M. A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2023) Investigating the Data Rate of Intelligent Reflecting Surfaces with Mutual Coupling and EMI. (doi: 10.1109/WCNC55385.2023.10118853)
Abualhayja'a, M., Centeno, A., Mohjazi, L., Abbasi, Q., Imran, M. (2023) On the Outage Performance of Reconfigurable Intelligent Surface-Assisted UAV Communications. (doi: 10.1109/WCNC55385.2023.10118821)
Ge, Y., Wang, J., Li, S., Qi, L., Zhu, S., Cooper, J., Imran, M. A., Abbasi, Q. H. (2023) WiFi sensing of Human Activity Recognition using Continuous AoA-ToF Maps. (doi: 10.1109/WCNC55385.2023.10118954)
Abbasi, Q. H., Tang, C., Ghadban, N., Hameed, H., Usman, M., Hussain, A., Imran, M. A. (2023) Towards AI-assisted RF hearing aids. ENT and Audiology News, 32,
Wang, Y., Huang, T., Jin, S., Wang, C., Shen, H., Li, C., Li, Y., Wu, W. (2023) A self-biased GaN LNA with 30 dB Gain and 21 dBm P1dB for 5G communications. International Journal of Microwave and Wireless Technologies, 15, pp. 547-553. (doi: 10.1017/S175907872200085X)
Shawky, M. A., Usman, M., Flynn, D., Imran, M. A., Abbasi, Q. H., Ansari, S., Taha, A. (2023) Blockchain-based secret key extraction for efficient and secure authentication in VANETs. Journal of Information Security and Applications, 74, (doi: 10.1016/j.jisa.2023.103476)
Kapoulea, S., Ahmad, M., Weides, M., Heidari, H. (2023) Cryo-CMOS Mixed-Signal Circuits for Scalable Quantum Computing: Challenges and Future Steps. (doi: 10.1109/ISCAS46773.2023.10182164)
Wagih, M. (2023) Engaging the public: using microwave wireless “chargers” to charge the interest of future engineers [Speaker’s Corner] IEEE Microwave Magazine, 24, pp. 150-153. (doi: 10.1109/MMM.2023.3242497)
Aljaloud, K., Sultan, K., Ikram, M., Alqahtani, A. H., Abbasi, Q. H., Hussain, R. (2023) Low-profile antenna system for cognitive radio in IoST CubeSat applications. Sensors, 23, (doi: 10.3390/s23104782)
Tsegay, F., Ghannam, R., Daniel, N., Butt, H. (2023) 3D printing smart eyeglass frames: a review. ACS Applied Engineering Materials, 1, pp. 1142-1163. (doi: 10.1021/acsaenm.2c00265)
Grant, K., Zhang, S., Kettle, J. (2023) Improving the Sustainability of Printed Circuit Boards Through Additive Printing. (doi: 10.1109/sustech57309.2023.10129587)
Khan, G. H., Khan, N. A., Bin Altaf, M. A., Abbasi, Q. (2023) A shallow autoencoder framework for epileptic seizure detection in EEG signal. Sensors, 23, (doi: 10.3390/s23084112)
Shawky, M. A., Shah, S. T., Abbasi, Q. H., Hussein, M., Imran, M. A., Hasan, S. F., Ansari, S., Taha, A. (2023) RIS enabled secret key generation for secured vehicular communication in the presence of denial-of-service attacks. Sensors, 23, (doi: 10.3390/s23084104)
Lubna, , Zahid, A., Mufti, N., Ullah, S., Nawaz, M. W., Sharif, A., Imran, M. A., Abbasi, Q. H. (2023) IoT enabled vacant parking slot detection system using inkjet-printed RFID tags. IEEE Sensors Journal, 23, pp. 7828-7835. (doi: 10.1109/JSEN.2023.3246382)
Wang, W., De Souza, M. M., Ghannam, R., Li, W. J., Roy, V. A.L. (2023) A novel micro-scaled multi-layered optical stress sensor for force sensing. Journal of Computational Electronics, 22, pp. 768-782. (doi: 10.1007/s10825-023-02014-y)
Abbasi, Q. H. (2023) AP-S Young Professional Ambassador Program update [Young Professionals] IEEE Antennas and Propagation Magazine, 65, pp. 126-129. (doi: 10.1109/MAP.2023.3240067)
Das, S. K., Benkhelifa, F., Sun, Y., Abumarshoud, H., Abbasi, Q. H., Imran, M. A., Mohjazi, L. (2023) Comprehensive review on ML-based RIS-enhanced IoT systems: basics, research progress and future challenges. Computer Networks, 224, (doi: 10.1016/j.comnet.2023.109581)
Nogueira, G. L., Kumar, D., Zhang, S., Alves, N., Kettle, J. (2023) Zero waste and biodegradable zinc oxide thin-film transistors for UV sensors and logic circuits. IEEE Transactions on Electron Devices, 70, pp. 1702-1709. (doi: 10.1109/TED.2023.3249126)
Taha, A., Barakat, B., Taha, M. M.A., Shawky, M. A., Lai, C. S., Hussain, S., Abideen, M. Z., Abbasi, Q. H. (2023) A comparative study of single and multi-stage forecasting algorithms for the prediction of electricity consumption using a UK-NHS hospital dataset. Future Internet, 15, (doi: 10.3390/fi15040134)
Wen, L., Sun, Z., Zheng, Q., Nan, X., Lou, Z., Liu, Z., Cumming, D. R.S., Li, B., Chen, Q. (2023) On-chip ultrasensitive and rapid hydrogen sensing based on plasmon-induced hot electron–molecule interaction. Light: Science and Applications, 12, (doi: 10.1038/s41377-023-01123-4)
Pires, T., Nourinovin, S., Abbas, H., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2023) Highly Sensitive Terahertz Electromagnetically Induced Transparency-Like Metasurface for Refractive Index Biosensing. (doi: 10.1109/IMAS55807.2023.10066946)
Saeed, U., Alqahtani, F., Shah, S. I., Ahmad, J., Abbasi, Q. H., Shah, S. A. (2023) Intelligent multimodal learning on body temperature monitoring: an observational study on RF radar sensing. Computer Systems Science and Engineering,
Han, R., Abohmra, A. A. Y., Nourinovin, S., Abbas, H., Ponciano, J., Shi, L.-F., Alomainy, A., Imran, M., Abbasi, Q. (2023) T-Ray Photoconductive Antenna Design for Biomedical Imaging Application. (doi: 10.1109/IMAS55807.2023.10066897)
Hameed, H., Lubna, L., Usman, M., Arshad, K., Hussain, A., Assaleh, K., Imran, M. A., Abbasi, Q. H. (2023) Identification of Hearing Impaired people in Crowded Environments using Wi-Fi signals.
Li, Z., Le Kernec, J., Abbasi, Q., Fioranelli, F., Yang, S., Romain, O. (2023) Radar-based human activity recognition with adaptive thresholding towards resource constrained platforms. Scientific Reports, 13, (doi: 10.1038/s41598-023-30631-x)
Song, S., Cai, S., Han, D., Garcia Nunez, C., Zhang, G., Wallace, G., Fleming, L., Craig, K., Reid, S., Martin, I. W., Rowan, S., Gibson, D. (2023) Tantalum oxide and silicon oxide mixture coatings deposited using microwave plasma assisted co-sputtering for optical mirror coatings in gravitational wave detectors. Applied Optics, 62, pp. B73-B78. (doi: 10.1364/ao.477211)
Liu, S., Yuan, X., Feng, W., Ren, A., Hu, Z., Ming, Z., Zahid, A., Abbasi, Q. H., Wang, S. (2023) A novel heteromorphic ensemble algorithm for hand pose recognition. Symmetry, 15, (doi: 10.3390/sym15030769)
Abubakar, A. I., Ahmad, I., Omeke, K. G., Ozturk, M., Ozturk, C., Abdel-Salam, A. M., Mollel, M. S., Abbasi, Q. H., Hussain, S., Imran, M. A. (2023) A survey on energy optimization techniques in UAV-based cellular networks: from conventional to machine learning approaches. Drones, 7, (doi: 10.3390/drones7030214)
Hassouna, S., Jamshed, M. A., Rains, J., Kazim, J. U. R., Ur Rehman, M., Abualhayja, M., Mohjazi, L., Cui, T. J., Imran, M. A., Abbasi, Q. H. (2023) A survey on reconfigurable intelligent surfaces: wireless communication perspective. IET Communications, 17, pp. 497-537. (doi: 10.1049/cmu2.12571)
Garcia Nunez, C., Wallace, G., Fleming, L., Craig, K., Song, S., Ahmadzadeh, S., Clark, C., Tait, S., Martin, I., Reid, S., Rowan, S., Gibson, D. (2023) Amorphous dielectric optical coatings deposited by plasma ion-assisted electron beam evaporation for gravitational wave detectors. Applied Optics, 62, pp. B209-B221. (doi: 10.1364/ao.477186)
Wang, Q., Li, W., Yu, Z., Abbasi, Q., Imran, M., Ansari, S., Sambo, Y., Wu, L., Li, Q., Zhu, T. (2023) An overview of emergency communication networks. Remote Sensing, 15, (doi: 10.3390/rs15061595)
Hejda, M., Malysheva, E., Owen-Newns, D., Al-Taai, Q. R. A., Zhang, W., Ortega-Piwonka, I., Javaloyes, J., Wasige, E., Dolores-Calzadilla, V., Figueiredo, J. M. L., Romeira, B., Hurtado, A. (2023) Artificial optoelectronic spiking neuron based on a resonant tunnelling diode coupled to a vertical cavity surface emitting laser. Nanophotonics, 12, pp. 857-867. (doi: 10.1515/nanoph-2022-0362)
Janjua, M. B., Abbas, H. T., Qaraqe, K. A., Arslan, H. (2023) Beam selection for ambient backscatter communication in beamspace mmWave symbiotic radio. IEEE Wireless Communications Letters, 12, pp. 560-564. (doi: 10.1109/LWC.2023.3235104)
Shawky, M. A., Jabbar, A., Usman, M., Imran, M., Abbasi, Q. H., Ansari, S., Taha, A. (2023) Efficient blockchain-based group key distribution for secure authentication in VANETs. IEEE Networking Letters, 5, pp. 64-68. (doi: 10.1109/LNET.2023.3234491)
Abohmra, A., Abbas, H., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2023) Flexible Terahertz Antenna Arrays based on Graphene for Body-Centric Wireless Communication. (doi: 10.23919/EuCAP57121.2023.10133572)
Rains, J., Kazim, J. U. R., Tukmanov, A., Zhang, L., Abbasi, Q., Imran, M. (2023) Fully-Addressable Varactor-Based Reflecting Metasurface with Dual-Linear Polarisation for Low Power Reconfigurable Intelligent Surfaces. (doi: 10.23919/EuCAP57121.2023.10133408)
Jabbar, A., Abbasi, Q., Pang, Z., Imran, M. A., Ur-Rehman, M. (2023) High Performance 60 GHz Beamforming Antenna Array For 5G and Beyond Industrial Applications. (doi: 10.23919/EuCAP57121.2023.10133620)
(2023) Intelligent Reconfigurable Surfaces (IRS) for Prospective 6G Wireless Networks. (doi: 10.1002/9781119875284)
Fabianczyk, R. D., Alkaraki, S., Aslam, M., Abbasi, Q., Evans, A., Jilani, S. F. (2023) Millimetre-Wave Multiple-Input-Multiple-Output Antenna Frontend for Beyond 5G Applications. (doi: 10.23919/EuCAP57121.2023.10133719)
Hassouna, S., Jamshed, M. A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2023) Reconfigurable Intelligent Surfaces Aided Wireless Communications with Electromagnetic Interference. (doi: 10.23919/EuCAP57121.2023.10133717)
Sun, Y., Sviridova, E., Kamp, M., Zhang, J., Kienle, L., Moran, D. A.J., Guselnikova, O., Ganin, A. Y. (2023) Elucidating catalytic sites governing the performance toward the hydrogen evolution reaction in ternary nitride electrocatalysts. ACS Applied Energy Materials, 6, pp. 1265-1273. (doi: 10.1021/acsaem.2c02941)
Li, Z., Fioranelli, F., Yang, S., Le Kernec, J., Abbasi, Q., Romain, O. (2023) Human Activity Classification with Adaptive Thresholding using Radar Micro-Doppler. (doi: 10.1109/Radar53847.2021.10028630)
Zhang, W., Hejda, M., Malysheva, E., Al-Taai, Q., Javaloyes, J., Wasige, E., Figueiredo, J. M. L., Calzadilla, V., Romeira, B., Hurtado, A. (2023) Tunable presynaptic weighting in optoelectronic spiking neurons built with laser-coupled resonant tunneling diodes. Journal of Physics D: Applied Physics, 56, (doi: 10.1088/1361-6463/aca914)
Haider, U. A., Noman, M., Ullah, H., Abutarboush, H. F., Abbasi, Q. H., Tahir, F. A. (2023) A fully passive 10-digit numeric keypad sensor using chipless RFID technology. IEEE Sensors Journal, 23, pp. 2978-2987. (doi: 10.1109/JSEN.2022.3232154)
Escobedo, P., Ramos-Lorente, C. E., Ejaz, A., Erenas, M. M., Martínez-Olmos, A., Carvajal, M. A., Garcia Nunez, C., de Orbe-Payá, I., Capitán-Vallvey, L. F., Palma, A. J. (2023) QRsens: Dual-purpose quick response code with built-in colorimetric sensors. Sensors and Actuators B: Chemical, 376, (doi: 10.1016/j.snb.2022.133001)
Shawky, M. A., Usman, M., Imran, M. A., Abbasi, Q. H., Ansari, S., Taha, A. (2023) Adaptive chaotic map-based key extraction for efficient cross-layer authentication in VANETs. Vehicular Communications, 39, (doi: 10.1016/j.vehcom.2022.100547)
Wang, Y., Fu, X., Wu, A., Huo, Y., Liu, C., Luan, P., Lei, L., Liang, F., Li, C. (2023) An advanced calibration method for probe leakage correction in on-wafer test systems. IEEE Transactions on Microwave Theory and Techniques, 71, pp. 682-690. (doi: 10.1109/TMTT.2022.3200050)
Malik, T., Hanif, N., Tahir, A., Abbas, S., Hanif, M. S., Tariq, F., Ansari, S., Abbasi, Q. H., Imran, M. A. (2023) Crowd control, planning, and prediction using sentiment analysis: an alert system for city authorities. Applied Sciences, 13, (doi: 10.3390/app13031592)
Rehman, M., Shah, R. A., Ali, N. A. A., Khan, M. B., Shah, S. A., Alomainy, A., Hayajneh, M., Yang, X., Imran, M. A., Abbasi, Q. H. (2023) Enhancing system performance through objective feature scoring of multiple persons' breathing using non-contact RF approach. Sensors, 23, (doi: 10.3390/s23031251)
Fan, H., Xie, H., Feng, Q., Bonizzoni, E., Heidari, H., McEwan, M. P., Ghannam, R. (2023) Interdisciplinary project-based learning: experiences and reflections from teaching electronic engineering in China. IEEE Transactions on Education, 66, pp. 73-82. (doi: 10.1109/TE.2022.3186184)
Xia, Y., Khamis, M., Fernandez, F. A., Heidari, H., Butt, H., Ahmed, Z., Wilkinson, T., Ghannam, R. (2023) State-of-the-art in smart contact lenses for human–machine interaction. IEEE Transactions on Human-Machine Systems, 53, pp. 187-200. (doi: 10.1109/THMS.2022.3224683)
Hussain, S., Abbas, H., Abbasi, Q., Imran, M. (2023) Metaverse for Engineering Education and Training.
Azargoshasb, T., Parvizi, R., Bozorgzadeh, F., Navid, H. A., Heidari, H. (2023) Smart green CQD@SiO2 hybrid coated optical fiber manifesting dual versatile absorptive and MIP features towards epinephrine detection. Nanoscale Advances, 5, pp. 459-470. (doi: 10.1039/D2NA00687A)
Shawky, M. A., Usman, M., Imran, M. A., Abbasi, Q. H., Ansari, S., Taha, A. (2023) Adaptive and Efficient Key Extraction for Fast and Slow Fading Channels in V2V Communications. (doi: 10.1109/VTC2022-Fall57202.2022.10012884)
Hu, C., Annese, V. F., Barrett, M. P., Cumming, D. R.S. (2023) Point-of-care platform for diagnosis of venous thrombosis by simultaneous detection of thrombin generation and D-dimer in human plasma. Analytical Chemistry, 95, pp. 1115-1122. (doi: 10.1021/acs.analchem.2c03819)
Yu, Z., Zahid, A., Taha, A., Taylor, W., Le Kernec, J., Heidari, H., Imran, M. A., Abbasi, Q. H. (2023) An intelligent implementation of multi-sensing data fusion with neuromorphic computing for human activity recognition. IEEE Internet of Things Journal, 10, pp. 1124-1133. (doi: 10.1109/JIOT.2022.3204581)
Qayyum, A., Tahir, A., Butt, M. A., Luke, A., Abbas, H. T., Qadir, J., Arshad, K., Assaleh, K., Imran, M. A., Abbasi, Q. H. (2023) Dental caries detection using a semi-supervised learning approach. Scientific Reports, 13, (doi: 10.1038/s41598-023-27808-9)
Ge, Y., Taha, A., Shah, S. A., Dashtipour, K., Zhu, S., Cooper, J., Abbasi, Q. H., Imran, M. A. (2023) Contactless WiFi sensing and monitoring for future healthcare - emerging trends, challenges and opportunities. IEEE Reviews in Biomedical Engineering, 16, pp. 171-191. (doi: 10.1109/RBME.2022.3156810)
Rains, J., Kazim, J. u. R., Tukmanov, A., Cui, T. J., Zhang, L., Abbasi, Q. H., Imran, M. A. (2023) High-resolution programmable scattering for wireless coverage enhancement: an indoor field trial campaign. IEEE Transactions on Antennas and Propagation, 71, pp. 518-530. (doi: 10.1109/TAP.2022.3216555)
Sharif, A., Althobaiti, T., Alotaibi, A. A., Ramzan, N., Imran, M. A., Abbasi, Q. H. (2023) Inkjet-printed UHF RFID sticker for traceability and spoilage sensing of fruits. IEEE Sensors Journal, 23, pp. 733-740. (doi: 10.1109/JSEN.2022.3224811)
Wagih, M. et al. (2023) Microwave-enabled wearables: Underpinning technologies, integration platforms, and next-generation roadmap. IEEE Journal of Microwaves, 3, pp. 193-226. (doi: 10.1109/JMW.2022.3223254)
Rahmani, H., Shetty, D., Wagih, M., Ghasempour, Y., Palazzi, V., Carvalho, N. B., Correia, R., Costanzo, A., Vital, D., Alimenti, F., Kettle, J., Masotti, D., Mezzanotte, P., Roselli, L., Grosinger, J. (2023) Next-generation IoT devices: sustainable eco-friendly manufacturing, energy harvesting, and wireless connectivity. IEEE Journal of Microwaves, 3, pp. 237-255. (doi: 10.1109/JMW.2022.3228683)
Nourinovin, S., Park, S. J., Abbasi, Q. H., Alomainy, A. (2023) An ultrathin and flexible terahertz electromagnetically induced transparency-like metasurface based on asymmetric resonators. EPJ Applied Metamaterials, 10, (doi: 10.1051/epjam/2023001)
Karami, K., Hassan, S., Taking, S., Ofiare, A., Dhongde, A., Al-Khalidi, A., Wasige, E. (2023) Comparative Study of Al2O3 and HfO2 as gate dielectric on AlGaN/GaN MOSHEMTs. International Journal of Electronics and Communication Engineering, 17, pp. 47-50.
Ullah, I., Wagih, M., Komolafe, A., Beeby, S. P. (2023) Effect of bandage materials on epidermal antenna. Engineering Proceedings, 30, (doi: 10.3390/engproc2023030012)
Jabbar, A., Jamshed, M. A., Abbasi, Q., Imran, M. A., Ur Rehman, M. (2023) Leveraging the role of dynamic reconfigurable antennas in viewpoint of industry 4.0 and beyond. Research, 6, (doi: 10.34133/research.0110)
Guan, L., Zhang, Z., Yang, X., Zhao, N., Fan, D., Imran, M. A., Abbasi, Q. H. (2023) Multi-person breathing detection with switching antenna array based on WiFi signal. IEEE Journal of Translational Engineering in Health and Medicine, 11, pp. 23-31. (doi: 10.1109/JTEHM.2022.3218638)
Aniel, F., Auton, G., Cumming, D., Feiginov, M., Gebert, S., González, T., Li, C., Lisauskas, A., Marinchio, H., Mateos, J., Palermo, C., Song, A., Treuttel, J., Varani, L., Zerounian, N. (2023) Terahertz electronic devices. Springer
2022
Rosa, S. L., Kadir, E. A., Abbasi, Q. H., Almansour, A. A., Othman, M., Siswanto, A. (2022) Patient Monitoring and Disease Analysis Based on IoT Wearable Sensors and Cloud Computing. (doi: 10.1109/ICECCME55909.2022.9988546)
Lourenco, J., Al-Taai, Q. R. A., Wasige, E., Figueiredo, J. (2022) Resonant Tunnelling Diode – Photodetectors for Spiking Neural Networks. (doi: 10.1088/1742-6596/2407/1/012047)
Song, Y., Taylor, W., Ge, Y., Usman, M., Imran, M. A., Abbasi, Q. H. (2022) Evaluation of deep learning models in contactless human motion detection system for next generation healthcare. Scientific Reports, 12, (doi: 10.1038/s41598-022-25403-y)
Zhao, J., Zhang, J., Walton, F., Ghannam, R., Wang, C., Heidari, H. (2022) A Comparative Study of Fault Diagnosis Methods of Photovoltaic Cells. (doi: 10.1109/ICECS202256217.2022.9971101)
Pavlidou, A., Liang, X., Heidari, H. (2022) A Delay-Based Reservoir Computing Model for Chaotic Series Prediction. (doi: 10.1109/ICECS202256217.2022.9971108)
Yuan, M., Das, R., Ghannam, R., Heidari, H. (2022) A Flexible Metamaterial Based on Split-Ring Resonator Design. (doi: 10.1109/ICECS202256217.2022.9970860)
Walton, F., Cerezo-Sanchez, M., Ge, C., Heidari, H. (2022) A Multi-Parametric Finite Element Analysis of Heat Distributions in Implanted Micro-LEDs. (doi: 10.1109/ICECS202256217.2022.9970997)
Liang, X., Zhong, Y., Lin, X., Huang, H., Li, T., Tang, J., Gao, B., Qian, H., Wu, H., Heidari, H. (2022) A Physical Reservoir Computing Model Based on Volatile Memristor for Temporal Signal Processing. (doi: 10.1109/ICECS202256217.2022.9970880)
Ullah, I., Wagih, M., Beeby, S. (2022) A Wearable Backscattering Modulator and RF Energy Harvester for UHF RFID Applications. (doi: 10.1109/ICECS202256217.2022.9970864)
Chen, B., Usman, M., Ghannam, R., Ali, M. Z., Imran, M. A., Abbasi, Q. H. (2022) A Wearable and Smart System for Diaper Change Identification. (doi: 10.1109/ICECS202256217.2022.9971004)
Zhang, J., Ghannam, R., Zhao, J., Xia, Y., Wang, C., Heidari, H. (2022) Analysis and Comparison of Two- and Four-State Operation Modes of Parallel-Hybrid Multi-Path Buck DC-DC Converter. (doi: 10.1109/ICECS202256217.2022.9971031)
Giagkoulovits, C., Ahmad, M., Nikbakhtnasrabadi, F., Imroze, F., Weides, M., Heidari, H. (2022) CryoCMOS Characterization Strategies and Challenges. (doi: 10.1109/ICECS202256217.2022.9971010)
Khosravi, S., Khan, A. R., Zoha, A., Ghannam, R. (2022) Employing a Wearable Eye-tracker to Observe Mind-wandering in Dynamic Stimuli. (doi: 10.1109/ICECS202256217.2022.9970787)
Khan, A. R., Bokhari, S. M., Khosravi, S., Hussain, S., Ghannam, R., Imran, M. A., Zoha, A. (2022) Feature Selection Mechanism for Attention Classification Using Gaze Tracking Data. (doi: 10.1109/ICECS202256217.2022.9970936)
Cerezo-Sanchez, M., Yalagala, B., McGlynn, E., Russell, E., Walton, F., Heidari, H. (2022) Flexible Neural Probe Modelling for Optimal Microelectrode-Tissue Interaction. (doi: 10.1109/ICECS202256217.2022.9971129)
Ghahremani arekhloo, N., Zuo, S., Wang, H., Imran, M., Klotz, T., Nazarpour, K., Heidari, H. (2022) Investigating the Volume Conduction Effect in MMG and EMG during Action Potential Recording. (doi: 10.1109/ICECS202256217.2022.9971020)
Xia, Y., Lunardi, A., Heidari, H., Ghannam, R. (2022) Low Cost Real-time Eye Tracking System for Motorsports. (doi: 10.1109/ICECS202256217.2022.9970888)
Ding, Y., Liang, X., Middelmann, T., Marquetand, J., Heidari, H. (2022) MMG/EMG Mapping with Reservoir Computing. (doi: 10.1109/ICECS202256217.2022.9971109)
McGlynn, E., Yalagala, B. P., Heidari, H. (2022) Microfabrication of Implantable, Flexible Neural Probes Towards Bidirectional Interfacing in the Deep Brain. (doi: 10.1109/ICECS202256217.2022.9971103)
Ge, C., Walton, F., Xu, W., Heidari, H. (2022) Orientationally Selective micro-Coil Design of Intracortical Magnetic Neurostimulation. (doi: 10.1109/ICECS202256217.2022.9970955)
Imroze, F., Nikbakhtnasrabadi, F., Danilin, S., Muhammad, A., Ahmad, M., Giagkoulovits, C., Heidari, H., Weides, M. (2022) Packaged CMOS cryogenic characterization for quantum computing applications. (doi: 10.1109/ICECS202256217.2022.9970996)
Teymoordel, Z., Parvizi, R., Heidari, H. (2022) Plasmon-Activated Gas Sensor Based on Lossy MoS2/Au Coated Optical Fibre. (doi: 10.1109/ICECS202256217.2022.9971121)
Bhatti, S., Khan, A. R., Hussain, S., Ghannam, R. (2022) Predicting Renewable Energy Resources using Machine Learning for Wireless Sensor Networks. (doi: 10.1109/ICECS202256217.2022.9970851)
Wang, X., Li, X., Chen, B., Ghannam, R. (2022) Psychophysiological Approach for Measuring Social Presence in A Team-Based Activity: A Comparison Between Real and Virtual Environments. (doi: 10.1109/ICECS202256217.2022.9970857)
AlQallaf, N., Ayaz, F., Bhatti, S., Hussain, S., Zoha, A., Ghannam, R. (2022) Solar Energy Systems Design in 2D and 3D: A Comparison of User Vital Signs. (doi: 10.1109/ICECS202256217.2022.9971065)
Wang, H., Arbustini, J., Elzenheimer, E., Schell, V., Hoft, M., Quandt, E., Schmidt, G., Heidari, H., Bahr, A. (2022) Study of Chopping Magnetic Flux Modulation on Surface Acoustic Wave Magnetic Sensor. (doi: 10.1109/ICECS202256217.2022.9970973)
Wagih, M., Georgiadou, D. G. (2022) Towards Solution-Processed RF Rectennas: Experimental Characterization and Non-Linear Modelling based on ZnO Nanogap Diodes. (doi: 10.1109/ICECS202256217.2022.9971051)
Abdalla, M., Ahmad, M., Windmill, J. F.C., Cochran, S., Heidari, H. (2022) Ultrasound Non-Destructive Evaluation/Testing using Capacitive Micromachined Ultrasound Transducer (CMUT) (doi: 10.1109/ICECS202256217.2022.9970887)
AlQallaf, N., Bhatti, S., Suett, R., Aly, S. G., Khalil, A. S. G., Ghannam, R. (2022) Visualising Climate Change using Extended Reality: A Review. (doi: 10.1109/ICECS202256217.2022.9970808)
Zhang, J., Hoare, D., Das, R., Holsgrove, M., Czyzewski, J., Mirzai, N., Mercer, J., Heidari, H. (2022) Wireless Impedance Platform for Autonomous Vascular Implantable Devices. (doi: 10.1109/ICECS202256217.2022.9970833)
Ghannam, R. (2022) Photovoltaic Systems Design: A Ridiculously Short Introduction and Future Outlook.
Dhongde, A., Taking, S., Ofiare, A., Karami, K., Elksne, M., Dwidar, M., Al-Khalidi, A., Wasige, E. (2022) DC and RF Characteristics of Buffer-Free AlGaN/GaN HEMT and MIS-HEMTs Using Si3N4 Passivated Mesa-Sidewall.
Azargoshasb, T., Parvizi, R., Navid, H. A., Parsanasab, G.-M., Heidari, H. (2022) Versatile selective absorption-based optical fiber toward epinephrine detection. Sensors and Actuators B: Chemical, 372, (doi: 10.1016/j.snb.2022.132551)
Saeed, U., Abbasi, Q. H., Shah, S. A. (2022) AI-driven lightweight real-time SDR sensing system for anomalous respiration identification using ensemble learning. CCF Transactions on Pervasive Computing and Interaction, 4, pp. 381-392. (doi: 10.1007/s42486-022-00113-6)
Asad, S. M., Valente Klaine, P., Naveed Bin Rais, R., Hussain, S., Abbasi, Q. H., Imran, M. A. (2022) Blockchain-enabled handover skipping for high mobility train passengers. Electronics Letters, 58, pp. 978-981. (doi: 10.1049/ell2.12658)
Bristow, N., Rengaraj, S., Chadwick, D. R., Kettle, J., Jones, D. L. (2022) Development of a LoRaWAN IoT node with ion-selective electrode soil nitrate sensors for precision agriculture. Sensors, 22, (doi: 10.3390/s22239100)
Omeke, K. G., Mollel, M., Shah, S. T., Arshad, K., Zhang, L., Abbasi, Q. H., Imran, M. A. (2022) Dynamic Clustering and Data Aggregation for the Internet-of-Underwater-Things Networks. (doi: 10.1109/CICN56167.2022.10008249)
Omeke, K. G., Abubakar, A. I., Zhang, L., Abbasi, Q. H., Imran, M. A. (2022) How reinforcement learning is helping to solve internet-of-underwater-things problems. IEEE Internet of Things Magazine, 5, pp. 24-29. (doi: 10.1109/IOTM.001.2200129)
Jamshed, M. A., Theodorou, C., Kalsoom, T., Anjum, N., Abbasi, Q. H., Ur-Rehman, M. (2022) Intelligent computing based forecasting of deforestation using fire alerts: a deep learning approach. Physical Communication, 55, (doi: 10.1016/j.phycom.2022.101941)
Jabbar, A., Jamshed, M. A., Shawky, M. A., Abbasi, Q. H., Imran, M. A., Ur Rehman, M. (2022) Multi-Gigabit Millimeter-Wave Industrial Communication: a Solution for Industry 4.0 and Beyond. (doi: 10.1109/GLOBECOM48099.2022.10001125)
Kettle, J., Aghaei, M., Ahmad, S., Fairbrother, A., Irvine, S., Jacobsson, J. J., Kazim, S., Kazukauskas, V., Lamb, D., Lobato, K., Mousdis, G. A., Oreski, G., Reinders, A., Schmitz, J., Yilmaz, P., Theelen, M. J. (2022) Review of technology specific degradation in crystalline silicon, cadmium telluride, copper indium gallium selenide, dye sensitised, organic and perovskite solar cells in photovoltaic modules: understanding how reliability improvements in mature technologies can enhance emerging technologies. Progress in Photovoltaics, 30, pp. 1365-1392. (doi: 10.1002/pip.3577)
Wang, H., Zuo, S., Cerezo-Sánchez, M., Ghahremani Arekhloo, N., Nazarpour, K., Heidari, H. (2022) Wearable super-resolution muscle–machine interfacing. Frontiers in Neuroscience, 16, (doi: 10.3389/fnins.2022.1020546)
Heidarnia, Z., Parvizi, R., Khoshsima, H., Heidari, H. (2022) Distinct absorption transducing features of silica supported MoO3/PANI hybrid coated optical fiber towards malathion monitoring in food samples. Sensors and Actuators B: Chemical, 371, (doi: 10.1016/j.snb.2022.132501)
Taylor, W., Khan, M. Z., Tahir, A., Taha, A., Abbasi, Q. H., Imran, M. (2022) An implementation of real-time activity sensing using wi-fi: identifying optimal machine learning techniques for performance evaluation. IEEE Sensors Journal, 22, pp. 21127-21134. (doi: 10.1109/JSEN.2022.3201973)
Liu, Y., Liang, X., Li, H., Deng, H., Zhang, X., Wen, D., Yuan, M., Heidari, H., Ghannam, R., Zhang, X. (2022) Ultralight smart patch with reduced sensing array based on reduced graphene oxide for hand gesture recognition. Advanced Intelligent Systems, 4, (doi: 10.1002/aisy.202200193)
Maclean, C., Wolfe, A., Bhatti, S., Centino, A., Ghannam, R. (2022) Virtual and Augmented Reality as Educational Tools for Modern Quantum Applications. (doi: 10.1109/icecs202256217.2022.9970858)
Cimbri, D., Morariu, R., Ofiare, A., Wasige, E. (2022) A High-Power InP Resonant Tunnelling Diode Heterostructure for 300-GHz Oscillator Sources. (doi: 10.23919/EuMIC54520.2022.9923482)
Shah, Y. D., Dada, A. C., Grant, J. P., Cumming, D. R.S., Altuzarra, C., Nowack, T. S., Lyons, A., Clerici, M., Faccio, D. (2022) An all-dielectric metasurface polarimeter. ACS Photonics, 9, pp. 3245-3252. (doi: 10.1021/acsphotonics.2c00395)
Ghannam, R. (2022) Can Extended Reality Help Us Tackle Climate Change.
Hu, C., Annese, V. F., Giagkoulovits, C., Barrett, M. P., Cumming, D. R. S. (2022) Factor VIII companion diagnostic for haemophilia. Frontiers in Bioengineering and Biotechnology, 10, (doi: 10.3389/fbioe.2022.1006600)
Annese, V. F., Hu, C., Barrett, M. P., Jones, R., Cumming, D. R. S. (2022) A CMOS-based multi-omics detection platform for simultaneous quantification of proteolytically active prostate specific antigen and glutamate in urine. IEEE Sensors Journal, 22, pp. 18870-18877. (doi: 10.1109/JSEN.2022.3198282)
Yu, Z., Zahid, A., Taha, A., Taylor, W., Rajab, K., Heidari, H., Imran, M. A., Abbasi, Q. H. (2022) A radar-based human activity recognition using a novel 3D point cloud classifier. IEEE Sensors Journal, 22, pp. 18218-18227. (doi: 10.1109/JSEN.2022.3198395)
Rehman, M., Ali, N. A. A., Shah, R. A., Khan, M. B., Shah, S. A., Alomainy, A., Yang, X., Imran, M. A., Abbasi, Q. H. (2022) Development of an intelligent real-time multi-person respiratory illnesses sensing system using SDR technology. IEEE Sensors Journal, 22, pp. 18858-18869. (doi: 10.1109/JSEN.2022.3196564)
Fan, D., Yang, X., Zhao, N., Guan, L., Abbasi, Q. H. (2022) Exercise monitoring and assessment system for home-based respiratory rehabilitation. IEEE Sensors Journal, 22, pp. 18890-18902. (doi: 10.1109/JSEN.2022.3200984)
Khan, M. Z., Farooq, M., Taha, A., Ramazan, N., Imran, M. A., Abbasi, Q. H. (2022) Localization Using Wireless Sensing for Future Healthcare. (doi: 10.1109/ICECS202256217.2022.9971116)
Abbasi, Q. H., Abbas, H. T., Shah, S. A., Zahid, A., Imran, M. A., Alomainy, A. (2022) Microwave and terahertz sensing. Elsevier
Taylor, W., Taha, A., Tahir, A., Abbasi, Q. H., Imran, M. A. (2022) Real-Time Contactless WiFi Based Room Detection of Sitting and Standing Human Motions. (doi: 10.1109/ICECS202256217.2022.9970930)
Tanwear, A., Liang, X., Paz, E., Böhnert, T., Ghannam, R., Ferreira, R., Heidari, H. (2022) Spintronic eyeblink gesture sensor with wearable interface system. IEEE Transactions on Biomedical Circuits and Systems, 16, pp. 779-792. (doi: 10.1109/TBCAS.2022.3190689)
Beeby, S., Arumugam, S., Hillier, N., Li, Y., Shi, J., Sun, Y., Wagih, M., Yong, S. (2022) Power supply sources for smart textiles. Elsevier
Li, C. (2022) Advances in Leakage Corrections for On-wafer S-parameter Measurements.
Zubair, M., Jabbar, A., Akinsolu, M. O., Imran, M. A., Liu, B., Abbasi, Q. H. (2022) Design of Truncated Microstrip Square Patch Antenna for Terahertz Communication. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886809)
Ghosh, J., Dutta, R., Sarkhel, A., Abbasi, Q. H. (2022) Design of miniaturize flexible wideband frequency selective surface for electromagnetic shielding application. Waves in Random and Complex Media, (doi: 10.1080/17455030.2022.2121442)
Abohmra, A., Abbas, H., Imran, M. A., Abbasi, Q. H. (2022) Flexible Antenna Arrays Based on Graphene for High-speed THz Communications. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886319)
Alblaihed, K. A., Abbasi, Q. H., Imran, M. A., Mohjazi, L. (2022) Gain Enhancement of Microstrip Patch Antenna for 28 GHz 5G Applications. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886673)
Taylor, W., Taha, A., Tahir, A., Shah, S. A., Abbasi, Q. H., Imran, M. A. (2022) Novel Contactless Sensing Technique for Real-time Human Activity Detection. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886894)
Wagih, M., Khan, M. R., Bhardwaj, S., Vital, D. (2022) Towards Wearable Wireless Power Harvesting using Clothing-Integrated Beamforming Structures. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9887178)
Ahmad, I., Kaur, J., Abbas, H. T., Abbasi, Q. H., Zoha, A., Imran, M. A., Hussain, S. (2022) UAV-assisted 5G Networks for Optimised Coverage Under Dynamic Traffic Load. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886848)
Rains, J., Kazim, J. U. R., Tukmanov, A., Zhang, L., Abbasi, Q. H., Imran, M. (2022) Varactor-based Reconfigurable Intelligent Surface with Dual Linear Polarisation at K-band. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9887367)
Hameed, H., Usman, M., Khan, M. Z., Hussain, A., Abbas, H., Imran, M. A., Abbasi, Q. H. (2022) Privacy-Preserving British Sign Language Recognition Using Deep Learning. (doi: 10.1109/EMBC48229.2022.9871491)
Hameed, H., Usman, M., Tahir, A., Hussain, A., Abbas, H., Cui, T. J., Imran, M. A., Abbasi, Q. H. (2022) Pushing the limits of remote RF sensing by reading lips under the face mask. Nature Communications, 13, (doi: 10.1038/s41467-022-32231-1)
Sheeraz, M., Aslam, A. R., Hafeez, N., Heidari, H., Altaf, M. A. B. (2022) A Wearable High Blood Pressure Classification Processor Using Photoplethysmogram Signals through Power Spectral Density Features. (doi: 10.1109/AICAS54282.2022.9869847)
Citoni, B., Ansari, S., Abbasi, Q. H., Imran, M. A., Hussain, S. (2022) Comparative analysis of an urban LoRaWAN deployment: real world vs. simulation. IEEE Sensors Journal, 22, pp. 17216-17223. (doi: 10.1109/JSEN.2022.3193504)
Sarfaz, M., Sohail, M. F., Alam, S., ur Rehman, M. J., Ghauri, S. A., Ravie, K., Abbas, H., Ansari, S. (2022) Capacity optimization of next-generation UAV communication involving non-orthogonal multiple access. Drones, 6, (doi: 10.3390/drones6090234)
Latif, S., Huma, Z. e., Jamal, S. S., Ahmed, F., Ahmad, J., Zahid, A., Dashtipour, K., Aftab, M. U., Ahmad, M., Abbasi, Q. H. (2022) Intrusion detection framework for the Internet of Things using a dense random neural network. IEEE Transactions on Industrial Informatics, 18, pp. 6435-6444. (doi: 10.1109/TII.2021.3130248)
Annese, V. F., Giagkoulovits, C., Hu, C., Al-Rawhani, M. A., Grant, J., Patil, S., Cumming, D. (2022) Micromolar metabolite measurement in an electronically multiplexed format. IEEE Transactions on Biomedical Engineering, 69, pp. 2715-2722. (doi: 10.1109/TBME.2022.3147855)
Ahmad, M., Giagkoulovits, C., Danilin, S., Weides, M., Heidari, H. (2022) Scalable cryoelectronics for superconducting qubit control and readout. Advanced Intelligent Systems, 4, (doi: 10.1002/aisy.202200079)
Wagih, M., Beeby, S. (2022) Thin flexible RF energy harvesting rectenna surface with a large effective aperture for sub µW/cm2 powering of wireless sensor nodes. IEEE Transactions on Microwave Theory and Techniques, 70, pp. 4328-4338. (doi: 10.1109/TMTT.2022.3192532)
Citoni, B., Ansari, S., Abbasi, Q. H., Imran, M. A., Hussain, S. (2022) Downlink Independent Throughput Optimisation in LoRaWAN. (doi: 10.1109/VTC2022-Spring54318.2022.9860650)
Wagih, M., Komolafe, A., Weddell, A. S., Beeby, S. (2022) 1 μW-3.75 W Dual-mode Near/far-field Wearable Wireless Power Transfer Using a Hybrid Rectenna. (doi: 10.1109/WPW54272.2022.9853859)
Vinnakota, S. S., Kumari, R., Majumder, B., Abbasi, Q. H. (2022) Numerical demonstration of a dispersion engineered metallic metasurface assisted mm-wave wireless sensor. Optics Continuum, 1, pp. 1795-1810. (doi: 10.1364/OPTCON.463840)
Nowack, T. S., Shah, Y. D., Escorcia, I., Grant, J. P., Kenney, M., Pusino, V., Faccio, D., Wasige, E., Cumming, D. R.S. (2022) Terahertz polarimetry with a monolithic metasurface. Optics Letters, 47, pp. 4199-4202. (doi: 10.1364/OL.463143)
Abbott, R. et al. (2022) Search for subsolar-mass binaries in the first half of Advanced LIGO’s and Advanced Virgo’s third observing run. Physical Review Letters, 129, (doi: 10.1103/PhysRevLett.129.061104)
Badshah, S. S., Saeed, U., Momand, A., Shah, S. Y., Shah, S. I., Ahmad, J., Abbasi, Q. H., Shah, S. A. (2022) UWB Radar Sensing for Respiratory Monitoring Exploiting Time-Frequency Spectrograms. (doi: 10.1109/SMARTTECH54121.2022.00040)
Farage, M.E., Li, C. (2022) A W-Band Rectangular Waveguide CRLH Frequency Scanning Array.
Cimbri, D., Yavas-Aydin, B., Hartmann, F., Jabeen, F., Worschech, L., Höfling, S., Wasige, E. (2022) Accurate quantum transport modeling of high-speed In 0.53 Ga 0.47 As/AlAs double-barrier resonant tunneling diodes. IEEE Transactions on Electron Devices, 69, pp. 4638-4645. (doi: 10.1109/TED.2022.3178360)
Arbustini, J., Muñoz, J., Wang, H., Elzenheimer, E., Hoffmann, J., Thormählen, L., Hayes, P., Niekiel, F., Heidari, H., Höft, M., Quandt, E., Schmidt, G., Bahr, A. (2022) MEMS magnetic field source for frequency conversion approaches for ME sensors. Current Directions in Biomedical Engineering, 8, pp. 309-312. (doi: 10.1515/cdbme-2022-1079)
Zahid, A., Dashtipour, K., Abbas, H. T., Mabrouk, I. B., Al-Hasan, M., Ren, A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2022) Machine learning enabled identification and real-time prediction of living plants’ stress using terahertz waves. Defence Technology, 18, pp. 1330-1339. (doi: 10.1016/j.dt.2022.01.003)
Aslam, A. R., Hafeez, N., Heidari, H., Bin Altaf, M. A. (2022) Channels and features identification: a review and a machine-learning based model with large scale feature extraction for emotions and ASD classification. Frontiers in Neuroscience, 16, (doi: 10.3389/fnins.2022.844851)
Saeidi, T., Alhawari, A. R.H., Almawgani, A. H.M., Alsuwian, T., Imran, M. A., Abbasi, Q. (2022) High gain compact UWB antenna for ground penetrating radar detection and soil inspection. Sensors, 22, (doi: 10.3390/s22145183)
Asad, S. M., Valente Klaine, P., Rais, R. N. B., Hussain, S., Abbasi, Q. H., Imran, M. A. (2022) Mobility Management in the Applications of 5G and Beyond: A Handover Skipping Topology Analysis. (doi: 10.1109/GPECOM55404.2022.9815787)
Zoha, A., Qadir, J., Abbasi, Q. H. (2022) Editorial for the research topic: AI-powered IoT for intelligent systems and smart applications. Frontiers in Communications and Networks, 3, (doi: 10.3389/frcmn.2022.959303)
Ofiare, A., Taking, S., Elksne, M., Al-Khalidi, A., Ghosh, S., Kappers, M., Oliver, R.A., Wasige, E. (2022) Approach to Normally-Off AlGaN/GaN MIS-HEMTs with High Drain Current Using AlGaN Overgrowth Technique.
Dhongde, A., Elksne, M., Karami, K., Wasige, E. (2022) Comparative Study of AlGaN/GaN HEMTs with and without the Buffer on SiC Substrates.
Dwidar, M., Wasige, E., Al-Khalidi, A. (2022) Effect of Annealing Temperature on the Sheet Resistance of AlN/GaN HEMTs.
Khan, M. Z., Taha, A., Taylor, W., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2022) Indoor Localization Using Software Defined Radio: A Non-Invasive Approach. (doi: 10.23919/AT-AP-RASC54737.2022.9814250)
Zhong, M., Cumming, D., Li, C. (2022) Power Enhancement of Planar Gunn Oscillators Using Injection Locking.
Cheng, H., Dhongde, A., Karami, K., Reynolds, P., Thoms, S., Wasige, E., Li, C. (2022) Reliable T-gate Process for THz HEMTs.
Jabbar, A., Abbasi, Q., Imran, M., Ur Rehman, M. (2022) Design of a 60 GHz Microstrip Antenna for Multi-Gigabit Industrial Communication in Viewpoint of Industry 4.0. (doi: 10.1109/iWAT54881.2022.9810999)
Hassouna, S., Rains, J., Kazim, J. U. R., Ur Rehman, M., Imran, M., Abbasi, Q. H. (2022) Discrete Phase Shifts for Intelligent Reflecting Surfaces in OFDM Communications. (doi: 10.1109/iWAT54881.2022.9810915)
Nadeem, A., Ashraf, M., Qadeer, N., Rizwan, K., Mehmood, A., Al Zahrani, A., Noor, F., Abbasi, Q. H. (2022) Tracking missing person in large crowd gathering using intelligent video surveillance. Sensors, 22, (doi: 10.3390/s22145270)
Wagih, M., Weddell, A., Beeby, S. (2022) Battery-free wireless light-sensing tag based on a long-range dual-port dual-polarized RFID platform. Sensors, 22, (doi: 10.3390/s22134782)
Walton, F., Cerezo Sanchez, M., McGlynn, E., Das, R., Heidari, H. (2022) Cleanroom strategies for micro- and nano-fabricating flexible implantable neural electronics. Philosophical Transactions of the Royal Society A: Mathematical, Physical and Engineering Sciences, 380, (doi: 10.1098/rsta.2021.0009)
Khan, M. Z., Taha, A., Farooq, M., Shawky, M. A., Imran, M., Abbasi, Q. H. (2022) Comparative Analysis of Artificial Intelligence on Contactless Human Activity Localization. (doi: 10.1109/ITC-Egypt55520.2022.9855712)
Cimbri, D., Wang, J., Wasige, E. (2022) Epitaxial Structure Simulation Study of In0.53Ga0.47As/AlAs Double-Barrier Resonant Tunnelling Diodes. (doi: 10.1109/IWMTS54901.2022.9832441)
Crawford, K. G., Grant, J., Hemakumara, D. T., Li, X., Thayne, I., Moran, D. A.J. (2022) High synergy atomic layer etching of AlGaN/GaN with HBr and Ar. Journal of Vacuum Science and Technology A: Vacuum, Surfaces, and Films, 40, (doi: 10.1116/6.0001862)
Cimbri, D., Morariu, R., Ofiare, A., Wasige, E. (2022) In0.53Ga0.47As/AlAs Double-Barrier Resonant Tunnelling Diodes with High-Power Performance in the Low-Terahertz Band. (doi: 10.1109/IWMTS54901.2022.9832442)
Abbott, R. et al. (2022) Narrowband searches for continuous and long-duration transient gravitational waves from known pulsars in the LIGO-Virgo third observing run. Astrophysical Journal, 932, (doi: 10.3847/1538-4357/ac6ad0)
Li, C. (2022) Modelling and Correction of Probe-Probe Crosstalk at mm wave Frequencies.
Abbott, R. et al. (2022) All-sky, all-frequency directional search for persistent gravitational waves from Advanced LIGO’s and Advanced Virgo’s first three observing runs. Physical Review D, 105, (doi: 10.1103/PhysRevD.105.122001)
Heidarnia, Z., Khoshsima, H., Parvizi, R., Heidari, H. (2022) Comprehensive investigation on chalcogenide thin film coated multimode optical fiber: Visible evanescent-wave absorption refractometer. Journal of Non-Crystalline Solids, 586, (doi: 10.1016/j.jnoncrysol.2022.121567)
Berrahma, F., Ghanem, K., Bousbia-Salah, H., Alomainy, A., Imran, M.A., Abbasi, Q.H. (2022) Integration of spatial modulation scheme with code division multiple access for VIVO based frequency selective nano sensor networks. IEEE Sensors Journal, 22, pp. 12245 - 12252. (doi: 10.1109/JSEN.2022.3174517)
Zhang, Y., Jiang, N., Zhao, A., Liu, S., Peng, J., Chen, L., Lavery, M. P.J., Abbas, H. T., Qiu, K. (2022) Security enhancement in coherent OFDM optical transmission with chaotic three-dimensional constellation scrambling. Journal of Lightwave Technology, 40, pp. 3749-3760. (doi: 10.1109/JLT.2022.3154091)
Wang, Q., Usman, M., Ali, M., Imran, M. A., Abbasi, Q. H. (2022) Foot Pressure Detection System for Diabetic Patients to Avoid Ulcers.
Ma, Q., Gao, W., Xiao, Q., Ding, L., Gao, T., Zhou, Y., Gao, X., Yan, T., Liu, C., Gu, Z., Kong, X., Abbasi, Q. H., Li, L., Qiu, C.-W., Li, Y., Cui, T. J. (2022) Directly wireless communication of human minds via non-invasive brain-computer-metasurface platform. eLight, 2, (doi: 10.1186/s43593-022-00019-x)
Karami, K., Dhongde, A., Cheng, H., Reynolds, P. M., Thoms, S., Reddy, B. A., Ritter, D., Li, C., Wasige, E. (2022) Robust sub-100 nm T-gate fabrication process using multi-step development.
Douglas, C. I., Nunez, C. G., Caffio, M., Gibson, D. (2022) Ultra-thin graphene foam based flexible piezoresistive pressure sensors for robotics. Key Engineering Materials, 922, pp. 79-86. (doi: 10.4028/p-oy94hj)
McGlynn, E., Walton, F., Das, R., Heidari, H. (2022) Neural microprobe modelling and microfabrication for improved implantation and mechanical failure mitigation. Philosophical Transactions of the Royal Society A: Mathematical, Physical and Engineering Sciences, 380, (doi: 10.1098/rsta.2021.0007)
Das, R., Curia, G., Heidari, H. (2022) Preface to ‘Advanced neurotechnologies: translating innovation for health and well-being’ Philosophical Transactions of the Royal Society A: Mathematical, Physical and Engineering Sciences, 380, (doi: 10.1098/rsta.2021.0004)
Muhammad, M., Li, M., Abbasi, Q. H., Goh, C., Imran, M. A. (2022) An adaptive diagonal loading technique to improve direction of arrival estimation accuracy for linear antenna array sensors. IEEE Sensors Journal, 22, pp. 10986-10994. (doi: 10.1109/JSEN.2022.3168785)
Wang, J., Xue, L.-Y., Liu, B., Li, C. (2022) Design of Terahertz InP pHEMT Using Machine Learning Assisted Global Optimization Techniques. (doi: 10.23919/EuMIC50153.2022.9784068)
Al-Taai, Q. R. A., Morariu, R., Wang, J., Al-Khalidi, A., Al-Moathin, A., Romeira, B., Figueiredo, J., Wasige, E. (2022) Towards an Excitable Microwave Spike Generator for Future Neuromorphic Computing. (doi: 10.23919/EuMIC50153.2022.9783686)
Sheeraz, M., Aslam, A. R., Altaf, M. A. B., Heidari, H. (2022) A Closed-Loop Ear Wearable EEG Measurement Device with Realtime Electrode Skin Impedance Measurement. (doi: 10.1109/NEWCAS52662.2022.9842161)
Liang, X., Li, H., Vuckovic, A., Mercer, J., Heidari, H. (2022) A neuromorphic model with delay-based reservoir for continuous ventricular heartbeat detection. IEEE Transactions on Biomedical Engineering, 69, pp. 1837-1849. (doi: 10.1109/TBME.2021.3129306)
Zhang, J., Das, R., Zhao, J., Mirzai, N., Mercer, J., Heidari, H. (2022) Battery-free and wireless technologies for cardiovascular implantable medical devices. Advanced Materials Technologies, 7, (doi: 10.1002/admt.202101086)
Shawky, M. A., Abbasi, Q. H., Imran, M. A., Ansari, S., Taha, A. (2022) Cross-Layer Authentication based on Physical-Layer Signatures for Secure Vehicular Communication. (doi: 10.1109/IV51971.2022.9827444)
Manzoor, H. U., Khan, A. R., Al-Quraan, M., Mohjazi, L., Taha, A., Abbas, H., Hussain, S., Imran, M. A., Zoha, A. (2022) Energy Management in an Agile Workspace using AI-driven Forecasting and Anomaly Detection. (doi: 10.1109/GPECOM55404.2022.9815599)
Wen, L., Nan, X., Li, J., Cumming, D. R. S., Hu, X., Chen, Q. (2022) Broad-band spatial light modulation with dual epsilon-near-zero modes. Opto-Electronic Advances, 5,
Dobrea, A., Jimenez, M., Corrigan, D. K., Ghannam, R. (2022) Biomarker Detection Techniques for Point-of-Need Diagnostics.
Cimbri, D., Wasige, E. (2022) An Advanced TCAD Quantum Transport-based Simulation Approach for InP RTD Devices Simulation.
Usman, M., Rains, J., Cui, T. J., Khan, M. Z., Kazim, J. U. R., Imran, M. A., Abbasi, Q. H. (2022) Intelligent wireless walls for contactless in-home monitoring. Light: Science and Applications, 11, (doi: 10.1038/s41377-022-00906-5)
Hussain, S., Qu, S.-W., Sharif, A. B., Abubakar, H. S., Wang, X.-H., Imran, M. A., Abbasi, Q. H. (2022) Current sheet antenna array and 5G: challenges, recent trends, developments, and future directions. Sensors, 22, (doi: 10.3390/s22093329)
Abohmra, A., Abbas, H. T., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2022) Flexible and Wearable Terahertz Antenna for Future Wireless Communication. (doi: 10.1109/iWAT54881.2022.9810911)
Dhongde, A., Taking, S., Elksne, M., Ofiare, A., Karami, K., Dwidar, M., Al-Khalidi, A., Wasige, E. (2022) High Performance of AlGaN/GaN HEMTs using Buffer-Free GaN on SiC Structure.
Karami, K., Taking, S., Ofiare, A., Elksne, M., Dhongde, A., Al-Khalidi, A., Wasige, E. (2022) Investigation of Al2O3, Si3N4 and SiO2 Used for Surface Passivation and Gate Dielectric on AlGaN/GaN Metal-Oxide-Semiconductor High Electron Mobility Transistors.
Cimbri, D., Wang, J., Al-Khalidi, A., Wasige, E. (2022) Resonant tunnelling diodes high-speed terahertz wireless communications - a review. IEEE Transactions on Terahertz Science and Technology, 12, pp. 226-244. (doi: 10.1109/TTHZ.2022.3142965)
Aghaei, M., Fairbrother, A., Gok, A., Ahmad, S., Kazim, S., Lobato, K., Oreski, G., Reinders, A., Schmitz, J., Theelen, M., Yilmaz, P., Kettle, J. (2022) Review of degradation and failure phenomena in photovoltaic modules. Renewable and Sustainable Energy Reviews, 159, (doi: 10.1016/j.rser.2022.112160)
Wagih, M., Komolafe, A., Weddell, A. S., Beeby, S. (2022) Broadband compact substrate-independent textile wearable antenna for simultaneous near- and far-field wireless power transmission. IEEE Open Journal of Antennas and Propagation, 3, pp. 398-411. (doi: 10.1109/OJAP.2022.3167089)
Abbott, R. et al. (2022) Search of the early O3 LIGO data for continuous gravitational waves from the Cassiopeia A and Vela Jr. supernova remnants. Physical Review D, 105, (doi: 10.1103/PhysRevD.105.082005)
Cimbri, D., Wasige, E. (2022) Modelling, Design, Fabrication, and Characterisation of In0.53Ga0.47As/AlAs Double-Barrier Resonant Tunnelling Diodes for Low-Terahertz Sources.
Mezher, M. A., Din, S., Ilyas, M., Bayat, O., Abbasi, Q. H., Ashraf, I. (2022) Data transmission enhancement using optimal coding technique over in vivo channel for interbody communication. Big Data, (doi: 10.1089/big.2021.0224)
Wagih, M., Hilton, G. S., Weddell, A. S., Beeby, S. (2022) Millimeter-wave power transmission for compact and large-area wearable IoT devices based on a higher order mode wearable antenna. IEEE Internet of Things Journal, 9, pp. 5229-5239. (doi: 10.1109/JIOT.2021.3107594)
Wang, J., Al-Khalidi, A., Ahearne, S., Wasige, E. (2022) 22Gbps/80cm Low-Cost THz Wireless System. (doi: 10.23919/EuMC50147.2022.9784247)
Thompson, O., Alkaraki, S., Abbasi, Q. H., Jilani, S. F., Evans, D. A. (2022) A Bio-degradable Textile-Based Graphene Antenna for the 5G Smart Wearables. (doi: 10.23919/EuCAP53622.2022.9769657)
Muhammad, M., Li, M., Abbasi, Q., Goh, C., Imran, M. A. (2022) A covariance matrix reconstruction approach for single snapshot direction of arrival estimation. Sensors, 22, (doi: 10.3390/s22083096)
Abbasi, Q. H. (2022) AP-S Young Professional Ambassador Program [Young Professionals] IEEE Antennas and Propagation Magazine, 64, pp. 79-80, 105. (doi: 10.1109/MAP.2022.3145720)
Wang, J., Naftaly, M., Wasige, E. (2022) An overview of terahertz imaging with resonant tunneling diodes. Applied Sciences, 12, (doi: 10.3390/app12083822)
Alblaihed, K. A., Kazim, J. U. R., Abbasi, Q. H., Imran, M. A., Mohjazi, L. (2022) Bandwidth Enhancement of Microstrip Patch Antenna Using Air Holes for WLAN Applications. (doi: 10.5013/IJSSST.a.23.02.07)
Saeed, U., Shah, S. Y., Ahmad, J., Imran, M. A., Abbasi, Q. H., Shah, S. A. (2022) Machine learning empowered COVID-19 patient monitoring using non-contact sensing: An extensive review. Journal of Pharmaceutical Analysis, 12, pp. 193-204. (doi: 10.1016/j.jpha.2021.12.006)
Jabbar, A., Abbasi, Q. H., Anjum, N., Kalsoom, T., Ramzan, N., Ahmed, S., Rafi-ul-Shan, P. M., Falade, O. P., Imran, M. A., Ur Rehman, M. (2022) Millimeter-wave smart antenna solutions for URLLC in industry 4.0 and beyond. Sensors, 22, (doi: 10.3390/s22072688)
Zhong, M., Cumming, D. R.S., Li, C. (2022) Numerical and Experimental Investigations of Self-mixing Effect of a Planar Gunn Diode Oscillator. (doi: 10.23919/EuMIC50153.2022.9783700)
Nourinovin, S., Navarro-Cía, M., Rahman, M. M., Philpott, M. P., Abbasi, Q. H., Alomainy, A. (2022) Terahertz metastructures for noninvasive biomedical sensing and characterization in future health care [bioelectromagnetics] IEEE Antennas and Propagation Magazine, 64, pp. 60-70. (doi: 10.1109/MAP.2022.3145712)
Covi, E., Donati, E., Brivio, S., Heidari, H. (2022) Editorial: emerging technologies and systems for biologically plausible implementations of neural functions. Frontiers in Neuroscience, 16, (doi: 10.3389/fnins.2022.863680)
Liang, X., Zhong, Y., Tang, J., Liu, Z., Yao, P., Sun, K., Zhang, Q., Gao, B., Heidari, H., Qian, H., Wu, H. (2022) Rotating neurons for all-analog implementation of cyclic reservoir computing. Nature Communications, 13, (doi: 10.1038/s41467-022-29260-1)
Khan, M. Z., Taha, A., Taylor, W., Imran, M. A., Abbasi, Q. H. (2022) Non-invasive localization using software-defined radios. IEEE Sensors Journal, 22, pp. 9018-9026. (doi: 10.1109/JSEN.2022.3160796)
David, T. W., Kettle, J. (2022) Design for a sustainability approach to organic solar cell design: the use of machine learning to quantify the trade-off between performance, stability and environmental impact. Journal of Physical Chemistry C, 126, pp. 4774-4784. (doi: 10.1021/acs.jpcc.1c10114)
Jamshed, M. A., Ali, K., Abbasi, Q. H., Imran, M. A., Ur Rehman, M. (2022) Challenges, applications and future of wireless sensors in internet of things: a review. IEEE Sensors Journal, 22, pp. 5482-5494. (doi: 10.1109/JSEN.2022.3148128)
Abbott, R. et al. (2022) Constraints on dark photon dark matter using data from LIGO’s and Virgo’s third observing run. Physical Review D, 105, (doi: 10.1103/PhysRevD.105.063030)
Al-Moathin, A., Watson, S., Tang, S., Ye, S., Di Gaetano, E., Al-Taai, Q. R. A., Eddie, I., Huang, Y., Zhang, R., Li, C., Hou, L., Kelly, A., Marsh, J. H. (2022) EML based on identical epitaxial layer, side-wall grating and HSQ planarization. IEEE Photonics Technology Letters, 34, pp. 317-320. (doi: 10.1109/LPT.2022.3155730)
Usman, M., Ansari, S., Taha, A., Zahid, A., Abbasi, Q. H., Imran, M. A. (2022) Terahertz-based joint communication and sensing for precision agriculture: a 6G use-case. Frontiers in Communications and Networks, 3, (doi: 10.3389/frcmn.2022.836506)
Khan, Z. U., Alkaraki, S., Abbasi, Q. H., Imran, M. A., Loh, T. H., Alomainy, A. (2022) 3D Printed Slotted Waveguide Antenna Array for Millimeter-wave Communication Systems. (doi: 10.23919/EuCAP53622.2022.9769598)
Hossain, K., Sabapathy, T., Jusoh, M., Soh, P. J., Ahmad, R. B., Jais, M. I., Osman, M. N., Abbasi, Q. H. (2022) A frequency-reconfigurable microstrip antenna with constant dipole-like radiation patterns using single bias, triple varactor tuning with reduced complexity. Wireless Personal Communications, 123, pp. 1003-1024. (doi: 10.1007/s11277-021-09167-8)
Yuan, C., Khan, M. B., Yang, X., Shah, F. H., Abbasi, Q. H. (2022) Cheyne-Stokes respiration perception via machine learning algorithms. Electronics, 11, (doi: 10.3390/electronics11060958)
Ali, S. M., Sovuthy, C., Noghanian, S., Saeidi, T., Majeed, M. F., Hussain, A., Masood, F., Khan, S. M., Shah, S. A., Abbasi, Q. H. (2022) Design and evaluation of a button sensor antenna for on-body monitoring activity in healthcare applications. Micromachines, 13, (doi: 10.3390/mi13030475)
Zhang, S., Bristow, N., David, T., Elliott, F., O'Mahony, J., Kettle, J. (2022) Development of an organic photovoltaic energy harvesting system for wireless sensor networks; application to autonomous building information management systems and optimisation of OPV module sizes for future applications. Solar Energy Materials and Solar Cells, 236, (doi: 10.1016/j.solmat.2021.111550)
Walton, F., McGlynn, E., Das, R., Zhong, H., Heidari, H., Degenaar, P. (2022) Magneto-optogenetic deep-brain multimodal neurostimulation. Advanced Intelligent Systems, 4, (doi: 10.1002/aisy.202100082)
Fan, H., Yue, H., Mao, J., Peng, T., Zuo, S., Feng, Q., Wei, Q., Heidari, H. (2022) Modelling and fabrication of wide temperature range Al0.24Ga0.76As/GaAs hall magnetic sensors. Journal of Semiconductors, 43, (doi: 10.1088/1674-4926/43/3/034101)
Abbott, R. et al. (2022) Search for intermediate-mass black hole binaries in the third observing run of Advanced LIGO and Advanced Virgo. Astronomy and Astrophysics, 659, (doi: 10.1051/0004-6361/202141452)
Khan, A. R., Zoha, A., Mohjazi, L., Sajid, H., Abbasi, Q., Imran, M. A. (2022) When Federated Learning Meets Vision: an Outlook on Opportunities and Challenges. (doi: 10.1007/978-3-030-95593-9_23)
Khan, M. B., Mustafa, A., Rehman, M., AbuAli, N. A., Yuan, C., Yang, X., Shah, F. H., Abbasi, Q. H. (2022) Non-contact smart sensing of physical activities during quarantine period using SDR technology. Sensors, 22, (doi: 10.3390/s22041348)
Abualhayja'a, M., Centeno, A., Mohjazi, L., Butt, M. M., Sehier, P., Abbasi, Q. H., Imran, M. A. (2022) Performance of Reconfigurable Intelligent Surfaces vs. Relaying for UAV-Assisted Communications. (doi: 10.23919/USNC-URSI51813.2021.9703626)
Nadeem, A., Ashraf, M., Rizwan, K., Qadeer, N., AlZahrani, A., Mehmood, A., Abbasi, Q. H. (2022) A novel integration of face-recognition algorithms with a soft voting scheme for efficiently tracking missing person in challenging large-gathering scenarios. Sensors, 22, (doi: 10.3390/s22031153)
Yang, K., Abbasi, Q. H., Fioranelli, F., Romain, O., Le Kernec, J. (2022) Bespoke Simulator for Human Activity Classification with Bistatic Radar. (doi: 10.1007/978-3-030-95593-9_7)
Zhang, X., Abbasi, Q. H., Fioranelli, F., Romain, O., Le Kernec, J. (2022) Elderly Care - Human Activity Recognition Using Radar with an Open Dataset and Hybrid Maps. (doi: 10.1007/978-3-030-95593-9_4)
Dhimish, M., Kettle, J. (2022) Impact of solar cell cracks caused during potential-induced degradation (PID) tests. IEEE Transactions on Electron Devices, 69, pp. 604-612. (doi: 10.1109/TED.2021.3135365)
Taha, A., Ge, Y., Taylor, W., Zoha, A., Abbasi, Q. H., Imran, M. A. (2022) Indoor Activity Position and Direction Detection Using Software Defined Radios. (doi: 10.1007/978-3-030-95593-9_2)
Tahir, A., Taylor, W., Taha, A., Usman, M., Shah, S. A., Imran, M. A., Abbasi, Q. T. (2022) IoT based fall detection system for elderly healthcare. Springer
Paosangthong, W., Torah, R., Beeby, S., Wagih, M. (2022) Textile-based triboelectric nanogenerator with alternating positive and negative freestanding woven structure for harvesting sliding energy in all directions. Nano Energy, 92, (doi: 10.1016/j.nanoen.2021.106739)
Taylor, W., Shah, S. A., Dashtipour, K., Le Kernec, J., Abbasi, Q. H., Assaleh, K., Arshad, K., Imran, M. A. (2022) Wireless Sensing for Human Activity Recognition using USRP. (doi: 10.1007/978-3-030-95593-9_5)
Saeed, U., Shah, S. Y., Shah, S. A., Liu, H., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Jan, S. U., Ahmad, J., Abbasi, Q. H. (2022) Multiple participants’ discrete activity recognition in a well-controlled environment using universal software radio peripheral wireless sensing. Sensors, 22, (doi: 10.3390/s22030809)
Kazim, J. U. R., Abbas, H., Ur Rehman, M., Alomainy, A., Kocabas, C., Yenigunc, E. O., Abbasi, Q. H., Imran, M. A. (2022) A Miniaturized Wideband 3 dB Rat-Race Coupler Utilizing Meander Lines. (doi: 10.1109/ICMAC54080.2021.9678260)
Taylor, W., Taha, A., Dashtipour, K., Shah, S. A., Abbasi, Q. H., Imran, M. A. (2022) AI-based Real-time Classification of Human Activity using Software Defined Radios. (doi: 10.1109/ICMAC54080.2021.9678242)
Asad, S. M., Dashtipour, K., Bin Rais, R. N., Abbasi, Q. H., Hussain, S., Imran, M. A. (2022) Employing Machine Learning for Predicting Transportation Modes under the COVID-19 Pandemic: A Mobility-Trends Analysis. (doi: 10.1109/UCET54125.2021.9674960)
Li, S., Ge, Y., Shentu, M., Zhu, S., Imran, M. A., Abbasi, Q. H., Cooper, J. (2022) Human Activity Recognition based on Collaboration of Vision and WiFi Signals. (doi: 10.1109/UCET54125.2021.9674970)
Kaur, J., Popoola, O. R., Imran, M. A., Abbasi, Q. H., Abbas, H. T. (2022) Improving Throughput For Mobile Receivers Using Adaptive Beamforming. (doi: 10.1109/ICMAC54080.2021.9678216)
Rains, J., Kazim, J. U. R., Zhang, L., Tukmanov, A., Abbasi, Q. H., Imran, M. (2022) Reflecting Metasurface Unit Cell Design with Multi-Bit Azimuthal Control. (doi: 10.1109/ICMAC54080.2021.9678298)
Malik, T., Tahir, A., Bilal, A., Dashtipour, K., Imran, M. A., Abbasi, Q. H. (2022) Social sensing for sentiment analysis of policing authority performance in smart cities. Frontiers in Communications and Networks, 2, (doi: 10.3389/frcmn.2021.821090)
Jabbar, A., Ramzan, R., Siddiqui, O., Amin, M., Imran, M. A., Abbasi, Q. H., Ur Rehman, M. (2022) Three-Port Lorentz Resonance Based Permittivity Sensor and Microwave Comparator. (doi: 10.1109/ICMAC54080.2021.9678261)
Abbott, R. et al. (2022) Search for continuous gravitational waves from 20 accreting millisecond x-ray pulsars in O3 LIGO data. Physical Review D, 105, (doi: 10.1103/PhysRevD.105.022002)
Rehman, M. U., Shafique, A., Khan, K. H., Khalid, S., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Ahmad, J., Shah, S. A., Abbasi, Q. H. (2022) Novel privacy preserving non-invasive sensing-based diagnoses of pneumonia disease leveraging deep network model. Sensors, 22, (doi: 10.3390/s22020461)
Wagih, M. (2022) Broadband low-loss on-body UHF to millimeter-wave surface wave links using flexible textile single wire transmission lines. IEEE Open Journal of Antennas and Propagation, 3, pp. 101-111. (doi: 10.1109/OJAP.2021.3136654)
Rahman, A., Roy, K. J., Rahman, K.M. A., Aktar, M. K., Kafi, M. A., Islam, M. S., Rahman, M. B., Islam, M. R., Hossain, K. S., Rahman, M. M., Heidari, H. (2022) Adhesion and proliferation of living cell on surface functionalized with glycine nanostructures. Nano Select, 3, pp. 188-200. (doi: 10.1002/nano.202100043)
Jesper Jacobsson, T. et al. (2022) An open-access database and analysis tool for perovskite solar cells based on the FAIR data principles. Nature Energy, 7, pp. 107-115. (doi: 10.1038/s41560-021-00941-3)
Chakraborty, M., Kettle, J., Dahiya, R. (2022) Electronic waste reduction through devices and printed circuit boards designed for circularity. IEEE Journal on Flexible Electronics, 1, pp. 4-23. (doi: 10.1109/JFLEX.2022.3159258)
Danilin, S., Barbosa, J., Farage, M., Zhao, Z., Shang, X., Burnett, J., Ridler, N., Li, C., Weides, M. (2022) Engineering the microwave to infrared noise photon flux for superconducting quantum systems. EPJ Quantum Technology, 9, (doi: 10.1140/epjqt/s40507-022-00121-6)
Yu, Z., Zahid, A., Ansari, S. S., Abbas, H. T., Heidari, H., Imran, M. A., Abbasi, Q. H. (2022) IMU sensing–based Hopfield neuromorphic computing for human activity recognition. Frontiers in Communications and Networks, 2, (doi: 10.3389/frcmn.2021.820248)
Al-Moathin, A., Smith, M. D., Thayne, I., Kuball, M., Li, C. (2022) Low Damage High Selectivity Cl2/N2/O2-Based Inductively Coupled Plasma Etching for GaN/AlGaN Heterostructures.
Khademhosseini, V., Dideban, D., Ahmadi, M. T., Heidari, H. (2022) Schemes for single electron transistor based on double quantum dot islands utilizing a graphene nanoscroll, carbon nanotube and fullerene. Molecules, 27, (doi: 10.3390/molecules27010301)
Wagih, M., Komolafe, A., Hillier, N. (2022) Screen-printable flexible textile-based ultra-broadband millimeter-wave DC-blocking transmission lines based on microstrip-embedded printed capacitors. IEEE Journal of Microwaves, 2, pp. 162-173. (doi: 10.1109/JMW.2021.3126927)
Bendiek, P., Taha, A., Abbasi, Q. H., Barakat, B. (2022) Solar irradiance forecasting using a data-driven algorithm and contextual optimisation. Applied Sciences, 12, (doi: 10.3390/app12010134)
Noman, M., Haider, U. A., Ullah, H., Tahir, F. A., Khan, M. U., Abbasi, Q. H. (2022) 12-Bit Chip-less RFID Tag with High Coding Capacity per Unit Area. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886297)
Wagih, M., Hilton, G. S., Weddell, A., Beeby, S. (2022) 5G-enabled e-textiles Based on a low-profile millimeter-wave textile antenna. Engineering Proceedings, 15, (doi: 10.3390/engproc2022015013)
Mohamed, A., Wagner, M., Heidari, H., Anders, J. (2022) A frontend for magnetoresistive sensors with a 2.2 pA/√Hz low-noise current source. IEEE Solid-State Circuits Letters, 5, pp. 17-20. (doi: 10.1109/LSSC.2022.3148362)
Nasir, M., Xia, Y., Sharif, A. B., Guo, G., Zhu, Q., Ur Rehman, M., Abbasi, Q. H. (2022) A high gain embedded helix and dielectric rod antenna with low side lobe levels for iot applications. Sensors, 22, (doi: 10.3390/s22207760)
Aitbar, I., Shoaib, N., Alomainy, A., Quddious, A., Nikolaou, S., Imran, M. A., Abbasi, Q. H. (2022) AMC integrated multilayer wearable antenna for multiband WBAN applications. Computers, Materials and Continua, 7, pp. 3227-3241. (doi: 10.32604/cmc.2022.023008)
Molloy, A., Beaumont, K., Alyami, A., Kirimi, M., Hoare, D., Mirzai, N., Heidari, H., Mitra, S., Neale, S. L., Mercer, J. R. (2022) Challenges to the development of the next generation of self-reporting cardiovascular implantable medical devices. IEEE Reviews in Biomedical Engineering, 15, pp. 260-272. (doi: 10.1109/RBME.2021.3110084)
Kaur, J., Popoola, O. R., Imran, M. A., Abbasi, Q. H., Abbas, H. T. (2022) Deep neural network for localization of mobile users using raytracing. (doi: 10.23919/USNC-URSI52669.2022.9887432)
Jabbar, A., Abbasi, Q. H., Imran, M. A., Ur Rehman, M. (2022) Design of a 60 GHz Antenna for Multi-Gigabit WiGig Communication in Industry 4.0. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886405)
Ullah, I., Wagih, M., Beeby, S. P. (2022) Design of textile antenna for moisture sensing. (doi: 10.3390/engproc2022015011)
Wagih, M., Malik, O., Weddell, A. S., Beeby, S. (2022) E-textile Breathing Sensor Using Fully Textile Wearable Antennas. (doi: 10.3390/engproc2022015009)
Saeed, U., Shah, S. A., Khan, M. Z., Alotaibi, A. A., Ramzan, N., Abbasi, Q. H. (2022) Intelligent reflecting surface-based non-LOS human activity recognition for next-generation 6G-enabled healthcare system. Sensors, 22, (doi: 10.3390/s22197175)
Hassouna, S., Rains, J., Kazim, J. U. R., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2022) Investigating the Data Rate of Intelligent Reflecting Surface Under Different Deployments. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886560)
Feng, Z., Ren, A., Chen, Z., Zahid, A., Ye, L., Imran, M. A., Abbasi, Q. H. (2022) Portable and feasible device to evaluate the technique of swimming practitioners. IEEE Access, 10, pp. 88093-88104. (doi: 10.1109/ACCESS.2022.3200743)
Hameed, H., Azam, N., Usman, M., Abbas, H., Imran, M. A., Abbasi, Q. H. (2022) RF Sensing For Smoking Detection At Oil Fields. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9887288)
Lubna, , Hameed, H., Ansari, S., Zahid, A., Sharif, A., Abbas, H. T., Alqahtani, F., Mufti, N., Ullah, S., Imran, M. A., Abbasi, Q. H. (2022) Radio frequency sensing and it’s innovative applications in diverse sectors: a comprehensive study. Frontiers in Communications and Networks, 3, (doi: 10.3389/frcmn.2022.1010228)
Ge, Y., Li, S., Zhu, S., Taha, A., Cooper, J., Imran, M., Abbasi, Q. H. (2022) Respiration Detection of Sedentary Person Using Ubiquitous WiFi Signals. (doi: 10.1109/AP-S/USNC-URSI47032.2022.9886717)
Paosangthong, W., Wagih, M., Torah, R., Beeby, S. (2022) Textile manufacturing compatible triboelectric nanogenerator with alternating positive and negative woven structure. Engineering Proceedings, 15, (doi: 10.3390/engproc2022015019)
Wagih, M., Shi, J. (2022) Towards the optimal antenna-based wireless sensing strategy: an ice sensing case study. IEEE Open Journal of Antennas and Propagation, 3, pp. 687-699. (doi: 10.1109/OJAP.2022.3182770)
Abohmra, A., Khan, Z. U., Abbas, H. T., Shoaib, N., Imran, M. A., Abbasi, Q. H. (2022) Two-dimensional materials for future terahertz wireless communications. IEEE Open Journal of Antennas and Propagation, 3, pp. 217-228. (doi: 10.1109/OJAP.2022.3143994)
Sharif, A., Ouyang, J., Raza, A., Hussain, S., Nasir, M., Arshad, K., Assaleh, K., Ramzan, N., Imran, M. A., Abbasi, Q. H. (2022) UHF RFID tag design using theory of characteristics modes for platform-tolerant and harsh metallic environments. IEEE Journal of Radio Frequency Identification, 6, pp. 524-533. (doi: 10.1109/JRFID.2022.3194992)
Karimi, M., Dideban, D., Heidari, H. (2022) Using the intelligent system to improve the delivered adequacy of dialysis by preventing intradialytic complications. Journal of Healthcare Engineering, 2022, (doi: 10.1155/2022/8160269)
Khosravi, S., Bailey, S. G., Parvizi, H., Ghannam, R. (2022) Wearable sensors for learning enhancement in higher education. Sensors, 22, (doi: 10.3390/s22197633)
2021
Yang, X., McGlynn, E., Das, R., Paşca, S. P., Cui, B., Heidari, H. (2021) Nanotechnology enables novel modalities for neuromodulation. Advanced Materials, 33, (doi: 10.1002/adma.202103208)
Ge, Y., Li, S., Shentu, M., Taha, A., Zhu, S., Cooper, J., Imran, M., Abbasi, Q. (2021) A Doppler-based Human Activity Recognition System using WiFi Signals. (doi: 10.1109/SENSORS47087.2021.9639680)
Taha, A., Taha, M. M.A., Barakat, B., Taylor, W., Abbasi, Q. H., Imran, M. A. (2021) AI-Based Fall Detection Using Contactless Sensing. (doi: 10.1109/SENSORS47087.2021.9639715)
Abbott, R. et al. (2021) Search for lensing signatures in the gravitational-wave observations from the first half of LIGO–Virgo’s third observing run. Astrophysical Journal, 923, (doi: 10.3847/1538-4357/ac23db)
Rains, J., Kazim, J. U. R., Zhang, L., Abbasi, Q. H., Imran, M. A., Tukmanov, A. (2021) 2.75-Bit Reflecting Unit Cell Design for Reconfigurable Intelligent Surfaces. (doi: 10.1109/APS/URSI47566.2021.9704689)
Német, A., Alkaraki, S., Abbasi, Q. H., Jilani, S. F. (2021) A Biodegradable Textile-based Graphene Antenna for 5G Wearable Applications. (doi: 10.1109/APS/URSI47566.2021.9704120)
Kazim, J. U. R., Abbas, H., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2021) A Wideband Miniaturized 3 dB Hybrid Coupler for Passive Beam Switching Application. (doi: 10.1109/APS/URSI47566.2021.9704554)
Al-Taai, Q. R. A., Wang, J., Morariu, R., Ofiare, A., Al-Khalidi, A., Wasige, E. (2021) Analysis of stability of nano- vs micro-sized resonant tunnelling diode (RTD) devices for future neuromorphic computing applications. International Journal of Nanoelectronics and Materials, 14, pp. 149-155.
Yan, L.-m., Abohmra, A., Kazim, J. U. R., Sharif, A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2021) Compact Magnetically Symmetric Antenna Design for Implantable Biomedical Applications. (doi: 10.1109/APS/URSI47566.2021.9704642)
Jabbar, A., Kazim, J. U. R., Imran, M. A., Abbasi, Q. H., Ur Rehman, M. (2021) Design of a Compact Ultra-Wideband Microstrip Antenna for Millimeter-Wave Communication. (doi: 10.1109/APS/URSI47566.2021.9704395)
Zhang, J., Das, R., Abbasi, Q. H., Mirzai, N., Mercer, J., Heidari, H. (2021) Dual-band Microstrip Patch Antenna for Fully-Wireless Smart Stent. (doi: 10.1109/APS/URSI47566.2021.9703759)
Kaur, J., Abbasi, Q. H., Sharif, A. B., Popoola, O., Imran, M. A., Abbas, H. T. (2021) Enhancing Wave Propagation via Contextual Beamforming. (doi: 10.1109/APS/URSI47566.2021.9703804)
Ofiare, A., Taking, S., Karami, K., Dhongde, A., Al-Khalidi, A., Wasige, E. (2021) Investigation of plasma induced etch damage/changes in AlGaN/GaN HEMTs. International Journal of Nanoelectronics and Materials, 14, pp. 29-36.
Yu, Z., Zahid, A., Taylor, W., Heidari, H., Imran, M. A., Abbasi, Q. H. (2021) Multi-Sensing Data Fusion for Human Activity Recognition Based on Neuromorphic Computing. (doi: 10.23919/USNC-URSI51813.2021.9703558)
Cimbri, D., Weimann, N., Al-Taai, Q. R. A., Ofiare, A., Wasige, E. (2021) Ohmic contacts optimisation for high-power InGaAs/AlAs double-barrier resonant tunnelling diodes based on a dual-exposure E-beam lithography approach. International Journal of Nanoelectronics and Materials, 14, pp. 11-19.
Sharif, A. B., Kaur, J., Abbas, H. T., Abbasi, Q. H., Imran, M. A., Arshad, K., Assaleh, K. (2021) Platform Tolerant UHF RFID Tag Design using Multi-resonant Surface for Supply Chain Visibility. (doi: 10.1109/APS/URSI47566.2021.9704524)
David, T. W., Amorim Soares, G., Bristow, N., Bagnis, D., Kettle, J. (2021) Predicting diurnal outdoor performance and degradation of organic photovoltaics via machine learning; relating degradation to outdoor stress conditions. Progress in Photovoltaics, 29, pp. 1274-1284. (doi: 10.1002/pip.3453)
Taylor, W., Taha, A., Dashtipour, K., Shah, S. A., Abbasi, Q. H., Imran, M. A. (2021) RF Based Real Time Human Motion Sensing. (doi: 10.1109/APS/URSI47566.2021.9703954)
Ge, Y., Dashtipour, K., Shah, S. A., Cooper, J., Abbasi, Q. H., Imran, M. A. (2021) Real-Time Human Activity Recognition System Exploiting Ubiquitous Wi-Fi Signals. (doi: 10.1109/APS/URSI47566.2021.9704160)
Wagih, M., Hillier, N., Weddell, A., Beeby, S. (2021) Textile-based Radio Frequency Energy Harvesting and Storage using Ultra-Compact Rectennas with High Effective-to-Physical Area Ratio. (doi: 10.1109/PowerMEMS54003.2021.9658367)
Suresh Kumar, S., Dashtipour, K., Abbasi, Q. H., Imran, M. A., Ahmad, W. (2021) The Challenges in Implementing Wearable Antennas for Large-Scale Health Monitoring. (doi: 10.1109/APS/URSI47566.2021.9703857)
Dhongde, A., Taking, S., Elksne, M., Samanta, S., Ofiare, A., Karami, K., Al-Khalidi, A., Wasige, E. (2021) The role of selective pattern etching to improve the Ohmic contact resistance and device performance of AlGaN/GaN HEMTs. International Journal of Nanoelectronics and Materials, 14, pp. 21-28.
Kazim, J. U. R., Cui, T. J., Zoha, A., Li, L., Shah, S. A., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) Wireless on walls: revolutionizing the future of health care. IEEE Antennas and Propagation Magazine, 63, pp. 87-93. (doi: 10.1109/MAP.2020.3036063)
Abbott, R. et al. (2021) Constraints from LIGO O3 data on gravitational-wave emission due to r-modes in the glitching pulsar PSR J0537–6910. Astrophysical Journal, 922, (doi: 10.3847/1538-4357/ac0d52)
Abbott, R. et al. (2021) All-sky search for long-duration gravitational-wave bursts in the third Advanced LIGO and Advanced Virgo run. Physical Review D, 104, (doi: 10.1103/PhysRevD.104.102001)
Ghannam, R. (2021) Using OneNote and MS Teams for Remotely Supervising Electronic Engineering Students.
Khosravi, S., Ghannam, R. (2021) Enhancing STEM Education using Wearable Biofeedback.
Khan, A. R., Khosravi, S., Hussain, S., Ghannam, R., Zoha, A., Imran, M. A. (2021) EXECUTE: Exploring Eye Tracking to Support E-learning. (doi: 10.1109/EDUCON52537.2022.9766506)
Xia, Y., Heidari, H., Ghannam, R. (2021) Photovoltaic Systems Design that Serves the Human Senses.
Xia, Y., Heidari, H., Ghannam, R. (2021) Reconfigurable Devices that Extend our Senses.
Khosravi, S., Khan, A. R., Zoha, A., Ghannam, R. (2021) Self-Directed Learning using Eye-Tracking: A Comparison between Wearable Head-worn and Webcam-based Technologies. (doi: 10.1109/EDUCON52537.2022.9766468)
AlQallaf, N., Chen, X., Ge, Y., Khan, A., Zoha, A., Hussain, S., Ghannam, R. (2021) Teaching Solar Energy Systems Design using Game-Based Virtual Reality. (doi: 10.1109/EDUCON52537.2022.9766460)
Sharif, A., Abbasi, Q. H., Arshad, K., Ansari, S., Ali, M. Z., Kaur, J., Abbas, H. T., Imran, M. A. (2021) Machine Learning enabled food contamination detection using RFID and Internet of Things system. Journal of Sensor and Actuator Networks, 10, (doi: 10.3390/jsan10040063)
Abbott, R. et al. (2021) Searches for continuous gravitational waves from young supernova remnants in the early third observing run of Advanced LIGO and Virgo. Astrophysical Journal, 921, (doi: 10.3847/1538-4357/ac17ea)
Abohmra, A., Abbas, H., Kazim, J. U. R., Rabbani, M. S., Li, C., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) An ultrawideband microfabricated gold-based antenna array for terahertz communication. IEEE Antennas and Wireless Propagation Letters, 20, pp. 2156-2160. (doi: 10.1109/LAWP.2021.3072562)
Cerezo Sanchez, M., Zuo, S., Moldovan, A., Cochran, S., Nazarpour, K., Heidari, H. (2021) Flexible Piezoelectric Sensors for Miniaturized Sonomyography. (doi: 10.1109/EMBC46164.2021.9630342)
Ur-Rehman, M., Sensale-Rodriguez, B., Alomainy, A., Yang, X., Abbasi, Q. H. (2021) Guest editorial: special cluster on antenna considerations for future millimeter-wave and terahertz wireless systems. IEEE Antennas and Wireless Propagation Letters, 20, pp. 2130-2135. (doi: 10.1109/LAWP.2021.3118612)
Wagih, M., Moody, T. (2021) Open-Source Low-Cost Antenna Measurement Setup for Rapid Echoic Measurements. (doi: 10.1109/CAMA49227.2021.9703629)
Kahwash, F., Barakat, B., Taha, A., Abbasi, Q. H., Imran, M. A. (2021) Optimising electrical power supply sustainability using a grid-connected hybrid renewable energy system—an NHS hospital case study. Energies, 14, (doi: 10.3390/en14217084)
Zhang, Y., Jiang, N., Liu, S., Lavery, M. P. J., Abbas, H., Qiu, K. (2021) Physical Layer Encryption in CO-OFDM Employing Chaotic Mapping and Novel 3D 16-Ary Constellation. (doi: 10.1109/UCET54125.2021.9674976)
Abbasi, M. I., Ismail, M. Y., Kamarudin, M. R., Abbasi, Q. H. (2021) Reconfigurable reflectarray antenna: a comparison between design using pin diodes and liquid crystals. Wireless Communications and Mobile Computing, 2021, (doi: 10.1155/2021/2835638)
Wang, J., Al-Khalidi, A., Ahearne, S., Wasige, E. (2021) 1080P HD Video Transmission using RTD Transmitter. (doi: 10.1109/UCMMT53364.2021.9569915)
AlQallaf, N., Chen, X., Hussain, S., Ghannam, R. (2021) Learning Sustainable Development using Game Based Virtual Reality.
Mohjazi, L., Muhaidat, S., Abbasi, Q. H., Imran, M. A., Dobre, O. A., Di Renzo, M. (2021) Battery recharging time models for reconfigurable intelligent surfaces-assisted wireless power transfer systems. IEEE Transactions on Green Communications and Networking, 6, pp. 1173-1185. (doi: 10.1109/TGCN.2021.3120834)
Abbott, R. et al. (2021) All-sky search for continuous gravitational waves from isolated neutron stars in the early O3 LIGO data. Physical Review D, 104, (doi: 10.1103/PhysRevD.104.082004)
Saeed, U., Shah, S. Y., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Abbasi, Q. H., Shah, S. A. (2021) Portable UWB RADAR sensing system for transforming subtle chest movement into actionable micro-doppler signatures to extract respiratory rate exploiting ResNet algorithm. IEEE Sensors Journal, 21, pp. 23518-23526. (doi: 10.1109/JSEN.2021.3110367)
Asad, S. M., Tahir, A., Bin Rais, R. N., Ansari, S., Abubakar, A. I., Hussain, S., Abbasi, Q. H., Imran, M. A. (2021) Edge intelligence in private mobile networks for next generation railway systems. Frontiers in Communications and Networks, 2, (doi: 10.3389/frcmn.2021.769299)
Citoni, B., Ansari, S., Abbasi, Q. H., Imran, M. A., Hussain, S. (2021) Comparative analysis of discrete time simulations and stochastic geometry models of a single gateway LoRaWAN network. (doi: 10.1109/SmartIoT52359.2021.00011)
Song, Y., Taylor, W., Ge, Y., Dashtipour, K., Imran, M. A., Abbasi, Q. H. (2021) Design and Implementation of a Contactless AI-enabled Human Motion Detection System for Next-Generation Healthcare. (doi: 10.1109/SmartIoT52359.2021.00027)
Rehman, M., Shah, R. A., Khan, M. B., Shah, S. A., AbuAli, N. A., Yang, X., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) Improving machine learning classification accuracy for breathing abnormalities by enhancing dataset. Sensors, 21, (doi: 10.3390/s21206750)
Fan, H., Xie, H., Ghannam, R. (2021) Wearable Electronics Education for Neurological Diseases. (doi: 10.1109/IGARSS47720.2021.9553356)
Heidari, H., Onireti, O., Das, R., Imran, M. (2021) Energy harvesting and power management for IoT devices in the 5G era. IEEE Communications Magazine, 59, pp. 91-97. (doi: 10.1109/MCOM.101.2100487)
James, R., Willman, E., Ghannam, R., Beeckman, J., Fernández, F. A. (2021) Hydrodynamics of fringing-field induced defects in nematic liquid crystals. Journal of Applied Physics, 130, (doi: 10.1063/5.0062532)
Wagih, M., Hilton, G. S., Weddell, A. S., Beeby, S. (2021) Dual-band dual-mode textile antenna/rectenna for simultaneous wireless information and power transfer (SWIPT) IEEE Transactions on Antennas and Propagation, 69, pp. 6322-6332. (doi: 10.1109/TAP.2021.3070230)
Hatem, T., Ismail, Z., Elmahgary, M. G., Ghannam, R., Ahmed, M. A., Abdellatif, S. O. (2021) Optimization of organic meso-superstructured solar cells for underwater IoT² self-powered sensors. IEEE Transactions on Electron Devices, 68, pp. 5319-5321. (doi: 10.1109/TED.2021.3101780)
Barzegar, M. H., Sabzehmeidani, M. M., Ghaedi, M., Avargani, V. M., Moradi, Z., Roy, V. A.L., Heidari, H. (2021) S-scheme heterojunction g-C3N4/TiO2 with enhanced photocatalytic activity for degradation of a binary mixture of cationic dyes using solar parabolic trough reactor. Chemical Engineering Research and Design, 174, pp. 307-318. (doi: 10.1016/j.cherd.2021.08.015)
David, T. W., Bristow, N., Stoichkov, V., Huang, H., Todeschini, G., Kettle, J. (2021) The effect of OPV module size on stability and diurnal performance: outdoor tests and application of a computer model. Energies, 14, (doi: 10.3390/en14196324)
Al-Moathin, A., Li, C., Wang, J., Al-Taai, Q. R. A., Eddie, I., Ye, S., Hou, L., Thoms, S., Kelly, A., Marsh, J. H. (2021) Traveling-Wave Electroabsorption Modulated Laser Based on Identical Epitaxial Layer Scheme and HSQ Planarization. (doi: 10.1109/CLEO/Europe-EQEC52157.2021.9542652)
Vali, M., Moezi, N., Heidari, H., Bayani, A. (2021) A scheme of quantum tunnel field effect transistor based on armchair graphene nano-ribbon. ECS Journal of Solid State Science and Technology, 10, (doi: 10.1149/2162-8777/ac2329)
Ahmad, W., Li, C., Gamage, K. A.A. (2021) Deployment of Robots Remotely in Teaching Programming and Robotics – Future of Engineering Laboratories.
Tamoor, T., Shoaib, N., Ahmed, F., Hassan, T., Quddious, A., Nikolaou, S., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) A multifunctional ultrathin flexible bianisotropic metasurface with miniaturized cell size. Scientific Reports, 11, (doi: 10.1038/s41598-021-97930-z)
Saeed, U., Shah, S. Y., Zahid, A., Anjum, N., Ahmad, J., Imran, M. A., Abbasi, Q. H., Shah, S. A. (2021) Wireless channel modelling for identifying six types of respiratory patterns with SDR sensing and deep multilayer perceptron. IEEE Sensors Journal, 21, pp. 20833-20840. (doi: 10.1109/JSEN.2021.3096641)
Hatem, T., Elmahgary, M. G., Ghannam, R., Ahmed, M. A., Abdellatif, S. O. (2021) Boosting dye-sensitized solar cell efficiency using AgVO3-doped TiO2 active layer. Journal of Materials Science: Materials in Electronics, 32, pp. 25318-25326. (doi: 10.1007/s10854-021-06990-4)
AlQallaf, N., Hussain, S., Ghannam, R. (2021) Interactive Map for Visualising Electronic Engineering Curricula.
Sharif, A., Kumar, R., Ouyang, J., Abbas, H. T., Alomainy, A., Arshad, K., Assaleh, K., Althuwayb, A., Imran, M. A., Abbasi, Q. H. (2021) Making assembly line in supply chain robust and secure using UHF RFID. Scientific Reports, 11, (doi: 10.1038/s41598-021-97598-5)
Ashleibta, A. M., Taha, A., Khan, M. A., Taylor, W., Tahir, A., Zoha, A., Abbasi, Q. H., Imran, M. A. (2021) 5G-enabled contactless multi-user presence and activity detection for independent assisted living. Scientific Reports, 11, (doi: 10.1038/s41598-021-96689-7)
Liang, L., Zheng, Q., Wen, L., Cumming, D. R.S., Chen, Q. (2021) Miniaturized spectroscopy with tunable and sensitive plasmonic structures. Optics Letters, 46, pp. 4264-4267. (doi: 10.1364/OL.426624)
Wagih, M., Shi, J. (2021) Wireless ice detection and monitoring using flexible UHF RFID tags. IEEE Sensors Journal, 21, pp. 18715-18724. (doi: 10.1109/JSEN.2021.3087326)
Khosravi, S., Ghannam, R. (2021) Calling all engineers: we need you! IEEE Potentials, 40, pp. 14-17. (doi: 10.1109/MPOT.2021.3073885)
Saeed, U., Shah, S. Y., Shah, S. A., Ahmad, J., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Alomainy, A., Abbasi, Q. H. (2021) Discrete human activity recognition and fall detection by combining FMCW RADAR data of heterogeneous environments for independent assistive living. Electronics, 10, (doi: 10.3390/electronics10182237)
Shah, S. A., Ramzan, N., Imran, M. A., Abbasi, Q. H. (2021) Editorial for the Special Issue on security and sensing devices for healthcare technologies. Micromachines, 12, (doi: 10.3390/mi12091028)
Citoni, B., Ansari, S., Abbasi, Q. H., Imran, M. A., Hussain, S. (2021) Impact of inter-gateway distance on LoRaWAN performance. Electronics, 10, (doi: 10.3390/electronics10182197)
Hassan, M. M., Ismail, Z. S., Hashem, E. M., Ghannam, R., Abdellatif, S. O. (2021) Investigating the tradeoff between transparency and efficiency in semitransparent bifacial mesosuperstructured solar cells for millimeter-scale applications. IEEE Journal of Photovoltaics, 11, pp. 1222-1235. (doi: 10.1109/JPHOTOV.2021.3086443)
Ansari, S. S., Taha, A., Dashtipour, K., Sambo, Y., Abbasi, Q. H., Imran, M. A. (2021) Urban air mobility—a 6G use case? Frontiers in Communications and Networks, 2, (doi: 10.3389/frcmn.2021.729767)
Cito, M., Cimbri, D., Childs, D., Baba, R., Harrison, B.A., Watt, A., Mukai, T., Wasige, E., Hogg, R. A. (2021) Micro-PL analysis of high current density resonant tunneling diodes for THz applications. Applied Physics Letters, 119, (doi: 10.1063/5.0059339)
Firouzi, F. et al. (2021) Harnessing the power of smart and connected health to tackle COVID-19: IoT, AI, robotics, and blockchain for a better world. IEEE Internet of Things Journal, 8, pp. 12826-12846. (doi: 10.1109/JIOT.2021.3073904)
Chen, M., Wen, L., Pan, D., Cumming, D. R.S., Yang, X., Chen, Q. (2021) Full-color nanorouter for high-resolution imaging. Nanoscale, 13, pp. 13024-13029. (doi: 10.1039/D1NR02166D)
Wagih, M. (2021) An Investigation of Meshed Printed Monopoles for Optically-Transparent Antennas.
Rehman, M., Shah, R. A., Khan, M. B., Ali, N. A. A., Alotaibi, A. A., Althobaiti, T., Ramzan, N., Shah, S. A., Yang, X., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) Contactless small-scale movement monitoring system using software defined radio for early diagnosis of COVID-19. IEEE Sensors Journal, 21, pp. 17180-17188. (doi: 10.1109/JSEN.2021.3077530)
Lakhan, A., Mastoi, Q.-u.-a., Dootio, M. A., Alqahtani, F., R. Alzahrani, I., Baothman, F., Shah, S. Y., Shah, S. A., Anjum, N., Abbasi, Q. H., Khokhar, M. S. (2021) Hybrid workload enabled and secure healthcare monitoring sensing framework in distributed fog-cloud network. Electronics, 10, (doi: 10.3390/electronics10161974)
Aman, W., Rehman, M. M. U., Ansari, S., Nasir, A. A., Qaraqe, K., Imran, M. A., Abbasi, Q. H. (2021) On the effective capacity of IRS-assisted wireless communication. Physical Communication, 47, (doi: 10.1016/j.phycom.2021.101339)
Alabbas, A. R., Hassnawi, L.A., Ilyas, M., Pervaiz, H., Abbasi, Q. H., Bayat, O. (2021) Performance enhancement of safety message communication via designing dynamic power control mechanisms in vehicular ad hoc networks. Computational Intelligence, 37, pp. 1286-1308. (doi: 10.1111/coin.12367)
Liu, Y., Khanbareh, H., Halim, M. A., Feeney, A., Zhang, X., Heidari, H., Ghannam, R. (2021) Piezoelectric energy harvesting for self-powered wearable upper limb applications. Nano Select, 2, pp. 1459-1479. (doi: 10.1002/nano.202000242)
Dangana, M., Ansari, S., Abbasi, Q. H., Hussain, S., Imran, M. A. (2021) Suitability of NB-IoT for indoor industrial environment: a survey and insights. Sensors, 21, (doi: 10.3390/s21165284)
Cimbri, D., Wasige, E. (2021) Terahertz communications with Resonant Tunnelling Diodes: status and perspectives. CRC Press
Scott-George, A., Li, C., Tang, Y. K., Shimul, S., Tareq Bin Ali, M., Marma, A., Pal, S. (2021) A Review on the Sustainability of Solar Home System for Rural Electrification. (doi: 10.1051/e3sconf/202129402003)
(2021) Autonomous Airborne Wireless Networks. (doi: 10.1002/9781119751717)
Khosravi, S., Bailey, S., Ghannam, R. (2021) Outreach Approach to Electronic Engineering Education via Wearable Technology.
Dai, S., Li, M., Abbasi, Q. H., Imran, M. A. (2021) A fast blocking matrix generating algorithm for generalized sidelobe canceller beamformer in high speed rail like scenario. IEEE Sensors Journal, 21, pp. 15775-15783. (doi: 10.1109/JSEN.2020.3002699)
Abbott, R. et al. (2021) Search for anisotropic gravitational-wave backgrounds using data from Advanced LIGO and Advanced Virgo’s first three observing runs. Physical Review D, 104, (doi: 10.1103/PhysRevD.104.022005)
Abbott, R. et al. (2021) Upper limits on the isotropic gravitational-wave background from advanced LIGO and Advanced Virgo's third observing run. Physical Review D, 104, (doi: 10.1103/PhysRevD.104.022004)
Komolafe, A., Zaghari, B., Torah, R., Weddell, A. S., Khanbareh, H., Michail Tsikriteas, Z., Vousden, M., Wagih, M., Tronco Jurado, U., Shi, J., Yong, S., Arumugam, S., Li, Y., Yang, K., Savelli, G., White, N. M., Beeby, S. (2021) E-textile technology review–from materials to application. IEEE Access, 9, pp. 97152-97179. (doi: 10.1109/ACCESS.2021.3094303)
Sharif, A. B., Yan, Y., Ouyang, J., Chattha, H. T., Arshad, K., Assaleh, K., Alotabi, A. A., Althobaiti, T., Ramzan, N., Abbasi, Q. H., Imran, M. A. (2021) Uniform magnetic field characteristics based UHF RFID tag for Internet of Things applications. Electronics, 10, (doi: 10.3390/electronics10131603)
Abbott, R. et al. (2021) Observation of gravitational waves from two neutron star–black hole coalescences. Astrophysical Journal Letters, 915, (doi: 10.3847/2041-8213/ac082e)
Bin Muhammad, M., Li, M., Abbasi, Q., Goh, C., Imran, M. (2021) A Novel Subspace-Averaging Direction of Arrival Estimation Technique. (doi: 10.1109/ICSIP52628.2021.9688940)
Bremner, D. J., Ansari, I. S., Macdougall, J., Hussain, S., Ma, M., Ponciano, J., Liu, X., Gamage, K. A.A., Abbas, H., Imran, M. A. (2021) Looking back: reviewing the challenges of policy development during the Covid-19 pandemic for a TNE partnership in Higher Education. Frontiers in Education, 6, (doi: 10.3389/feduc.2021.643323)
Ghannam, R., Xia, Y., Shen, D., Fernandez, F. A., Heidari, H., Roy, V. A.L. (2021) Reconfigurable surfaces using fringing electric fields from nanostructured electrodes in nematic liquid crystals. Advanced Theory and Simulations, 4, (doi: 10.1002/adts.202100058)
Heidari, H., Öztürk, M., Ghannam, R., Law, M.-K., Khanbareh, H., Miah, A. H. (2021) IEEE Access special section editorial: energy harvesting technologies for wearable and implantable devices. IEEE Access, 9, pp. 91324-91327. (doi: 10.1109/ACCESS.2021.3088622)
Ghannam, R. (2021) Contact Lenses and Human Machine Interfaces.
Aslam, A. R., Hafeez, N., Heidari, H., Altaf, M. A. B. (2021) An 8.62 µW Processor for Autism Spectrum Disorder Classification using Shallow Neural Network. (doi: 10.1109/AICAS51828.2021.9458412)
Barakat, B., Taha, A., Samson, R., Steponenaite, A., Ansari, S., Langdon, P. M., Wassell, I. J., Abbasi, Q., Imran, M. A., Keates, S. (2021) 6G opportunities arising from Internet of Things use cases: a review paper. Future Internet, 13, (doi: 10.3390/fi13060159)
Abbott, R. et al. (2021) Constraints on cosmic strings using data from the third Advanced LIGO–Virgo observing run. Physical Review Letters, 126, (doi: 10.1103/PhysRevLett.126.241102)
Dashtipour, K., Taylor, W., Ansari, S., Gogate, M., Zahid, A., Sambo, Y., Hussain, A., Abbasi, Q. H., Imran, M. A. (2021) Public perception of the fifth generation of cellular networks (5G) on social media. Frontiers in Big Data, 4, (doi: 10.3389/fdata.2021.640868)
Hussain, S., Abbasi, Q., Ur Rehman, M., Abbas, H., Ansari, I., Imran, M. (2021) Student-Staff Partnership for Co-Creating Tutorial Based Feedback Approach.
Sodhro, A. H., Gurtov, A., Zahid, N., Pirbhulal, S., Wang, L., Rahman, M. M. U., Imran, M. A., Abbasi, Q. H. (2021) Towards convergence of AI and IoT for energy efficient communication in smart homes. IEEE Internet of Things Journal, 8, pp. 9664-9671. (doi: 10.1109/JIOT.2020.3023667)
Taylor, W., Dashtipour, K., Shah, S. A., Hussain, A., Abbasi, Q. H., Imran, M. A. (2021) Radar sensing for activity classification in elderly people exploiting micro-doppler signatures using machine learning. Sensors, 21, (doi: 10.3390/s21113881)
Yuan, M., Das, R., McGlynn, E., Ghannam, R., Abbasi, Q. H., Heidari, H. (2021) Wireless communication and power harvesting in wearable contact lens sensors. IEEE Sensors Journal, 21, pp. 12484-12497. (doi: 10.1109/JSEN.2021.3055077)
bin Imtiaz, M. S., Babar Ali, C., Kausar, Z., Shah, S. Y., Shah, S. A., Ahmad, J., Imran, M. A., Abbasi, Q. H. (2021) Design of portable exoskeleton forearm for rehabilitation of monoparesis patients using tendon flexion sensing mechanism for health care applications. Electronics, 10, (doi: 10.3390/electronics10111279)
Shi, J., Wagih, M. (2021) Flexible Direct-Write Printed RF Sensor for RF Ice Sensing. (doi: 10.1109/FLEPS51544.2021.9469841)
Heidari, H., Mcfarlane, N., Kim, C. (2021) Guest Editorial Special Issue on Selected Papers From IEEE ISCAS 2020. IEEE Transactions on Biomedical Circuits and Systems, 15, pp. 366-368. (doi: 10.1109/TBCAS.2021.3100739)
Alani, S., Zakaria, Z., Saeidi, T., Ahmad, A., Imran, M. A., Abbasi, Q. H. (2021) Microwave imaging of breast skin utilizing elliptical UWB antenna and reverse problems algorithm. Micromachines, 12, (doi: 10.3390/mi12060647)
Rehman, M., Shah, R. A., Khan, M. B., AbuAli, N. A., Shah, S. A., Yang, X., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) RF sensing based breathing patterns detection leveraging USRP devices. Sensors, 21, (doi: 10.3390/s21113855)
Abbott, R. et al. (2021) Diving below the spin-down limit: constraints on gravitational waves from the energetic young pulsar PSR J0537-6910. Astrophysical Journal Letters, 913, (doi: 10.3847/2041-8213/abffcd)
Suresh Kumar, S., Dashtipour, K., Abbasi, Q. H., Imran, M. A., Ahmad, W. (2021) A review on wearable and contactless sensing for COVID-19 with policy challenges. Frontiers in Communications and Networks, 2, (doi: 10.3389/frcmn.2021.636293)
Aman, W., Rahman, M. M. U., Abbas, H. T., Khalid, M., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2021) Securing the insecure: a first-line-of-defense for body-centric nanoscale communication systems operating in THz band. Sensors, 21, (doi: 10.3390/s21103534)
McGlynn, E., Nabaei, V., Ren, E., Galeote-Checa, G., Das, R., Curia, G., Heidari, H. (2021) The future of neuroscience: flexible and wireless implantable neural electronics. Advanced Science, 8, (doi: 10.1002/advs.202002693)
Samanta, S., Wang, J., Wasige, E. (2021) Two-Step Lithography RTD Fabrication Process Using Air-Bridge Technology.
Covi, E., Donati, E., Liang, X., Kappel, D., Heidari, H., Payvand, M., Wang, W. (2021) Adaptive extreme edge computing for wearable devices. Frontiers in Neuroscience, 15, (doi: 10.3389/fnins.2021.611300)
Fan, H., Feng, L., Zhang, K., Fang, Z., Cen, Y., Li, Y., Li, D., Feng, Q., Gatti, U., Heidari, H. (2021) Fast-transient radiation-hardened low-dropout voltage regulator for space applications. IEEE Transactions on Nuclear Science, 68, pp. 1094-1102. (doi: 10.1109/TNS.2021.3070697)
Wagih, M., Weddell, A. S., Beeby, S. (2021) Omnidirectional dual-polarized low-profile textile rectenna with over 50% efficiency for sub-μW/cm2 wearable power harvesting. IEEE Transactions on Antennas and Propagation, 69, pp. 2522-2536. (doi: 10.1109/TAP.2020.3030992)
Fotouhi, S., Tabatabaeian, A., Zuo, S., Liu, S., Heidari, H., Fotouhi, M. (2021) Application of Electrical Resistance Change Method for Impact Damage Monitoring in Quasi-isotropic Hybrid Composites.
Li, Y., Zuo, S., Ranford-Cartwright, L., Mirzai, N., Heidari, H. (2021) Magnetoresistance Sensor with Analog Frontend for Lab-on-Chip Malaria Parasites Detection. (doi: 10.1109/ISCAS51556.2021.9401067)
Fan, H., Li, B., Liu, J., Wei, Q., Heidari, H. (2021) Project-Based Course in Electronic Engineering Education. (doi: 10.1109/ISCAS51556.2021.9401483)
Das, R., McGlynn, E., Yuan, M., Heidari, H. (2021) Serpentine-Shaped Metamaterial Energy Harvester for Wearable and Implantable Medical Systems. (doi: 10.1109/ISCAS51556.2021.9401288)
Cimbri, D., Yavas-Aydin, B., Jabeen, F., Höfling, S., Wasige, E. (2021) Modeling of High-Power Resonant Tunneling Diodes through the Non-Equilibrium Green’s Function Method.
Shah, S. M. Q. A., Ahmed, F., Shoaib, N., Quddious, A., Nikolaou, S., Abbasi, Q. H. (2021) An Angularly Stable Anisotropic Metasurface for Polarization Conversion Applications. (doi: 10.23919/EuCAP51087.2021.9411192)
(2021) Backscattering and RF Sensing for Future Wireless Communication. (doi: 10.1002/9781119695721)
Alhawari, A. R. H., Majeed, S. F., Saeidi, T., Mumtaz, S., Alghamdi, H., Hindi, A. T., Almawgani, A. H. M., Imran, M. A., Abbasi, Q. H. (2021) Compact elliptical UWB antenna for underwater wireless communications. Micromachines, 12, (doi: 10.3390/mi12040411)
Omeke, K. G., Mollel, M. S., Ozturk, M., Ansari, S., Zhang, L., Abbasi, Q., Imran, M. (2021) DEKCS: a dynamic clustering protocol to prolong underwater sensor networks. IEEE Sensors Journal, 21, pp. 9457-9464. (doi: 10.1109/JSEN.2021.3054943)
Al-Moathin, A., Li, C., Hou, L., Marsh, J. H. (2021) Novel Design for Electroabsorption Modulator Based on Microstrip Transmission Line Technology.
Das, S., Tang, Y. K., Marma, S., Hasan, K., Ahmed, K., Nessa, A., Ali, M. T. B., Pal, S. K., Li, C., Marma, D. A. G., Saha, S. (2021) Design and Analysis of an AC Coupled Photovoltaic System for an Off-grid Community in Chittagong Hill Tracts. (doi: 10.1109/ICREGA50506.2021.9388295)
Mollel, M. S., Abubakar, A. I., Öztürk, M., Kaijage, S., Kisangiri, M., Hussain, S., Imran, M. A., Abbasi, Q. H. (2021) A survey of machine learning applications to handover management in 5G and beyond. IEEE Access, 9, pp. 45770 -45802. (doi: 10.1109/ACCESS.2021.3067503)
Mahmood, S. N., Ishak, A. J., Saeidi, T., Soh, A. C., Jalal, A., Imran, M. A., Abbasi, Q. H. (2021) Full ground ultra-wideband wearable textile antenna for breast cancer and wireless area body network applications. Micromachines, 12, (doi: 10.3390/mi12030322)
Farage, M., Zhao, Z., Abbasi, Q., Li, C. (2021) Evaluation of a 300 GHz Near Field Antenna Measurement System.
Abbott, R. et al. (2021) All-sky search in early O3 LIGO data for continuous gravitational-wave signals from unknown neutron stars in binary systems. Physical Review D, 103, (doi: 10.1103/PhysRevD.103.064017)
Basu, R., Rao, J. N., Letizia, R., Ni, Q., Wasige, E., Al-Khalidi, A. (2021) Front End for D-band High Data Rate Point to Point Links.
Wagih, M., Hillier, N., Yong, S., Weddell, A. S., Beeby, S. (2021) RF-powered wearable energy harvesting and storage module based on e-textile coplanar waveguide rectenna and supercapacitor. IEEE Open Journal of Antennas and Propagation, 2, pp. 302-314. (doi: 10.1109/OJAP.2021.3059501)
Annese, V. F., Patil, S. B., Hu, C., Giagkoulovits, C., Al-Rawhani, M. A., Grant, J., Macleod, M., Clayton, D.J., Heaney, L.M., Daly, R., Accarino, C., Shah, Y. D., Cheah, B. C., Beeley, J., Evans, T.R.J., Jones, R., Barrett, M. P., Cumming, D. R.S. (2021) A monolithic single-chip point-of-care platform for metabolomic prostate cancer detection. Microsystems and Nanoengineering, 7, (doi: 10.1038/s41378-021-00243-4)
Wagih, M., Hilton, G. S., Weddell, A., Beeby, S. (2021) 2.4 GHz Wearable Textile Antenna/Rectenna for Simultaneous Information and Power Transfer. (doi: 10.23919/EuCAP51087.2021.9411499)
Fan, H., Zhang, J., Zuo, S., Hu, Q., Feng, Q., Heidari, H. (2021) A CMOS hall sensor modelling with readout circuitry and microcontroller processing for magnetic detection. Review of Scientific Instruments, 92, (doi: 10.1063/5.0038295)
Belaoura, W., Ghanem, K., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2021) A cooperative massive MIMO system for future In vivo nanonetworks. IEEE Systems Journal, 15, pp. 331-337. (doi: 10.1109/JSYST.2020.2995671)
Karbalaei, M., Dideban, D., Heidari, H. (2021) A sectorial scheme of gate-all-around field effect transistor with improved electrical characteristics. Ain Shams Engineering Journal, 12, pp. 755-760. (doi: 10.1016/j.asej.2020.04.015)
Wagih, M., Weddell, A. S., Beeby, S. (2021) Analyzing and Maximizing the Power Harvesting Efficiency of a Textile Rectenna Through Reflector-Based Shielding. (doi: 10.23919/EuCAP51087.2021.9411484)
Tan, M. C., Li, D., Abbasi, Q. H., Imran, M. A. (2021) Antenna Design Challenges and Future Directions for Modern Transportation Market. Springer
Saeidi, T., Ismail, I., Noghanian, S., Alhawari, A. R.H., Abbasi, Q. H., Imran, M. A., Zeain, M.Y., Ali, S. M. (2021) High gain triple-band metamaterial-based antipodal Vivaldi MIMO antenna for 5G communications. Miscromachines, 12, (doi: 10.3390/mi12030250)
Kazim, J. U. R., Abohmra, A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2021) A Corrugated SIW Based Slot Antenna for Terahertz Application. (doi: 10.1109/IEEECONF35879.2020.9329508)
Dai, S., Li, M., Imran, M. A., Abbasi, Q. H. (2021) A Fast Blocking Matrix Generating Algorithm for Generalized Sidelobe Canceller Beamforming. (doi: 10.1109/IEEECONF35879.2020.9329735)
Tan, M. C., Li, D., Abbasi, Q. H., Imran, M. (2021) An Amplitude Distribution Network in the T/R Module for Beamforming Applications. (doi: 10.1109/IEEECONF35879.2020.9329728)
Muhammad, M., Li, M., Abbasi, Q. H., Goh, C., Imran, M. (2021) Auto-calibration of Linear Array Antenna Positioning for Single Snapshot Direction of Arrival Estimation. (doi: 10.1109/IEEECONF35879.2020.9330495)
Ullah, U., Al-hasan, M., Koziel, S., Mabrouk, I. B., Abbasi, Q., Alomainy, A. (2021) Correlation Reduction in Closely-Spaced MIMO Antenna With Circular Polarization Diversity. (doi: 10.1109/IEEECONF35879.2020.9329856)
Ashleibta, A., Shah, S., Zahid, A., Imran, M. A., Abbasi, Q. H. (2021) Software Defined Radio Based Testbed for Large Scale Body Movements. (doi: 10.1109/IEEECONF35879.2020.9330027)
Sharif, A., Ouyang, J., Arshad, K., Imran, M. A., Abbasi, Q. H. (2021) Spider Web Shaped Near-field UHF RFID Reader Antenna for Healthcare and IoT Applications. (doi: 10.1109/IEEECONF35879.2020.9330372)
Abohmra, A., Kazim, J. U. R., Abbas, H., Imran, M., Alomainy, A., Rehman, M., Abbasi, Q. H. (2021) Ultra-wideband Hybrid PICA Terahertz Antenna for High-Resolution Biomedical Imaging. (doi: 10.1109/IEEECONF35879.2020.9329897)
Yang, X., Guan, L., Li, Y., Wang, W., Zhang, Q., Ur Rehman, M., Abbasi, Q. H. (2021) Contactless finger tapping detection at C band. IEEE Sensors Journal, 21, pp. 5249-5258. (doi: 10.1109/JSEN.2020.3032558)
Ashleibta, A. M., Abbasi, Q. H., Shah, S. A., Khalid, A., AbuAli, N. A., Imran, M. A. (2021) Non-invasive RF sensing for detecting breathing abnormalities using software defined radios. IEEE Sensors Journal, 21, pp. 5111-5118. (doi: 10.1109/JSEN.2020.3035960)
Fan, H., Wang, J., Feng, Q., Hu, Q., Zuo, S., Nabaei, V., Heidari, H. (2021) Detection techniques of biological and chemical Hall sensors. RSC Advances, 11, pp. 7257-7270. (doi: 10.1039/D0RA10027G)
Shah, S. A., Ahmad, J., Masood, F., Shah, S. Y., Pervaiz, H., Taylor, W., Imran, M. A., Abbasi, Q. H. (2021) Privacy-preserving wandering behaviour sensing in dementia patients using modified logistic and dynamic Newton Leipnik maps. IEEE Sensors Journal, 21, pp. 3669-3679. (doi: 10.1109/JSEN.2020.3022564)
Sun, Q.-J., Lei, Y., Zhao, X.-H., Han, J., Cao, R., Wu, W., Heidari, H., Li, W.-J., Sun, Q., Roy, V. A.L. (2021) Scalable fabrication of hierarchically structured graphite/polydimethylsiloxane composite films for large-area triboelectric nanogenerators and self-powered tactile sensing. Nano Energy, 80, (doi: 10.1016/j.nanoen.2020.105521)
Crawford, K. G., Maini, I., Macdonald, D. A., Moran, D. A.J. (2021) Surface transfer doping of diamond: a review. Progress in Surface Science, 96, (doi: 10.1016/j.progsurf.2021.100613)
Sabzehmeidani, M. M., Mahnaee, S., Ghaedi, M., Heidari, H., Roy, V. A.L. (2021) Carbon based materials: a review of adsorbents for inorganic and organic compounds. Materials Advances, 2, pp. 598-627. (doi: 10.1039/D0MA00087F)
Shah, S. M. Q. A., Shoaib, N., Ahmed, F., Alomainy, A., Quddious, A., Nikolaou, S., Imran, M. A., Abbasi, Q. H. (2021) A multiband circular polarization selective metasurface for microwave applications. Scientific Reports, 11, (doi: 10.1038/s41598-021-81435-w)
Elksne, M., Al-Khalidi, A., Wasige, E. (2021) Thick GaN Capped AlGaN/GaN HEMTs for Reduced Surface Effects.
Rizwan, A., Zoha, A., Mabrouk, I. B., Sabbour, H., Al-Sumaiti, A. S., Alomaniy, A., Imran, M. A., Abbasi, Q. H. (2021) A review on the state of the art in atrial fibrillation detection enabled by machine learning. IEEE Reviews in Biomedical Engineering, 14, pp. 219-239. (doi: 10.1109/RBME.2020.2976507)
Haponow, L., Kettle, J., Allsop, J. (2021) Optimization of a continuous hot embossing process for fabrication of micropyramid structures in thermoplastic sheets. Journal of Vacuum Science and Technology B, 39, (doi: 10.1116/6.0000551)
Mahmood, S. N., Ishak, A. J., Jalal, A., Saeidi, T., Shafie, S., Che Soh, A., Imran, M. A., Abbasi, Q. H. (2021) A bra monitoring system using a miniaturized wearable ultra-wideband MIMO antenna for breast cancer imaging. Electronics, 10, (doi: 10.3390/electronics10212563)
Ashour, A. S., Wahba, M. A., Ghannam, R. (2021) A cascaded classification-segmentation reversible system for computer-aided detection and cells counting in microscopic peripheral blood smear basophils and eosinophils images. IEEE Access, 9, pp. 78883-78901. (doi: 10.1109/ACCESS.2021.3083703)
Kazim, J. U. R., Khan, Z. U., Rains, J., Abbas, H. T., Ur Rehman, M., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2021) A miniaturized series fed tri-slot coplanar Vivaldi antenna for RADAR application with reduced ground plane effect. IEEE Open Journal of Antennas and Propagation, 2, pp. 949-953. (doi: 10.1109/OJAP.2021.3112786)
Mohamed, A., Heidari, H., Anders, J. (2021) A readout circuit for tunnel magnetoresistive sensors employing an ultra-low-noise current source. (doi: 10.1109/ESSCIRC53450.2021.9567752)
Zhang, W., Al-Khalidi, A., Figueiredo, J., Al-Taai, Q. R. A., Wasige, E., Hadfield, R. H. (2021) Analysis of excitability in resonant tunneling diode-photodetectors. Nanomaterials, 11, (doi: 10.3390/nano11061590)
Taufique, A., Rizwan, A., Imran, A., Arshad, K., Zoha, A., Abbasi, Q. H., Imran, M. A. (2021) Big data analytics for 5G networks: utilities, frameworks, challenges and opportunities. John Wiley & Sons Ltd
Kettle, J., Kumar, D. (2021) Biodegradable Zinc Oxide Thin Film Transistors.
Zhang, Q., Zhou, X., Li, Y., Yang, X., Abbasi, Q. H. (2021) Clinical recognition of sensory ataxia and cerebellar ataxia. Frontiers in Human Neuroscience, 15, (doi: 10.3389/fnhum.2021.639871)
Wagih, M. (2021) Comments on “A passive and wireless sensor based on RFID antenna for detecting mechanical deformation” IEEE Open Journal of Antennas and Propagation, 2, pp. 870. (doi: 10.1109/OJAP.2021.3099244)
Ahmed, F., Tamoor, T., Hassan, T., Shoaib, N., Alomainy, A., Abbasi, Q. H. (2021) Design and development of a multi-functional bi-anisotropic metasurface with ultra-wide out of band transmission. Scientific Reports, 11, (doi: 10.1038/s41598-021-03705-x)
Ali, S. M., Sovuthy, C., Noghanian, S., Ali, Z., Abbasi, Q. H., Imran, M. A., Saeidi, T., Socheatra, S. (2021) Design and evaluation of a flexible dual-band meander line monopole antenna for on- and off-body healthcare applications. Micromachines, 12, (doi: 10.3390/mi12050475)
Al-Taai, Q. R. A., Al-Khalidi, A., Wang, J., Romeira, B., Figueiredo, J., Wasige, E. (2021) Extremely low-power consumption nano-RTD photodetectors for future neuromorphic computing.
Abohmra, A., Alomainy, A., Kazim, J. U. R., Imran, M. A., Abbas, H., Abbasi, Q. H. (2021) Folded Terahertz Antenna based on MoS2 and Gold for Biomedical Imaging. (doi: 10.1109/APS/URSI47566.2021.9704512)
David, T., Amorim, G., Bagnis, D., Bristow, N., Selbach, S., Kettle, J. (2021) Forecasting OPV outdoor performance, degradation rates and diurnal performances via machine learning. (doi: 10.1109/PVSC45281.2020.9300859)
Karami, K., Taking, S., Dhongde, A., Ofiare, A., Al-Khalidi, A., Wasige, E. (2021) Heavily doped n++ GaN cap layer AlN/GaN metal oxide semiconductor high electron mobility transistor. International Journal of Nanoelectronics and Materials, 14, pp. 45-51.
Karami, K., Taking, S., Ofiare, A., Dhongde, A., Al-Khalidi, A., Wasige, E. (2021) High performance of n++GaN/AlN/GaN high electron mobility transistor.
Taha, A., Hopthrow, T., Wu, R., Adams, N., Brown, J., Zoha, A., Abbasi, Q. H.,, Imran, M. A., Krabicka, J. (2021) Identifying the lack of energy-conscious behaviour in clinical and non-clinical settings: an NHS case study. Electronics, 10, (doi: 10.3390/electronics10202468)
Jilani, S. F., Maskay, A., Alkaraki, S., Abbasi, Q. H., Alomainy, A. (2021) Miniaturized Meander-Line Dipole Antenna for Short-Range Wireless Communication Networks. (doi: 10.23919/EuCAP51087.2021.9411480)
Wagih, M., Weddell, A. S., Beeby, S. (2021) Powering E-Textiles Using a Single Thread Radio Frequency Energy Harvesting Rectenna. (doi: 10.3390/proceedings2021068016)
Zhao, J., Xu, Z., Law, M.-K., Heidari, H., Abdellatif, S. O., Imran, M. A., Ghannam, R. (2021) Simulation of crystalline silicon photovoltaic cells for wearable applications. IEEE Access, 9, pp. 20868-20877. (doi: 10.1109/ACCESS.2021.3050431)
(2021) Special Issue: Advanced Sensing Techniques for Intelligent Human Activity Recognition Using Machine Learning. Electronics,
Jooypa, H., Dideban, D., Heidari, H. (2021) Statistical strategies to capture correlation between overshooting effect and propagation delay time in nano-CMOS inverters. IEEE Access, 9, pp. 65340-65345. (doi: 10.1109/ACCESS.2021.3076202)
Shah, M., Cheema, H. M., Abbasi, Q. H. (2021) Substrate integrated waveguide antenna system for 5G in-band full duplex applications. Electronics, 10, (doi: 10.3390/electronics10202456)
Ghannam, R., Hussain, S., Hua, F., González, M. Á. C. (2021) Supporting team based learning using electronic laboratory notebooks: perspectives from transnational students. IEEE Access, 9, pp. 43241-43252. (doi: 10.1109/ACCESS.2021.3065611)
Nawaz, H., Tahir, A., Ahmed, N., Fayyaz, U. U., Mahmood, T., Jaleel, A., Gogate, M., Dashtipour, K., Masud, U., Abbasi, Q. (2021) Ultra-low-power, high accuracy 434 MHz indoor positioning system for smart homes leveraging machine learning models. Entropy, 23, (doi: 10.3390/e23111401)
2020
Li, Y., Fan, H., Feng, Q., Hu, Q., Hu, L., Chen, H., Heidari, H. (2020) A Fast Transient Response and High PSR Low Drop-Out Voltage Regulator. (doi: 10.1109/ICECS49266.2020.9294867)
Ghannam, R., Heidari, H., You, H., Yuan, M. (2020) An Efficient RF-DC Rectifier Design for RF Energy Harvesting Systems. (doi: 10.1109/ICECS49266.2020.9294836)
Zhao, J., Jiang, Y., Law, M.-K., Ghannam, R., Imran, M., Heidari, H. (2020) An Implantable Photovoltaic Energy Harvesting System With Skin Optical Analysis. (doi: 10.1109/ICECS49266.2020.9294875)
Li, J., Wang, Y., Shi, J., Heidari, H. (2020) Design and Implementation of Close-Loop Detection for Coupled Core Fluxgate Magnetic Sensors. (doi: 10.1109/ICECS49266.2020.9294782)
McGlynn, E., Das, R., Heidari, H. (2020) Encapsulated Magnetoelectric Composites for Wirelessly Powered Brain Implantable Devices. (doi: 10.1109/ICECS49266.2020.9294847)
Oo Htet, K., Moradi, F., Ghannam, R., Heidari, H. (2020) Energy-Efficient Start-Up Dickson Charge Pump for Batteryless Biomedical Implant Devices. (doi: 10.1109/ICECS49266.2020.9294827)
Lenard, K., Liang, X., Tanwear, A., Heidari, H. (2020) Eye Tracking Simulation for a Magnetic-Based Contact Lens System. (doi: 10.1109/ICECS49266.2020.9294969)
Tanwear, A., Paz, E., Böhnert, T., Ferreira, R., Heidari, H. (2020) Eyelid Gesture Control Using Wearable Tunnelling Magnetoresistance Sensors. (doi: 10.1109/ICECS49266.2020.9294878)
Liu, Y., Zuo, S., Liang, X., Heidari, H., Khanbareh, H., Ghannam, R. (2020) Gesture Recognition Wristband Device with Optimised Piezoelectric Energy Harvesters. (doi: 10.1109/ICECS49266.2020.9294809)
Zuo, S., Nazarpour, K., Heidari, H. (2020) High-Precision Biomagnetic Measurement System Based on Tunnel Magneto-Resistive Effect. (doi: 10.1109/ICECS49266.2020.9294789)
Xia, Y., Heidari, H., Fan, H., Ghannam, R. (2020) Hybrid Microenergy Harvesters for Smart Contact Lenses. (doi: 10.1109/ICECS49266.2020.9294884)
Liang, X., Tanwear, A., Liu, Y., Yuan, M., Ghannam, R., Vuckovic, A., Heidari, H. (2020) Live Demonstration: Gaze Following System for Noninvasively Testing Electronic Contact Lens. (doi: 10.1109/ICECS49266.2020.9294953)
Elattar, A.M., Khabiri, G., Khalil, A.S., Saber, M.R., Ghannam, R., Ammar, A.M., Khalil, M.M.H. (2020) Optimization of Key Parameters Towards High Performance Perovskite Solar Cells. (doi: 10.1109/ICECS49266.2020.9294855)
Galeote-Checa, G., Nabaei, V., Das, R., Heidari, H. (2020) Wirelessly Powered and Modular Flexible Implantable Device. (doi: 10.1109/ICECS49266.2020.9294856)
Paoloni, C., Basu, R., Billa, L. R., Rao, J. M., Letizia, R., Ni, Q., Wasige, E., Al-Khalidi, A., Wang, J., Morariu, R. (2020) Long‐range millimetre wave wireless links enabled by travelling wave tubes and resonant tunnelling diodes. IET Microwaves, Antennas and Propagation, 14, pp. 2110-2114. (doi: 10.1049/iet-map.2020.0084)
Imran, M. A., Zoha, A., Zhang, L., Abbasi, Q. H. (2020) Grand challenges in IoT and sensor networks. Frontiers in Communications and Networks, 1, (doi: 10.3389/frcmn.2020.619452)
Ghannam, R., Curia, G., Brante, G., Khosravi, S., Hua, F. (2020) Implantable and wearable neuroengineering education: a review of postgraduate programmes. IEEE Access, 8, pp. 212396-212408. (doi: 10.1109/ACCESS.2020.3040064)
Buchanan, W. J., Imran, M. A., Ur Rehman, M., Zhang, L., Abbasi, Q. H., Chrysoulas, C., Haynes, D., Pitropakis, N., Papadopoulos, P. (2020) Review and critical analysis of privacy-preserving infection tracking and contact tracing. Frontiers in Communications and Networks, 1, (doi: 10.3389/frcmn.2020.583376)
De Rossi, F., Barbé, J., Tanenbaum, D. M., Cinà, L., Castriotta, L. A., Stoichkov, V., Wei, Z., Tsoi, W. C., Kettle, J., Sadula, A., Chircop, J., Azzopardi, B., Xie, H., Di Carlo, A., Lira-Cantú, M., Katz, E. A., Watson, T. M., Brunetti, F. (2020) An interlaboratory study on the stability of all‐printable hole transport material–free perovskite solar cells. Energy Technology, 8, (doi: 10.1002/ente.202000134)
Shah, S. A., Tahir, A., Ahmad, J., Zahid, A., Parvez, H., Shah, S. Y., Ashleibta, A. M. A., Hasanali, A., Khattak, S., Abbasi, Q. H. (2020) Sensor fusion for identification of freezing of gait episodes using Wi-Fi and radar imaging. IEEE Sensors Journal, 20, pp. 14410-14422. (doi: 10.1109/JSEN.2020.3004767)
Karbalaei, M., Dideban, D., Heidari, H. (2020) A nano-FET structure comprised of inherent paralleled TFET and MOSFET with improved performance. Ain Shams Engineering Journal, 11, pp. 1105-1112. (doi: 10.1016/j.asej.2020.03.013)
Das, R., Heidari, H. (2020) Biointegrated implantable brain devices. Wiley-IEEE
Ghannam, R., Hao, Y., Liu, Y., Xiao, Y. (2020) Energy harvesting for wearable and portable devices. Wiley-IEEE
(2020) Engineering and Technology for Healthcare. (doi: 10.1002/9781119644316)
David, T. W., Anizelli, H., Jacobsson, T. J., Gray, C., Teahan, W., Kettle, J. (2020) Enhancing the stability of organic photovoltaics through machine learning. Nano Energy, 78, (doi: 10.1016/j.nanoen.2020.105342)
Yu, Z., Zahid, A., Ansari, S., Abbas, H., Abdulghani, A. M., Heidari, H., Imran, M. A., Abbasi, Q. H. (2020) Hardware-based Hopfield Neuromorphic computing for fall detection. Sensors, 20, (doi: 10.3390/s20247226)
Rizwan, A., Ozturk, M., Abu Ali, N., Zoha, A., Abbasi, Q. H., Imran, M. A. (2020) Machine learning for decision making in healthcare. Wiley-IEEE
Abbasi, Q. H., Abbas, H. T., Imran, M. A., Alomainy, A. (2020) Pervasive sensing: macro to nanoscale. Wiley-IEEE
Tanwear, A., Liang, X., Liu, Y., Vuckovic, A., Ghannam, R., Böhnert, T., Paz, E., Freitas, P. P., Ferreira, R., Heidari, H. (2020) Spintronic sensors based on magnetic tunnel junctions for wireless eye movement gesture control. IEEE Transactions on Biomedical Circuits and Systems, 14, pp. 1299-1310. (doi: 10.1109/TBCAS.2020.3027242)
Ahmeda, K., Ubochi, B., Alqaysi, M.H., Al-Khalidi, A., Wasige, E., Kalna, K. (2020) The role of SiN/GaN cap interface charge and GaN cap layer to achieve enhancement mode GaN MIS-HEMT operation. Microelectronics Reliability, 115, (doi: 10.1016/j.microrel.2020.113965)
Imran, M. A., Chattha, H. T., Kiourti, A., He, Y., Hashmi, R. M., Alam, M. Z., Alomainy, A., Abbasi, Q. H. (2020) IEEE Access Special Section: Antenna and Propagation for 5G and Beyond. IEEE Access, 8, pp. 207343-207351. (doi: 10.1109/ACCESS.2020.3037625)
Asad, S. M., Ansari, S., Öztürk, M., Dashtipour, K., Rais, R. N. B., Hussain, S., Abbasi, Q. H., Imran, M. A. (2020) Mobility management-based autonomous energy-aware framework using machine learning approach in dense mobile networks. Signals, 1, pp. 170-187. (doi: 10.3390/signals1020010)
Wagih, M., Weddell, A. S., Beeby, S. (2020) Meshed high-impedance matching network-free rectenna optimized for additive manufacturing. IEEE Open Journal of Antennas and Propagation, 1, pp. 615-626. (doi: 10.1109/ojap.2020.3038001)
Huang, H., Coote, T., Bristow, N., David, T. W., Kettle, J., Todeschini, G. (2020) Development of an Improved Computer Model for Organic Photovoltaic Cells. (doi: 10.1109/ICRERA49962.2020.9242779)
Yang, K., Bi, D., Deng, Y., Zhang, R., Ur Rahman, M. M., Ali, N. A., Imran, M. A., Jornet, J. M., Abbasi, Q. H., Alomainy, A. (2020) A comprehensive survey on hybrid communication in context of molecular communication and terahertz communication for body-centric nanonetworks. IEEE Transactions on Molecular, Biological and Multi-Scale Communications, 6, pp. 107-133. (doi: 10.1109/TMBMC.2020.3017146)
Wagih, M., Hilton, G. S., Weddell, A. S., Beeby, S. (2020) Broadband millimeter-wave textile-based flexible rectenna for wearable energy harvesting. IEEE Transactions on Microwave Theory and Techniques, 68, pp. 4960-4972. (doi: 10.1109/TMTT.2020.3018735)
Yu, Z., Machado, P., Zahid, A., Abdulghani, A. M., Dashtipour, K., Heidari, H., Imran, M. A., Abbasi, Q. H. (2020) Energy and performance trade-off optimization in heterogeneous computing via reinforcement learning. Electronics, 9, (doi: 10.3390/electronics9111812)
Salehirozveh, M., Dehghani, P., Zimmermann, M., Roy, V. A.L., Heidari, H. (2020) Graphene field effect transistor biosensors based on aptamer for amyloid-β detection. IEEE Sensors Journal, 20, pp. 12488 - 12494. (doi: 10.1109/JSEN.2020.3000583)
Vieira, D. H., Badiei, N., Evans, J. E., Alves, N., Kettle, J., Li, L. (2020) Improvement of the deep UV sensor performance of a β-Ga2O3 photodiode by coupling of two planar diodes. IEEE Transactions on Electron Devices, 67, pp. 4947-4952. (doi: 10.1109/TED.2020.3022341)
Aghaei, M., Kettle, J., Reinders, A.H.M.E. (2020) Reliability and Durability Research Activities of PV Modules, Components and Systems in Cost Action Pearl PV.
Murtaza, H., Iqbal, M. A., Abbasi, Q. H., Hussain, S., Xing, H., Imran, M. A. (2020) Correlation analysis of vital signs to monitor disease risks in ubiquitous healthcare system. EAI Endorsed Transactions on Industrial Networks and Intelligent Systems, 7, (doi: 10.4108/eai.18-5-2020.165676)
Bristow, N., Elliott, F., O'Mahony, J., Kartopu, G., Oklobia, O., Irvine, S., Kettle, J. (2020) Development of a Wireless Sensor Node for Building Information Management Systems. (doi: 10.1109/WF-IoT48130.2020.9221255)
McGlynn, E., Das, R., Nabaei, V., Heidari, H. (2020) Polymer-based Implantable Neural Probe Nanofabrication.
Al Ayidh, A., Chang, B., Zhao, G., Ghannam, R., Imran, M. A. (2020) Energy-Efficient Power Allocation in URLLC Enabled Wireless Control for Factory Automation Applications. (doi: 10.1109/PIMRC48278.2020.9217133)
Taylor, W., Abbasi, Q. H., Dashtipour, K., Ansari, S., Shah, S. A., Khalid, A., Imran, M. A. (2020) A review on the state-of-the-art in non-contact sensing for COVID-19. Sensors, 20, (doi: 10.3390/s20195665)
Wagih, M., Weddell, A. S., Beeby, S. (2020) Millimeter-wave power harvesting: a review. IEEE Open Journal of Antennas and Propagation, 1, pp. 560-578. (doi: 10.1109/OJAP.2020.3028220)
Mollel, M. S., Abubakar, A. I., Ozturk, M., Kaijage, S., Kisangiri, M., Zoha, A., Imran, M. A., Abbasi, Q. H. (2020) Intelligent handover decision scheme using double deep reinforcement learning. Physical Communication, 42, (doi: 10.1016/j.phycom.2020.101133)
Bilal, M., Saleem, R., Abbasi, Q. H., Kasi, B., Shafique, M. F. (2020) Miniaturized and flexible FSS-based EM shields for conformal applications. Transactions on Electromagnetic Compatibility, 62, pp. 1703-1710. (doi: 10.1109/TEMC.2019.2961891)
Wagih, M., Weddell, A. S., Beeby, S. (2020) Rectennas for radio-frequency energy harvesting and wireless power transfer: a review of antenna design [antenna applications corner] IEEE Antennas and Propagation Magazine, 62, pp. 95-107. (doi: 10.1109/MAP.2020.3012872)
Zuo, S., Schmalz, J., Özden, M.-Ö., Gerken, M., Su, J., Niekiel, F., Lofink, F., Nazarpour, K., Heidari, H. (2020) Ultrasensitive magnetoelectric sensing system for pico-Tesla MagnetoMyoGraphy. IEEE Transactions on Biomedical Circuits and Systems, 14, pp. 971-984. (doi: 10.1109/TBCAS.2020.2998290)
Khan, M. B., Zhang, Z., Li, L., Zhao, W., Al Hababi, M. A. M., Yang, X., Abbasi, Q. H. (2020) A systematic review of non-contact sensing for developing a platform to contain COVID-19. Micromachines, 11, (doi: 10.3390/mi11100912)
Fazilah, A. F. M., Jusoh, M., Sabapathy, T., Abbasi, Q., Rahim, H. A., Yasin, M. N. M., Kamarudin, R., Majid, H. A., Soh, P. J. (2020) A Flexible and Compact Metamaterial UHF RFID Tag for Remote Sensing in Human Health. (doi: 10.1109/UCET51115.2020.9205380)
Zhao, Z., Farage, M. E., Yi, Y., Li, C. (2020) A Quasi-optical THz Imaging System Using a One-port Vector Network Analyser. (doi: 10.1109/UCET51115.2020.9205425)
Kazim, J. U. R., Ur-Rehman, M., Al-Hasan, M., Mabrouk, I. B., Imran, M. A., Abbasi, Q. H. (2020) Design of 1-Bit Digital Subwavelength Metasurface Element for Sub-6 GHz Applications. (doi: 10.1109/UCET51115.2020.9205382)
Hossain, K., Sabapathy, T., Jusoh, M., Soh, P. J., Raghava, N.S., Podilchak, S. K., Schreurs, D., Abbasi, Q. H. (2020) ENG and NZRI Characteristics of Decagonal- Shaped Metamaterial for Wearable Applications. (doi: 10.1109/UCET51115.2020.9205409)
Omeke, K. G., Mollel, M. S., Zhang, L., Abbasi, Q. H., Imran, M. A. (2020) Energy Optimisation Through Path Selection for Underwater Wireless Sensor Networks. (doi: 10.1109/UCET51115.2020.9205429)
Wu, S., Abdul Ghani, A. M., Ansari, S., Imran, M. A., Abbasi, Q. H. (2020) IoT Enabled Smart Lighting System Using STM32 Microcontroller with High Performance ARM® Cortex®-M3 Core. (doi: 10.1109/UCET51115.2020.9205363)
Jilani, S. F., Abbasi, Q. H., Alomainy, A. (2020) Millimetre-Wave MIMO Array of a Compact Grid Antenna for 5G Wireless Networks and Beyond. (doi: 10.1109/UCET51115.2020.9205326)
Mahmood, A., Aman, W., Ur Rahman, M. M., Imran, M.A., Abbasi, Q. H. (2020) Preventing Identity Attacks in RFID Backscatter Communication Systems: a Physical-Layer Approach. (doi: 10.1109/UCET51115.2020.9205427)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2020) Sensor Aided Beamforming in Vehicular Environment. (doi: 10.1109/UCET51115.2020.9205411)
Xia, Y., Heidari, H., Ghannam, R. (2020) Smart Wristband for Gesture Recognition. (doi: 10.1109/UCET51115.2020.9205426)
Asad, S. M., Dashtipour, K., Hussain, S., Abbasi, Q. H., Imran, M. A. (2020) Travelers-Tracing and Mobility Profiling Using Machine Learning in Railway Systems. (doi: 10.1109/UCET51115.2020.9205456)
Miao, L., Guo, X., Abbas, H. T., Qaraqe, K. A., Abbasi, Q. H. (2020) Using Machine Learning to Predict the Future Development of Disease. (doi: 10.1109/UCET51115.2020.9205373)
Liang, X., Fan, H., Mercer, J., Heidari, H. (2020) A Delay-Based Neuromorphic Processor for Arrhythmias Detection. (doi: 10.1109/ISCAS45731.2020.9181032)
Fan, H., Zhang, J., Li, Y., Feng, Q., Fang, K., Wen, H., Lin, L., Qi, X., Diao, X., Bonizzoni, E., Maloberti, F., Ghannam, R., Heidari, H. (2020) Innovative Engineering Education in Circuits and Systems. (doi: 10.1109/ISCAS45731.2020.9180649)
Nabaei, V., Panuccio, G., Heidari, H. (2020) Neural Microprobe Device Modelling for Implant Micromotions Failure Mitigation. (doi: 10.1109/ISCAS45731.2020.9180497)
Ali, S. M., Sovuthy, C., Imran, M. A., Socheatra, S., Abbasi, Q. H., Abidin, Z. Z. (2020) Recent advances of wearable antennas in materials, fabrication methods, designs, and their applications: state-of-the-art. Micromachines, 11, (doi: 10.3390/mi11100888)
Menéndez, M.F., Martinez, A., Sánchez, P., Gomez, D., Andrés, L.J., Haponow, L., Bristow, N., Kettle, J., Korochkina, T., Gethin, D.T. (2020) Development of intermediate layer systems for direct deposition of thin film solar cells onto low cost steel substrates. Solar Energy, 208, pp. 738-746. (doi: 10.1016/j.solener.2020.08.046)
Ghannam, R., Allan, W., Roy, S. (2020) Exam Setting and Moderation in a Transnational Engineering Programme. (doi: 10.1109/TREET50959.2020.9189755)
Ghannam, R., Ansari, I. S. (2020) Interactive Tree Map For Visualising Transnational Engineering Curricula. (doi: 10.1109/TREET50959.2020.9189750)
Abdelaty, A. A. R., Hanna, A. R. N., Fahim, M. M. K., Elsharkawy, H. M., Ghannam, R., Khalil, A. S. G. (2020) Solar Thermal Collector Education Using Polysun Simulations Software. (doi: 10.1109/TREET50959.2020.9189749)
Xeni, N., Ghannam, R., Georgiev, V., Adamu-Lema, F., Badami, O., Asenov, A. (2020) The Use of TCAD Simulations in Semiconductor Devices Teaching. (doi: 10.1109/TREET50959.2020.9189752)
Ghannam, R., Curia, G., Brante, G., Fan, H., Heidari, H. (2020) Wearable Electronics for Neurological Applications: a Review of Undergraduate Engineering Programmes. (doi: 10.1109/TREET50959.2020.9189753)
Ge, Y., Ansari, S., Abdulghani, A., Imran, M. A., Abbasi, Q. (2020) Intelligent Instruction-Based IoT Framework for Smart Home Applications using Speech Recognition. (doi: 10.1109/SmartIoT49966.2020.00037)
Xu, Z., Ansari, S., Abdulghani, A. M., Imran, M. A., Abbasi, Q. (2020) IoT Enabled Smart Security Framework for 3D Printed Smart Home. (doi: 10.1109/SmartIoT49966.2020.00026)
Ilyas, M., Bayat, O., Ucan, O. N., Imran, M. A., Abbasi, Q. (2020) Location Dependent Channel Characteristics for Implantable Devices. (doi: 10.1109/AECT47998.2020.9194165)
Zhao, J., Ghannam, R., Htet, K. O., Liu, Y., Law, M.-k., Roy, V. A.L., Imran, M. A., Michel, B., Heidari, H. (2020) Self-powered implantable medical devices: photovoltaic energy harvesting review. Advanced Healthcare Materials, 9, (doi: 10.1002/adhm.202000779)
Azargoshasb, T., Navid, H. A., Parvizi, R., Heidari, H. (2020) Evanescent wave optical trapping and sensing on polymer optical fibers for ultra-trace detection of glucose. ACS Omega, 5, pp. 22046-22056. (doi: 10.1021/acsomega.0c01908)
Fan, H., Li, S., Cen, Y., Feng, Q., Heidari, H. (2020) A Horizontal Hall Sensor 3D COMSOL Model. (doi: 10.1109/MWSCAS48704.2020.9184586)
Melino, G., Accarino, C., Riehle, M., Potter, M., Fineron, P., Annese, V. F., Grant, J. P., Al-Rawhani, M., Beeley, J., Escorcia Carranza, I., Cumming, D. R.S. (2020) Capsule endoscopy compatible fluorescence imager demonstrated using bowel cancer tumours. IEEE Sensors Journal, 20, pp. 9763-9771. (doi: 10.1109/JSEN.2020.2990293)
Fan, H., Li, S., Nabaei, V., Feng, Q., Heidari, H. (2020) Modelling of three-axis Hall effect sensors based on integrated magnetic concentrator. IEEE Sensors Journal, 20, pp. 9919-9927. (doi: 10.1109/JSEN.2020.2989325)
(2020) Antennas and Propagation for 5G and Beyond.
Hu, C., Annese, V., Velugotla, S., Al-Rawhani, M. A., Cheah, B. C., Grant, J., Barrett, M. P., Cumming, D. R.S. (2020) Disposable paper-on-CMOS platform for real-time simultaneous detection of metabolites. IEEE Transactions on Biomedical Engineering, 67, pp. 2417-2426. (doi: 10.1109/TBME.2019.2962239)
Ghannam, R. (2020) Do you call that a lab notebook? IEEE Potentials, 39, pp. 21-24. (doi: 10.1109/MPOT.2020.2968798)
Li, H., Liang, X., Shrestha, A., Liu, Y., Heidari, H., Le Kernec, J., Fioranelli, F. (2020) Hierarchical sensor fusion for micro-gestures recognition with pressure sensor array and radar. IEEE Journal of Electromagnetics, RF and Microwaves in Medicine and Biology, 4, pp. 225-232. (doi: 10.1109/JERM.2019.2949456)
Samipour, A., Dideban, D., Heidari, H. (2020) Impact of substitutional metallic dopants on the physical and electronic properties of germanene nanoribbons: a first principles study. Results in Physics, 18, (doi: 10.1016/j.rinp.2020.103333)
Karbalaei, M., Dideban, D., Heidari, H. (2020) Influence of high-K insulator and source stack on the performance of a double gate tunnel FET: a simulation study. Journal of Computational Electronics, 19, pp. 1077-1084. (doi: 10.1007/s10825-020-01497-3)
Mezher, M., Ilyas, M., Bayat, O., Abbasi, Q. H. (2020) Bit Error Rate Performance of In-vivo Radio Channel Using Maximum Likelihood Sequence Estimation. (doi: 10.1109/ICECCE49384.2020.9179248)
Abohmra, A., Abbas, H., Al-Hasan, M., Mabrouk, I. B., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2020) Terahertz antenna array based on a hybrid perovskite structure. IEEE Open Journal of Antennas and Propagation, 1, pp. 464-471. (doi: 10.1109/OJAP.2020.3020239)
Zuo, S., Nazarpour, K., Böhnert, T., Paz, E., Freitas, P., Ferreira, R., Heidari, H. (2020) Integrated Pico-Tesla Resolution Magnetoresistive Sensors for Miniaturised Magnetomyography. (doi: 10.1109/EMBC44109.2020.9176266)
Hussain, S., Abbasi, Q. H., Soler, L., Watts, C., Yao, E., Imran, M. (2020) Customised Student Learning.
Linardopoulou, K., Viora, L., Abbasi, Q. H., Fioranelli, F., Le Kernec, J., Jonsson, N. (2020) Lameness Detection in Dairy Cows: Evaluation of the Agreement and Repeatability of Mobility Scoring.
Kazim, J. U. R., Ur-Rehman, M., Abohmra, A., Sheikh, F., Kaiser, T., Al-Hasan, M., Mabrouk, I. B., Imran, M. A., Abbasi, Q. H. (2020) A 1-bit High-Gain Flexible Metasurface Reflectarray for Terahertz Application. (doi: 10.1109/IWMTS49292.2020.9166152)
Jameel, F., Khan, W. U., Jamshed, M. A., Pervaiz, H., Abbasi, Q., Jantti, R. (2020) Reinforcement Learning for Scalable and Reliable Power Allocation in SDN-based Backscatter Heterogeneous Network. (doi: 10.1109/INFOCOMWKSHPS50562.2020.9162720)
Wu, A., Liu, C., Liang, F., Zou, X., Wang, Y., Luan, P., Li, C. (2020) Calibration on the fly—a novel two-port S-parameter measurement method for on-wafer leaky systems. IEEE Transactions on Microwave Theory and Techniques, 68, pp. 3558-3564. (doi: 10.1109/TMTT.2020.2988461)
Ashleibta, A. M., Zahid, A., Shah, S. A., Abbasi, Q. H., Imran, M. A. (2020) Flexible and scalable software defined radio based testbed for large scale body movement. Electronics, 9, (doi: 10.3390/electronics9091354)
Wagih, M., Weddell, A. S., Beeby, S. (2020) High-Efficiency Sub-1 GHz Flexible Compact Rectenna based on Parametric Antenna-Rectifier Co-Design. (doi: 10.1109/IMS30576.2020.9223796)
Wagih, M., Hillier, N., Yong, S., Weddell, A. S., Beeby, S. (2020) Wearable E-Textile Wireless RF Power Supply Based on a Textile Supercapacitor and a Flexible Rectenna Filament. (doi: 10.1109/FLEPS49123.2020.9239429)
Wagih, M., Komolafe, A., Zaghari, B. (2020) Wearable Wireless Power Transfer Using Direct-Write Dispenser Printed Flexible Coils. (doi: 10.1109/FLEPS49123.2020.9239595)
Wagih, M., Cetinkaya, O., Zaghari, B., Weddell, A. S., Beeby, S. (2020) Real-world performance of sub-1 GHz and 2.4 GHz textile antennas for RF-powered body area networks. IEEE Access, 8, pp. 133746-133756. (doi: 10.1109/ACCESS.2020.3011603)
Li, C., Wu, A., Liu, C., Liang, F., Wang, Y., Luan, P. (2020) A “Calibration on the Fly” Method for Millimeter-wave On-wafer Measurement.
Fraser, J. P., Masaityte, L., Zhang, J., Laing, S., Moreno-Lopez, J. C., McKenzie, A. F., McGlynn, J. C., Panchal, V., Graham, D., Kazakova, O., Pichler, T., MacLaren, D., Moran, D. A.J., Ganin, A. Y. (2020) Selective phase growth and precise-layer control in MoTe2. Communications Materials, 1, (doi: 10.1038/s43246-020-00048-4)
Iqbal, M. A., Abbas, H. T., Ahmad, W., Ur Rehman, M., Hussain, S., Bremner, D. (2020) Assessment of Computer Networks During the Pandemic and Beyond.
Mollel, M. S., Kaijage, S. F., Kisangiri, M., Imran, M., Abbasi, Q. H. (2020) Multi-User Position based on Trajectories-Aware Handover Strategy for Base Station Selection with Multi-Agent Learning. (doi: 10.1109/ICCWorkshops49005.2020.9145184)
Abbasi, Q., Hussain, S. (2020) Teaching Continuity of Electrical and Computer Engineering Courses under Covid-19 Pandemic.
Wagih, M. (2020) Direct-Write Dispenser Printing for Rapid Antenna Prototyping on Thin Flexible Substrates. (doi: 10.23919/EuCAP48036.2020.9135625)
Wagih, M., Weddell, A. S., Beeby, S. (2020) Sub-1 GHz Flexible Concealed Rectenna Yarn for High-Efficiency Wireless-Powered Electronic Textiles. (doi: 10.23919/EuCAP48036.2020.9136041)
Taylor, W., Ashleibta, A. M. A., Shah, S. A., Imran, M., Abbasi, Q. (2020) Software Defined Radio Based Activity Recognition for Remote Healthcare Driven by Machine Learning.
Khan, J. S., Tahir, A., Ahmad, J., Shah, S. A., Abbasi, Q. H., Russell, G., Buchanan, W. (2020) 5G-FOG: Freezing of Gait Identification in Multi-Class Softmax Neural Network Exploiting 5G Spectrum. (doi: 10.1007/978-3-030-52243-8_3)
Ghannam, R., Ahmad, W. (2020) Teaching teamwork to transnational students in engineering and technology. Compass, 13, (doi: 10.21100/compass.v13i2.1040)
Kumar, D., Gomes, T. C., Alves, N., Fugikawa-Santos, L., Smith, G. C., Kettle, J. (2020) UV phototransistors-based upon spray coated and sputter deposited ZnO TFTs. IEEE Sensors Journal, 20, pp. 7532-7539. (doi: 10.1109/JSEN.2020.2983418)
Shah, Y. D., Connolly, P. W.R., Grant, J. P., Hao, D., Accarino, C., Ren, X., Kenney, M., Annese, V., Rew, K. G., Greener, Z. M., Altmann, Y., Faccio, D., Buller, G. S., Cumming, D. R.S. (2020) Ultralow-light-level color image reconstruction using high-efficiency plasmonic metasurface mosaic filters. Optica, 7, pp. 632-639. (doi: 10.1364/OPTICA.389905)
Lia, D., Lia, Z., Li, W., Fan, H., Wang, C., Che, H., Zeng, X., Feng, Q., Heidari, H. (2020) An implementation of hot-swap circuit with high reliability. Microelectronics Journal, 100, (doi: 10.1016/j.mejo.2020.104777)
Anizelli, H., David, T. W., Tyagi, P., Laureto, E., Kettle, J. (2020) Enhancing the stability of perovskite solar cells through functionalisation of metal oxide transport layers with self-assembled monolayers. Solar Energy, 203, pp. 157-163. (doi: 10.1016/j.solener.2020.04.035)
Zuo, S., Heidari, H., Farina, D., Nazarpour, K. (2020) Miniaturized magnetic sensors for implantable magnetomyography. Advanced Materials Technologies, 5, (doi: 10.1002/admt.202000185)
Wu, A., Fu, X., Liu, C., Li, C., Wang, Y., Liang, F., Luan, P. (2020) Optimal design of passive devices for verifying on-wafer noise parameter measurement systems. IEEE Transactions on Instrumentation and Measurement, 69, pp. 2837-2844. (doi: 10.1109/TIM.2019.2929671)
Zhao, J., Ghannam, R., Law, M. K., Imran, M. A., Heidari, H. (2020) Photovoltaic power harvesting technologies in biomedical implantable devices considering the optimal location. IEEE Journal of Electromagnetics, RF and Microwaves in Medicine and Biology, 4, pp. 148-155. (doi: 10.1109/JERM.2019.2937970)
Wagih, M., Wei, Y., Komolafe, A., Torah, R., Beeby, S. (2020) Reliable UHF long-range textile-integrated RFID tag based on a compact flexible antenna filament. Sensors, 20, (doi: 10.3390/s20123435)
García Núñez, C., Braña, A. F., López, N., Pau, J. L., García, B. J. (2020) Single GaAs nanowire based photodetector fabricated by dielectrophoresis. Nanotechnology, 31, (doi: 10.1088/1361-6528/ab76ee)
Imran, M. A., Ozturk, M., Abubakar, A. I., Klaine, P. V., Hussain, S., Abbasi, Q. H. (2020) Mobility prediction based resource management. John Wiley & sons Ltd
Imran, M. A., Turkmen, A., Ozturk, M., Nadas, J., Abbasi, Q. H. (2020) Seamless indoor/outdoor coverage in 5G. Wiley
Sharif, A., Guo, J., Ouyang, J., Arshad, K., Imran, M. A., Abbasi, Q. H. (2020) Ultra-wideband Sensor Antenna Design for 5G/UWB Based Real Time Location Systems. (doi: 10.1109/iWAT48004.2020.1570618250)
Rizwan, A., Ali, N. A., Zoha, A., Ozturk, M., Alomaniy, A., Imran, M. A., Abbasi, Q. H. (2020) Non-invasive hydration level estimation in human body using Galvanic Skin Response. IEEE Sensors Journal, 20, pp. 4891-4900. (doi: 10.1109/JSEN.2020.2965892)
Taylor, W., Shah, S. A., Dashtipour, K., Zahid, A., Abbasi, Q. H., Imran, M. A. (2020) An intelligent non-invasive real time human activity recognition system for next-generation healthcare. Sensors, 20, (doi: 10.3390/s20092653)
Asad, S. M., Ahmad, J., Hussain, S., Zoha, A., Abbasi, Q. H., Imran, M. A. (2020) Mobility prediction-based optimisation and encryption of passenger traffic-flows using machine learning. Sensors, 20, (doi: 10.3390/s20092629)
Wagih, M., Weddell, A. S., Beeby, S. (2020) Characterizing and Modelling Non-Linear Rectifiers for RF Energy Harvesting. (doi: 10.1109/PowerMEMS49317.2019.82063202439)
Wagih, M., Komolafe, A. O., Zaghari, B. (2020) Position Independent Wearable 6.78 MHz Near-Field Radiative Wireless Power Transfer using Electrically-Small Embroidered Textile Coils. (doi: 10.1109/PowerMEMS49317.2019.51289502905)
Dong, Z., Abdulghani, A. M., Imran, M. A., Abbasi, Q. H. (2020) Artificial Intelligence enabled Smart Refrigeration Management System using Internet of Things Framework. (doi: 10.1145/3398329.3398338)
Sun, J., Abdulghani, A. M., Imran, M. A., Abbasi, Q. H. (2020) IoT Enabled Smart Fertilization and Irrigation Aid for Agricultural Purposes. (doi: 10.1145/3398329.3398339)
Vosti, H., Stant, L. T., Matei, C., Salter, M. J., Li, C., Ridler, N. M., Aaen, P. H. (2020) An Interferometric Characterization Technique for Extreme Impedance Microwave Devices. (doi: 10.1109/ARFTG47584.2020.9071748)
Dideban, D., Karbalaei, M., Moezi, N., Heidari, H. (2020) Improvement of a nano-scale silicon on insulator field effect transistor performance using electrode, doping and buried oxide engineering. Journal of Nanostructures, 10, pp. 317-326. (doi: 10.22052/JNS.2020.02.011)
Fan, H., Mao, J., Feng, Q., Qi, X., Li, D., Feng, L., Hu, D., Diao, X., Ghannam, R., Heidari, H. (2020) The Design of Intelligent Sensor Interface Circuit Based on 1451.2. (doi: 10.1109/BICOP48819.2019.9059585)
Nabaei, V., Panuccio, G., Heidari, H. (2020) Computational Modelling of Brain Implantable Microprobes for Diminishing Micromotions Failure.
McGlynn, E., Das, R., Nabaei, V., Heidari, H. (2020) Polymer-based Flexible Implantable Neural Probe for Epilepsy Treatment.
Wagih, M., Weddell, A. S., Beeby, S. (2020) Millimeter-Wave Textile Antenna for On-Body RF Energy Harvesting in Future 5G Networks. (doi: 10.1109/wptc45513.2019.9055541)
Dalal Hammood, A., Rahim, H. A., Alkhayyat, A., Ahmad, B. R., Jusoh, M., Abbasi, Q. H. (2020) Non-Cooperative Game Theory Approach for Cognitive Cooperative Communication in WBAN. (doi: 10.1109/ICSIMA47653.2019.9057305)
Das, R., Moradi, F., Heidari, H. (2020) Biointegrated and wirelessly powered implantable brain devices: a review. IEEE Transactions on Biomedical Circuits and Systems, 14, pp. 343-358. (doi: 10.1109/TBCAS.2020.2966920)
Yuan, M., Das, R., Ghannam, R., Wang, Y., Reboud, J., Fromme, R., Moradi, F., Heidari, H. (2020) Electronic contact lens: a platform for wireless health monitoring applications. Advanced Intelligent Systems, 2, (doi: 10.1002/aisy.201900190)
Shah, S. A., Ahmad, J., Tahir, A., Ahmed, F., Russel, G., Shah, S. Y., Buchanan, W., Abbasi, Q. H. (2020) Privacy-preserving non-wearable occupancy monitoring system exploiting Wi-Fi imaging for next-generation body centric communication. Micromachines, 11, (doi: 10.3390/mi11040379)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. A. (2020) A wideband beamforming antenna array for 802.11ac and 4.9 GHz in modern transportation market. IEEE Transactions on Vehicular Technology, 69, pp. 2659-2670. (doi: 10.1109/TVT.2019.2963111)
Baidoo-Williams, H. E., Ur Rahman, M. M., Abbasi, Q. H. (2020) Channel impulse response-based source localization in a diffusion-based molecular communication system. Internet Technology Letters, 3, (doi: 10.1002/itl2.143)
Samipour, A., Dideban, D., Heidari, H. (2020) Impact of an antidote vacancy on the electronic and transport properties of germanene nanoribbons: A first principles study. Journal of Physics and Chemistry of Solids, 138, (doi: 10.1016/j.jpcs.2019.109289)
Karbalaei, M., Dideban, D., Heidari, H. (2020) Impact of high-k gate dielectric with different angles of coverage on the electrical characteristics of gate-all-around field effect transistor: a simulation study. Results in Physics, 16, (doi: 10.1016/j.rinp.2019.102823)
Al-Khalidi, A., Alharbi, K. H., Wang, J., Morariu, R., Wang, L., Khalid, A., Figueiredo, J., Wasige, E. (2020) Resonant tunnelling diode terahertz sources with up to 1 mW output power in the J-band. IEEE Transactions on Terahertz Science and Technology, 10, pp. 150-157. (doi: 10.1109/TTHZ.2019.2959210)
(2020) Wearable Wireless Devices. (doi: 10.3390/books978-3-03928-443-6)
Yuan, M., Zhao, J., Das, R., Ghannam, R., Abbasi, Q. H., Assaad, M., Heidari, H. (2020) Magnetic Resonance-based Wireless Power Transfer for Implantable Biomedical Microelectronics Devices. (doi: 10.1109/ISSPIT47144.2019.9001857)
Imran, M. A., Al Ayidh, A., Li, L., Zhao, G., Abbasi, Q. H. (2020) URLLC massive MIMO link operation design for wireless networked control system. John Wiley & sons Ltd
Ren, A., Zahid, A., Zoha, A., Shah, S. A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2020) Machine learning driven approach towards the quality assessment of fresh fruits using non-invasive sensing. IEEE Sensors Journal, 20, pp. 2075-2083. (doi: 10.1109/JSEN.2019.2949528)
Hussain, S., Abbasi, Q. H., Ghannam, R., Ur Rehman, M., Imran, M. (2020) Tutorials as a Tool for Enhancement in Assessment and Feedback through Student Partnership.
Wagih, M., Komolafe, A., Zaghari, B. (2020) Dual-receiver wearable 6.78 MHz resonant inductive wireless power transfer glove using embroidered textile coils. IEEE Access, 8, pp. 24630-24642. (doi: 10.1109/ACCESS.2020.2971086)
Li, H., Shrestha, A., Heidari, H., Le Kernec, J., Fioranelli, F. (2020) Bi-LSTM network for multimodal continuous human activity recognition and fall detection. IEEE Sensors Journal, 20, pp. 1191-1201. (doi: 10.1109/JSEN.2019.2946095)
Kafi, M. A., Aktar, M. K., Heidari, H. (2020) Mammalian cell based electrochemical sensor for label free monitoring of analytes. Wiley-IEEE Press
Al-Rawhani, M. A., Hu, C., Giagkoulovits, C., Annese, V. F., Cheah, B. C., Beeley, J., Velugotla, S., Accarino, C., Grant, J. P., Mitra, S., Barrett, M. P., Cochran, S., Cumming, D. R.S. (2020) Multimodal integrated sensor platform for rapid biomarker detection. IEEE Transactions on Biomedical Engineering, 67, pp. 614-623. (doi: 10.1109/TBME.2019.2919192)
Accarino, C., Annese, V. F., Cheah, B. C., Al-Rawhani, M. A., Shah, Y. D., Beeley, J., Giagkoulovits, C., Mitra, S., Cumming, D. R.S. (2020) Noise characteristics with CMOS sensor array scaling. Measurement, 152, (doi: 10.1016/j.measurement.2019.107325)
Wagih, M., Komolafe, A., Zaghari, B. (2020) Separation-independent wearable 6.78 MHz near-field radiative wireless power transfer using electrically small embroidered textile coils. Energies, 13, (doi: 10.3390/en13030528)
(2020) Smart Sensors for Environmental and Medical Applications.
Das, R., Heidari, H. (2020) A Self-tracked High-dielectric Wireless Power Transfer System for Neural Implants. (doi: 10.1109/ICECS46596.2019.8964953)
Galeote-Checa, G., Uke, K., Sohail, L., Das, R., Heidari, H. (2020) Flexible Wirelessly Powered Implantable Device. (doi: 10.1109/ICECS46596.2019.8964995)
Wang, W., Liang, X., Assaad, M., Heidari, H. (2020) Wearable Wristworn Gesture Recognition Using Echo State Network. (doi: 10.1109/ICECS46596.2019.8965219)
Aljihmani, L., Abbas, H., Mansoor, B., Hijazi, Z., Abbasi, Q., Qaraqe, K. (2020) In Situ Remote Monitoring of Novel Biodegradable Cardiovascular Stents - Design and Validation.
Khenkin, M. V. et al. (2020) Consensus statement for stability assessment and reporting for perovskite photovoltaics based on ISOS procedures. Nature Energy, 5, pp. 35-49. (doi: 10.1038/s41560-019-0529-5)
Yang, X., Fan, D., Ren, A., Zhao, N., Shah, S. A., Alomainy, A., Ur-Rehman, M., Abbasi, Q. H. (2020) Diagnosis of the Hypopnea syndrome in the early stage. Neural Computing and Applications, 32, pp. 855-866. (doi: 10.1007/s00521-019-04037-8)
Alimi, Y., Pusino, V., Steer, M. J., Cumming, D.R.S. (2020) InSb avalanche photodiodes on GaAs substrates for mid-infrared detection. IEEE Transactions on Electron Devices, 67, pp. 179-184. (doi: 10.1109/TED.2019.2956283)
Mohamed, A., Schmid, M., Tanwear, A., Heidari, H., Anders, J. (2020) A Low Noise CMOS Sensor Frontend for a TMR-based Biosensing Platform. (doi: 10.1109/SENSORS47125.2020.9278826)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2020) A Recursive Calibration Approach for Smart Antenna Beamforming Frontend. (doi: 10.23919/EuCAP48036.2020.9135881)
Usman, M., Qaraqe, M., Asghar, M. R., Gebremariam, A. A., Ansari, I. S., Granelli, F., Abbasi, Q. H. (2020) A business and legislative perspective of V2X and mobility applications in 5G networks. IEEE Access, 8, pp. 67426-67435. (doi: 10.1109/ACCESS.2020.2986129)
Dai, S., Li, M., Abbasi, Q. H., Imran, M. A. (2020) A zero placement algorithm for synthesis of flat top beam pattern with low sidelobe level. IEEE Access, 8, pp. 225935-225944. (doi: 10.1109/ACCESS.2020.3045287)
Yu, Z., Abdulghani, A. M., Zahid, A., Heidari, H., Imran, M. A., Abbasi, Q. H. (2020) An overview of neuromorphic computing for artificial intelligence enabled hardware-based hopfield neural network. IEEE Access, 8, pp. 67085-67099. (doi: 10.1109/ACCESS.2020.2985839)
Zahid, A., Abbas, H. T., Escorcia Carranza, I., Grant, J., Imran, M. A., Cumming, D., Abbasi, Q. H. (2020) Assessing the Salt Constituents Characteristics in Aqueous Solutions Using Terahertz Waves. (doi: 10.1109/IEEECONF35879.2020.9329818)
Ur Rehman, M., Hussain, S., Ansari, I., Abdulghani, A. M., Centeno, A., Abbas, H., Heidari, H., Hong, Y., Ponciano, J., Abbasi, Q. H., Qadir, J., Imran, M. A. (2020) Assessment and Feedback Under Disruptive Circumstances in Trans-National Education. (doi: 10.1109/TALE48869.2020.9368427)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. A. (2020) Design and characterization of T/R module for commercial beamforming applications. IEEE Access, 8, pp. 130252-130262. (doi: 10.1109/ACCESS.2020.3009531)
Cen, Y., Feng, W., Yang, P., Fan, H., Li, Y., Niu, Y., Liao, Z., Qi, X., Wang, B., Ran, Y., Li, W., Feng, Q., Heidari, H. (2020) Design of capacitor array in 16-bit ultra high precision SAR ADC for the wearable electronics application. IEEE Access, 8, pp. 175230-175243. (doi: 10.1109/ACCESS.2020.3024807)
Abbasi, M. A. B., Abbasi, Q. H. (2020) Development challenges of millimetre-wave 5G beamformers. John Wiley & Sons Ltd
Muhammad, M., Li, M., Abbasi, Q. H., Goh, C., Imran, M. (2020) Direction of Arrival Estimation Using Hybrid Spatial Cross-Cumulants and Root-MUSIC. (doi: 10.23919/EuCAP48036.2020.9135813)
Vieira, D. H., Badiei, N., Evans, J. E., Alves, N., Kettle, J., Li, L. (2020) Electrical Characterisation of β-Ga2O3 Schottky Diode for Deep UV Sensor Applications. (doi: 10.1109/SENSORS47125.2020.9278829)
Rizwan, A., Ali, N.A., Zoha, A., Alomainy, A., Imran, M.A., Abbasi, Q.H. (2020) Galvanic Skin Response Based Non-invasive Method of Hydration Level Estimation in Human Body.
Abdul-Aziz, M. R.R., Hassan, A., Abdel-Aty, A. A.R., Saber, R., Ghannam, R., Anis, B., Heidari, H., Khalil, A. S.G. (2020) High performance supercapacitor based on laser induced graphene for wearable devices. IEEE Access, 8, pp. 200573-200580. (doi: 10.1109/ACCESS.2020.3035828)
Fan, H., Cheng, W., Feng, Q., Feng, L., Li, D., Diao, X., Cen, Y., Heidari, H. (2020) High-precision adaptive slope compensation circuit for DC-DC converter in wearable devices. IEEE Access, 8, pp. 34104-34112. (doi: 10.1109/ACCESS.2020.2974852)
Ghannam, R., Abbasi, Q. H., Hussain, S. (2020) Improving Student Engagement in a Transnational Engineering Education Programme Using Piazza.
Zhang, W., Abdulghani, A. M., Imran, M. A., Abbasi, Q. H. (2020) Internet of Things (IoT) Enabled Smart Home Safety Barrier System. (doi: 10.1145/3398329.3398341)
Zhou, M., Abdulghani, A. M., Imran, M. A., Abbasi, Q. H. (2020) Internet of Things (IoT) Enabled Smart Indoor Air Quality Monitoring System. (doi: 10.1145/3398329.3398342)
Hu, X., Abdulghani, A. M., Imran, M., Abbasi, Q. H. (2020) Internet of Things (IoT) for Healthcare Application: Wearable Sleep Body Position Monitoring System Using IoT Platform. (doi: 10.1145/3398329.3398340)
Furstenau, L. B., Sott, M. K., Kipper, L. M., Machado, Ê. L., López-Robles, J. R., Dohan, M. S., Cobo Martin, M. J., Zahid, A., Abbasi, Q. H., Imran, M. A. (2020) Link between sustainability and industry 4.0: trends, challenges and new perspectives. IEEE Access, 8, pp. 140079-140096. (doi: 10.1109/ACCESS.2020.3012812)
Zuo, S., Nazarpour, K., Gerken, M., Heidari, H. (2020) Magnetomyography. Institution of Engineering and Technology
Dai, S., Li, M., Abbasi, Q. H., Imran, M. (2020) Non-Gaussian Colored Noise Generation for Wireless Channel Simulation with Particle Swarm Optimizer. (doi: 10.23919/EuCAP48036.2020.9135826)
Soares, G.A., David, T.W., Anizelli, H., Miranda, B., Rodrigues, J., Lopes, P., Martins, J., Cunha, T., Vilaça, R., Kettle, J., Bagnis, D. (2020) Outdoor performance of organic photovoltaics at two different locations: a comparison of degradation and the effect of condensation. Journal of Renewable and Sustainable Energy, 12, (doi: 10.1063/5.0025622)
Althobaiti, T., Sharif, A., Ouyang, J., Ramzan, N., Abbasi, Q. H. (2020) Planar pyramid shaped UHF RFID tag antenna with polarisation diversity for IoT applications using characteristics mode analysis. IEEE Access, 8, pp. 103684-103696. (doi: 10.1109/ACCESS.2020.2999256)
Sott, M. K., Furstenau, L. B., Kipper, L. M., Giraldo, F. D., López-Robles, J. R., Cobo, M. J., Zahid, A., Abbasi, Q. H., Imran, M. A. (2020) Precision techniques and agriculture 4.0 technologies to promote sustainability in the coffee sector: state of the art, challenges and future trends. IEEE Access, 8, pp. 149854-149867. (doi: 10.1109/ACCESS.2020.3016325)
Wahba, M. A., Ashour, A. S., Ghannam, R. (2020) Prediction of harvestable energy for self-powered wearable healthcare devices: filling a gap. IEEE Access, 8, pp. 170336-170354. (doi: 10.1109/ACCESS.2020.3024167)
Ghannam, R., Hussain, S., Abbasi, Q. H., Imran, M. A. (2020) Remote supervision of engineering undergraduates in a transnational programme between Scotland and China. International Journal of Engineering Education, 36, pp. 1333-1339.
Ashyap, A. Y.I., Dahlan, S. H. B., Abidin, Z. Z., Hasmin Dahri, M., Majid, H. A., Kamarudin, M. R., Khee Yee, S., Jamaluddin, M. H., Alomainy, A., Abbasi, Q. H. (2020) Robust and efficient integrated antenna with EBG-DGS enabled wide bandwidth for wearable medical device applications. IEEE Access, 8, pp. 56346-56358. (doi: 10.1109/ACCESS.2020.2981867)
Fan, H., Wu, X., Ghannam, R., Feng, Q., Heidari, H., Imran, M. A. (2020) Teaching embedded systems for energy harvesting applications: a comparison of teaching methods adopted in UESTC and KTH. IEEE Access, 8, pp. 50780-50791. (doi: 10.1109/ACCESS.2020.2980336)
Wang, Y., Li, L.-A., Li, C., Ao, J.-P., Wang, X., Hao, Y. (2020) Thermal analysis of AlGaN/GaN hetero-structural Gunn diodes on different substrates through numerical simulation. IEEE Journal of the Electron Devices Society, 8, pp. 134-139. (doi: 10.1109/JEDS.2020.2967473)
Li, Y., Zuo, S., Nabaei, V., Thompson, J., Mirzai, N., Ranford-Cartwright, L., Heidari, H. (2020) Tunnel Magnetoresistance Sensor for Point-of-Care and Rapid Label-free Malaria Diagnosis.
2019
Jilani, S. F., Abbasi, Q. H., Imran, M. A., Alomainy, A. (2019) Design and analysis of millimeter-wave antennas for the fifth generation networks and beyond. John Wiley & sons Ltd
Li, J., Zhang, X., Shi, J., Heidari, H., Wang, Y. (2019) Performance degradation effect countermeasures in residence times difference (RTD) fluxgate magnetic sensors. IEEE Sensors Journal, 19, pp. 11819-11827. (doi: 10.1109/JSEN.2019.2936552)
Liang, D. T. R., Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2019) Radome Design with Improved Aerodynamics and Radiation for Smart Antennas in Automotive Applications. (doi: 10.1109/RFIT.2019.8929217)
Abbas, H. T., Alic, L., Erraguntla, M., Ji, J. X., Abdul-Ghani, M., Abbasi, Q. H., Qaraqe, M. K. (2019) Predicting long-term type 2 diabetes with support vector machine using oral glucose tolerance test. PLoS ONE, 14, (doi: 10.1371/journal.pone.0219636)
Liu, Y., Ghannam, R., Heidari, H. (2019) Smart Multi-Sensor Wristband for Gesture Classification.
Komolafe, A., Wagih, M., Valavan, A., Ahmed, Z., Stuikys, A., Zaghari, B. (2019) A smart cycling platform for textile-based sensing and wireless power transfer in smart cities. Proceedings, 32, (doi: 10.3390/proceedings2019032007)
Zoha, A., Abbasi, Q. H., Imran, M. A. (2019) A non-event based approach for non-intrusive load monitoring. Wiley-IEEE Press
Rahman, M. A., Rashid, M., Le Kernec, J., Philippe, B., Barnes, S., Fioranelli, F., Yang, S., Romain, O., Abbasi, Q., Loukas, G., Imran, M. (2019) A secure occupational therapy framework for monitoring cancer patients’ quality of life. Sensors, 19, (doi: 10.3390/s19235258)
Zoha, A., Abbasi, Q. H., Imran, M. A. (2019) Anomaly detection and self-healing in industrial wireless networks. Wiley-IEEE Press
Zahid, A., Abbas, H. T., Ren, A., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2019) Application of terahertz sensing at nano-scale for precision agriculture. Wiley-IEEE Press
Sharif, A., Guo, J., Ouyang, J., Sun, S., Arshad, K., Imran, M. A., Abbasi, Q. H. (2019) Compact base station antenna based on image theory for UWB/5G RTLS embraced smart parking of driverless cars. IEEE Access, 7, pp. 180898-180909. (doi: 10.1109/ACCESS.2019.2959130)
Karbalaei, M., Dideban, D., Heidari, H. (2019) Improvement in electrical characteristics of Silicon on Insulator (SOI) transistor using Graphene material. Results in Physics, 15, (doi: 10.1016/j.rinp.2019.102806)
Citoni, B., Fioranelli, F., Imran, M. A., Abbasi, Q. (2019) Internet of things and LoRaWAN enabled future smart farming. IEEE Internet of Things Journal, 2, pp. 14-19. (doi: 10.1109/IOTM.0001.1900043)
Sharif, A., Ouyang, J., Yan, Y., Raza, A., Imran, M. A., Abbasi, Q. H. (2019) Low-cost inkjet-printed RFID tag antenna design for remote healthcare applications. IEEE Journal of Electromagnetics, RF and Microwaves in Medicine and Biology, 3, pp. 261-268. (doi: 10.1109/JERM.2019.2924823)
Jilani, S. F., Abbasi, Q. H., Alomainy, A. (2019) Millimetre-wave flexible wearable antenna design and challenges for 5G and beyond. Institution of Engineering and Technology
Sodhro, A. H., Obaidat, M. S., Abbasi, Q. H., Pace, P., Pirbhulal, S., Yasar, A.-U.-H., Fortino, G., Imran, M. A., Qaraqe, M. (2019) Quality of service optimization in IoT driven intelligent transportation system. IEEE Wireless Communications, 26, pp. 10-17. (doi: 10.1109/MWC.001.1900085)
Abbasi, Q. H. (2019) Supervisor and supervisee expectations. IEEE Antennas and Propagation Magazine, 61, pp. 57-58. (doi: 10.1109/MAP.2019.2944334)
Paosangthong, W., Wagih, M., Torah, R., Beeby, S. (2019) Textile-based triboelectric nanogenerator with alternating positive and negative freestanding grating structure. Nano Energy, 66, (doi: 10.1016/j.nanoen.2019.104148)
Tahir, A., Ahmad, J., Shah, S. A., Morison, G., Skelton, D. A., Larigani, H., Abbasi, Q. H., Imran, M. A., Gibson, R. M. (2019) WiFreeze: multiresolution scalograms for freezing of gait detection in Parkinson’s leveraging 5G spectrum with deep learning. Electronics, 8, (doi: 10.3390/electronics8121433)
(2019) Wireless Automation as an Enabler for the Next Industrial Revolution. (doi: 10.1002/9781119552635)
Samipour, A., Dideban, D., Heidari, H. (2019) First principles study of the ambipolarity in a germanene nanoribbon tunneling field effect transistor. ECS Journal of Solid State Science and Technology, 8, pp. M111-M117. (doi: 10.1149/2.0021912jss)
Liang, X., Ghannam, R., Vuckovic, A., Heidari, H. (2019) Delay-based Neuromorphic Processor for Cognitive Biomedical Signal Processing.
Xeni, N., Ghannam, R., Udama, F., Georgiev, V., Asenov, A. (2019) Semiconductor Device Visualization using TCAD Software: Case Study for Biomedical Applications.
Ur Rehman, M., Abbasi, Q. H. (2019) Using RF Energy Harvesting in Remote Patient Health Monitoring Systems.
Zahid, A., Abbas, H. T., Ren, A., Zoha, A., Heidari, H., Shah, S. A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2019) Machine learning driven non-invasive approach of water content estimation in living plant leaves using terahertz waves. Plant Methods, 15, (doi: 10.1186/s13007-019-0522-9)
Tyagi, P., David, T. W., Stoichkov, V. D., Kettle, J. (2019) Multivariate approach for studying the degradation of perovskite solar cells. Solar Energy, 193, pp. 12-19. (doi: 10.1016/j.solener.2019.09.054)
Morariu, R., Wang, J., Cornescu, A. C., Al-Khalidi, A., Ofiare, A., Figueiredo, J. M.L., Wasige, E. (2019) Accurate small-signal equivalent circuit modelling of resonant tunneling diodes to 110 GHz. IEEE Transactions on Microwave Theory and Techniques, 67, pp. 4332-4340. (doi: 10.1109/TMTT.2019.2939321)
Abohmra, A., Ramani, S., Sharif, A., Imran, M. A., Abbasi, Q., Ahmad, W. (2019) Novel Flexible and Wearable 2.4 GHz Antenna for Body Centric Applications. (doi: 10.1109/DASC/PiCom/CBDCom/CyberSciTech.2019.00082)
Shah, S. A., Yang, X., Abbasi, Q. H. (2019) Cognitive healthcare system and its application in pill-rolling assessment. International Journal of Numerical Modelling: Electronic Networks, Devices and Fields, 32, (doi: 10.1002/jnm.2632)
Liang, X., Li, H., Wang, W., Liu, Y., Ghannam, R., Fioranelli, F., Heidari, H. (2019) Fusion of wearable and contactless sensors for intelligent gesture recognition. Advanced Intelligent Systems, 1, (doi: 10.1002/aisy.201900088)
Heidari, H., Nabaei, V. (2019) Magnetic Sensors for Biomedical Applications. Wiley-IEEE Press
(2019) Nano-Electromagnetic Communication at Terahertz and Optical Frequencies: Principles and Applications. (doi: 10.1049/SBEW542E)
Ren, A., Zahid, A., Yang, X., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2019) Terahertz (THz) application in food contamination detection. Institution of Engineering and Technology
Al-Moathin, A., Hou, L., Ofiare, A., Wang, J., Ye, S., Li, C., Marsh, J. H. (2019) Thick film hydrogen silsesquioxane planarization for passive component technology associated with electronic-photonic integrated circuits. Journal of Vacuum Science and Technology B: Microelectronics and Nanometer Structures, 37, (doi: 10.1116/1.5123286)
David, T. W., Anizelli, H., Tyagi, P., Gray, C., Teahan, W., Kettle, J. (2019) Using large datasets of organic photovoltaic performance data to elucidate trends in reliability between 2009 and 2019. IEEE Journal of Photovoltaics, 9, pp. 1768-1773. (doi: 10.1109/JPHOTOV.2019.2939070)
Shaowei, D., Abbasi, Q. H., Li, M., Imran, M. (2019) Beamforming Optimization Based on Kalman Filter for Vehicle in Constrained Route. (doi: 10.1109/APUSNCURSINRSM.2019.8888482)
Ren, A., Zahid, A., Imran, M. A., Abbasi, Q. H., Alomainy, A. (2019) Monitoring Quality Control of Fruits Using Terahertz Sensing. (doi: 10.1109/APUSNCURSINRSM.2019.8888479)
Zhang, Y., Ghannam, R., Valyrakis, M., Heidari, H. (2019) Design and Implementation of a 3D Printed Sensory Ball for Wireless Water Flow Monitoring. (doi: 10.1109/UCET.2019.8881861)
Sheikh, F., Mabrouk, I. B., Alomainy, A., Abbasi, Q. H., Kaiser, T. (2019) Indoor Material Properties Extraction from Scattering Parameters at Frequencies From 750 GHz to 1.1 THz. (doi: 10.1109/IMWS-AMP.2019.8880096)
Abbas, H.T., Aljihmani, L., Abbasi, Q. H., Qaraqe, K.A. (2019) On the Existence of Terahertz Plasmons in Two-dimensional Semiconductor Heterostructures. (doi: 10.1109/ICEAA.2019.8879335)
Abbas, H. T., Abbasi, Q. H., Aljihmani, L. N., Boudjemline, Y., Hijazi, Z., Mansoor, B., Qaraqe, K. A. (2019) Remote Monitoring of Absorbable Cardiovascular Stents Using Millimetre Waves. (doi: 10.1109/ISWCS.2019.8877268)
Heidari, H., Mak, P.-I., Anders, J., Hall, D. (2019) Guest editorial special issue on magnetic sensing systems for biomedical application. IEEE Sensors Journal, 19, pp. 8970-8970. (doi: 10.1109/JSEN.2019.2929887)
Li, H., Shrestha, A., Heidari, H., Le Kernec, J., Fioranelli, F. (2019) Magnetic and radar sensing for multimodal remote health monitoring. IEEE Sensors Journal, 19, pp. 8979-8989. (doi: 10.1109/JSEN.2018.2872894)
Thabit, A. A., Mahmoud, M. S., Alkhayyat, A., Abbasi, Q. H. (2019) Energy harvesting Internet of Things health-based paradigm: toward outage probability reduction through inter-wireless body area network cooperation. International Journal of Distributed Sensor Networks, 15, (doi: 10.1177/1550147719879870)
Yang, X., Shah, S. A., Ren, A., Fan, D., Zhao, N., Zheng, S., Wang, W., Soh, P. J., Abbasi, Q. H. (2019) S-band sensing-based motion assessment framework for cerebellar dysfunction patients. IEEE Sensors Journal, 19, pp. 8460-8467. (doi: 10.1109/JSEN.2018.2861906)
Li, H., Shrestha, A., Fioranelli, F., Le Kernec, J., Heidari, H. (2019) FMCW radar and inertial sensing synergy for assisted living. Journal of Engineering, 2019, pp. 6784-6789. (doi: 10.1049/joe.2019.0558)
Zhang, R., Abbasi, Q. H., Alomainy, A. (2019) Power Distribution and Performance Analysis of Terahertz Communication in Artificial Skin. (doi: 10.1145/3345312.3345461)
Abbas, H., Zahed, K., Alic, L., Zhu, Y., Sasangohar, F., Mehta, R., Lawley, M., Abbasi, Q. H., Qaraqe, K. A. (2019) A Wearable, Low-cost Hand Tremor Sensor for Detecting Hypoglycemic Events in Diabetic Patients. (doi: 10.1109/RFM.2018.8846546)
McGlynn, E., Nabaei, V., Das, R., Heidari, H. (2019) Brain Implantable Hybrid Neuranics for Epilepsy Treatment.
Mao, A., Zahid, A., Ur Rehman, M., Imran, M. A., Abbasi, Q. H. (2019) Detection of Pressure and Heat in a Compressive Orthotic for Diabetes Prevention Using Nanotechnology. (doi: 10.1109/RFM.2018.8846491)
Deng, J., Sun, W., Guan, L., Zhao, N., Khan, M. B., Ren, A., Zhao, J., Yang, X., Abbasi, Q. H. (2019) Noninvasive suspicious liquid detection using wireless signals. Sensors, 19, (doi: 10.3390/s19194086)
Abohmra, A., Jilani, F., Abbas, H., Alomainy, A., Ur-Rehman, M., Imran, M. A., Abbasi, Q. H. (2019) Flexible and Wearable Graphene-based Terahertz Antenna for Body-Centric Applications. (doi: 10.1109/IWMTS.2019.8823687)
Aifeng, R., Zahid, A., Imran, M. A., Alomainy, A., Fan, D., Abbasi, Q. H. (2019) Terahertz Sensing for Fruit Spoilage Monitoring. (doi: 10.1109/IWMTS.2019.8823735)
Accarino, C., Melino, G., Annese, V., Al-Rawhani, M. A., Shah, Y. D., Maneuski, D., Giagkoulovits, C., Grant, J. P., Mitra, S., Buttar, C., Cumming, D. R.S. (2019) A 64x64 SPAD array for portable colorimetric sensing, fluorescence and X-ray imaging. IEEE Sensors Journal, 19, pp. 7319-7327. (doi: 10.1109/JSEN.2019.2916424)
Kumar, D., Kettle, J. (2019) High performing metal–oxide semiconductor thin-film transistors. IET
Sharif, A., Ouyang, J., Raza, A., Imran, M. A., Abbasi, Q. H. (2019) Inkjet-printed UHF RFID tag based system for salinity and sugar detection. Microwave and Optical Technology Letters, 61, pp. 2161-2168. (doi: 10.1002/mop.31863)
Zahid, A., Abbas, H. T., Sheikh, F., Kaiser, T., Zoha, A., Imran, M. A., Abbasi, Q. H. (2019) Monitoring health status and quality assessment of leaves using terahertz frequency. FERMAT, 35,
Ren, A., Zahid, A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2019) Establishing A Novel Technique for the Detection of Water Contamination Using Terahertz Waves. (doi: 10.1109/IEEE-IWS.2019.8804074)
Dai, S., Li, M., Abbasi, Q. H., Imran, M. A. (2019) Improve Tracking Speed of Beamformer With Simplified Zero Placement Algorithm. (doi: 10.1109/IEEE-IWS.2019.8804154)
Abohmra, A., Jilani, F., Abbas, H., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2019) Terahertz Antenna based on Graphene for Wearable Applications. (doi: 10.1109/IEEE-IWS.2019.8803929)
Cornescu, A. C., Morariu, R., Ofiare, A., Al-Khalidi, A., Wang, J., Figueiredo, J. M.L., Wasige, E. (2019) High efficiency bias stabilisation for resonant tunneling diode oscillators. IEEE Transactions on Microwave Theory and Techniques, 67, pp. 3449-3454. (doi: 10.1109/TMTT.2019.2916602)
Abbas, H. T., Aljihmani, L. N., Nevels, R. D., Qaraqe, K. A. (2019) Electromagnetic scattering of two-dimensional electronic systems. IEEE Access, 7, pp. 106521-106526. (doi: 10.1109/ACCESS.2019.2932506)
Fan, H., Zhang, J., Cai, J., Feng, Q., Li, D., Zhang, K., Cen, Y., Heidari, H. (2019) Design Considerations of Data Converters for Industrial Technology. (doi: 10.1109/ICICDT.2019.8790925)
Annese, V. F., Hu, C., Accarino, C., Giagkoulovits, C., Patil, S. B., Al-Rawhani, M. A., Beeley, J., Cheah, B. C., Velugotla, S., Grant, J. P., Cumming, D. R.S. (2019) The Multicorder: A Handheld Multimodal Metabolomics-on-CMOS Sensing Platform. (doi: 10.1109/IWASI.2019.8791347)
Zhao, J., Oo Htet, K., Ghannam, R., Imran, M., Heidari, H. (2019) Modelling of Implantable Photovoltaic Cell based on Human Skin Types. (doi: 10.1109/PRIME.2019.8787735)
Zuo, S., Chen, J., Ghannam, R., Heidari, H. (2019) On Chip Counting and Localisation of Magnetite Pollution Nanoparticles. (doi: 10.1109/PRIME.2019.8787848)
Aljihmani, L., Zhu, Y., Abbas, H. T., Mehta, R., Sasangohar, F., Erraguntla, M., Abbasi, Q. H., Qarage, K. (2019) Spectral Analysis of Hand Tremors induced during a Fatigue Test. (doi: 10.1109/CBMS.2019.00135)
(2019) Enabling 5G Communication Systems to Support Vertical Industries.
Yuan, M., Heidari, H. (2019) Wireless Power Transfer in Wearable Smart Contact Lenses [Open access]
Meraj-E-Mustafa, , Izhar, R., Wahidi, M.S., Tahir, F. A., Abbasi, Q. H. (2019) A Broadband 90° Polarization Rotator Metasurface. (doi: 10.1109/COMPEM.2019.8778944)
Li, H., Shrestha, A., Heidari, H., Le Kernec, J., Fioranelli, F. (2019) Activities Recognition and Fall Detection in Continuous Data Streams Using Radar Sensor. (doi: 10.1109/IMBIOC.2019.8777855)
Li, X., Fu, Y.-C., Cho, S.-J., Hemakumara, D., Floros, K., Moran, D., Thayne, I. G. (2019) Developments of Atomic Layer Etch Processes and their Applications in Fabricating III-V Compound Semiconductor Devices.
Hemakumara, D., Li, X., Floros, K., Cho, S., Guinney, I., Humphreys, C., Thayne, I. G., O'Mahony, A., Knoops, H., Moran, D. (2019) Improved Performance of GaN Metal-Oxide-Semiconductor Capacitors byPplasma ALD of AlN Interlayer.
Kenney, M., Grant, J., Cumming, D. R.S. (2019) Alignment-insensitive bilayer THz metasurface absorbers exceeding 100% bandwidth. Optics Express, 27, pp. 20886-20900. (doi: 10.1364/OE.27.020886)
Zahid, A., Abbas, H. T., Imran, M. A., Qaraqe, K. A., Alomainy, A., Cumming, D. R.S., Abbasi, Q. H. (2019) Characterization and water content estimation method of living plant leaves using terahertz waves. Applied Sciences, 9, (doi: 10.3390/app9142781)
Ghannam, R., Kussmann, M., Wolf, A., Khalil, A. S.G., Imran, M. A. (2019) Solar energy educational programme for sustainable development in Egypt. Global Journal of Engineering Education, 21, pp. 128-133.
Ridler, N. M., Clarke, R. G., Li, C., Salter, M. J. (2019) Strategies for traceable submillimeter-wave vector network analyzer measurements. IEEE Transactions on Terahertz Science and Technology, 9, pp. 392-398. (doi: 10.1109/TTHZ.2019.2911870)
Chen, A., Li, C., Huang, Y., Zhou, J. (2019) Compact mm-Wave Coplanar Diplexer Design Without Using Air-bridges.
Kenney, M. G., Grant, J., Hao, D., Docherty, K., Mills, G., Jeffrey, G., Macleod, D., Henry, D., MacKay, P., Sorel, M., Lamb, R. A., Cumming, D., Bodermann, B., Frenner, K., Silver, R. M. (2019) Large Area Metasurface Lenses in the NIR Region. (doi: 10.1117/12.2527157)
Sheikh, F., Abbasi, Q. H., Kaiser, T. (2019) On Channels with Composite Rough Surfaces at Terahertz Frequencies.
Muhammad, M., Li, M., Abbasi, Q. H., Goh, C., Imran, M. A. (2019) Performance Evaluation for Direction of Arrival Estimation Using 4-Element Linear Array.
Zhang, W., Watson, S., Figueiredo, J., Wang, J., Cantú, H. I., Tavares, J., Pessoa, L., Al-Khalidi, A., Salgado, H., Wasige, E., Kelly, A. E. (2019) Optical direct intensity modulation of a 79GHz resonant tunneling diode-photodetector oscillator. Optics Express, 27, pp. 16791-16797. (doi: 10.1364/OE.27.016791)
Al-Khalidi, A., Wang, J., Wasige, E. (2019) Mm-wave/THz Multi-Gigabit Wireless Links Using Resonant Tunnelling Diodes.
Li, C., Tang, Y. K., Saha, S., Bin Ali, M. T., Basith, M. A. (2019) Current Status of Solar Home Systems in Bangladesh.
Li, C., Tang, Y. K., Saha, S., Ali, M. T. B., Basith, M. A., Marma, A. (2019) Feasibility Studies on Deploying a Self-Contained Solar-Hydraulic Pilot Power Plant in a Rural Area in Bangladesh.
Fan, H., Heidari, H., Maloberti, F., Li, D., Hu, D., Cen, Y. (2019) Method for improving spurious free dynamic range (SFDR) and signal-to-noise-and-distortion ratio (SNDR) of capacitor-resistor combined successive approximation register (SAR) analog-to-digital converter (ADC) by capacitor re-configuration.
Fan, H., Yang, J., Feng, Q., Li, D., Hu, D., Cen, Y., Heidari, H., Maloberti, F., Li, J., Su, H. (2019) Method of arranging capacitor array of successive approximation register analog-to-digital converter.
Yah, N.F.N., Rahim, H.A., Malek, M., Lee, Y.S., Yahaya, N.Z., Jusoh, M., Abbasi, Q.H., Mirza, S. (2019) Ultrathin Metamaterial Microwave Absorber Using Coconut Coir Fibre Over X-Band Frequency Range. (doi: 10.1109/ICCSPA.2019.8713715)
Munir, H. M., Ghannam, R., Li, H., Younas, T., Golilarz, N. A., Hassan, M., Siddique, A. (2019) Control of distributed generators and direct harmonic voltage controlled active power filter for accurate current sharing and power quality improvement in islanded microgrid. Inventions, 4, (doi: 10.3390/inventions4020027)
Gomes, T. C., Kumar, D., Fugikawa-Santos, L., Alves, N., Kettle, J. (2019) Optimization of the anodization processing for aluminum oxide gate dielectrics in ZnO thin film transistors by multivariate analysis. ACS Combinatorial Science, 21, pp. 370-379. (doi: 10.1021/acscombsci.8b00195)
Alkhayyat, A., Thabit, A. A., Al-Mayali, F. A., Abbasi, Q. H. (2019) WBSN in IoT health-based application: toward delay and energy consumption minimizing. Journal of Sensors, 2019, (doi: 10.1155/2019/2508452)
Fan, H., Liu, Y., Yin, G., Feng, Q., Niu, Y., Che, H., Zeng, X., Shen, Q., Xie, X., He, X., Chen, W., Heidari, H. (2019) Innovations of Microcontroller Unit Based on Experiment. (doi: 10.1109/ISCAS.2019.8702526)
Elksne, M., Al-Khalidi, A., Wasige, E. (2019) A planar distributed channel AlGaN/GaN HEMT technology. IEEE Transactions on Electron Devices, 66, pp. 2454-2458. (doi: 10.1109/TED.2019.2907152)
Mohamadzade, B., Hashmi, R. M., Simorangkir, R. B.V.B., Gharaei, R., Ur Rehman, S., Abbasi, Q. H. (2019) Recent advances in fabrication methods for flexible antennas in wearable devices: state of the art. Sensors, 19, (doi: 10.3390/s19102312)
Shakoor, A., Grant, J., Grande, M., Cumming, D. R.S. (2019) Towards portable nanophotonic sensors. Sensors, 19, (doi: 10.3390/s19071715)
Manjakkal, L., Navaraj, W. T., García Núñez, C., Dahiya, R. (2019) Graphene–graphite polyurethane composite based high‐energy density flexible supercapacitors. Advanced Science, 6, (doi: 10.1002/advs.201802251)
Hussain, S., Abbasi, Q. H., Ansari, I. S., Qadir, J., Imran, M. A. (2019) Online Interactivity Tools to Support Student Centered Learning in Large Classes.
Wasige, E., Wang, J., Al-Khalidi, A. (2019) Mm-wave/THz Multi-Gigabit Wireless Links.
Ghannam, R., Valente Klaine, P., Imran, M. (2019) Artificial intelligence for photovoltaic systems. Springer
Khademhosseini, V., Dideban, D., Ahmadi, M. T., Ismail, R., Heidari, H. (2019) Investigating the electrical characteristics of a single electron transistor utilizing graphene nanoribbon as the island. Journal of Materials Science: Materials in Electronics, 30, pp. 8007-8013. (doi: 10.1007/s10854-019-01121-6)
Sharif, A., Ouyang, J., Yang, F., Chathta, H. T., Imran, M., Alomainy, A., Abbasi, Q. H. (2019) Low-cost, inkjet-printed UHF RFID tag based system for Internet of Things applications using characteristic modes. IEEE Internet of Things Journal, 6, pp. 3962-3975. (doi: 10.1109/JIOT.2019.2893677)
Watson, S., Zhang, W., Tavares, J., Figueiredo, J., Cantu, H., Wang, J., Wasige, E., Salgado, H., Pessoa, L., Kelly, A. (2019) Resonant tunneling diode photodetectors for optical communications. Microwave and Optical Technology Letters, 61, pp. 1121-1125. (doi: 10.1002/mop.31689)
Li, X., Hemakumara, D., Fu, Y.-C., Moran, D., Thayne, I. (2019) A Study of In-situ X-ray Photoelectron Spectroscopy Surface Analysis in Development of Atomic Layer Etch for GaN/AlGaN Based Power Device Fabrication.
Abbasi, Q. H., Abdelaziz, A., Zhang, R. (2019) Capacity Evaluation of In-Vivo Nano-Sensors at Terahertz Frequencies Using Multiple Antenna Techniques.
Parvizi, R., Azad, S., Dashtian, K., Ghaedi, M., Heidari, H. (2019) Natural source-based graphene as sensitising agents for air quality monitoring. Scientific Reports, 9, (doi: 10.1038/s41598-019-40433-9)
Rahimian, A., Abbasi, Q. H., Alomainy, A., Alfadhl, Y. (2019) A low-profile 28-GHz rotman lens-fed array beamformer for 5G conformal subsystems. Microwave and Optical Technology Letters, 61, pp. 671-675. (doi: 10.1002/mop.31604)
Zhao, J., Ghannam, R., Yuan, M., Tam, H., Imran, M., Heidari, H. (2019) Design, test and optimization of inductive coupled coils for implantable biomedical devices. Journal of Low Power Electronics, 15, pp. 76-86. (doi: 10.1166/jolpe.2019.1597)
Ren, A., Fan, D., Yang, X., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2019) State-of-the-art terahertz sensing for food and water security – a comprehensive review. Trends in Food Science and Technology, 85, pp. 241-251. (doi: 10.1016/j.tifs.2019.01.019)
Stoichkov, V., Sweet, T.K.N., Jenkins, N., Kettle, J. (2019) Studying the outdoor performance of organic building-integrated photovoltaics laminated to the cladding of a building prototype. Solar Energy Materials and Solar Cells, 191, pp. 356-364. (doi: 10.1016/j.solmat.2018.11.040)
Wise, N., Heidari, H. (2019) Developing smart tourism destinations with the Internet of Things. Springer Nature
Alkhayyat, A., Abbasi, Q. H. (2019) Multiple Traffics Support in Wireless Body Area Network over Cognitive Cooperative Communication.
Liang, X., Ghannam, R., Heidari, H. (2019) Wrist-worn gesture sensing with wearable intelligence. IEEE Sensors Journal, 19, pp. 1082-1090. (doi: 10.1109/JSEN.2018.2880194)
Wan, S., Zhao, Y., Wang, T., Gu, Z., Abbasi, Q. H., Choo, K.-K. R. (2019) Multi-dimensional data indexing and range query processing via Voronoi diagram for internet of things. Future Generation Computer Systems, 91, pp. 382-391. (doi: 10.1016/j.future.2018.08.007)
Fernandez, B., Lobo, L., Tyagi, P., Stoichkov, V., Kettle, J., Pereiro, R. (2019) Rapid evaluation of different perovskite absorber layers through the application of depth profile analysis using glow discharge – Time of flight mass spectrometry. Talanta, 192, pp. 317-324. (doi: 10.1016/j.talanta.2018.09.059)
Ur Rehman, M., Kalsoom, T., Malik, N., Safdar, G. A., Chattha, H. T., Ramzan, N., Abbasi, Q. H. (2019) A Wearable Antenna for mmWave IoT Applications. (doi: 10.1109/APUSNCURSINRSM.2018.8608233)
Ashraf, M. A., Tahir, F. A., Abbasi, Q. H. (2019) Circularly Polarized C-shaped Monopole Antenna for C-Band Applications. (doi: 10.1109/APUSNCURSINRSM.2018.8608614)
Sharif, A., Ouyang, J., Chattha, H. T., Abbasi, Q. H. (2019) Tunable Folded-Patch UHF RFID Tag Antenna Design using Theory of Characteristic Modes. (doi: 10.1109/APUSNCURSINRSM.2018.8608266)
Elksne, M., Al-Khalidi, A., Wasige, E. (2019) AlGaN/GaN HEMTs With Improved Thermal Efficiency.
García Núñez, C., Manjakkal, L., Dahiya, R. (2019) Energy autonomous electronic skin. npj Flexible Electronics, 3, (doi: 10.1038/s41528-018-0045-x)
Ilyas, M., Ucan, O. N., Bayat, O., Nasir, A. A., Imran, M. A., Alomainy, A., Abbasi, Q. (2019) Evaluation of ultra-wideband in vivo radio channel and its effects on system performance. Transactions on Emerging Telecommunications Technologies, 30, (doi: 10.1002/ett.3530)
Wagih, M., Wei, Y., Beeby, S. (2019) Flexible 2.4 GHz node for body area networks with a compact high-gain planar antenna. IEEE Antennas and Wireless Propagation Letters, 18, pp. 49-53. (doi: 10.1109/LAWP.2018.2880490)
Jilani, S. F., Munoz, M., Abbasi, Q. H., Alomainy, A. (2019) Millimeter-wave liquid crystal polymer based conformal antenna array for 5G applications. IEEE Antennas and Wireless Propagation Letters, 18, pp. 84-88. (doi: 10.1109/LAWP.2018.2881303)
Ozair Iqbal, M., Mahboob Ur Rahman, M., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2019) Modulation mode detection and classification for in-vivo nano-scale communication systems operating in terahertz band. IEEE Transactions on NanoBioscience, 18, pp. 10-17. (doi: 10.1109/TNB.2018.2882063)
Zuo, S., Fan, H., Nazarpour, K., Heidari, H. (2019) A CMOS Analog Front-End for Tunnelling Magnetoresistive Spintronic Sensing Systems. (doi: 10.1109/ISCAS.2019.8702219)
Wei, Y., Zahid, A., Heidari, H., Imran, M., Abbasi, Q. H. (2019) A Compact Non-Invasive WearableVital Signal Monitoring System. (doi: 10.1109/PRIMEASIA.2018.8597778)
Yuan, Z., Huang, J., Zao, Z., Zahid, A., Heidari, H., Ghannam, R., Abbasi, Q. H. (2019) A Compact Wearable System for Detection and Estimation of Open Wound Status In Diabetic Patient. (doi: 10.1109/PRIMEASIA.2018.8598064)
You, Z., Zahid, A., Heidari, H., Imran, M., Abbasi, Q. H. (2019) A Compact Wearable System for Detection of Plantar Pressure for Diabetic Foot Prevention. (doi: 10.1109/PRIMEASIA.2018.8597990)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2019) A Flexible Low-Cost Hybrid Beamforming Structure for Practical Beamforming Applications. (doi: 10.1109/RFIT.2019.8929162)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2019) A Wideband Beam Forming Antenna Array for 802.11ac and 4.9 GHz.
Chen, Y., Ghannam, R., Heidari, H. (2019) Air Quality Monitoring Using Portable Multi-Sensory Module for Neurological Disease Prevention. (doi: 10.1109/UCET.2019.8881892)
Fan, H., Diao, X., Li, Y., Fang, K., Wen, H., Li, D., Zhang, K., Cen, Y., Zhang, D., Feng, Q., Heidari, H. (2019) An external capacitor-less low-dropout voltage regulator using a transconductance amplifier. IEEE Transactions on Circuits and Systems II: Express Briefs, 66, pp. 1748-1752. (doi: 10.1109/TCSII.2019.2921874)
Masrakin, K., Rahim, H. A., Soh, P. J., Abdulmalek, M., Adam, I., Warip, M. N. M., Abbasi, Q. H., Yang, X. (2019) Assessment of worn textile antennas’ exposure on the physiological parameters and well-being of adults. IEEE Access, 7, pp. 98946-98958. (doi: 10.1109/ACCESS.2019.2928343)
Sheikh, F., Alissa, M., Zahid, A., Abbasi, Q. H., Kaiser, T. (2019) Atmospheric Attenuation Analysis in Indoor THz Communication Channels. (doi: 10.1109/APUSNCURSINRSM.2019.8888704)
Zafar, S., Aman, W., Rahman, M. M. U., Alomainy, A., Abbasi, Q. H. (2019) Channel Impulse Response-based Physical Layer Authentication in a Diffusion-based Molecular Communication System. (doi: 10.1109/UCET.2019.8881878)
Omeke, K. G., Abohmra, A., Imran, M. A., Abbasi, Q. H., Zhang, L. (2019) Characterization of RF signals in Different Types of Water. (doi: 10.1049/cp.2019.0695)
Sharif, A., Ouyang, J., Yan, Y., Imran, M. A., Abbasi, Q. H. (2019) Circular Polarized RFID Tag Antenna Design using Characteristic Mode Analysis. (doi: 10.1109/IWAT.2019.8730810)
Patil, S. B., Annese, V. F., Cumming, D. (2019) Commercial aspects of biosensors for diagnostics and environmental monitoring. Elsevier
Al Ayidh, A., Battistela Nadas, J., Ghannam, R., Zhao, G., Imran, M. (2019) Communication and Control Co-Design Using MIMO Wireless Network. (doi: 10.1109/UCET.2019.8881847)
Turkmen, A., Mollel, M. S., Ozturk, M., Yao, S., Zhang, L., Ghannam, R., Imran, M. A. (2019) Coverage Analysis for Indoor-Outdoor Coexistence for Millimetre-Wave Communication. (doi: 10.1109/UCET.2019.8881890)
Zhao, X., Ghannam, R., Abbasi, Q. H., Heidari, H. (2019) Design and Implementation of Portable Sensory System for Air Pollution Monitoring. (doi: 10.1109/PRIMEASIA.2018.8597655)
Zhang, R., Yang, K., Yang, B., AbuAli, N. A., Hayajneh, M., Philpott, M., Abbasi, Q. H., Alomainy, A. (2019) Dielectric and double debye parameters of artificial normal skin and melanoma. Journal of Infrared, Millimeter and Terahertz Waves, 40, pp. 657-672. (doi: 10.1007/s10762-019-00597-x)
Muhammad, M., Li, M., Abbasi, Q., Goh, C., Imran, M. (2019) Direction of Arrival Estimation Using Root-Transformation Matrix Technique. (doi: 10.1109/APUSNCURSINRSM.2019.8889249)
Zahid, A., Abbasi, Q. H. (2019) Electromagnetic Properties of Plant Leaves at Terahertz Frequencies for Health Status Monitoring. (doi: 10.1109/IMBIOC.2019.8777782)
Oo Htet, K., Zhao, J., Ghannam, R., Heidari, H. (2019) Energy-Efficient Start-up Power Management for Batteryless Biomedical Implant Devices. (doi: 10.1109/ICECS.2018.8617874)
Hammood, D. A., Rahim, H. A., Ahmad, R. B., Alkhayyat, A., Salleh, M. E. M., Abdulmalek, M., Jusoh, M., Abbasi, Q. H. (2019) Enhancement of the duty cycle cooperative medium access control for wireless body area networks. IEEE Access, 7, pp. 3348-3359. (doi: 10.1109/ACCESS.2018.2886291)
Aljihmani, L., Abbas, H., Zhu, Y., Mehta, R., Sasangohar, F., Erraguntla, M., Lawley, M., Abbasi, Q. H., Qaraqe, K. A. (2019) Features of Physiologic Tremor in Diabetic Patients. (doi: 10.1109/ISC246665.2019.9071646)
Yuan, M., Ghannam, R., Karadimas, P., Heidari, H. (2019) Flexible RFID Patch for Food Spoilage Monitoring. (doi: 10.1109/PRIMEASIA.2018.8598134)
Zhao, N., Zhang, Z., Ren, A., Zhao, J., Yang, X., Ur-Rehman, M., Abbasi, Q. H. (2019) Hand palm local channel characterization for millimeter-wave body-centric applications. IEEE Access, 7, pp. 150976-150982. (doi: 10.1109/ACCESS.2019.2946844)
Mollel, M., Ozturk, M., Kaijage, S., Kisangiri, M., Onireti, O., Imran, M. A., Abbasi, Q. H. (2019) Handover Management in Dense Networks with Coverage Prediction from Sparse Networks. (doi: 10.1109/WCNCW.2019.8902854)
Dai, S., Li, M., Abbasi, Q. H., Imran, M. (2019) Hardware Efficient Adaptive Beamformer Based on Cyclic Variable Step Size. (doi: 10.1109/APUSNCURSINRSM.2018.8608636)
Abohmra, A., Jilani, S., Abbas, H., Alomainy, A., Imran, M., Abbasi, Q. (2019) High Bandwidth Perovskite Based Antenna for High- Resolution Biomedical Imaging at Terahertz. (doi: 10.1109/APUSNCURSINRSM.2019.8888453)
Kumar, D., Stoichkov, V., Brousseau, E., Smith, G. C., Kettle, J. (2019) High performing AgNW transparent conducting electrodes with a sheet resistance of 2.5 Ω Sq−1 based upon a roll-to-roll compatible post-processing technique. Nanoscale, 11, pp. 5760-5769. (doi: 10.1039/C8NR07974A)
Abohmra, A., Jilani, F., Abbas, H., Alomainy, A., Imran, M. A., Abbasi, Q. H. (2019) Hybrid Terahertz Antenna Design for Body-Centric Applications. (doi: 10.1049/cp.2019.0704)
Abbasi, Q. H., Kiourti, A., Heidari, H., He, Y., Warkiani, M., Alomainy, A. (2019) IEEE Access special section Editorial: wearable and implantable devices and systems. IEEE Access, 7, pp. 139512-139517. (doi: 10.1109/ACCESS.2019.2942728)
Ren, A., Zahid, A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2019) Introducing a Novel Technique of Detecting Fruits Contaminations Using Terahertz Sensing. (doi: 10.1109/IWAT.2019.8730602)
Abohmra, A., Jilani, F., Abbas, H., Ghannam, R., Heidari, H., Imran, M. A., Abbasi, Q. H. (2019) Low-profile Flexible Perovskite based Millimetre Wave Antenna. (doi: 10.1109/IMBIOC.2019.8777839)
Li, J., Heidari, H., Shi, J., Wang, Y. (2019) Magnetic Crosstalk Suppression and Probe Miniaturization of Coupled Core Fluxgate Sensors. (doi: 10.1109/SENSORS43011.2019.8956872)
Jilani, S. F., Abbasi, Q. H., Alomainy, A. (2019) Millimeter-Wave Compact and High-Performance Two-Dimensional Grid Array for 5G Applications. (doi: 10.1109/APUSNCURSINRSM.2019.8889123)
Zahid, A., Abbas, H. T., Sheikh, F., Kaiser, T., Zoha, A., Imran, M. A., Abbasi, Q. H. (2019) Monitoring Health Status and Quality Assessment of Leaves Using Terahertz Frequency. (doi: 10.1109/APUSNCURSINRSM.2019.8889356)
Sharif, A., Ouyang, J., Imran, M. A., Abbasi, Q. H. (2019) Orientation insensitive UHF RFID Tag Antenna With Polarization Diversity Using Characteristic Mode Analysis. (doi: 10.1109/APUSNCURSINRSM.2019.8888324)
Wagih, M., Weddell, A. S., Beeby, S. (2019) Overcoming the efficiency barrier of textile antennas: a transmission lines approach. Proceedings, 32, (doi: 10.3390/proceedings2019032018)
Abbas, H., Alic, L., Rios, M., Abdul-Ghani, M., Qaraqe, K. (2019) Predicting Diabetes in Healthy Population through Machine Learning. (doi: 10.1109/cbms.2019.00117)
Kettle, J. (2019) Ready cells for large-scale systems. Nature Energy, 4, pp. 536-537. (doi: 10.1038/s41560-019-0422-2)
Fan, H., Li, S., Feng, Q., Chen, W., Ye, X., Xie, S., Heidari, H. (2019) Reform and Practice of Analog Circuits. (doi: 10.1109/APCCAS.2018.8605620)
Asad, S. M., Ozturk, M., Rais, R. N. B., Zoha, A., Hussain, S., Abbasi, Q. H., Imran, M. A. (2019) Reinforcement Learning Driven Energy Efficient Mobile Communication and Applications. (doi: 10.1109/ISSPIT47144.2019.9001888)
McGhee, J., Moran, D. A., Georgiev, V. P. (2019) Simulations of Surface Transfer Doping of Hydrogenated Diamond by MoO3 Metal Oxide. (doi: 10.1109/EUROSOI-ULIS45800.2019.9041887)
Ullah, U., Koziel, S., Mabrouk, I. B., Abbasi, Q., Alomainy, A. (2019) Single-Point-Fed Broadband CP Antenna with Enhanced Axial Ratio. (doi: 10.1109/UCET.2019.8881837)
Rizwan, A., Zoha, A., Alomainy, A., Ali, N.A., Imran, M.A., Abbasi, Q.H. (2019) Skin Conductance as Proxy for the Identification of Hydration Level in Human Body. (doi: 10.1109/IMBIOC.2019.8777806)
Ouyang, J., Sharif, A., Yan, Y., Abbasi, Q. H. (2019) Small Conformal UHF RFID Tag Antenna for Labelling Fruits. (doi: 10.1109/APMC46564.2019.9038296)
Wang, Y., Zuo, S., Ghannam, R., Heidari, H. (2019) Smart Multi-Sensory Ball for Water Quality Monitoring. (doi: 10.1109/PRIMEASIA.2018.8597945)
Bertram, J., Tanwear, A., Rodriguez, A., Paterson, G., McVitie, S., Heidari, H. (2019) Spin-Hall Nano-Oscillator Simulations. (doi: 10.1109/SENSORS43011.2019.8956860)
Baset, A., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2019) Terahertz antenna design for wearable applications. Institution of Engineering and Technology
Paosangthong, W., Wagih, M., Torah, R., Beeby, S. (2019) Textile manufacturing compatible triboelectric nanogenerator with alternating positive and negative freestanding grating structure. Proceedings, 32, (doi: 10.3390/proceedings2019032023)
Ilyas, M., Bayat, O., Imran, M. A., Abbasi, Q. H. (2019) Ultra Wideband in Vivo Channel Modelling with Respect to Ex Vivo Antenna Location.
Kachroo, A., Vishwakarma, S., Dixon, J. N., Abuella, H., Popuri, A., Abbasi, Q. H., Bunting, C. F., Jacob, J. D., Ekin, S. (2019) Unmanned aerial vehicle-to-wearables (UAV2W) indoor radio propagation channel measurements and modeling. IEEE Access, 7, pp. 73741-73750. (doi: 10.1109/ACCESS.2019.2920103)
Sun, Y., Liang, X., Fan, H., Imran, M., Heidari, H. (2019) Visual Hand Tracking on Depth Image Using 2-D Matched Filter. (doi: 10.1109/UCET.2019.8881866)
Chen, Y., Liang, X., Assaad, M., Heidari, H. (2019) Wearable Resistive-based Gesture-Sensing Interface Bracelet. (doi: 10.1109/UCET.2019.8881832)
Sharif, A., Ouyang, J., Chattha, H. T., Imran, M. A., Abbasi, Q. H. (2019) Wearable UHF RFID Tag Antenna Design Using Hilbert Fractal Structure. (doi: 10.1109/UCET.2019.8881857)
Abbasi, Q. H., Alomainy, A., Heidari, H. (2019) Wearable wireless devices. Applied Sciences, 9, (doi: 10.3390/app9132643)
Chen, J., Ghannam, R., Imran, M., Heidari, H. (2019) Wireless Power Transfer for 3D Printed Unmanned Aerial Vehicle (UAV) Systems. (doi: 10.1109/PRIMEASIA.2018.8597848)
2018
Patil, S. B., Dheeman, D. S., Al-Rawhani, M. A., Velugotla, S., Nagy, B., Cheah, B. C., Grant, J. P., Accarino, C., Barrett, M. P., Cumming, D. R.S. (2018) An integrated portable system for single chip simultaneous measurement of multiple disease associated metabolites. Biosensors and Bioelectronics, 122, pp. 88-94. (doi: 10.1016/j.bios.2018.09.013)
Liu, F., Yogeswaran, N., García Núñez, C., Gregory, D., Dahiya, R. (2018) Graphene-ZnO NWs Film for Large-Area UV Photodetector. (doi: 10.1109/ICSENS.2018.8589639)
Li, H., Fioranelli, F., Le Kernec, J., Heidari, H. (2018) Hierarchical Classification on Multimodal Sensing for Human Activity Recogintion and Fall Detection. (doi: 10.1109/ICSENS.2018.8589797)
Zhao, J., Ghannam, R., Abbasi, Q. H., Imran, M., Heidari, H. (2018) Simulation of Photovoltaic Cells for Implantable Sensory Applications. (doi: 10.1109/ICSENS.2018.8589840)
Rahimian, A., Jilani, S. F., Abbasi, Q. H., Alomainy, A., Alfadhl, Y. (2018) A Millimetre-Wave Two-Dimensional 64-Element Array for Large-Scale 5G Antenna Subsystems.
Moh Chuan, T., Li, M., Abbasi, Q. H., Imran, M. A. (2018) An antenna array with enhanced gain and bandwidth for 802.11ac and 4.9GHz beamforming applications.
Guan, H., Yang, X., Sun, W., Ren, A., Fan, D., Zhao, N., Guan, L., Haider, D., Abbasi, Q. H. (2018) Posture-specific breathing detection. Sensors, 18, (doi: 10.3390/s18124443)
Ahmad, W., Imran, M., Ghannam, R. (2018) Blended Learning for Effective Block Teaching in a TNE Program.
Ahmad, W., Imran, M., Ghannam, R. (2018) Enhancing Student Engagement via Interactive, Collaborative and Recording Tools.
Fan, H., Wang, C., Xiong, H., Feng, Q., Li, D., Zhang, K., Diao, X., Lin, L., Heidari, H. (2018) A Bit Cycling Method for Improving the DNL/INL in Successive Approximation Register (SAR) Analog-to-Digital Converter (ADC) (doi: 10.1109/NGCAS.2018.8572141)
Ullah, H., Tahir, F. A., Chattha, H. T., Abbasi, Q. H. (2018) An Invariant Dual-beam Snowflake Antenna for Future 5G Communications. (doi: 10.1109/ANTEM.2018.8572926)
Haider, S. S., Tahir, F. A., Chattha, H. T., Abbasi, Q. H. (2018) Compact Polarization Diversity Antenna for 28/38 GHz Bands. (doi: 10.1109/ANTEM.2018.8572938)
Fan, H., Wu, X., Zhang, T., Feng, Q., Feng, L., Li, D., Zhang, K., Hu, D., Cen, Y., Heidari, H. (2018) High-Resolution ADCs for Biomedical Imaging Systems. (doi: 10.1109/NGCAS.2018.8572126)
Ahmad, W., Ghannam, R., Imran, M. (2018) Course design for achieving the graduate attributes of the 21st Century UK Engineer.
He, Y., Liang, K., Li, J., Abbasi, Q. H. (2018) A Novel Mobile Phone Antenna for Effectively Reducing Specific Absorption Rate. (doi: 10.1049/cp.2018.1234)
Tan, M. C., Li, M., Abbasi, Q. H., Imran, M. (2018) A Smart and Low-cost Enhanced Antenna System for Industrial Wireless Broadband Communication. (doi: 10.1049/cp.2018.1218)
Zhang, R., Yang, K., Abbasi, Q., Qaraqe, K. A., Alomainy, A. (2018) Impact of Fibroblast Cell Density on the Material Parameters of Thin Artificial Human Skin in the Terahertz Band. (doi: 10.1049/cp.2018.0773)
Sharif, A., Ouyang, J., Chattha, H. T., Long, R., Raza, A., Abbasi, Q. H. (2018) UHF RFID Tag Antenna Design for Challenging Environment Surfaces. (doi: 10.1049/cp.2018.1222)
Chattha, H. T., Aftab, N., Akram, M., Sheriff, N., Huang, Y., Abbasi, Q. H. (2018) Frequency reconfigurable patch antenna with bias tee for wireless LAN applications. IET Microwaves, Antennas and Propagation, 12, pp. 2248-2254. (doi: 10.1049/iet-map.2018.5526)
Beeley, J., Melino, G., Al-Rawhani, M., Turcanu, M., Stewart, F., Cochran, S., Cumming, D. (2018) Imaging fluorophore-labelled intestinal tissue via fluorescence endoscope capsule. Proceedings, 2, (doi: 10.3390/proceedings2130766)
Shakoor, A., Cheah, B. C., al-Rawhani, M. A., Grande, M., Grant, J., Gouveia, L. C. P., Cumming, D. R.S. (2018) CMOS nanophotonic sensor with integrated readout system. IEEE Sensors Journal, 18, pp. 9188-9194. (doi: 10.1109/JSEN.2018.2870255)
Heidari, H. (2018) Magnetoelectronics: Electronic skins with a global attraction. Nature Electronics, 1, pp. 578-579. (doi: 10.1038/s41928-018-0165-2)
Khademhosseini, V., Dideban, D., Ahmadi, M. T., Ismail, R., Heidari, H. (2018) Impact of hydrogen adsorption on the performance of a single electron transistor utilizing Fullerene quantum dots. ECS Journal of Solid State Science and Technology, 7, pp. M191-M194. (doi: 10.1149/2.0281811jss)
Gamage, K. A.A., Hussain, S., Abbasi, Q. H. (2018) Final Year Project Allocations for Undergraduate Engineering Students in TNE Programs. (doi: 10.20472/TEC.2018.006.002)
Hughes, L., Bristow, N., Korochkina, T., Sanchez, P., Gomez, D., Kettle, J., Gethin, D. (2018) Assessing the potential of steel as a substrate for building integrated photovoltaic applications. Applied Energy, 229, pp. 209-223. (doi: 10.1016/j.apenergy.2018.07.119)
Wang, J., Al-Khalidi, A., Wang, L., Morariu, R., Ofiare, A., Wasige, E. (2018) 15 Gb/s 50-cm wireless link using a high power compact III-V 84 GHz transmitter. IEEE Transactions on Microwave Theory and Techniques, 66, pp. 4698-4705. (doi: 10.1109/TMTT.2018.2859983)
Fan, H., Li, D., Kelin, Z., Cen, Y., Feng, Q., Qiao, F., Heidari, H. (2018) A 4-channel 12-bit high-voltage radiation-hardened digital-to-analog converter for low orbit satellite applications. IEEE Transactions on Circuits and Systems I: Regular Papers, 65, pp. 3698-3706. (doi: 10.1109/TCSI.2018.2856851)
(2018) Circuits and Systems for Biomedical Applications: UKAS 2018.
Al-Mishmish, H., Akhayyat, A., Rahim, H. A., Hammood, D. A., Ahmad, R. B., Abbasi, Q. H. (2018) Critical data-based incremental cooperative communication for wireless body area network. Sensors, 18, (doi: 10.3390/s18113661)
Zuo, S., Nazarpour, K., Heidari, H. (2018) Device modelling of MgO-barrier tunnelling magnetoresistors for hybrid spintronic-CMOS. IEEE Electron Device Letters, 39, pp. 1784-1787. (doi: 10.1109/LED.2018.2870731)
Hou, Y., Yang, X., Abbasi, Q. H. (2018) Efficient AoA-based wireless indoor localization for hospital outpatients using mobile devices. Sensors, 18, (doi: 10.3390/s18113698)
Xie, C., Pusino, V., Khalid, A., Craig, A. P., Marshall, A., Cumming, D. R.S. (2018) Monolithically integrated InAsSb-based nBnBn heterostructure on GaAs for infrared detection. IEEE Journal of Selected Topics in Quantum Electronics, 24, (doi: 10.1109/JSTQE.2018.2828101)
Fernandes, R. V., Urbano, A., Duarte, J. L., Bristow, N., Kettle, J., Laureto, E. (2018) Tuning the optical properties of luminescent down shifting layers based on organic dyes to increase the efficiency and lifetime of P3HT: PCBM photovoltaic devices. Journal of Luminescence, 203, pp. 165-171. (doi: 10.1016/j.jlumin.2018.06.053)
Liang, L., Hu, X., Wen, L., Zhu, Y., Yang, X., Zhou, J., Zhang, Y., Escorcia Carranza, I., Grant, J., Jiang, C., Cumming, D. R.S., Li, B., Chen, Q. (2018) Unity integration of grating slot waveguide and microfluid for terahertz sensing. Laser and Photonics Reviews, 12, (doi: 10.1002/lpor.201800078)
Heidari, H., Zuo, S., Krasoulis, A., Nazarpour, K. (2018) CMOS Magnetic Sensors for Wearable Magnetomyography. (doi: 10.1109/EMBC.2018.8512723)
Zuo, S., Tanwear, A., Heidari, H. (2018) Modelling of Spintronic Nanodevices for Neuromorphic Sensing Chips.
Khan, Z. U., Abbasi, Q. H., Belenguer, A., Loh, T. H., Alomainy, A. (2018) Empty Substrate Integrated Waveguide Slot Antenna Array for 5G Applications. (doi: 10.1109/IMWS-5G.2018.8484494)
Jilani, S. F., Abbasi, Q. H., Alomainy, A. (2018) Inkjet-Printed Millimetre-Wave PET-Based Flexible Antenna for 5G Wireless Applications. (doi: 10.1109/IMWS-5G.2018.8484603)
García Núñez, C., Vilouras, A., Navaraj, W. T., Liu, F., Dahiya, R. (2018) ZnO nanowires based flexible UV photodetector system for wearable dosimetry. IEEE Sensors Journal, 18, pp. 7881-7888. (doi: 10.1109/JSEN.2018.2853762)
Zhang, Q., Haider, D., Wang, W., Shah, S. A., Yang, X., Abbasi, Q. H. (2018) Chronic obstructive pulmonary disease warning in the approximate ward environment. Applied Sciences, 8, (doi: 10.3390/app8101915)
Ahmed, A., Kalsoom, T., Ur-Rehman, M., Ramzan, N., Karim, S., Abbasi, Q. H. (2018) Design and study of a small implantable antenna design for blood glucose monitoring. Applied Computational Electromagnetics Society Journal, 33,
Haider, D., Ren, A., Fan, D., Zhao, N., Yang, X., Tanoli, S. A. K., Zhang, Z., Hu, F., Shah, S. A., Abbasi, Q. H. (2018) Utilizing 5G spectrum for healthcare to detect the tremors and breathing activity for multiple sclerosis. Transactions on Emerging Telecommunications Technologies, 29, (doi: 10.1002/ett.3454)
Hosseini, V. K., Dideban, D., Ahmadi, M. T., Ismail, R., Heidari, H. (2018) Single electron transistor scheme based on multiple quantum dot islands: carbon nanotube and fullerene. ECS Journal of Solid State Science and Technology, 7, pp. M145-M152. (doi: 10.1149/2.0081810jss)
Humphreys, M., Grant, J.P., Escorcia-Carranza, I., Accarino, C., Kenney, M., Shah, Y.D., Rew, K.G., Cumming, D.R.S. (2018) Video-rate terahertz digital holographic imaging system. Optics Express, 26, pp. 25805-25813. (doi: 10.1364/OE.26.025805)
Chattha, H. T., Abbasi, Q. H., Ur-Rahman, M., Alomainy, A., Tahir, F. A. (2018) Antenna systems for Internet of Things. Wireless Communications and Mobile Computing, 2018, (doi: 10.1155/2018/8691612)
Li, J., Ghannam, R., Heidari, H. (2018) Design and Implementation of Smart Home Sensory Systems for Environmental Monitoring.
Ghannam, R., Brante, G., Heidari, H., Imran, M. (2018) Artificial Intelligence for Solar Energy Harvesting in Wireless Sensor Networks.
Saberi Moghaddam, R., Ghannam, R., Heidari, H. (2018) Perovskite Photodiode for Wearable Electronics.
Zuo, S., Ghannam, R., Heidari, H. (2018) Spintronic Nanodevices for Neuromorphic Sensing Chips.
Sharif, A., Ouyang, J., Yan, Y., Chattha, H. T., Raza, A., Abbasi, Q. H. (2018) Small Conformal UHF RFID Tag Antenna for Labelling Fruits.
Giagkoulovits, C., Cheah, B. C., Al-Rawhani, M. A., Accarino, C., Busche, C., Grant, J. P., Cumming, D. R.S. (2018) A 16 x 16 CMOS amperometric microelectrode array for simultaneous electrochemical measurements. IEEE Transactions on Circuits and Systems I: Regular Papers, 65, pp. 2821-2831. (doi: 10.1109/TCSI.2018.2794502)
Maricar, M. I., Khalid, A., Dunn, G., Greedy, S., Thomas, D. W.P., Cumming, D.R.S., Oxley, C.H. (2018) An electrical equivalent circuit to simulate the output power of an AlGaAs/GaAs planar Gunn diode oscillator. Microwave and Optical Technology Letters, 60, pp. 2144-2148. (doi: 10.1002/mop.31312)
Wagih, M., Wei, Y., Yong, S., Beeby, S. (2018) Connecting and Powering Flexible IoT, an Insole Case Study.
Manjakkal, L., García Núñez, C., Dang, W., Dahiya, R. (2018) Flexible self-charging supercapacitor based on graphene-Ag-3D graphene foam electrodes. Nano Energy, 51, pp. 604-612. (doi: 10.1016/j.nanoen.2018.06.072)
Yin, Z., Bonizzoni, E., Heidari, H. (2018) Magnetoresistive biosensors for on-chip detection and localisation of paramagnetic particles. IEEE Journal of Electromagnetics, RF and Microwaves in Medicine and Biology, 2, pp. 179-185. (doi: 10.1109/JERM.2018.2858562)
Macdonald, D. A., Crawford, K. G., Tallaire, A., Issaoui, R., Moran, D. A.J. (2018) Performance enhancement of Al2O3/H-diamond MOSFETs utilizing vacuum annealing and V2O5 as a surface electron acceptor. IEEE Electron Device Letters, 39, pp. 1354-1357. (doi: 10.1109/LED.2018.2856920)
Fan, H., Li, J., Feng, Q., Sun, H., Heidari, H. (2018) Exploiting smallest error to calibrate non-linearity in SAR ADCs. IEEE Access, 6, pp. 42930-42940. (doi: 10.1109/ACCESS.2018.2852729)
Oo Htet, K., Ghannam, R., Abbasi, Q. H., Heidari, H. (2018) Power management using photovoltaic cells for implantable devices. IEEE Access, 6, pp. 42156-42164. (doi: 10.1109/ACCESS.2018.2860793)
García Núñez, C., Liu, F., Navaraj, W., Christou, A., Shakthivel, D., Dahiya, R. (2018) Heterogeneous integration of contact-printed semiconductor nanowires for high performance devices on large areas. Microsystems and Nanoengineering, 4, (doi: 10.1038/s41378-018-0021-6)
Li, C., Liu, C., Wu, A., Ridler, N. (2018) A new SOLT calibration method for leaky on-wafer measurements using a 10-term error model. IEEE Transactions on Microwave Theory and Techniques, 66, pp. 3894-3900. (doi: 10.1109/TMTT.2018.2832052)
Stoichkov, V., Bristow, N., Troughton, J., De Rossi, F., Watson, T.M., Kettle, J. (2018) Outdoor performance monitoring of perovskite solar cell mini-modules: diurnal performance, observance of reversible degradation and variation with climatic performance. Solar Energy, 170, pp. 549-556. (doi: 10.1016/j.solener.2018.05.086)
Abbas, H. T., Zeng, X., Nevels, R. D., Zubairy, M. S. (2018) Deep subwavelength imaging via tunable terahertz plasmons. Applied Physics Letters, 113, (doi: 10.1063/1.5035312)
Rizwan, A., Zoha, A., Ahmad, W., Arshad, K., Ali, N., Alomainy, A., Imran, M.A., Abbasi, Q.H. (2018) A review on the role of nano-communication in future healthcare systems: A big data analytics perspective. IEEE Access, 6, pp. 41903-41920. (doi: 10.1109/ACCESS.2018.2859340)
Vasilevska, M., Al-Khalidi, A., Wasige, E. (2018) Thermal Performance of AlGaN/GaN HEMTs on SiC Substrates.
Ilyas, M., Bayat, O., Abbasi, Q. H. (2018) Experimental Analysis of Ultra Wideband In Vivo Radio Channel. (doi: 10.1109/SIU.2018.8404517)
Zahid, A., Yang, K., Heidari, H., Li, C., Imran, M. A., Alomainy, A., Abbasi, Q. H. (2018) Terahertz Characterisation of Living Plant Leaves for Quality of Life Assessment Applications. (doi: 10.23919/URSI.2018.8406770)
Fan, H., Yang, J., Maloberti, F., Feng, Q., Li, D., Hu, D., Cen, Y., Heidari, H. (2018) High-Resolution ADCs Design in Image Sensors. (doi: 10.1109/LASCAS.2018.8399935)
Zhang, R., Yang, K., Abbasi, Q. H., AbuAli, N. A., Alomainy, A. (2018) Impact of cell density and collagen concentration on the electromagnetic properties of dermal equivalents in the terahertz band. IEEE Transactions on Terahertz Science and Technology, 8, pp. 381-389. (doi: 10.1109/TTHZ.2018.2825111)
Stoichkov, V., Kumar, D., Tyagi, P., Kettle, J. (2018) Multistress testing of OPV modules for accurate predictive aging and reliability predictions. IEEE Journal of Photovoltaics, 8, pp. 1058-1065. (doi: 10.1109/JPHOTOV.2018.2838438)
Abdellatif, S., Sharifi, P., Kirah, K., Ghannam, R., Khalil, A.S.G., Erni, D., Marlow, F. (2018) Refractive index and scattering of porous TiO 2 films. Microporous and Mesoporous Materials, 264, pp. 84-91. (doi: 10.1016/j.micromeso.2018.01.011)
Al-Khalidi, A., Alharbi, K., Wang, J., Wasige, E. (2018) A Compact Terahertz Source Technology for Automotive Radar and Other Applications.
Fatholah nejad, H., Dideban, D., Ketabi, A., Vali, M., Bayani, A. H., Heidari, H. (2018) Tuning the analog and digital performance of Germanene nanoribbon field effect transistors with engineering the width and geometry of source, channel and drain region in the ballistic regime. Materials Science in Semiconductor Processing, 80, pp. 18-23. (doi: 10.1016/j.mssp.2018.02.007)
García Núñez, C., Braña, A. F., López, N., García, B. J. (2018) A novel growth method to improve the quality of GaAs nanowires grown by Ga-assisted chemical beam epitaxy. Nano Letters, 18, pp. 3608-3615. (doi: 10.1021/acs.nanolett.8b00702)
Fan, D., Ren, A., Zhao, N., Yang, X., Zhang, Z., Shah, S. A., Hu, F., Abbasi, Q. H. (2018) Breathing rhythm analysis in body centric networks. IEEE Access, 6, pp. 32507-32513. (doi: 10.1109/ACCESS.2018.2846605)
Elksne, M., Al-Khalidi, A., Wasige, E. (2018) AlGaN/GaN HEMTs With Reduced Self‐Heating.
Jilani, S. F., Abbasi, Q. H., Khan, Z. U., Loh, T.-H., Alomainy, A. (2018) A Ka‐band antenna based on an enhanced Franklin model for 5G cellular networks. Microwave and Optical Technology Letters, 60, pp. 1562-1566. (doi: 10.1002/mop.31194)
Li, H., Shrestha, A., Heidari, H., Le Kernec, J., Fioranelli, F. (2018) A multi-sensory approach for remote health monitoring of older people. IEEE Journal of Electromagnetics, RF and Microwaves in Medicine and Biology, 2, pp. 102-108. (doi: 10.1109/JERM.2018.2827099)
Jornet, J. M., Balasubramaniam, S., Alomainy, A., Wallace, V., Abbasi, Q. H. (2018) Editorial on “In-and-off body-centric nano-scale wireless communication and networks” Nano Communication Networks, 16, pp. 91. (doi: 10.1016/j.nancom.2018.02.004)
Michel, B., Moll, N., Ghannam, R. (2018) Light-reflecting grating structure for photovoltaic devices.
Ahmed, A., Ur Rehman, M., Abbasi, Q. H. (2018) Miniature Implantable Antenna Design for Blood Glucose Monitoring. (doi: 10.23919/ROPACES.2018.8364219)
Chattha, H. T., Hanif, M., Yang, X., Rana, I. E., Abbasi, Q. H. (2018) Frequency reconfigurable patch antenna for 4G LTE applications. Progress in Electromagnetics Research M, 69, pp. 1-13. (doi: 10.2528/PIERM18022101)
Escorcia, I., Grant, J. P., Gouveia, L., Cumming, D. R.S. (2018) Terahertz Imagers Based on Metamaterial Structures Monolithically Integrated in Standard CMOS Technologies. (doi: 10.1117/12.2304335)
Fan, H., Yang, J., Maloberti, F., Feng, Q., Li, D., Hu, D., Cen, Y., Heidari, H. (2018) High Linearity SAR ADC for Smart Sensor Applications. (doi: 10.1109/ISCAS.2018.8350998)
Accarino, C., Al-Rawhani, M., Shah, Y. D., Maneuski, D., Mitra, S., Buttar, C., Cumming, D. R.S. (2018) Low Noise and High Photodetection Probability SPAD in 180 nm Standard CMOS Technology. (doi: 10.1109/ISCAS.2018.8351173)
Oo Htet, K., Fan, H., Heidari, H. (2018) Switched Capacitor DC-DC Converter for Miniaturised Wearable Systems. (doi: 10.1109/ISCAS.2018.8351795)
Li, S.-S., Pusino, V., Chan, S.-C., Sorel, M. (2018) Experimental investigation on feedback insensitivity in semiconductor ring lasers. Optics Letters, 43, pp. 1974-1977. (doi: 10.1364/OL.43.001974)
Ur Rehman, M., Abbasi, Q. H. (2018) Human body effects on LTE femtocell antennas. John Wiley & Sons, Ltd
Nagy, B., Al-Rawhani, M. A., Cheah, B. C., Barrett, M. P., Cumming, D. R.S. (2018) Immunoassay multiplexing on a complementary metal oxide semiconductor photodiode array. ACS Sensors, 3, pp. 953-959. (doi: 10.1021/acssensors.7b00972)
Latif, S., Khan, M. Y., Qayyum, A., Qadir, J., Usman, M., Ali, S. M., Abbasi, Q. H., Imran, M. (2018) Mobile technologies for managing non-communicable-diseases in developing countries. IGI Global
Nabaei, V., Chandrawati, R., Heidari, H. (2018) Magnetic biosensors: modelling and simulation. Biosensors and Bioelectronics, 103, pp. 69-86. (doi: 10.1016/j.bios.2017.12.023)
Pinton, N., Grant, J., Collins, S., Cumming, D. R.S. (2018) Exploitation of magnetic dipole resonances in metal–insulator–metal plasmonic nanostructures to selectively filter visible light. ACS Photonics, 5, pp. 1250-1261. (doi: 10.1021/acsphotonics.7b00959)
Ur Rehman, M., Malik, N.A., Safdar, G.A., Yang, K., Chattha, H.T., Abbasi, Q.H. (2018) Design and Analysis of a Millimetre-Wave Wearable Antenna.
Chattha, H.T., Hanif, M., Raza, A., Sharif, X., Yang, X., Abbasi, Q.H., Ur Rehman, M. (2018) Reconfigurable Antenna Design for Portable Applications.
Grant, J., Kenney, M., Shah, Y. D., Escorcia-Carranza, I., Cumming, D. S. (2018) CMOS compatible metamaterial absorbers for hyperspectral medium wave infrared imaging and sensing applications. Optics Express, 26, pp. 10408-10420. (doi: 10.1364/OE.26.010408)
Ilyas, M., Ucan, O. N., Bayat, O., Yang, X., Abbasi, Q. H. (2018) Mathematical modeling of ultra wideband in vivo radio channel. IEEE Access, 6, pp. 20848-20854. (doi: 10.1109/ACCESS.2018.2823741)
Tyagi, P., Hua, S.-C., Amorim, D. R., Faria, R.M., Kettle, J., Horie, M. (2018) All-conjugated block copolymers for efficient and stable organic solar cells with low temperature processing. Organic Electronics, 55, pp. 146-156. (doi: 10.1016/j.orgel.2018.01.032)
Crawford, K. G., Tallaire, A., Li, X., Macdonald, D. A., Qi, D., Moran, D. A.J. (2018) The role of hydrogen plasma power on surface roughness and carrier transport in transfer-doped H-diamond. Diamond and Related Materials, 84, pp. 48-54. (doi: 10.1016/j.diamond.2018.03.005)
Shah, S. A., Ren, A., Fan, D., Zhang, Z., Zhao, N., Yang, X., Luo, M., Wang, W., Hu, F., Ur Rehman, M., Badarneh, O. S., Abbasi, Q. H. (2018) Internet of things for sensing: a case study in healthcare system. Applied Sciences, 8, (doi: 10.3390/app8040508)
Abdelaziz, A. F., Yang, K., Qaraqe, K., Boutros, J., Abbasi, Q., Alomainy, A. (2018) Multiple Input Multiple Output InVivo Communication for Nano Sensor at Terahertz Frequencies.
Abbasi, Q. H., Alomainy, A., Jornet, J., Han, C., Chen, Y. (2018) Nano-antennas, nano-transceivers and nano-networks/communications. IEEE Access, 6, pp. 8270-8272. (doi: 10.1109/ACCESS.2018.2805578)
Li, X., Zhou, H., Hemakumara, D., Cho, S.-J., Floros, K., Moran, D., Thayne, I. (2018) A Study of In-Situ Auger Spectroscopic Surface Analysis in Development of Atomic Layer Etch for GaN/AlGaN Based Power Device Fabrication.
Zhang, R., Yang, K., Abbasi, Q. H., Qaraqe, K. A., Alomainy, A. (2018) Analytical modelling of the effect of noise on the terahertz in-vivo communication channel for body-centric nano-networks. Nano Communication Networks, 15, pp. 59-68. (doi: 10.1016/j.nancom.2017.04.001)
Shah, Y. D., Grant, J., Hao, D., Kenney, M., Pusino, V., Cumming, D. R.S. (2018) Ultra-narrow line width polarization-insensitive filter using a symmetry-breaking selective plasmonic metasurface. ACS Photonics, 5, pp. 663-669. (doi: 10.1021/acsphotonics.7b01011)
Crawford, K. G., Qi, D., McGlynn, J., Ivanov, T. G., Shah, P. B., Weil, J., Tallaire, A., Ganin, A. Y., Moran, D. A.J. (2018) Thermally stable, high performance transfer doping of diamond using transition metal oxides. Scientific Reports, 8, (doi: 10.1038/s41598-018-21579-4)
Rotaru, M. D., Wagih, M. A. (2018) Analysis and Design of Low Loss Differential Transmission Line Structures for High Speed Applications. (doi: 10.1109/EPTC.2017.8277541)
Hao, D., Hu, C., Grant, J., Glidle, A., Cumming, D. R.S. (2018) Hybrid localized surface plasmon resonance and quartz crystal microbalance sensor for label free biosensing. Biosensors and Bioelectronics, 100, pp. 23-27. (doi: 10.1016/j.bios.2017.08.038)
Bristow, N., Kettle, J. (2018) Outdoor organic photovoltaic module characteristics: benchmarking against other PV technologies for performance, calculation of Ross coefficient and outdoor stability monitoring. Solar Energy Materials and Solar Cells, 175, pp. 52-59. (doi: 10.1016/j.solmat.2017.10.008)
Hu, C., Al-Rawhani, M. A., Cheah, B. C., Velugotla, S., Cumming, D. R.S. (2018) Hybrid dual mode sensor for simultaneous detection of two serum metabolites. IEEE Sensors Journal, 18, pp. 484-493. (doi: 10.1109/JSEN.2017.2774359)
Al-Khalidi, A., Alharbi, K., Wang, J., Wasige, E. (2018) THz Electronics for Data Centre Wireless Links - the TERAPOD Project. (doi: 10.1109/ICUMT.2017.8255202)
Malik, N. A., Ur-Rehman, M., Safdar, G. A., Abbasi, Q. H. (2018) Extremely Low Profile Flexible Antenna for Medical Body Area Networks. (doi: 10.1109/APMC.2017.8251428)
Li, X., Cho, S.-J., Floros, K., Hemakumara, D., Zhou, H., Guiney, I., Moran, D., Humphreys, C., Thayne, I.G. (2018) In-situ Auger Spectroscopy Analysis of an Atomic Layer Etching Process for GaN/AlGaN-based Power Device Fabrication.
Melvin, A. A., Stoichkov, V. D., Kettle, J., Mogilyansky, D., Katz, E. A., Visoly-Fisher, I. (2018) Lead iodide as a buffer layer in UV-induced degradation of CH3NH3PbI3 films. Solar Energy, 159, pp. 794-799. (doi: 10.1016/j.solener.2017.11.054)
Martin, S., Heidari, H., Tousimojarad, A., Cochran, S. (2018) Arm Mbed – AWS IoT System Integration [Open access]
Garcia Nunez, C., Navaraj, W. T., Liu, F., Shakthivel, D., Dahiya, R. (2018) Large-area self-assembly of silica microspheres/nanospheres by temperature-assisted dip-coating. ACS Applied Materials and Interfaces, 10, pp. 3058-3068. (doi: 10.1021/acsami.7b15178)
Wang, J., Al-Khalidi, A., Morariu, R., Ofiare, A., Wang, L., Wasige, E. (2018) 15 Gbps Wireless Link Using W-band Resonant Tunnelling Diode Transmitter. (doi: 10.23919/EuRAD.2018.8546598)
Usman, M., Rizwan Asghar, M., Ansari, I. S., Granelli, F., Abbasi, Q. H., Qaraqe, K. (2018) A Marketplace for Efficient and Secure Caching for IoT Applications in 5G Networks. (doi: 10.1109/WCNC.2018.8377254)
Elksne, M., Al-Khalidi, A., Wasige, E. (2018) AlGaN/GaN HEMT with Distributed Gate for Improved Thermal Performance. (doi: 10.23919/EuMIC.2018.8539896)
Clarke, R.G., Li, C., Ridler, N.M. (2018) An Intra-laboratory Investigation of On-wafer Measurement Reproducibility at Millimeter-wave Frequencies. (doi: 10.1109/ARFTG.2017.8255866)
Al-Khalidi, A., Wang, J., Wasige, E. (2018) Compact J-band Oscillators with 1 mW RF Output Power and over 110 GHz Modulation Bandwidth. (doi: 10.1109/IRMMW-THz.2018.8510099)
Li, J., Fan, H., Wu, Y., Feng, Q., Heidari, H. (2018) Comparator Design in Sensors for Environmental Monitoring. (doi: 10.1088/1755-1315/151/1/012030)
Abdellatif, S., Kirah, K., Ghannam, R., Khalil, A.S.G., Anis, W. (2018) Comprehensive Study of Various Light Trapping Techniques Used for Sandwiched Thin Film Solar Cell Structures. (doi: 10.1117/12.2291613)
Fan, H., Li, J., Qin, Y., Feng, Q., Li, D., Hu, D., Cen, Y., Heidari, H. (2018) Design of sensor system for air pollution monitoring. Springer
Fan, X., Sun, W., Ren, A., Fan, D., Zhao, N., Haider, D., Yang, X., Abbasi, Q. H. (2018) Detection and diagnosis of paralysis agitans. IEEE Access, 6, pp. 73023-73029. (doi: 10.1109/ACCESS.2018.2882134)
Wu, A., Li, C., Sun, J., Wang, Y., Liu, C. (2018) Development of a Verification Technique for On-wafer Noise Figure Measurement Systems. (doi: 10.1109/ARFTG.2017.8255878)
Saberi Moghaddam, R., Draper, E. R., Wilson, C., Heidari, H., Adams, D. J. (2018) Effect of electric field on the electrical properties of a self-assembled perylene bisimide. RSC Advances, 8, pp. 34121-34125. (doi: 10.1039/C8RA06870D)
Dahiya, R., Navaraj, W. T., García Núñez, C., Shakthivel, D., Liu, F. (2018) Electronic Skin with Energy Autonomy and Distributed Neural Data Processing.
Zhang, R., Yang, K., Abbasi, Q., AbuAli, N. A., Alomainy, A. (2018) Experimental Characterization of Artificial Human Skin with Melanomas for Accurate Modelling and Detection in Healthcare Application. (doi: 10.1109/IRMMW-THz.2018.8509886)
Garcia Nunez, C., Liu, F., Xu, S., Dahiya, R. (2018) Integration Techniques for Micro/Nanostructure-Based Large-Area Electronics. Cambridge University Press
Jilani, S. F., Aziz, A. K., Abbasi, Q. H., Alomainy, A. (2018) Ka-band Flexible Koch Fractal Antenna with Defected Ground Structure for 5G Wearable and Conformal Applications. (doi: 10.1109/PIMRC.2018.8580692)
Cheah, B. C., Cumming, D. R.S. (2018) Metabolomics on CMOS for personalised medicine. Springer
Fan, H., Heidari, H., Maloberti, F., Li, D., Hu, D., Cen, Y. (2018) Method for improving sfdr and sndr of capacitor-resistor combined sar adc by capacitor re-configuration.
Abdelaziz, A., Yang, K., Qaraqe, K., Boutros, J., Abbasi, Q. H., Alomainy, A. (2018) Multiple Antenna Techniques for Terahertz Nano-Bio Communication. (doi: 10.1109/MECBME.2018.8402408)
Ren, A., Qing, M., Zhao, N., Wang, M., Gao, G., Yang, X., Zhang, Z., Hu, F., Ur Rehman, M., Abbasi, Q. H. (2018) Nano-ferrite near-field microwave imaging for in-body applications. IEEE Access, 6, pp. 29551-29557. (doi: 10.1109/ACCESS.2018.2843780)
Zhang, W., Watson, S., Wang, J., Figueiredo, J., Wasige, E., Kelly, A. E. (2018) Optical Characteristics Analysis of Resonant Tunneling Diode Photodiode Based Oscillators. (doi: 10.1109/VTCSpring.2018.8417889)
Li, X., Zhou, H., Flores, K., Cho, S.-J., Hemakumara, D., Moran, D., Thayne, I. (2018) Optimization of Atomic Layer Etch Process for Fabrication of Dual Barrier GaN-Based Power Device Using In-Situ Auger Spectrometric Surface Analysis.
Kumar, D., Gomes, T., Alves, N., Kettle, J. (2018) Understanding UV Sensor Performance in ZnO TFTs through the Application of Multivariate Analysis. (doi: 10.1109/ICSENS.2018.8630303)
2017
Vilouras, A., Navaraj, W., Heidari, H., Dahiya, R. (2017) Flexible Pressure Sensing System for Tongue-Based Control of Prosthetic Hands. (doi: 10.1109/ICSENS.2017.8234020)
Li, H., Shrestha, A., Fioranelli, F., Le Kernec, J., Heidari, H., Pepa, M., Cippitelli, E., Gambi, E., Spinsante, S. (2017) Multisensor Data Fusion for Human Activities Classification and Fall Detection. (doi: 10.1109/ICSENS.2017.8234179)
Shah, S., Heidari, H. (2017) On-chip Magnetoresistive Sensors for Detection and Localization of Paramagnetic Particles. (doi: 10.1109/ICSENS.2017.8233894)
García Núñez, C., Taube, W., Liu, F., Dahiya, R. (2017) ZnO Nanowires Based Flexible UV Photodetectors for Wearable Dosimetry. (doi: 10.1109/ICSENS.2017.8234428)
Xie, C., Aziz, M., Pusino, V., Khalid, A., Steer, M., Thayne, I. G., Sorel, M., Cumming, D. R.S. (2017) Single-chip, mid-Infrared array for room temperature video rate imaging. Optica, 4, pp. 1498-1502. (doi: 10.1364/OPTICA.4.001498)
al-Khateeb, H., Epiphaniou, G., Reviczky, A., Karadimas, P., Heidari, H. (2017) Proactive threat detection for connected cars using recursive Bayesian estimation. IEEE Sensors Journal, 18, pp. 4822-4831. (doi: 10.1109/JSEN.2017.2782751)
Ur Rehman, M., Malik, N. A., Yang, X., Abbasi, Q. H., Zhang, Z., Zhao, N. (2017) A low profile antenna for millimeter-wave body-centric applications. IEEE Transactions on Antennas and Propagation, 65, pp. 6329-6337. (doi: 10.1109/TAP.2017.2700897)
(2017) CMOS Circuits for Biological Sensing and Processing. (doi: 10.1007/978-3-319-67723-1)
Dong, B., Ren, A., Shah, S. A., Hu, F., Zhao, N., Yang, X., Haider, D., Zhang, Z., Zhao, W., Abbasi, Q. H. (2017) Monitoring of atopic dermatitis using leaky coaxial cable. Healthcare Technology Letters, 4, pp. 244-248. (doi: 10.1049/htl.2017.0021)
Alduais, N.A.M., Abdullah, J., Jamil, A., Heidari, H. (2017) Performance evaluation of real-time multivariate data reduction models for adaptive-threshold in wireless sensor networks. IEEE Sensors Letters, 1, (doi: 10.1109/LSENS.2017.2768218)
Fan, H., Liu, Y., Li, J., Maloberti, F., Feng, Q., Li, D., Hu, D., Cen, Y., Heidari, H. (2017) Towards highly linear high resolution successive approximation register ADCs for the Internet of Things. Nanoscience and Nanotechnology Letters, 9, pp. 2076-2082. (doi: 10.1166/nnl.2017.2543)
Cochran, S., Button, T.W., Cox, B.F., Cumming, D.R.S., Gourevich, D., Lay, H.S., Mulvana, H., Nathke, I.S., Stewart, F. (2017) Nanotechnology in Multimodal Theranostic Capsule Endoscopy. (doi: 10.1109/NANO.2017.8117439)
Zhang, R., Yang, K., Abbasi, Q. H., Qaraqe, K. A., Alomainy, A. (2017) Investigating the Impact of Fibroblast Cell Density on Optical Properties of Dermal Equivalents Using Terahertz Time Domain Spectroscopy.
Mahmood, A., Aman, W., Iqbal, M. O., Rahman, M. M. U., Abbasi, Q. H. (2017) Channel Impulse Response-based Distributed Physical Layer Authentication. (doi: 10.1109/VTCSpring.2017.8108524)
Iqbal, M. O., Mahmood, A., Rahman, M. M. U., Abbasi, Q. H. (2017) Distributed Beamforming with Wirelessly Powered Relay Nodes. (doi: 10.1109/VTCSpring.2017.8108316)
Rahman, M. M. U., Yasmeen, A., Abbasi, Q. H. (2017) Exploiting Lack of Hardware Reciprocity for Sender-Node Authentication at the PHY Layer. (doi: 10.1109/VTCSpring.2017.8108526)
Votsi, H., Li, C., Aaen, P. H., Ridler, N. M. (2017) An active interferometric method for extreme impedance on-wafer device measurements. IEEE Microwave and Wireless Components Letters, 27, pp. 1034-1036. (doi: 10.1109/LMWC.2017.2750086)
Yang, K., Chopra, N., Abbasi, Q. H., Qaraqe, K., Alomainy, A. (2017) Dielectric Constant Measurement of Collagen at Terahertz Band Using Terahertz Time Domain Spectroscopy. (doi: 10.1109/APUSNCURSINRSM.2017.8072801)
Kenney, M., Grant, J., Shah, Y. D., Escorcia-Carranza, I., Humphreys, M., Cumming, D. R.S. (2017) Octave-spanning broadband absorption of terahertz light using metasurface fractal-cross absorbers. ACS Photonics, 4, pp. 1604-1612. (doi: 10.1021/acsphotonics.7b00906)
Wang, J., Al-Khalidi, A., Zhang, C., Ofiare, A., Wang, L., Wasige, E., Figueiredo, J. M. L. (2017) Resonant Tunneling Diode as High Speed Optical/Electronic Transmitter. (doi: 10.1109/UCMMT.2017.8068497)
Chattha, H. T., Nasir, M., Abbasi, Q. H., Huang, Y., Aljaafreh, S. S. (2017) Planar inverted-f antenna for universal serial bus dongle applications. Turkish Journal of Electrical Engineering and Computer Sciences, 25, pp. 4280-4286. (doi: 10.3906/elk-1701-19)
Anizelli, H. S., Stoichkov, V., Fernandes, R. V., Duarte, J. L., Laureto, E., Kettle, J., Visoly-Fisher, I., Katz, E. A. (2017) Application of luminescence downshifting materials for enhanced stability of CH3NH3PbI3(1-x)Cl3x perovskite photovoltaic devices. Organic Electronics, 49, pp. 129-134. (doi: 10.1016/j.orgel.2017.06.056)
Liang, X., Heidari, H., Dahiya, R. (2017) Wearable Capacitive-based Wrist-worn Gesture Sensing System. (doi: 10.1109/NGCAS.2017.80)
Al-Rawhani, M. A., Cheah, B. C., Giagkoulovits, C., Shakoor, A., Nagy, B., Beeley, J., Cumming, D. R.S. (2017) Wide-Range Optical CMOS-Based Diagnostics. (doi: 10.1109/ISCAS.2017.8050214)
Taube Navaraj, W., García Núñez, C., Shakthivel, D., Vinciguerra, V., Labeau, F., Gregory, D. H., Dahiya, R. (2017) Nanowire FET based neural element for robotic tactile sensing skin. Frontiers in Neuroscience, 11, (doi: 10.3389/fnins.2017.00501)
Wang, J., Al-Khalidi, A., Zhang, C., Cornescu, A., Morariu, R., Wasige, E. (2017) Resonant Tunneling Diode Oscillator Source for Terahertz Applications.
Kenney, M., Grant, J., Shah, Y. D., Escorcia-Carranza, I., Humphreys, M., Cumming, D. (2017) Fractal Metasurface Absorbers with Octave-Spanning Bandwidth.
Li, C., Liua, C., Wua, A., Ridlera, N. (2017) Uncertainty Analysis of Calibration Standards for On-wafer Measurements over 110 GHz.
Aziz, M., Xie, C., Pusino, V., Khalid, A., Steer, M., Thayne, I. G., Cumming, D. R.S. (2017) Multispectral mid-infrared light emitting diodes on a GaAs substrate. Applied Physics Letters, 111, (doi: 10.1063/1.4986396)
Demir, A. F., Abbasi, Q. H., Ankarali, Z. E., Alomainy, A., Qaraqe, K., Serpedin, E., Arslan, H. (2017) Anatomical region-specific in vivo wireless communication channel characterization. IEEE Journal of Biomedical and Health Informatics, 21, pp. 1254-1262. (doi: 10.1109/JBHI.2016.2618890)
Heidari, H., Wacker, N., Dahiya, R. (2017) Bending induced electrical response variations in ultra-thin flexible chips and device modeling. Applied Physics Reviews, 4, (doi: 10.1063/1.4991532)
García Núñez, C., Taube, W., Dahiya, R. (2017) Electronic-Skin Based on Graphene for Robotics.
Glover, J., Khalid, A., Cumming, D., Dunn, G. M., Kuball, M., Bajo, M. M., Oxley, C. H. (2017) Thermal profiles within the channel of planar gunn diodes using micro-particle sensors. IEEE Electron Device Letters, 38, pp. 1325-1327. (doi: 10.1109/LED.2017.2731961)
Watson, S., Zhang, W., Wang, J., Al-Khalidi, A., Cantu, H., Figueiredo, J., Wasige, E., Kelly, A. E. (2017) Resonant Tunneling Diode Oscillators for Optical Communications. (doi: 10.1117/12.2276319)
Bissell, V., Rodrigues, G. C., Wang, J., Al-Khalidi, A., Alharbi, K. H., Wasige, E. (2017) Resonant Tunneling Diode Photodetectors for Optical Communications. (doi: 10.1117/12.2271317)
Salter, P. S., Booth, M. J., Courvoisier, A., Moran, D. A.J., MacLaren, D. A. (2017) High resolution structural characterisation of laser-induced defect clusters inside diamond. Applied Physics Letters, 111, (doi: 10.1063/1.4993118)
Floros, K., Li, X., Guiney, I., Cho, S.-J., Hemakumara, D., Wallis, D. J., Wasige, E., Moran, D. A.J., Humphreys, C. J., Thayne, I. G. (2017) Dual barrier InAlN/AlGaN/GaN-on-silicon high-electron-mobility transistors with Pt and Ni based gate stacks. Physica Status Solidi A: Applications and Materials Science, 214, (doi: 10.1002/pssa.201600835)
Li, C., Loh, T.-H., Tian, Z., Xu, Q., Huang, Y. (2017) Evaluation of chamber effects on antenna efficiency measurements using non-reference antenna methods in two reverberation chambers. IET Microwaves, Antennas and Propagation, 11, pp. 1536-1541. (doi: 10.1049/iet-map.2015.0838)
Kettle, J., Stoichkov, V., Kumar, D., Corazza, M., Gevorgyan, S.A., Krebs, F.C. (2017) Using ISOS consensus test protocols for development of quantitative life test models in ageing of organic solar cells. Solar Energy Materials and Solar Cells, 167, pp. 53-59. (doi: 10.1016/j.solmat.2017.04.005)
Hemakumara, D., Li, X., Floros, K., Cho, S., Guiney, I., Moran, D., Humphreys, C., O'Mahony, A., Knoops, H., Thayne, I. G. (2017) 4x Reduction in Gan MOSCAP Flatband Voltage Hysteresis with an In-situ Deposited Sin Cap and Device Processing in a Cluster Tool.
Fan, H., Maloberti, F., Li, D., Hu, D., Cen, Y., Heidari, H. (2017) Capacitor Mismatch Calibration Technique to Improve the SFDR of 14-Bit SAR ADC. (doi: 10.1109/ISVLSI.2017.97)
Heidari, H., Liu, F., Dahiya, R. (2017) Towards flexible magnetoelectronics for robotic applications. (doi: 10.1109/ACIRS.2017.7986111)
Kultavewuti, P., Zhu, E. Y., Xing, X., Qian, L., Pusino, V., Sorel, M., Aitchison, J. S. (2017) Polarization-entangled photon pair sources based on spontaneous four wave mixing assisted by polarization mode dispersion. Scientific Reports, 7, (doi: 10.1038/s41598-017-06010-8)
Li, X., Fu, Y.-C., Peralagu, S., Cho, S., Floros, K., Hemakumara, D., Smith, M., Guiney, I., Moran, D., Humphreys, C., Thayne, I.G. (2017) Atomic layer etch processes developed in an ICP/RIE etching system for etching III-V compound semiconductor materials.
Yang, X., Fang, M., Ren, A., Zhang, Z., Abbasi, Q. H., Alomainy, A., Mehran, K., Hao, Y. (2017) Reverse recognition of body postures using on-body radio channel characteristics. IET Microwaves, Antennas and Propagation, 11, pp. 1212-1217. (doi: 10.1049/iet-map.2016.0990)
Hemakumara, D., Li, X., Cho, S., Floros, K., Guiney, I., Moran, D., Humphreys, C., O'Mahony, A., Knoops, H., Thayne, I.G. (2017) The Impact on GaN MOS Capacitor Performance of In‐situ Processing in a Clustered ALD/ICP/RIE Tool.
Stewart, F. R., Qiu, Y., Lay, H. S., Newton, I. P., Cox, B. F., Al-Rawhani, M. A., Beeley, J., Liu, Y., Huang, Z., Cumming, D. R.S., Näthke, I., Cochran, S. (2017) Acoustic sensing and ultrasonic drug delivery in multimodal theranostic capsule endoscopy. Sensors, 17, (doi: 10.3390/s17071553)
Escorcia Carranza, I., Grant, J. P., Gough, J., Cumming, D. (2017) Terahertz metamaterial absorbers implemented in CMOS technology for imaging applications: scaling to large format focal plane arrays. IEEE Journal of Selected Topics in Quantum Electronics, 23, (doi: 10.1109/JSTQE.2016.2630307)
Abbasi, Q. H., Nasir, A. A., Yang, K., Qaraqe, K., Alomainy, A. (2017) Cooperative in-vivo nano-network communication at terahertz frequencies. IEEE Access, 5, pp. 8642-8647. (doi: 10.1109/ACCESS.2017.2677498)
Zhang, R., Yang, K., Abbasi, Q. H., Qaraqe, K. A., Alomainy, A. (2017) Analytical characterisation of the terahertz in-vivo nano-network in the presence of interference based on TS-OOK communication scheme. IEEE Access, 5, pp. 10172-10181. (doi: 10.1109/ACCESS.2017.2713459)
Cornescu, A., Wang, J., Al-Khalidi, A., Morariu, R., Wasige, E. (2017) IV Characteristics of a Stabilized Resonant Tunnelling Diodes.
Wang, J., Al-Khalidi, A., Cornescu, A., Morariu, R., Khalid, A.-u.-H., Cumming, D., Wasige, E. (2017) Loading Effect of W-band Resonant Tunneling Diode Oscillator by Using Load-Pull Measurement.
García Núñez, C., Navaraj, W. T., Polat, E. O., Dahiya, R. (2017) Energy autonomous flexible and transparent tactile skin. Advanced Functional Materials, 27, (doi: 10.1002/adfm.201606287)
Vilouras, A., Heidari, H., Gupta, S., Dahiya, R. (2017) Modeling of CMOS devices and circuits on flexible ultrathin chips. IEEE Transactions on Electron Devices, 64, pp. 2038-2046. (doi: 10.1109/TED.2017.2668899)
Ur-Rehman, M., Abbasi, Q. H., Rahman, A., Khan, I., Chattha, H. T., Matin, M. A. (2017) Millimetre-wave antennas and systems for the future 5G. International Journal of Antennas and Propagation, 2017, (doi: 10.1155/2017/6135601)
Wasige, E., Al-Khalidi, A., Alharbi, K., Wang, J. (2017) High performance microstrip resonant tunneling diode oscillators as terahertz sources. (doi: 10.1109/UCMMT.2016.7873950)
Li, X., Floros, K., Cho, S.-J., Hemakumara, D., Moran, D., Thayne, I. (2017) Damage to Algan/Gan Power Device Materials from Cl2 and Ar Plasma Based Atomic Layer Etching and its Elimilation via a Low Temperature Rapid Thermal Annealing.
Wasige, E., Alharbi, K. H., Al-Khalidi, A., Wang, J., Khalid, A. (2017) Resonant Tunnelling Diode Terahertz Sources for Broadband Wireless Communications. (doi: 10.1117/12.2256357)
Redondo-Cubero, A., Gómez-Castaño, M., García Núñez, C., Domínguez, M., Vázquez, L., Pau, J.L. (2017) Zinc Nitride Thin Films: Basic Properties and Applications. (doi: 10.1117/12.2253044)
Shakoor, A., Cheah, B. C., Hao, D., Al-Rawhani, M., Nagy, B., Grant, J., Dale, C., Keegan, N., McNeil, C., Cumming, D. R.S. (2017) Monolithic Integration of a Plasmonic Sensor with CMOS Technology. (doi: 10.1117/12.2250504)
Wen, S., Heidari, H., Vilouras, A., Dahiya, R. (2017) A Wearable Fabric-Based RFID Skin Temperature Monitoring Patch. (doi: 10.1109/ICSENS.2016.7808919)
Alharbi, K. H., Khalid, A., Ofiare, A., Wang, J., Wasige, E. (2017) Diced and grounded broadband bow-tie antenna with tuning stub for resonant tunnelling diode terahertz oscillators. IET Microwaves, Antennas and Propagation, 11, pp. 310-316. (doi: 10.1049/iet-map.2016.0395)
Shakoor, A., Grande, M., Grant, J., Cumming, D. R.S. (2017) One-dimensional silicon nitride grating refractive index sensor suitable for integration with CMOS detectors. IEEE Photonics Journal, 9, (doi: 10.1109/JPHOT.2016.2644962)
Heidari, H., Liu, F., Dahiya, R. (2017) Magnetoelectronics on Bendable Ultra-Thin Si Chips.
Navaraj, W., Shakthivel, D., García Núñez, C., Liu, F., Gregory, D., Dahiya, R. (2017) Metal-Assisted Chemical Etched Si Nanowires for High-Performance Large Area Flexible Electronics.
Roger, I., Moca, R., Miras, H., Crawford, K. G., Moran, D. A.J., Ganin, A. Y., Symes, M. D. (2017) The direct hydrothermal deposition of cobalt-doped MoS2 onto fluorine-doped SnO2 substrates for catalysis of the electrochemical hydrogen evolution reaction. Journal of Materials Chemistry A, 5, pp. 1472-1480. (doi: 10.1039/C6TA08287D)
Taube, W., Liu, F., Vilouras, A., Shakthivel, D., Garcia Nunez, C., Heidari, H., Labeau, F., Gregory, D., Dahiya, R. (2017) Modelling of Nanowire FETs Based Neural Network for Tactile Pattern Recognition in E-Skin. (doi: 10.1109/BioCAS.2016.7833859)
Alharbi, K. H., Khalid, A., Ofiare, A., Wang, J., Wasige, E. (2017) Broadband Bow-Tie Slot Antenna with Tuning Stub for Resonant Tunnelling Diode Oscillators with Novel Configuration for Substrate Effects Suppression. (doi: 10.1109/EuMC.2016.7824369)
Wang, J., Al-Khalidi, A., Alharbi, K., Ofiare, A., Zhou, H., Wasige, E., Figueiredo, J. (2017) High Performance Resonant Tunneling Diode Oscillators as Terahertz Sources. (doi: 10.1109/EuMC.2016.7824348)
Al-Rawhani, M. A., Cheah, B. C., MacDonald, A. I., Martin, C., Hu, C., Beeley, J., Gouveia, L. C., Grant, J. P., Campbell, G., Barrett, M. P., Cumming, D. R.S. (2017) A colorimetric CMOS-based platform for rapid total serum cholesterol quantification. IEEE Sensors Journal, 17, pp. 240-247. (doi: 10.1109/JSEN.2016.2629018)
Heidari, H., Garcia Nunez, C., Dahiya, R. (2017) E-Skin Module with Heterogeneously Integrated Graphene Touch Sensors and CMOS Circuitry. (doi: 10.1109/ICSENS.2016.7808760)
El-Sallabi, H., Aldosari, A., Abbasi, Q. H. (2017) Modeling of Fading Figure for Non-stationary Indoor Radio Channels. (doi: 10.1109/MMS.2016.7803820)
Zhang, R., Yang, K., Alomainy, A., Abbasi, Q. H., Qaraqe, K., Shubair, R. M. (2017) Modelling of the Terahertz Communication Channel for In-vivo Nano-networks in the Presence of Noise. (doi: 10.1109/MMS.2016.7803812)
Chopra, N., Phipott, M., Alomainy, A., Abbasi, Q. H., Qaraqe, K., Shubair, R. M. (2017) THz Time Domain Characterization of Human Skin Tissue for Nano-Electromagnetic Communication. (doi: 10.1109/MMS.2016.7803787)
Dhillon, S.S. et al. (2017) The 2017 terahertz science and technology roadmap. Journal of Physics D: Applied Physics, 50, (doi: 10.1088/1361-6463/50/4/043001)
Lei, K.-M., Heidari, H., Mak, P.-I., Law, M.-K., Maloberti, F., Martins, R. P. (2017) A handheld high-sensitivity micro-NMR CMOS platform with B-field stabilization for multi-type biological/chemical assays. IEEE Journal of Solid-State Circuits, 52, pp. 284-297. (doi: 10.1109/JSSC.2016.2591551)
Ridler, N., Li, C. (2017) Benchmarking Electrical Loss in Rectangular Metallic Waveguide at Submillimeter Wavelengths. (doi: 10.1109/UCMMT.2017.8068355)
Davy, A., Pessoa, L., Renaud, C., Wasige, E., Naftaly, M., Kurner, T., George, G., Cojocari, O., O'Mahony, N., Porcel, M. A. G. (2017) Building an end user focused THz based ultra high bandwidth wireless access network: The TERAPOD approach. (doi: 10.1109/ICUMT.2017.8255205)
Escorcia Carranza, I., Grant, J., Gough, J., Cumming, D. R.S. (2017) CMOS Terahertz Metamaterial Based 64 × 64 Bolometric Detector Arrays. (doi: 10.1109/IRMMW-THz.2017.8067138)
Yang, K., Chopra, N., Abbasi, Q. H., Qaraqe, K., Alomainy, A. (2017) Collagen analysis at terahertz band using double-debye parameter extraction and particle swarm optimisation. IEEE Access, 5, pp. 27850-27856. (doi: 10.1109/ACCESS.2017.2674520)
Fernandes, R. V., Bristow, N., Stoichkov, V., Anizelli, H. S., Duarte, J. L., Laureto, E., Kettle, J. (2017) Development of multidye UV filters for OPVs using luminescent materials. Journal of Physics D: Applied Physics, 50, (doi: 10.1088/1361-6463/50/2/025103)
Gupta, S., Vilouras, A., Heidari, H., Dahiya, R. (2017) Device Modelling of Silicon Based High-Performance Flexible Electronics. (doi: 10.1109/ISIE.2017.8001578)
Fan, H., Heidari, H., Maloberti, F., Li, D., Hu, D., Cen, Y. (2017) High Resolution and Linearity Enhanced SAR ADC for Wearable Sensing Systems.
Giagkoulovits, C., Al-Rawhani, M. A., Cheah, B. C., Martin, C., Busche, C., Cronin, L., Cumming, D. R.S. (2017) Hybrid Amperometric and Potentiometric Sensing Based on a CMOS ISFET Array. (doi: 10.1109/ICSENS.2017.8234249)
Cheah, B. C., MacDonald, A. I., Barrett, M. P., Cumming, D. R.S. (2017) Metabolomics on integrated circuit. Procedia Technology, 27, pp. 53-54. (doi: 10.1016/j.protcy.2017.04.025)
Kumar, D., Stoichkov, V., Ghosh, S., Smith, G.C., Kettle, J. (2017) Mixed-dimension silver nanowires for solution-processed, flexible, transparent and conducting electrodes with improved optical and physical properties. Flexible and Printed Electronics, 2, (doi: 10.1088/2058-8585/aa6011)
Shakthivel, D., Liu, F., García Núñez, C., Taube, W., Dahiya, R. (2017) Nanomaterials Processing for Flexible Electronics. (doi: 10.1109/ISIE.2017.8001581)
García Nuñez, C., Braña, A. F., Lopez, N., Pau, J. L., García, B. J. (2017) Photodetector Fabrication by Dielectrophoretic Assembly of GaAs Nanowires Grown by a Two-steps Method. (doi: 10.1117/12.2274007)
Rahman, M. M. U., Abbasi, Q. H., Chopra, N., Qaraqe, K., Alomainy, A. (2017) Physical layer authentication in nano networks at terahertz frequencies for biomedical applications. IEEE Access, 5, pp. 7808-7815. (doi: 10.1109/ACCESS.2017.2700330)
Mitra, S., Cumming, D. R.S. (2017) Preface. Springer
Wang, J., Rodrigues, G. C., Al-Khalidi, A., Figueiredo, J. M.L., Wasige, E. (2017) Resonant tunnelling diode based high speed optoelectronic transmitters. (doi: 10.1117/12.2276350)
Postgraduate research students
Refine By
-
{{student.surname}} {{student.forename}}
{{student.surname}} {{student.forename}}
({{student.subject}})
{{student.title}}
The Electronics research cluster brings together world-leading expertise across high-frequency systems, micro/nanoelectronics, microsystem technologies, and sustainable device design.
Our interdisciplinary teams are advancing the next generation of electronic systems, addressing global challenges in communication, sensing, medical diagnostics, and sustainability.
Research division
PhD opportunities
Find out more about PhD opportunities with the Electronics research cluster:

RF, Telecom and Sensing
We develop novel microwave, mmWave and THz components, devices and circuits as well as emerging materials and technologies for wireless sensing, imaging, communications and energy harvesting.
Our group covers a wide range of both basic and applied research focusing on first principles of engineering science with a goal to realise efficient and optimized wireless systems and components for communications, sensing and imaging applications.
Our research focus is on advanced technologies and circuits for the microwave, millimeterwave, and/or sub-millimeterwave (aka terahertz) frequency bands and the integration of these with other physical domains to achieve new system functionality.
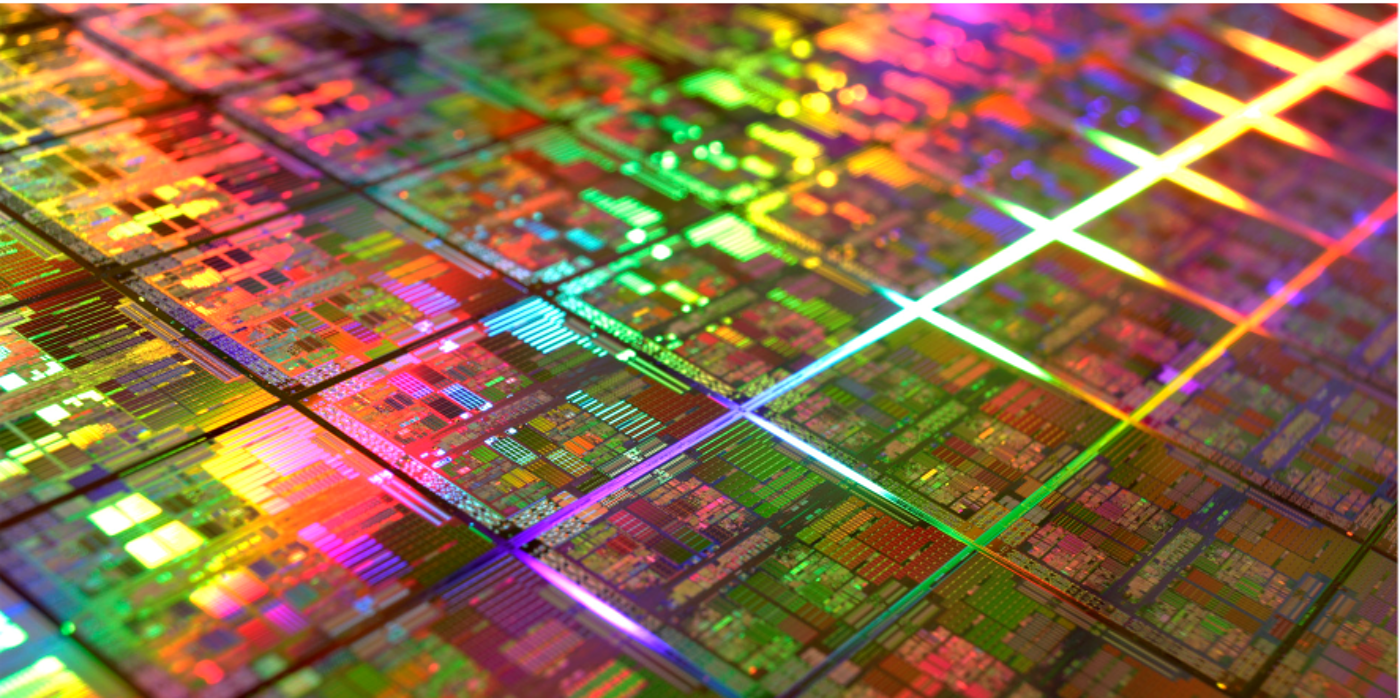
Nanoelectronics & Microsystems
We work on micro/nanoelectronics design for medical (wearables and implantables) and industrial (quantum computing and ultrasound systems) applications. Our research is broadly ranging from theoretical, simulation, design, fabrication and experimental work in fundamental physics to applications of materials and electronics.
Our group researches and develops a wide range of leading-edge technologies including: Combined electronic sensor and actuator systems; Medical diagnostic devices; Integrated single-chip CMOS sensor devices Sensor arrays; Wireless sensors; Terahertz technology and systems; and Control and data processing hardware and software for sensor systems'

Advanced Electronic Materials
-
Advanced Semiconductor Materials & Devices:
Our group specialises in the research and development of advanced semiconductor materials and devices for a range of electronic, sensing and quantum applications.
Design and manufacture of sustainable electronics using additive manufacturing and cleanroom processes for applications across sensors, computing, to wearables. We design low-waste electronics for recyclability, reliability and sustainability using less hazardous materials, and conduct leading life-cycle assessment (LCAs) of electronic systems.

